“半导体制造和封装正在融合,在这个过程当中,封装已经成为一个非常重要、有趣的创新所在”英特尔封装研究与系统解决方案总监Johanna Swan如是说。
正如我们所见,在当今半导体市场当中,那些少数还在致力于先进制程发展的企业们,都开始向先进封装技术方向进行拓展。而这也意味着封装技术,尤其是先进封装技术已经被业界视为是继续推进摩尔定律继续发展的关键之一。
同时,这种融合也促进了晶圆代工市场的变化。在这其中,发生在英特尔身上的改变最为受到关注。那么,对于英特尔来说,封装技术到底扮演着怎样的一个角色,他们又是如何看待封装技术的发展,很值得我们去探究。
封装技术所扮演的角色
作为IDM模式的代表,在英特尔新任CEO帕特·基辛格走马上任后,这个引领者半导体行业数十年发展的企业宣布,要迎接制造业的新纪元,即IDM 2.0。帕特·基辛格曾强调在IDM 2.0时代,英特尔的核心能力依然是设计、制造、封装一体化的能力。
我们看到,在封装技术的重要性日益凸显的今天,在英特尔宣布英特尔将迈入IDM 2.0后,先进封装的重要性也得到了重点强调。
帕特·基辛格曾指出,英特尔在封装技术方面的领先性,是一项重要的差异化因素。这使英特尔能够在一个普适计算的世界中,通过将多种IP或芯片封装在一起,从而交付独一无二、定制化的产品,满足客户多样性的需求。
如果说,曾经英特尔的先进封装技术,只有英特尔的产品才能享受得到。那么在IDM 2.0的时代里,英特尔的先进封装技术很有可能被更多的产品采用。
这要归功于,英特尔所提出的英特尔代工服务(IFS)。在此前的报道中,曾有媒体这样描述IFS的优势——IFS事业部与其他代工服务的差异化在于,它结合了领先的制程和封装技术,并支持x86内核、ARM和RISC-V生态系统IP的生产,从而为客户交付世界级的IP组合。
对此,Johanna Swan也在接受半导体行业观察的采访时称:“可以肯定的是,英特尔代工厂客户将可以使用我们已准备好部署的前沿封装技术,包括2D、2.5D或3D技术。”
据Johanna Swan介绍,在进入到IDM 2.0时代后,英特尔将继续开发2D、2.5D 和 3D 等先进封装技术。英特尔也会将这些技术提供给代工客户,以满足他们独特的产品需求。
Hybrid Bonding将成为英特尔先进封装发展关键
从上述这些回复中,我们可以发现,先进封装将成为未来产品实现差异化的关键。因此,对于先进封装的理解,以及区别于其他代工厂商在先进封装上的优势,可能会成为其先进封装技术是否能被更大的市场所接纳的关键所在。
在英特尔看来,在功率效率、互连密度和可扩展性等方面的提升,是指引着英特尔先进封装发展的明灯。以此为基础,英特尔也曾在其架构日上展示了其封装技术路线图。

如图所示,从标准封装到EMIB(嵌入式多管芯互联桥接)再到Foveros,凸点间距从100μm缩减到50-25μm。而无论是EMIB(嵌入式多管芯互联桥接)还是Foveros,这都是英特尔在先进封装领域的过往,对于未来,他们将怎么走下去?
Johanna Swan表示:“我们拥有的发展机会是在每毫米立方体上提供最多的区块并获得每毫米立方体最多的功能。但在这方面我们还没有走到极限。”
基于这种理解,英特尔也将在未来致力于开发小于10微米凸点间距的封装技术。
在英特尔看来,混合结合(Hybrid Bonding)是实现小于10微米凸点间距的关键技术之一。Hybrid Bonding也是去年英特尔在其架构上首次提出的方案。在今年的 ECTC中,英特尔再次公布了关于Hybrid Bonding的一些细节。据英特尔介绍,采用Hybrid Bonding还可实现更小的外形尺寸。

据介绍,凸点间距为50微米的Foveros,在每平方毫米中包含大约 400 个凸点。但对实现小于10微米的凸点间距的Hybrid Bonding,则可在每平方毫米容纳10,000 个凸点。Johanna Swan表示表示:“这样,我们便可以在两个芯片之间实现更多的互连,这也意味着采用这种方式可以提供更小、更简单的电路,因为它们实际上可以相互叠加。因此,也不必做扇入(fan-in)和扇出(fan-out)。有了这个更简单的电路,我们可以使用更低的电容。然后开始降低该通道的功率。”
与此同时,Johanna Swan也指出,由于Foveros和Hybrid Bonding在组装工艺上存在着差异,因此,在使用Hybrid Bonding时,需要一种新的制造、清洁和测试方法。

采用Hybrid Bonding的初衷是为了将更多的IP或区块(tile)集成在一起,同时实现芯片到芯片的互连。而这就意味着,从焊接转向Hybrid Bonding,即要保持制造流程以相同的速度进行,还要将更多的IP或芯片放置在一起。
为解决这一挑战,英特尔正在考虑的解决方案是进行批量组装,他们称之为自组装。据介绍,英特尔正在联手CEA-LETI 在推进混合结合(Hybrid Bonding)自组装研究。
Johanna Swan表示,混合结合(Hybrid Bonding)的技术进步同样可用于CO-EMIB和ODI架构,这些架构则是英特尔先进封装在可扩展性方面所推出的技术。


由此,我们可以看出,Hybrid Bonding不仅能够在功率效率、互连密度的提升上提供帮助,还可以在可扩展性方面提供支持。也因此,笔者认为Hybrid Bonding将成为英特尔先进封装发展关键。
先进封装将走向何处?
市场是驱动封装技术升级的重要因素。
“提供独特的解决方案,推动了我们关注的技术。”Johanna Swan表示:“产品需求的不断进化,才是真正推动封装需要转变的原因。”她认为,封装技术进步会随着用户的差异化需求而出现。
在Johanna Swan看来,定制化是实现下一阶段异构集成的真正原因。因此,市场将需要获得更多不同的节点或 IP 组合,在不同的制程或节点上执行此操作。通过这种混合搭配,可以为特定客户进行深度定制。
在此基础之上,Johanna Swan认为极致的异构集成是封装技术的未来趋势。她表示:“封装技术将继续具有缩小尺寸的特征,正如我们在架构日展示的那样,我们能够将越来越小的 IP 和越来越小的区块(tile)封装在一起。”
写在最后
制程&封装是英特尔未来发展的六大技术支柱之一。作为这个支柱当中重要的一部分,英特尔也对其封装技术进行了一系列的布局。这其中就包括在今年5月份,英特尔宣布,将投资35亿美元,为其位于新墨西哥州的里奥兰乔工厂配备先进的封装设备,包括Foveros技术,预计2021年底动工。
除此之外,英特尔在还在诸多半导体行业权威会议上所发表的论文和演讲当中,也频繁地讲到了他们对于先进封装的最近研究以及进展。
从这一系列动作当中,我们可以透过英特尔这一行业巨头,看到封装技术的价值正在发生变化。
发布评论请先 登录
五家大厂盯上,英特尔EMIB成了?
吉方工控亮相2025英特尔技术创新与产业生态大会
英特尔先进封装,新突破
英特尔先进封装:助力AI芯片高效集成的技术力量

为什么无法检测到OpenVINO™工具套件中的英特尔®集成图形处理单元?
请问OpenVINO™工具套件英特尔®Distribution是否与Windows® 10物联网企业版兼容?
英特尔任命王稚聪担任中国区副董事长
英特尔计划分拆RealSense深度摄像头业务
英特尔与Stellantis Motorsports携手推进自适应控制技术
英特尔IEDM 2024大晒封装、晶体管、互连等领域技术突破






 英特尔封装技术路线
英特尔封装技术路线


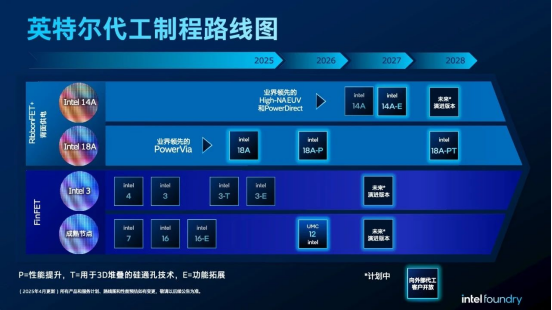











评论