为了适应目前电路组装高密度要求,微电子封装技术的发展日新月异,各种新技术、新工艺层出不穷。最新出现的CSP(芯片尺寸封装)使裸芯片尺寸与封装尺寸基本相近,这样在相同封装尺寸时有更多的I/O数,使电路组装密度大幅度提高。但是人们在应用中也发现,无论采用何种封装技术后的裸芯片,在封装后裸芯片的性能总是比未封装的要差一些。于是人们对传统的混合集成电路(HIC)进行彻底的改变,提出了多芯片组件(Multi Chip Module,即MCM)这种先进的封装模式。
MCM是90年代以来发展较快的一种先进混合集成电路,它把几块IC芯片或CSP组装在一块电路板上,构成功能电路板,就是多芯片组件,它是电路组件功能实现系统级的基础,图1展示了采用MCM封装技术的IBM Power 5处理器,可以清楚地看到它由八块芯片构成。随着MCM的兴起,使封装的概念发生了本质的变化,在80年代以前,所有的封装是面向器件的,而MCM可以说是面向部件的或者说是面向系统或整机。MCM技术集先进印刷电路板技术、先进混合集成电路技术、先进表面安装技术、半导体集成电路技术于一体,是典型的垂直集成技术,对半导体器件来说,它是典型的柔性封装技术,是一种电路的集成。MCM的出现使电子系统实现小型化、模块化、低功耗、高可靠性提供了更有效的技术保障,是微电子学领域的一项重大变革技术,对现代化的计算机、自动化、通讯业等领域将产生重大影响。
MCM的基本类型
根据互连和封装电子学会(IPC)标准,现在所用的MCM分为三类:MCM-C、MCM-D和MCM-L,分类按基材种类划分。MCM-C(Multi Chip Module-Ceramic)采用陶瓷烧制基材,导体是一层层烧制金属制成的,层间的通孔互连与导体一块生成。电阻可以在外层进行烧制,最后用激光修整到精确值。所有导体和电阻都印刷到基板上,加工方法颇为复杂;MCM-D(Multi Chip Module-Deposited Thin Film)采用沉积硅基片,制造过程类似于集成电路。基片是由硅和宽度在1 m~1mm之间的导体构成,通孔则是由各种金属通过真空沉积而形成;MCM-L(Multi Chip Module-Laminate)采用层压有机基材,制造采用普通印制板的加工方法。应用印刷和蚀刻法制成铜导线,钻出盲孔、埋孔和通孔并镀铜,内层的互连由EDA(电子设计自动化)软件设计来定。MCM-L由于采用普通的印制电路板的加工方法,具有低成本、工期短、投放市场时间短的绝对优势。
MCM的基本特点
MCM是在高密度多层互连基板上,采用微焊接、封装工艺将构成电子电路的各种微型元器件(IC裸芯片及片式元器件)组装起来,形成高密度、高性能、高可靠性的微电子产品(包括组件、部件、子系统、系统)。它是适应现代电子系统短、小、轻、薄和高速、高性能、高可靠性、低成本的发展方向而在多层印制板(PCB)和表面安装技术(SMT)的基础上发展起来的新一代微电子封装与组装技术,是实现系统集成的有力手段。典型的MCM应至少具有以下特点:
MCM是将多块未封装的IC芯片高密度安装在同一块基板上构成的部件,省去了IC的封装材料和工艺,节约了原材料,减少了制造工艺,缩小整机/组件封装尺寸和重量。
MCM是高密度组装产品,其互连线长度极大缩短,与封装好的SMD相比,减少了外引线寄生效应对电路高频,高速性能的影响,芯片间的延迟减少了75%。
MCM的多层布线基板导体层数应不小于4层,能把数字电路,模拟电路,功能器件,光电器件等合理地制作在同一部件内,构成多功能高性能子系统或系统,使线路之间的串扰噪声减少,阻抗易控,电路性能提高。
MCM技术多选用陶瓷材料作为组装基板,因此,与SMT用PCB基板相比,热匹配性能和耐冷热冲击力要强的多,因而使产品的可靠性获得了极大的提高。
MCM集中了先进的半导体IC的精细加工技术,厚、薄膜混合集成材料与工艺技术,厚膜、陶瓷与PCB的多层基板技术以及MCM电路的模拟、仿真、优化设计、散热和可靠性设计、芯片的高密度互连与封装等一系列技术。因此,有人称其为混合形式的全片集成WSI(Wafer-scale Integration)技术。
CSP的出现促进MCM的发展
对MCM的制作成品率影响最大的莫过于IC芯片。因为MCM高成品率要求各类IC芯片都是确实的芯片KGD(Known Good Die),而裸芯片无论是芯片制造商还是使用者都难以进行全面测试老化筛选,因而给组装MCM带来无法确定芯片性能的不利因素。一旦装上的芯片不合格,这块MCM就会不合格并难以返修。例如,一个系统被设计成带12个电路芯片的MCM,假设其优质品的概率全部是95%,那么该MCM合格的概率就等于0.95的12次幂,即合格率降为54%,这样的结果导致大约两个MCM就有一个需要返修、重做,生产成本增加。正是成本和成品率阻碍着MCM的应用和发展。而成本又与成品率息息相关,因此,如何提高MCM的成品率就成为进一步促进MCM工业化的关键问题之一。
CSP(Chip Scale Package,芯片尺寸封装)的出现很好地解决了这一问题。CSP不仅具有封装IC芯片的一切优点,如能拾起测试、老化等,CSP还具有裸芯片的一切优点,因为它的尺寸只有芯片大小。有的CSP,如PI介质层CSP,还可以实现大圆片的“封装”,大圆片工艺完成后与普通芯片一样划片。可以说,各类CSP真正解决了单芯片IC的KGD问题。解决了组装MCM的后顾之忧,大大提高MCM的成品率,其成本也会大为降低。
CSP的引脚间距按SMT的要求(如0.5~1.27mm)布置Pb/Sn焊接凸点,因此可以使用常规的SMT在厚、薄膜HIC多层基板上或PCB多层基板上对CSP进行贴装并再流焊,使MCM的工业化成为可能,也使SMT提高到一个新的水平。
当一个大而复杂的系统规定了MCM所占的封装面积时,往往一层MCM难以实现,可以设计成立体化的叠装MCM,既减小了所占面积,又充分利用了空间。由于CSP解决了KGD问题,所以叠装MCM的成品率才有保证。
CSP的出现,解决了芯片小,封装大的矛盾,它既有封装器件的一切便利,又有裸芯片尺寸小,性能优的特点,这就为MCM的迅速发展应用解决了后顾之忧,因为组装MCM的所有芯片都经过老化筛选、测试,使芯片成为真正的KGD。另外,由于CSP的“外引线”凸点均是Pb/Sn焊料,使用SMT进行贴装焊接十分方便,MCM的工业化规模生产才能得以实现。
MCM与HIC的异同
MCM是将多块未封装的IC芯片高密度地安装在同一高密度多层布线基板上构成的部件。一般而言,MCM与HIC并无本质差别,它基本上是混合集成技术的延伸产品,无论HIC还是MCM,所有基板的面积都是一定的,其结构是组件化产品。然而,MCM并不就是HIC,MCM与HIC存在着一定的区别,其区别主要在于:HIC在各种基板上安装的主要是无源元件,半导体器件所占的比例非常小,作为HIC用的半导体期间可以是裸芯片也可以是经过封装后的器件,在通常情况下,制成部件的电路较为简单。而MCM在各种高密度多层基板上安装的主体是半导体器件,确切地是未封装半导体器件芯片,制成部件的电路一般都较为复杂,由此可知,MCM技术是混合集成技术的延伸,是HIC技术与WSI技术的综合,也是PCB技术与IC裸芯片封装技术的结合,是混合集成技术的高级产品。
MCM的应用
MCM的应用范围很广,包括了从价格低廉的“低档”消费电子产品用于军事、航天和医疗等领域的高性能的“高档”电子产品。表1列出了全球各种MCM产品制造的情况。
MCM的发展趋势
通常所说的多芯片组件都是指二维的(2D-MCM),它的所有元器件都布置在一个平面上,不过它的基板内互连线的布置是三维。随着微电子技术的进一步发展,芯片的集成度大幅度提高,对封装的要求也更加严格,2D-MCM的缺点也逐渐暴露出来。目前,2D-MCM组装效率最高可达85%,已接近二维组装所能达到的最大理论极限,这已成为混合集成电路持续发展的障碍。为了改变这种状况,三维的多芯片组件(3D-MCM)就应运而生了,其最高组装密度可达200%。3D-MCM是指元器件除了在x-y平面上展开以外,还在垂直方向(Z方向)上排列,与2D-MCM相比,3D-MCM具有更高的集成度、组装效率、更小的体积及重量、降低功耗,信号传输速度增加等优点。
MCM在组装密度、信号传输速度、电性能以及可靠性等方面独具优势,是目前能最大限度地提高集成度、提高高速单片IC性能,制作高速电子系统,实现整机小型化、多功能化、高可靠性、高性能的最有效途径。MCM早在80年代初期就曾以多种形式存在,但由于成本昂贵,大都只用于军事、航天及大型计算机上。随着技术的进步及成本的降低,近年来,MCM在计算机、通信、雷达、数据处理、汽车行业、工业设备、仪器与医疗等电子系统产品上得到越来越广泛的应用,成为最有发展前途的高级微组装技术。例如利用MCM制成的微波和毫米波SOP(System-on-a -package),为集成不同材料系统的部件提供了一项新技术使得将数字专用集成电路、射频集成电路和微机电器件封装在一起成为可能。3D-MCM是为适应军事宇航、卫星、计算机、通信的迫切需要而近年来在国外得到迅速发展的高新技术,是实现系统集成的重要技术途径。目前3D-MCM已被应用到高性能大容量的存储器组件和计算机系统,充分发挥了三维多芯片组件技术的优越性。
随着微电子技术的发展,微电子封装将向微型化、轻型化和薄型化方向发展。3-D封装技术具有降低功耗、减轻重量、缩小体积、减弱噪声、降低成本等优点。它将是未来微电子封装的主要发展方向。电子系统(整机)向小型化、高性能化、多功能化、高可靠和低成本发展已成为目前的主要趋势,从而对系统集成的要求也越来越迫切。实现系统集成的技术途径主要有两个:一是半导体单片集成技术,二是MCM技术。前者是通过晶片规模的集成技术(WSI),将高性能数字集成电路(含存储器、微处理器、图像和信号处理器等)和模拟集成电路(含各种放大器、变换器等)集成为单片集成系统。后者是通过3D-MCM技术实现WSI的功能。
3D-MCM技术是现代微组装技术发展的重要方向,是新世纪微电子技术领域的一项关键技术。由于宇航、卫星、计算机及通信等军事和民用领域对提高组装密度、减轻重量、减小体积、高性能和高可靠性等方面的迫切需求,加之3D-MCM在满足上述要求方面具有的独特优点,近年来正得到广泛的应用。
结束语
由于MCM的先进性,促使整机在小型化、多功能化、高可靠、高性能发面有了很大进展,发展势头迅猛,目前已经成功地用于大型通用计算机和超级巨型机中,今后将用于工作站、个人计算机、医用电子设备和汽车电子设备等领域。1992年至1996年MCM以11.1%的年递增率发展,今年产值有可能突破110亿美元,21世纪初将进入全面实用化阶段,迎来MCM全面推广应用和电子设备革命的年代。
责任编辑:gt
-
芯片
+关注
关注
463文章
54422浏览量
469267 -
集成电路
+关注
关注
5464文章
12685浏览量
375699 -
封装
+关注
关注
128文章
9330浏览量
149044
发布评论请先 登录
一文详解多芯片组件MCM技术
封装的革命:比较单芯片与多芯片组件的优势

LTCC微波多芯片组件中键合互连的微波特性
MC34262系列PFC控制芯片的应用研究
多芯片组件技术的基本类型有哪些?
多芯片组件的特点_多芯片组件的分类
多芯片组件的基本特点、应用和发展趋势
车用多芯片组件AEC-Q104规范




 多芯片组件的基本特点及应用研究
多芯片组件的基本特点及应用研究

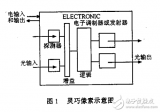




评论