热风回流焊是整个BGA返修工艺的关键。其中有几个问题比较重要:
1、芯片返修回流焊的曲线应当与芯片的原始焊接曲线接近,热风回流焊曲线可分成四个区间:预热区,加热区,回流区,冷却区,四个区间的温度、时间参数可以分别设定,通过与计算机连接,可以将这些程序存储和随时调用。
2、在回流焊过程中要正确选择各区的加热温度和时间,同时应注意升温速度。一般在100℃以前,最大升温速度不超过6 ℃/s,100℃以后最大升温速度不超过3℃ /s,在冷却区,最大冷却速度不超过6℃/s。因为过高的升温速度和降温速度都可能损坏PCB和芯片,这种损坏有时是肉眼不能观察到的。不同的芯片,不同的焊锡膏,应选择不同的加热温度和时间。如CBGA芯片的回流温度应高于PBGA的回流温度,90Pb/10Sn应较63Sn/37Pb焊锡膏选用更高的回流温度。对免洗焊膏,其活性低于非免洗焊膏,因此,焊接温度不宜过高,焊接时间不宜过长,以防止焊锡颗粒的氧化。
3、热风回流焊中,PCB板的底部必须能够加热。加热有两个目的:避免由于PCB板单面受热而产生翘曲和变形;使焊锡膏溶化时间缩短。对大尺寸板返修BGA,底部加热尤其重要。BGA-3592-G返修设备的底部加热方式有两种,一种是热风加热,一种是红外加热。热风加热的优点是加热均匀,一般返修工艺建议采用这种加热。红外加热的缺点是PCB受热不均匀。
4、要选择好的热风回流喷嘴。热风回流喷嘴属于非接触式加热,加热时依靠高温空气流使BGA芯片上各焊点的焊锡同时溶化。美国OK集团首先发明这种喷嘴,它将BGA元件密封,保证在整个回流过程中有稳定的温度环境,同时可保护相邻元件不被对流热空气加热损坏。
在电子产品尤其是电脑与通信类电子产品的生产领域,半导体器件向微小型化、多功能化、绿色化发展,各种封装技术不断涌现,BGA/CSP是当今封装技术的主流。其优势在于进一步缩小半导体器件的封装尺寸,因而提高了高密度贴装技术水平,十分适合电子产品轻、薄、短、小及功能多样化的发展方向。
编辑:hfy
-
pcb
+关注
关注
4421文章
24024浏览量
427013 -
BGA
+关注
关注
5文章
588浏览量
52027 -
回流焊
+关注
关注
14文章
542浏览量
18629
发布评论请先 登录
SMT 量产工艺指南:铂芯片传感器回流焊、焊盘设计与良率提升



气体质量流量计和微量氧传感器在真空回流焊炉中的应用
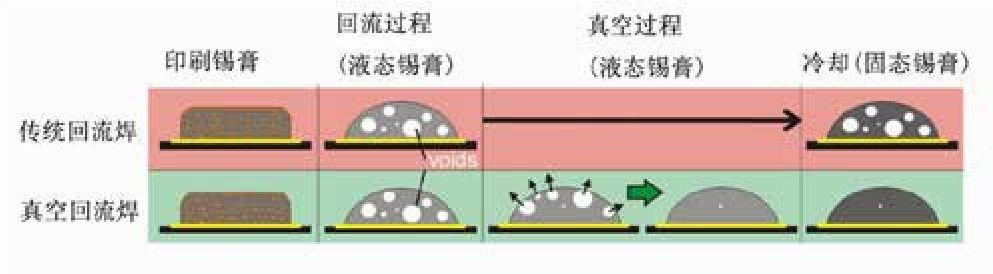
晋力达小型回流焊的优势

浅谈回流焊接技术的工艺流程
激光锡焊工艺能否替代传统回流焊

什么是回流焊,大型双导轨回流焊的优势有哪些

多温区可变建模的SMT回流焊温度曲线智能仿真方法研究

回流焊问题导致SMT产线直通率下降,使用我司回流焊后改善的案例
回流焊技术:赋能电子制造的卓越解决方案




 浅谈BGA返修工艺的关键:热风回流焊
浅谈BGA返修工艺的关键:热风回流焊


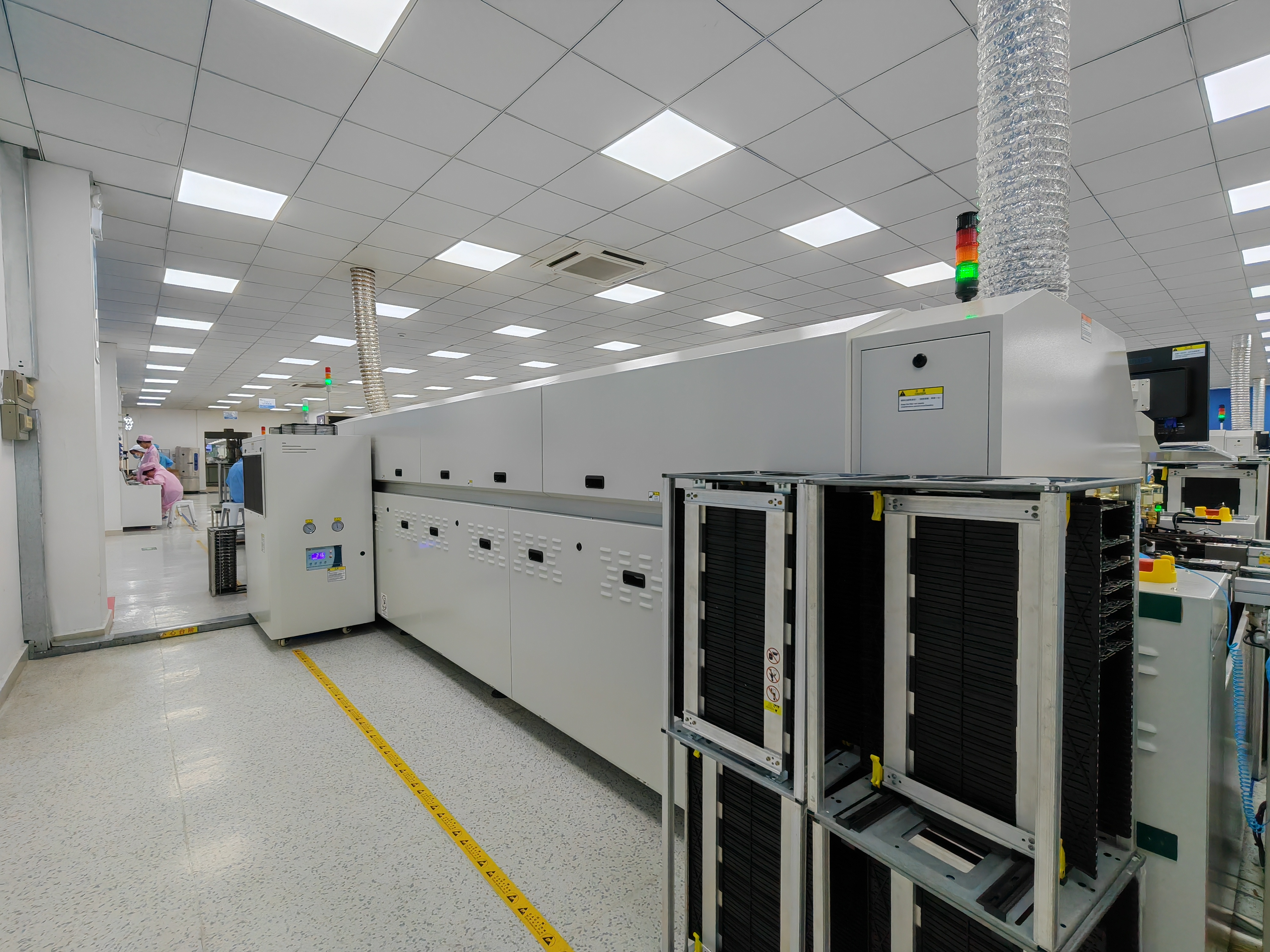



评论