锡膏的模板印刷是用于高产量电子电路制造的最快速、最省成本的方法。不幸的是,该方法对于间距小于300微米的元件已经不是太好。对于这些元件,粘性助焊剂工艺是一个较好的方法;它可以直接在装备有助焊剂浸涂单元的密间距元件贴装机上实施。
在粘性助焊剂工艺中的四个步骤是:吸取元件、将元件锡球浸泡到助焊剂、对中元件和在基板上贴装元件。因为该工艺允许处理锡球间距小至100微米的元件,所以共晶锡球的倒装芯片装配可能会及其有趣。
当具有共晶锡球的倒装芯片贴装在锡膏中时,其位置通常在回流期间通过液态焊锡的自我对中得到纠正。同样,共晶锡球贴装在助焊剂中的大多数元件位置也会通过自我对中来纠正。一项最新的研究项目调查了贴装在助焊剂中的共晶锡球在焊点的形成与贴装精度之间的关系。
研究的准备
由于在获得元件和基板上的局限,这里避免了使用极其小间距的元件,以简化这些试验。使用了两种元件:750微米间距的CSP和450微米的倒装芯片。结果推断到间距小至100微米的元件。使用了两种不同的板面布局:铜箔界定的布局,用于CSP贴装和阻焊(RS)界定的布局,用于倒装芯片(图1)。
也使用了一台先进的元件贴装机,具有3西格码的9微米精度,装备有助焊剂浸涂单元。使用一种免洗粘性倒装芯片助焊剂,适合于浸涂。
通过增加在三种不同的铜焊盘尺寸和三种不同的阻焊开口上偏移来完成验证试验。元件贴装在X方向增加正与负的偏移。所有给定的偏移都是从名义位置测量的。执行了两种正对CSP和倒装芯片的不同试验计划。总共贴装了450片CSP和450片倒装芯片。
CSP的试验
在助焊剂单元中助焊剂层的厚度是在95微米,等于50%的CSP锡球高度。CSP首先在助焊剂单元浸涂,然后贴装在试验板上,五个负的和五个正的偏移步。对于每一个偏移步,在三种不同的铜箔界定的焊盘布局上贴装15个元件:
. 铜焊盘 = 锡球直径
. 铜焊盘 = 85%的锡球直径
. 铜焊盘 = 70%的锡球直径
图1、阻焊层界定
和阻焊层界定的布局 图2、阻焊层界定
落脚点的贴装区域 图3、阻焊层界定
落脚点的贴装极限
贴装之后,将板焊接,对元件进行电器测试。菊花链测量结果在图2中用蓝色的点划线显示。在图中也显示有阻焊的理论公差位置。
三个理论区域是:
. 一个一直好的、安全区域,与铜箔焊盘或焊接区域对应
. 一个过渡区域,它是阻焊的公差区域;但贴装在这里时,焊接将取决于阻焊的位置。
. 一个总是出错的区域,它超出了阻焊的公差界限;在这个区域的连接没有焊接到。
几个板的测量显示,阻焊的位置(公差)不总是一致的,可能在所有方向移动,偏差在-30微米到+35微米之间变化。最大允许的贴装偏移(图3)等于铜焊盘的尺寸(安全区域)。阻焊不能在铜焊盘上,并且不能厚于铜迹线。在后一种情况中,如果阻焊偏移达到最大,并且锡球贴装在铜焊盘的边沿上,锡球将不会接触到铜箔(图4)。
过渡区域或者阻焊可以移动的区域的使用,可以增加允许的贴装偏移,但是这取决于阻焊的位置和最小的阻焊开口(图5)。在图6中,贴装的精度是以所有公差的函数给出的。
图4、有于厚的阻焊层
锡球没有接触铜箔 图5、名义的阻焊层位置
增加允许的贴装偏差 图6、贴装精度是铜箔
界定的区域的公差的函数
对于有局部基准点的CSP与铜箔界定的落脚点,得到四个结论。首先,当锡球接触到铜箔焊盘区域时,在回流时总是会焊接到。在看作是:
贴装精度 < (最小铜箔焊盘直径)/2
假设阻焊不比铜箔焊盘厚。这个结果在理想的环境下发生;需要进一步的研究来确定一个实际界限。在这个阶段,可以建议一个10%的安全边界,这意味着可以推荐+-40%偏出焊盘的贴装偏移。
第二,在过渡区域,不是所有的锡球都将在回流期间焊接,取决于阻焊的位置。
第三,当阻焊在正方向偏移时,在正方向的允许偏移增加,在负方向减小。
最后,当阻焊在负方向偏移时,在负方向的允许偏移增加,在正方向减小。
倒装芯片的试验
对于倒装芯片的浸涂,在助焊剂单元内的助焊剂厚度是70微米,50%的倒装芯片锡球高度。进行了与CSP一样的试验。倒装芯片以五个负向和五个正向偏移贴装。对于每个偏移步,在三种不同的阻焊界定的焊盘布局上贴装15个元件:
. 阻焊开口 = 锡球直径
. 阻焊开口 = 85%的锡球直径
. 阻焊开口 = 70%的锡球直径
在贴装之后,将板焊接,使用菊花链测量方法对元件进行测量。使用了几块板,在所有的板上阻焊层的位置由于有阻焊层的公差而都不同。在分析之后得出一下结论:
. 基准点的尺寸带来额外的偏差。这个偏差可以增加、补偿或减小给定的偏移。因此,对于正向/负向上的一定偏差,都发现有焊接/没有焊接的倒装芯片。
. 对于阻焊层开口=70%锡球直径的组合,一些锡球坐落在阻焊层上,没有接触铜箔。在回流期间,这些锡球没有焊接。
对于倒装芯片的贴装,使用了局部的阻焊层界定的基准点。在图7中,显示了理论公差极限和试验的结果(蓝色点划线)。
两个可见的理论区域是一个阻焊层开口区域和一个总是出错的区域(超出阻焊层开口)。当贴装在这里时,连接点没有焊接。图8显示相对于阻焊层界定的落脚点与贴装区域的锡球位置。
图7、对于阻焊层界定
的 落脚点的贴装区域 图8、倒装芯片的公差极限 图9、贴装精度是阻焊层
界定的区域的公差的函数
当锡球贴装在阻焊层的边缘上时,不是所有的元件将流动回到焊盘上。这里应该考虑一个安全的边界,取决于某些公差。图9显示贴装精度是所有公差的函数。 在一种安全的情况中,锡球接触铜箔表面。在最高的贴装精度中阻焊层的高度起着重要的作用(图10)。安全边界也取决于锡球直径与阻焊开口的关系(图11)。如果锡球接触铜箔表面,安全边界可以计算(图12)。
图10、对于厚的阻焊层
安全边界增加 图11、对于较小的锡球直径
安全边界减少
图12、计算的安全边界
表1包含为试验中使用的倒装芯片所计算的安全边界和贴装精度,三种不同的阻焊层厚度。
表1、计算的安全边界和贴装精度
锡球直径
190微米
阻焊层开口
190微米 阻焊层开口
160微米
阻焊层厚度(微米) 安全边界(微米) 贴装精度(微米) 贴装精度(微米)
5 30 65 50
10 42 53 38
15 51 44 29
对于具有局部阻焊层界定的基准点的倒装芯片和阻焊层所界定的落脚点,结论是:
. 在锡球直径、最小阻焊开口和阻焊层高度之间存在很强的关系。所有参数在最大的贴装精度中都起重要的作用。
. 从这些试验的结果看到,从阻焊开口的20%的允许偏离对于阻焊层开口大于或等于85%锡球直径的情况是一个安全值。在这些情况中,铜箔焊盘上的阻焊层高度小于或等于10微米。
. 如果阻焊层界定的基准点发生偏移,阻焊层界定的落脚点也会偏移相同的距离。允许的偏移对于偏离的和非偏离的阻焊层是相同的。
. 对于阻焊层开口=70%锡球直径的试验组合,一些锡球坐落在阻焊层上,不接触铜箔。在回流期间,这些锡球没有焊接。
该研究揭示,贴装精度取决于元件间距和板的布局。对于铜箔界定的落脚点,洗球必须接触焊盘。因此,允许40%偏离焊盘的贴装偏移。对于阻焊层界定的落脚点,在锡求职晶、阻焊层开口和阻焊层高度之间存在很强的关系。允许的贴装偏移是20%偏离阻焊层开口。
该研究结果向低至100微米间距尺寸的推论在表2中显示,假设对于CSP,铜焊盘尺寸应该是70%的锡球直径,对于倒装芯片,阻焊层的开口尺寸应该至少是85%的锡球直径。
表2、对用粘性助焊剂贴装的CSP的推荐贴装精度(微米,3西格码)
间距 CSP在铜箔界定的焊盘上 倒装芯片在铜箔界定的焊盘上
750微米 80 50
500微米 70 40
400微米 60 30
300微米 40 25
250微米 25
200微米(主要微处理器) 20
150微米(主要微处理器) 17
125微米(开发中) 14
100微米(开发中) 10
对于CSP和倒装芯片元件的推荐贴装精度保证最高的工艺品质。较低精度的贴装工艺不一定会造成错误,但是失效的机会将增加。
- 使用粘性(5543)
- 芯片装配(5834)
相关推荐
倒装芯片与表面贴装工艺
倒装芯片和晶片级封装技术及其应用
倒装芯片应用的设计规则
倒装芯片的特点和工艺流程
倒装晶片装配对助焊剂应用单元的要求
倒装晶片的组装工艺流程
倒装晶片的组装的助焊剂工艺
倒装晶片的组装的回流焊接工艺
倒装晶片的贴装工艺控制
倒装晶片贴装设备
助焊剂产品的基本知识与作用
PCB板加工的助焊剂残留该怎么清理呢?
PCB电路板表面处理工艺助焊剂的特点和检验方法
PoP装配SMT工艺的的控制
smt无铅助焊剂的特点、问题与对策
典型PoP的SMT贴装步骤
无卤低固水基免洗助焊剂的主要特点是什么?
无铅焊接对助焊剂的要求-购线网
晶圆级CSP装配回流焊接过程
晶圆级CSP装配工艺的印制电路板焊盘设计方式
晶圆级CSP装配底部填充工艺的特点
晶圆级CSP元件的重新贴装印刷锡膏
晶圆级CSP的锡膏装配和助焊剂装配
晶圆级CSP贴装工艺吸嘴的选择
焊锡丝中的助焊剂怎么用?
助焊剂的工作原理
 8451
8451采用无铅(Pb)装配流程装配高含铅的DS2502倒装芯片
 694
694
采用无铅(Pb)装配流程装配高含铅的DS2502倒装芯片
 656
656
采用无铅(Pb)装配流程装配高含铅的DS2502倒装芯片
 858
858FC倒装芯片装配技术介绍
 46
46倒装芯片CSP封装
 45
45助焊剂的主要成分介绍
 62673
62673助焊剂选择与使用
 19069
19069
免清洗助焊剂好用吗_免清洗助焊剂如何使用
 12848
12848自制助焊剂方法
 45476
45476PCBA生产中助焊剂的特性与选择要求
 3622
3622PCBA生产中助焊剂涂敷方式的种类及特点介绍
 4357
4357PCBA产品加工中的助焊剂固体物量的选择
 2153
2153PCB板波峰焊助焊剂着火的原因及解决方法
 7501
7501糊状助焊剂的用途及优势介绍
 2979
2979SMT贴片加工中四种常见的助焊剂介绍
 12876
12876如何为SMT加工选择合适的助焊剂
 3138
3138助焊剂在焊接中的主要作用体现在哪几方面
 13247
13247波峰焊的助焊剂喷头堵塞要如何解决,有什么方法
 5863
5863助焊剂的喷头堵了怎么办,可有什么处理方法
 1442
1442助焊剂在波峰焊接过程中的作用、原理及工作模式
 2206
2206波峰焊助焊剂喷头的工作原理
 3206
3206波峰焊机如何选择助焊剂
 1191
1191波峰焊助焊剂的类型有哪些呢?
 1417
1417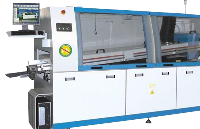
波峰焊助焊剂喷涂系统的维护方法与注意事项
 576
576助焊剂残留为何会导致电子故障?
 1688
1688SMT贴片无铅助焊剂的六点要求
 403
403焊锡丝中的助焊剂怎么用?
 1603
1603
浅谈一下助焊膏和助焊剂的区别?
 1915
1915
锡膏厂家讲一下助焊剂的危害有哪些?
 1078
1078
无卤低固水基免洗助焊剂的主要特点是什么?
 487
487
锡膏厂家带您了解低固体含量的免清洗助焊剂
 517
517
揭秘回流焊后期处理:助焊剂残留的影响及对策
 2508
2508
SMT贴片加工助焊剂的作用要求
 381
381倒装晶片装配对助焊剂应用单元的要求
 168
168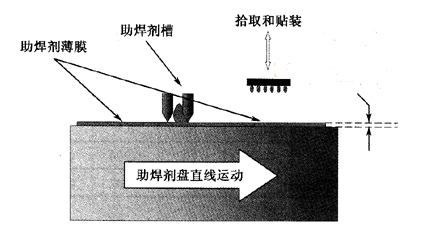
倒装晶片的组装工艺流程
 352
352
PCB板用倒装芯片(FC)装配技术
 388
388使用免清洗助焊剂有必要清洗吗?
 383
383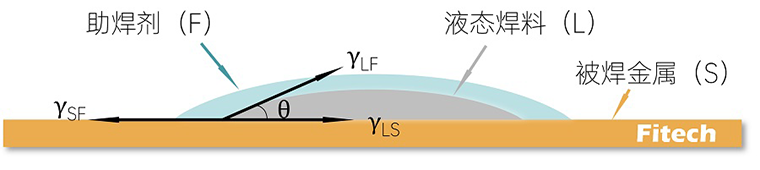
smt贴片中的锡膏助焊剂种类有哪些?
 466
466
助焊剂清洗不干净问题的产生原因与解决方案
 452
452环氧助焊剂助力倒装芯片封装工艺
 107
107
 电子发烧友App
电子发烧友App











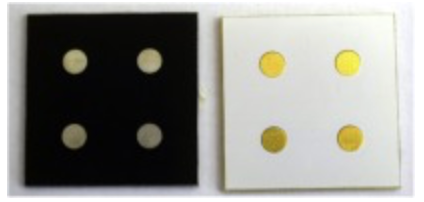










评论