半导体产品中的金属污染会对设备性能产生不利影响,并影响制造工艺的产量。为了满足对晶圆基板更高产量和性能的需求,必须最大限度地减少晶圆表面和基板本身的污染。最常见的金属污染物是过渡金属或碱性元素。过渡金属主要通过半导体材料扩散并以各种氧化物形式聚集在表面,通常是纳米级污染物。
纳米级污染物
无论是单个还是聚集的纳米颗粒,都可能导致晶圆线之间的损坏或短路。随着对更小线宽的需求,需要检测半导体材料和该行业所用化学品中粒径更小且颗粒数更少的污染物1。
四甲基氢氧化铵(TMAH)
就是这样一种化学物质,它是一种季铵盐,在光刻工艺和液晶显示器(LCD)中广泛应用于光刻胶的开发。由于其在这些要求苛刻的应用中的广泛使用,TMAH中杂质的分析变得越来越重要。最常见的TMAH形式是浓度为2-25%的水溶液。然而,在实际应用中,大多数半导体应用的浓度均在1-3%之间2。为了表征半导体化学品中的纳米级污染物,需要一种能够同时测定超低量溶解杂质和纳米级杂质的检测技术。
电感耦合等离子体质谱(ICP-MS)作为一种多元素检测技术,具有灵敏度高、样品类型灵活(气体、液体和固体)、测量速度快、线性动态范围宽等优点。
为了表征纳米颗粒,ICP-MS可在单颗粒模式下运行(SP-ICP-MS),并已被证明是一种用于检测和测量纳米颗粒的强大技术。这种方法可以测定多种纳米颗粒特征,如无机成分、浓度、粒径、粒径分布和聚集3。使用ICP-MS分析纳米颗粒时,必须有一个数据采集快速且驻留时间极低(低至10 μs)的系统。这是因为较短的驻留时间允许在单个纳米颗粒羽流中进行多次强度读数(其典型瞬态信号为400-600 μs)。相比之下,在较长的驻留时间下,纳米颗粒羽流上捕获的读数数量减少,这影响峰值的定义,因此对从数据得出的结论产生负面影响,这对于含有混合粒径的纳米颗粒(作为聚集物)的溶液尤其如此。较短的驻留时间也可以降低背景噪音,而NP峰的积分强度保持不变,从而将颗粒从噪音中分离出来,改善检测限。
另一个需要解决的挑战是基质来源的多原子干扰和基质抑制/增强效应,尤其是在高碳含量材料的直接分析中。TMAH就是这样一种基质材料。这种情况下,一个配有两个分析仪四极杆和一个四极杆反应池的系统对分析极其有益,即在第一个四极杆中实现质量分离,然后在反应池中进行可重复且可靠的反应(即使使用纯反应气体,如纯氨),也可以降低许多元素的检测限(DL)和背景当量浓度(BEC)。当使用反应气体时,还需要ICP-MS减少反应池中离子流的“拉伸”,因为离子通过与反应气体的物理相互作用而失去动能时经常发生这种情况。因此,轴向场技术等功能对于解决该情况非常有益。
在本研究中,使用NexION5000多重四极杆ICP-MS(珀金埃尔默Inc.,美国康涅狄格州谢尔顿)以单颗粒模式(SP-ICP-MS)对稀释的TMAH进行表征,证明其适用于半导体工业中使用的工艺化学品的常规实验室分析。
实验
1
标准品和样品制备
本研究中使用了超纯水(UPW)(电阻率≥18.2 MΩ.cm)和高纯TMAH(Tamapure,日本神奈川)。流速和传输效率(TE)测试用溶液、溶解的标准品和纳米颗粒(NP)加标溶液均在5% TMAH中制备。
通过使用颗粒浓度为100,000个颗粒/mL的30、50 和100 nm金颗粒标准品(珀金埃尔默Inc.)和一系列质量浓度为0.25、0.5和1 ppb的溶解金标准品,根据粒径测量传输效率(TE)。分析元素的溶解标准品中所有元素的浓度分别为0.25、0.5和1 ppb,但Si除外,其质量浓度为1、5和10 ppb。在实验条件下,TE值为5.24%
纳米颗粒(NP)加标溶液含有一份50 nm的金颗粒标准品(珀金埃尔默Inc.)、两份100 nm和200 nm的Si颗粒标准品(nanoComposix Inc.,美国加亚州圣地亚哥)和两份30 nm和60 nm的银颗粒标准品(nanoComposix Inc.)。
将未知的TMAH样品稀释至5%。对于纳米颗粒分析,必须将样品稀释至300,000个颗粒/mL以下,以防止出现双重合分析,即多个NP同时进入等离子体。对于该样品,需要对样品中的不同元素颗粒进行多次稀释。在这种情况下,通过使用5% TMAH连续稀释样品。
2
仪器和方法
所有SP-ICP-MS数据均使用NexION 5000 ICP-MS(珀金埃尔默Inc.)单颗粒模式与SyngistixNano应用软件模块进行采集。仪器组件/参数如表1所示。元素在MS/MS或仅Q3模式下测量。采用并优化了三种气体配置-冷等离子体条件下的氢气反应模式、氨气反应模式和标准模式(无气体),以提供更佳的干扰消除和检测限。所使用的数据采集参数如表2所示。使用智能采样获得结果,消除了每种元素之间的冲洗和吸收时间,但也会因不同元素检测方法之间的任何功率、气体流速或气体类型变化而暂停。
表1. NexION ICP-MS仪器组件和工作条件

表2.元素、同位素和采集参数(点击查看大图)

向下滑动查看表1、表2全部内容
硅(Si)是一种较难分析的元素,在质量数为28时受到碳和氮的干扰。除了这些干扰之外,进样系统通常为硅基,特别是中心管和炬管。为了尽可能降低这种背景,Si在稍冷的等离子体中进行分析,射频功率为1000 W。与颗粒强度相比,还利用更短的25 μs驻留时间来降低背景,并优化了各元素的RPq值,以控制反应,提高干扰消除效果。通用反应池中的轴向场技术(AFT)也可以进行优化。在纳米颗粒的应用中,该参数可用于在离子流通过反应池时将其保持在一起,当需要通过气体消除干扰时其特别有用。每份样品测量三次,每次分析都提供有关粒径、颗粒浓度和溶解(离子)浓度的信息。
结果和讨论
1
校准曲线和空自TMAH分析
空白扫描5% TMAH时,发现某些元素的背景升高,尤其是硅(图1)。为了正确测定纳米颗粒的粒径,不考虑曲线图的截距,利用曲线图的斜率确定溶解校准的粒径,这意味着使用标准加入法(MSA)进行校准,曲线如图1所示。校准范围内所有元素的相关系数(R)均高于0.9995。如图1中的实时信号所示,无污染TMAH中存在一些纳米颗粒。出于该原因,扫描5% TMAH中的颗粒作为加标样品和未知样品的基线。

图1.5% TMAH中目标元素的实时空白信号(用于校准曲线、流速和传输效率测量),以及使用MSA获取的相应校准曲线(点击查看大图)
向下滑动查看图1全部内容
表3中的结果表明除Ga外,所有元素都存在少量颗粒,其中一些粒径较大,特别是Si和Fe。
表3.5% TMAH中目标元素的纳米颗粒结果(点击查看大图)

LOD=检测限;AND=未检测到
2
纳米颗粒加标
向5% TMAH样品中加入已知的纳米颗粒,以评估TMAH基质中粒径和颗粒数的准确度。向5% TMAH中加入100 nm和200 nm SiO2(nanoComposix Inc.)、30 nm和60 nm Ag(nanoComposix Inc.)以及50 nm Au纳米颗粒(珀金埃尔默Inc.)。加标样品的粒径分布如图2所示。所有加标的纳米颗粒均以预期粒径为中心分布均匀,表明这些颗粒可以在5% TMAH中进行分析。

图2.空自5% TMAH和纳米颗粒加标TMAH的直方图。
测得的平均粒径和颗粒数以及认证值如表4所示。对于所有颗粒,测得的粒径均在认证值范围内(以橙色列显示),并且颗粒浓度接近预期值(以绿色列显示)。
表4.5% TMAH中认证粒径和纳米颗粒浓度与SP-ICP-MS测量值(点击查看大图)

3
未知样品
对未知的TMAH样品进行了粒径和数量检测。与其他样品一样,将样品稀释至5%,然后进行分析。观察到Al、Si和Fe的溶解浓度很高。对于这些元素,需要较高的稀释度来降低溶解浓度并显示颗粒,而其他元素则需要较低的稀释倍数。样品用5% TMAH稀释,以保持粘度和基质一致。
未知样品所需的稀释量可以通过连续稀释确定。当粒径保持不变而颗粒数因稀释而减少时,则认为达到了正确的稀释度。未知样品中Al在不同稀释度下的原始数据和粒径分布如图3所示。

图3.未知样品中AI在不同稀释度下的实时信号和纳米颗粒粒径直方图(点击查看大图)
稀释10倍(10x)时,溶解分数很大,颗粒数很少,这可能是由于溶解的Al、Al纳米颗粒的双重合或两者的混合。然而,进一步稀释至100倍(100x)和200倍(200x)会降低溶解浓度,并显示溶液中存在Al颗粒。稀释度的定量结果见表5。可以看出,在10倍稀释时,溶解浓度较高,导致颗粒计数很低,而在比较100倍和200倍稀释时,颗粒粒径和浓度与溶解浓度更一致,表明这是AI纳米颗粒分析所需的正确稀释倍数。对其他元素进行了类似的研究。
表5.考虑稀释倍数后,未知TMAH样品中AI的稀释试验结果(点击查看大图)

为了获得不同元素的正确颗粒数和粒径,可能需要根据原溶液中目标元素的溶解浓度和颗粒数进行不同的稀释。
表6中的结果表明,在未知TMAH样品的情况下,Ag、Ce和Ga只需要10倍稀释就可以得到有效的粒径和浓度结果,而其他元素都需要更大的稀释倍数,Al、Cr和Fe需要100倍稀释,Si至少需要200倍稀释。TMAH中最可能形成颗粒的元素是那些可形成氢氧化物的元素,如AI和Fe。这些元素可能存在于原溶液中,也可能来自半导体工厂老化的基础设施,通常在用于生产之前对其进行测量以了解化学品的纯度,并再次评估工厂周围的化学品运输管道是否对纳米颗粒背景有一定贡献。
表6.未知TMAH样品中选定元素的稀释试验结果(点击查看大图)

Ag、Ce和Ga等颗粒可能来自晶圆(如Ga)或制造工艺的一部分(Ce),通常浓度较低,分析时需要较小的稀释度。
结论
1
SP-ICP-MS是一种用于分析半导体行业范围内有机溶剂中颗粒的有用工具。在珀金埃尔默NexION ICP-MS系列中,通用池技术(UCT)的优势包括利用AFT和RPq因子对瞬态羽流信号进行卓越的干扰消除和控制。NexION 5000多重四极杆ICP-MS的附加功能能够在MS/MS和质量转移模式下运行,可实现出色的干扰消除。此外,长时间使用100%氨气作为反应气体的功能非常有利于提高铁(Fe)等元素的DL,其中丰度最高的同位素(amu 56)被ArO+干扰所掩盖。纯氨气可在不产生碰撞化学反应的情况下消除这种干扰,从而防止离子流拉伸而离子流拉伸会导致一些信号在检测闽值以下丢失,从而造成NP粒径不正确。
2
可在单颗粒模式下运行的NexION 5000 ICP-MS被证明适用于TMAH中超痕量水平的NP杂质的常规定量分析。本研究使用标准加入法(MSA)来解释一些元素(如Si)的高背景,这些元素在低水平下难以量化。该方法的准确性通过加标Ag、Si和Au颗粒的无污染TMAH中颗粒粒径和数量的优异回收率得到了验证。
-
半导体
+关注
关注
339文章
31316浏览量
266938 -
晶圆
+关注
关注
53文章
5458浏览量
132823 -
ICP
+关注
关注
0文章
80浏览量
13970
发布评论请先 登录
最全最详尽的半导体制造技术资料,涵盖晶圆工艺到后端封测
用785便携拉曼光谱仪成功为知名化学医药企业测试化学品
半导体材料市场构成分析
《炬丰科技-半导体工艺》硅纳米柱与金属辅助化学蚀刻的比较
《炬丰科技-半导体工艺》DI-O3水在晶圆表面制备中的应用
《炬丰科技-半导体工艺》GaN的晶体湿化学蚀刻
《炬丰科技-半导体工艺》III-V族半导体纳米线结构的光子学特性
《炬丰科技-半导体工艺》半导体行业的湿化学分析——总览
化学品包装防水透气膜在化学品包装中应用的优点
酸性化学品供应控制系统
如何选择适合12英寸大硅片抛光后清洗的化学品




 内外皆精密|使用NexION 5000 SP-ICP-MS分析半导体工艺化学品中的金属纳米颗粒
内外皆精密|使用NexION 5000 SP-ICP-MS分析半导体工艺化学品中的金属纳米颗粒

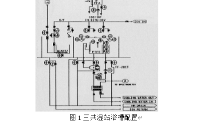





评论