随着电力电子技术的飞速发展,碳化硅(SiC)金属氧化物半导体场效应晶体管(MOSFET)因其优异的性能,如高开关速度、低导通电阻和高工作温度,逐渐成为高频、高效功率转换应用的理想选择。然而,SiC MOSFET的栅氧可靠性问题一直是制约其广泛应用的关键因素之一。栅氧层的可靠性直接影响到器件的长期稳定性和使用寿命,因此,如何有效验证SiC MOSFET栅氧可靠性成为了业界关注的焦点。
本文将详细介绍一种常用的栅氧可靠性验证方法——经时介电击穿(TDDB)测试,并通过实验数据和寿命预测模型,评估SiC MOSFET栅氧层的可靠性。
TDDB失效机理
经时介电击穿(TDDB)是一种用于评估栅氧层可靠性的重要测试方法。其基本原理是通过在栅氧层上施加恒定的电压应力,观察栅氧层在长时间应力作用下的击穿行为。TDDB失效机理主要包括以下几个步骤:
1.缺陷生成:在电场应力的作用下,栅氧层中的缺陷逐渐生成。这些缺陷可能是由于制造过程中的杂质、界面态或晶格不匹配引起的。
2.电荷捕获:电场应力会导致电荷在栅氧层中捕获,形成局部高电场区域,进一步加速缺陷的生成。
3.导电通道形成:随着缺陷的积累,栅氧层中会形成导电通道,导致局部电流密度增加。
4.击穿发生:当导电通道的密度达到一定程度时,栅氧层会发生击穿,导致器件失效。

图一 SiO2体内形成渗流路径简化二维模型
栅氧内部产生缺陷的物理机理并没有一个准确的结论,广泛认同的模型有基于电场的热化学 E 模型、基于电流的阳极空穴注入1/E模型、基于缺陷自身位置与能量的幸运缺陷模型以及不涉及真实物理机理但有助于早期失效筛选的局部栅氧变薄模型,下表列出了不同模型的特点及其寿命推算公式。

TDDB实验流程
了解TDDB的失效机理后,我们可以知道器件的栅氧可靠性测试是可以通过改变施加在器件上的应力加速的,加速因子为栅极电压VG与环境温度Ta,图2是TDDB测试的实验流程,旨在确定击穿电压并在不同温度和电压条件下评估栅氧可靠性。

图2TDDB实验流程
(1)器件初筛:每组实验选用20颗SiC MOSFET器件,初筛选取电学特性符合规范的器件,以获取更加准确的失效分布;
(2)TZDB测试:确定器件的击穿电压(VBD),为TDDB测试提供参考电压,如果知道器件的栅氧层厚度,可以计算器件失效时的临界击穿场强;
(3)设置TDDB加速应力:在升温完成后施加栅极电压应力,并实时监测每颗器件的栅极泄漏电流IGSS,根据不同的测试温度和栅极应力可以将器件分为不同的测试组;
(4)器件失效判据:TDDB测试老化板需要在器件的栅极串联一颗保险丝,其作用是限制器件的栅极的电流,一旦器件出现失效,保险丝可以及时熔断,电流归零,记录此时的总应力时间,即为该器件的失效时间;
(5)实验停止判据:一般情况下,TDDB实验为完全寿命实验,即需要所有器件出现失效;为了缩短TDDB实验时间,也可以采用80%器件失效作为实验结束判据。
以上为TDDB实验的流程,通过控制加速因子,可以得出器件在不同温度、不同应力下的失效时间,而器件栅氧失效的数据处理常常使用威布尔分布(Weibull distribution)进行分析,在实验中可以使用以下公式计算第i个器件在n个样本中的累计失效率F(i):

同时,累计失效率与失效时间也满足以下关系:

因此只需要计算出ln(-ln(1-F))的值和ln(t)的值,通过线性回归获得的斜率与截距,经过计算后就可以得到形状参数β及本征寿命t63.2,同时可以获得栅氧寿命的威布尔分布图:

图3栅氧失效威布尔分布图[4]
从图中可以看到对于不同的测试条件,器件的失效时间是不同的,这对应了不同的应力下的失效分布,四条曲线的形状参数β存在区别,一般来说,随着应力的减小,β也会提高,测试获得的寿命也约接近真实值。同时,也可以注意到每组器件都会有几个点与拟合曲线的距离较远,这说明器件出现了早期失效,这些器件的预估寿命也会远小于正常寿命,对应了浴盆曲线的早期高失效率阶段。

图4浴盆曲线风险函数
E模型寿命预测
通过TDDB实验获取器件的失效分布后,结合器件栅氧失效的机理,也就是之前提到的E模型、1/E模型等,我们可以通过这些模型合理地预测SiC MOSFET器件的栅氧可靠性。
这里以E模型为例进行简单介绍,E模型的器件本征失效寿命tBD满足:

其中Eox为器件的栅氧电场强度,从公式可知,器件的本征寿命的对数与栅氧电场强度呈现线性关系,因此可以通过多个电压点的本征寿命拟合,外推正常工作电压条件下的失效率63.2%的本征寿命,同时也可以计算1ppm、10ppm以及100ppm失效率下的器件本征寿命,这里也为大家解答一个疑问,为什么工业上常常使用E模型进行寿命外推?
我们来看图5,这是使用E模型、1/E模型以及幂律模型进行寿命外推获得的曲线,可以看到,E模型的推算寿命是最为保守的,尽管E模型主要是作用于高电场强度下的模型,在低压下,1/E模型和幂律模型拟合度更高,但获得的寿命也更加高,因此为了保证器件栅氧长期使用的可靠性,E模型成为了工业上栅氧寿命外推的首选公式。
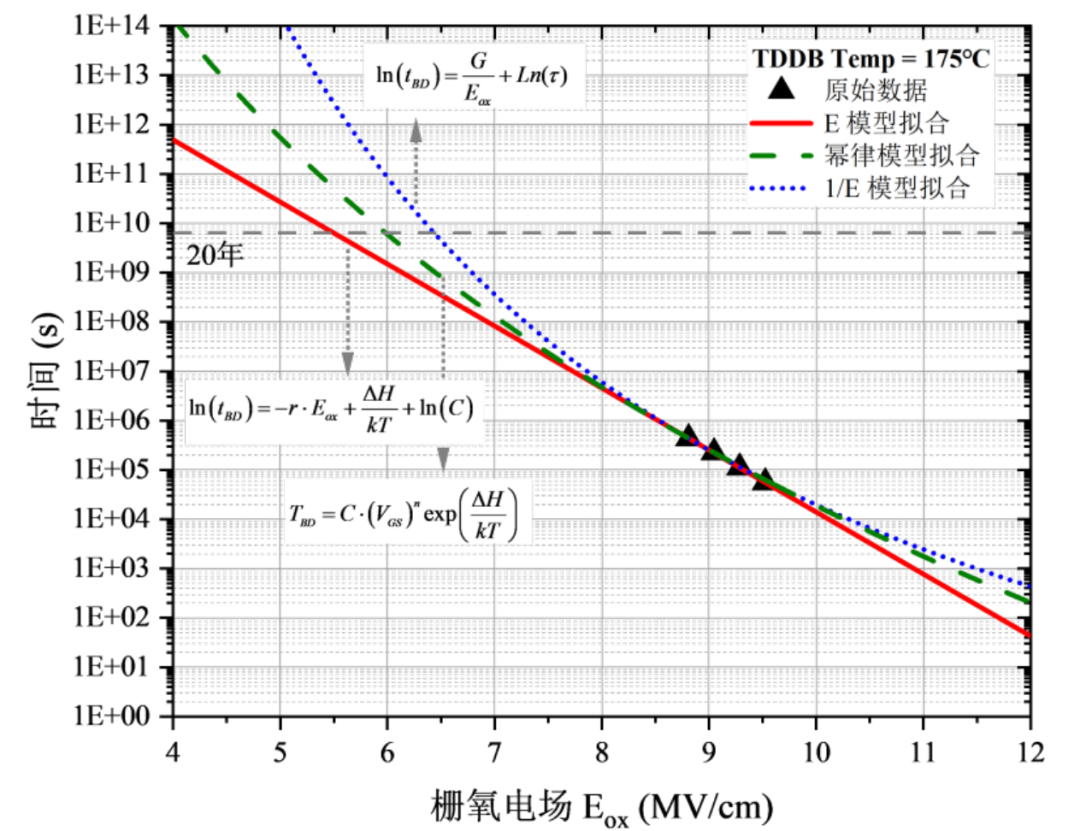
图5 不同模型寿命外推的拟合曲线[5]
小结:通过TDDB测试和寿命预测模型,我们可以有效评估SiC MOSFET栅氧的可靠性。实验结果表明,栅氧层的击穿时间与电场强度密切相关,且在不同应力条件下表现出不同的失效分布特性。基于E模型和1/E模型的寿命预测,可以为SiC MOSFET的设计和应用提供重要的可靠性参考。
然而,需要注意的是,TDDB测试仅能模拟栅氧层在恒定应力下的失效行为,实际应用中,器件可能会经历复杂的动态应力条件。因此,未来的研究可以进一步探索动态应力下的栅氧可靠性评估方法,以更全面地反映SiC MOSFET在实际工作环境中的可靠性表现。
关于扬杰
扬州扬杰电子科技股份有限公司是国内少数集半导体分立器件芯片设计制造、器件封装测试、终端销售与服务等产业链垂直一体化(IDM)的杰出厂商。产品线含盖分立器件芯片、MOSFET、IGBT&功率模块、SiC、整流器件、保护器件、小信号等,为客户提供一揽子产品解决方案。
公司产品广泛应用于汽车电子、清洁能源、工控、5G通讯、安防、AI、消费电子等诸多领域。
公司于2014年1月23日在深交所上市,证券代码300373,相信在您的关怀支持下,我们一定能够成为世界信赖的功率半导体伙伴。
-
MOSFET
+关注
关注
151文章
10812浏览量
234966 -
晶体管
+关注
关注
78文章
10440浏览量
148612 -
SiC
+关注
关注
32文章
3863浏览量
70125 -
碳化硅
+关注
关注
26文章
3548浏览量
52664
原文标题:如何验证SiC MOSFET栅氧可靠性——TDDB测试及栅氧寿命评估
文章出处:【微信号:yangjie-300373,微信公众号:扬杰科技】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
三菱电机SiC MOSFET的可靠性测试

什么是MOSFET栅极氧化层?如何测试SiC碳化硅MOSFET的栅氧可靠性?
SiC-SBD关于可靠性试验
SiC-MOSFET的可靠性
SiC MOSFET:经济高效且可靠的高功率解决方案
从硅过渡到碳化硅,MOSFET的结构及性能优劣势对比
SiC MOSFET FIT率和栅极氧化物可靠性的关系
ROHM SiC-MOSFET的可靠性试验
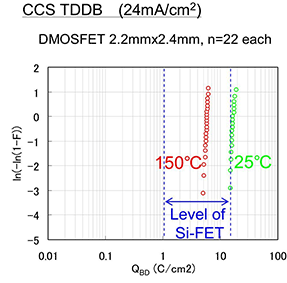
AEC---SiC MOSFET 高温栅氧可靠性研究

瞻芯电子参与编制SiC MOSFET可靠性和动态开关测试标准




 如何测试SiC MOSFET栅氧可靠性
如何测试SiC MOSFET栅氧可靠性

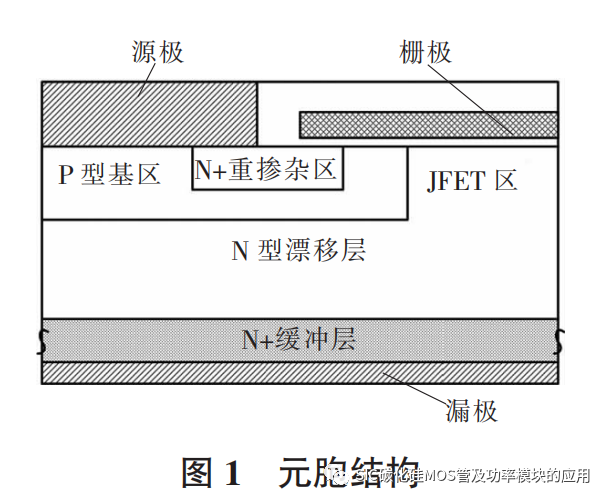

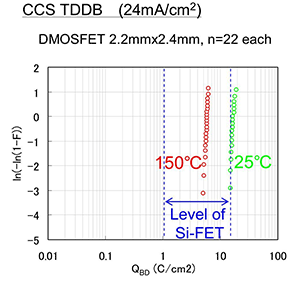





评论