摘要:碳化硅 SiC功率器件因其卓越的材料性能,表现出巨大的应用前景,其中金属-氧化物-场效应晶体管 MOSFET是最重要的器件。3300 V SiC MOSFET 可应用于轨道交通和智能电网等大功率领域,能显著提高效率,降低装置体积。在这些应用领域中,对功率器件的可靠性要求很高,为此,针对自主研制的3300V SiC MOSFET 开展栅氧可靠性研究。首先,按照常规的评估技术对其进行了高温栅偏 HTGB试验;其次,针对高压SiC MOSFET 的特点进行了漏源反偏时栅氧电热应力的研究。试验结果表明,在高压 SiC MOSFET 中,漏源反偏时栅氧的电热应力较大,在设计及使用时应尤为注意。
碳化硅 SiC(silicon carbide)功率器件因其卓越的材料优势,近年来得到迅速发展。高压、高频、高温和高功率密度等器件特性,使其在高效电能转换领域有巨大的市场, 其中金属-氧化物-场效应晶体管MOSFET的发展最引人关注。目前中、低压 SiC MOSFET已经部分商业化,Cree、Rohm 和 Infineon 等公司先后推出了相关产品,被广泛应用于电源、光伏和新能源汽车等领域。以 3300 V 为代表的高压 SiC MOSFET 已经出现样品, 并逐步在轨道交通和机车牵引等领域展开试用,大幅提升了系统的效率,降低系统体积。
与 Si 功率器件相同,SiC MOSFET 按照沟道方向可以分为平面型 MOSFET 和沟槽型 MOSFET。平面型 MOSFET 工艺相对简单,但 JFET 区域会存在夹断效应, 造成导通电阻增大;沟槽型MOSFET通过垂直沟道,解决了 JFET 区域电流夹断的问题,降低了器件的导通电阻,同时缩小了芯片元胞结构的尺寸,以实现更大的电流能力,但 SiC 沟槽的刻蚀及氧化工艺难度较大,且沟槽底部的电场尖峰较高,容易造成提前击穿,需要进行专门保护。
功率器件的可靠性是指在其工作边界内长期使用的寿命, 通过加速老化试验来进行研究。SiC MOSFET 可靠性的研究主要集中在栅极氧化层方面,由于 SiC 材料由 Si 和 C 两种原子组成,栅极氧化层时通过热氧化, 将 Si 元素变成 SiO2,C 则转化为 CO 或者 CO2 排出,C 元素如不能顺利排出,则会使氧化层质量下降, 造成器件可靠性下降。因此,SiC MOSFET 器件的栅氧可靠性问题是长期以来的研究热点。
1. 3300 V SiC MOSFET
1.1 器件结构
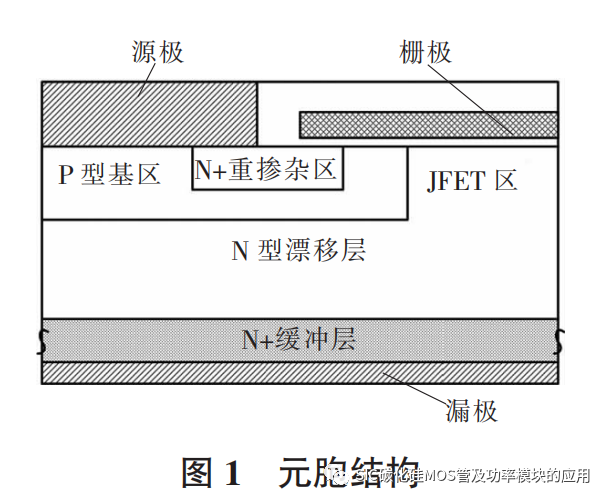
采用平面栅技术,基于中车时代电气半导体有限公司的工艺平台完成 3300V SiC MOSFET 芯片的制造,其元胞截面结构见图 1。其中,在外延层上通过离子注入工艺,依次形成 P 型基区与 N+重掺杂区, 然后完成栅极和源极的图形化。P 型基区中间的区域被称为“JFET 区”,该区域的尺寸对芯片的电流能力有直接影响。设计中对 JFET 区的宽度进行了分组, 分别设置了 2.5、3.5 和 4.5 μm 3 种结构。
1.2 参数性能
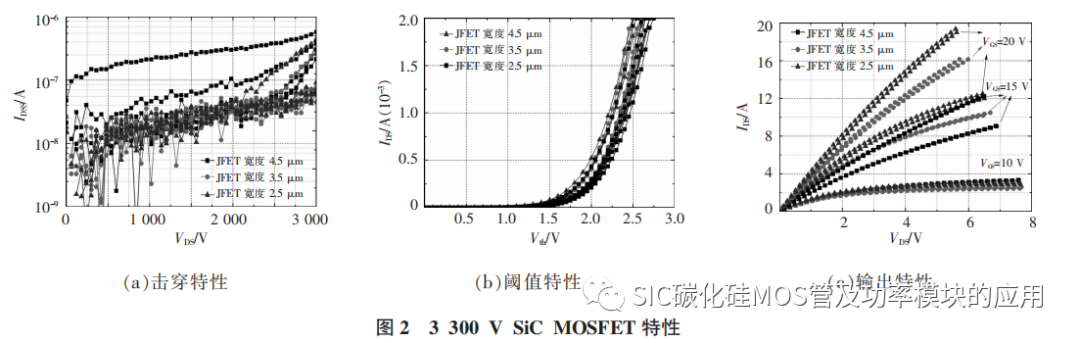
对完成制备的 3300V SiC MOSFET 器件,使用 Agilent B1505A 进行击穿特性、阈值特性和输出特性的测试,测试结果如图 2 所示。
从测试结果来看, 器件在 3000V 电压下漏电流 IDSS<1 μA,JFET 宽度为 4.5 μm 结构漏电流略大;器件的阈值电压 Vth≈2.5 V,与设计无相关性;器件的漏极电流 IDS 与 JFET 关系很大,在 VGS=20 V、VDS=2V 时,3 种结构的漏极电流 IDS 依次为 8、7 和 5.0 A。
2.高温栅偏试验
2.1 试验过程

高温栅偏 HTGB(high temperature gate bias)试验主要是对器件栅氧可靠性的考核,用于表征栅氧的质量及寿命等。挑选 6 只不同结构的 3300V SiC MOSFET 按照如下条件进行试验:Ta=150 ℃,VDS=0 V,VGS=20 V,t=168 h。器件在 HTGB 试验过程中, 栅极漏电 IGSS 的监控结果如图 3 所示。从监控结果来看,考核过程中器件栅极漏电 IGSS 稳定,且小于 0.3 nA,未出现失效。
2.2 考核分析
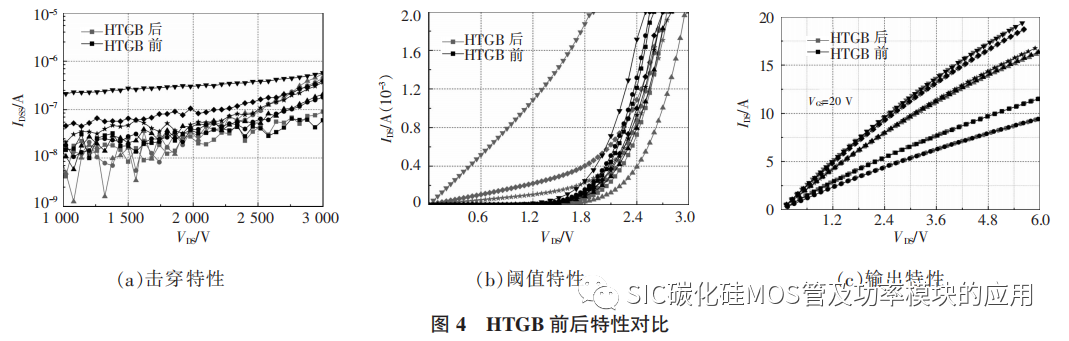
对被考核的器件依次进行击穿特性、阈值特性和输出特性的测试, 并与考核前测试结果进行对比。考核前后的器件参数对比结果如图 4 所示。
图 4 中,在考核后的击穿电压测试中,被测 6只器件,有 3 只发生失效,击穿电压变为 0 V;失效器件的阈值特性与合格器件出现明显差异,阈值曲线变软,如图 4(b)所示;而输出特性与合格器件未发现明显区别。结合图 3 的监控数据,在考核过程中器件栅极漏电流小于 0.3 nA,监控数据正常。因此,失效应该是发生在 HTGB 试验后击穿电压测试阶段,在器件承受反向较高的偏压时,栅氧化层被击穿,造成栅源穿通,导致阈值电压异常。
3.反偏栅应力试验
针对击穿特性评估中,出现栅氧的失效问题,基于 3300V SiC MOSFET 开展进一步研究,以评估高压 SiC MOSFET 器件在反偏时栅氧的电应力问题。
3.1 试验原理

在 MOSFET 击穿电压测试时, 漏极加高压,源极与栅极短接接地, 实际存在漏源和漏栅 2 个漏电通道。漏源之间的漏电流 IDS 实际是 PN 结漏电流;漏栅之间的漏电流 IDG 实际是 MOSFET 器件在承受反偏电压时栅氧的漏电流。图 5 为该试验的原理,通过 R1 和 R2 分别记录漏栅电流 IDG 与漏源电流 IDS。
3.2 试验条件
挑选 JFET 宽度为 2.5 μm 器件 2 只、JFET 宽度为 3.5 μm 器件 6 只、JFET 宽度为 4.5 μm 器件 2 只,共 10 只器件进行试验,测试条件如下。
条件 1:Ta=150 ℃,VCC=30 V,t=30 min;
条件 2:Ta=150 ℃,VCC =1 500 V,t=60 min;
条件 3:Ta=150 ℃,VCC=2 000 V,t=120 min;
条件 4:Ta=175 ℃,VCC=2 000 V,t=60 min。
记录漏源之间漏电流 IDS 和漏栅之间漏电流 IDG。
3.3 试验结果
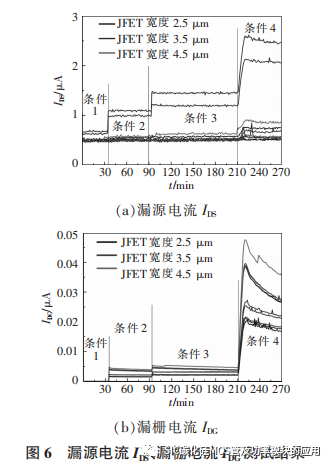
图 6 为漏源之间漏电流 IDS 和漏栅之间漏电流IDG 的试验结果。不同设计器件的 IDS 和 IDG 漏电与考核中电热应力的关系如表 1 所示。
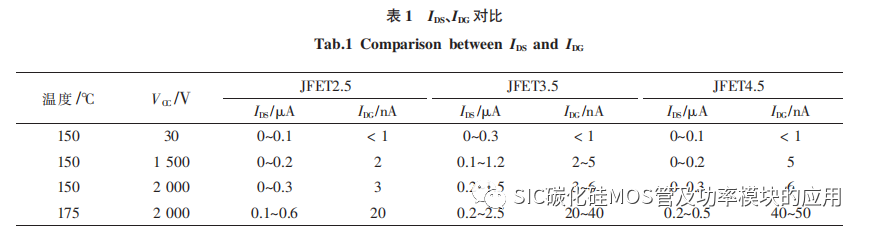
从图 6 及表 1 可以看出, 对于 3 种不同 JFET宽度设计的 3300V SiC MOSFET。
(1)漏源之间的漏电流 IDS,主要是 PN 结漏电,随着 VCC 的增大及温度的升高而增大;不同器件的漏电有差别,受终端保护环设计、材料缺陷等影响较大,与 JFET 宽度设计无关。
(2)漏栅之间的漏电流 IDG,主要是栅氧的漏电流, 会随着温度的升高及栅氧电应力的增大而增大。在本次试验中, 未直接给栅极施加电应力,但IDG 随着漏源之间耐压 VDS 的增大而增大,并且表现出与 JFET 宽度的相关性,JFET 宽度越宽, 该漏电越大。在 VDS=2000 V,Ta=175 ℃时,该漏电已达到50 nA,说明此时栅氧承受着很大的栅应力。
3.4 仿真验证
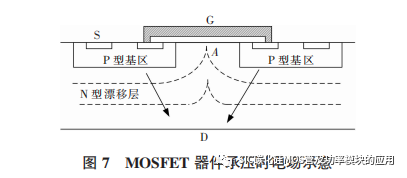
SiC MOSFET 器件在承受漏源耐压时, 如图7所示, 正面的 P 型基区/N 型漂移层结扩展以承受电压。随着反向耐压的增大,耗尽层(图 7 中虚线)会继续往垂直方向扩展。与此同时在器件横向方面,同样会存在电场扩展,造成 A 点的电势升高。
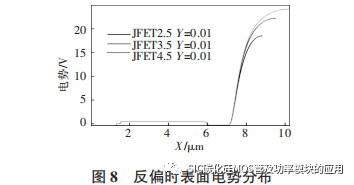
借助 TCAD Sentaurus 仿真软件,对漏源耐压为2 000 V 时, 不同 JFET 宽度中栅氧下 0.01 μm 处的电势进行仿真,结果如图 8 所示,其中 X 表示沿着沟道方向的横向距离,Y 表示栅氧下 0.01 μm 处。3 种JFET 宽度下,A 点(JFET 区中心点,栅氧下 0.01 μm处)的电势分别达到 17.5、22.1 和 25 V。JFET 越宽,该点的电势越高,这也能够证明图 6 中的试验结果。
4.结语
通过对3300V SiC MOSFET 栅氧可靠性的试验研究,发现不同芯片设计中,栅氧在 MOSFET 器件承受反偏电压时所承受的应力不同。该电应力随着反偏电压的增大及温度的升高而增大。针对这种现象,在高压 SiC MOSFET 器件可靠性评估中应额外考虑;此外,需要在设计及应用中对该隐患加以重视。

来源:变流与逆变技术
审核编辑:汤梓红
-
MOSFET
+关注
关注
141文章
6569浏览量
210134 -
光伏
+关注
关注
24文章
2337浏览量
67361 -
晶体管
+关注
关注
76文章
9054浏览量
135211 -
SiC
+关注
关注
27文章
2435浏览量
61404 -
碳化硅
+关注
关注
24文章
2432浏览量
47532
原文标题:3300V SiC MOSFET 栅氧可靠性研究
文章出处:【微信号:芯长征科技,微信公众号:芯长征科技】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
SiC-SBD关于可靠性试验
SiC-MOSFET与Si-MOSFET的区别
SiC-MOSFET的可靠性
沟槽结构SiC-MOSFET与实际产品
罗姆成功实现SiC-SBD与SiC-MOSFET的一体化封装
SiC MOSFET:经济高效且可靠的高功率解决方案
从硅过渡到碳化硅,MOSFET的结构及性能优劣势对比
SiC MOSFET FIT率和栅极氧化物可靠性的关系
SiC MOSFET的器件演变与技术优势
碳化硅SiC MOSFET:低导通电阻和高可靠性的肖特基势垒二极管
ROHM SiC-MOSFET的可靠性试验
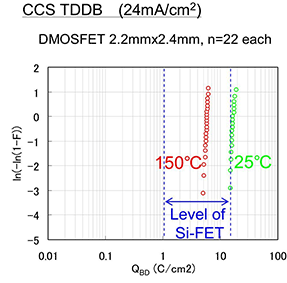




 3300V SiC MOSFET栅氧可靠性研究
3300V SiC MOSFET栅氧可靠性研究

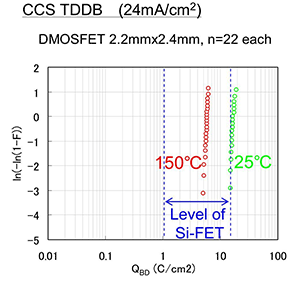












评论