本文简单介绍了热氧化与PECVD生成氧化硅的方式以及热氧化方式与PECVD的性能比较。
用PECVD做的氧化硅与热氧的氧化硅刻蚀速率同,热氧的氧化硅速率明显较慢,这是为什么?
热氧化与PECVD生成氧化硅的方式
热氧化是在高温下通过化学反应在硅表面生成氧化硅的方式。有干湿氧两种方式,方程式为:
干氧化 Si + O₂ → SiO₂
湿氧化 Si + 2H₂O → SiO₂ + 2H₂
由于是用热量来维持反应,因此需要高温,在1100℃左右。
而PECVD是在相对低温下利用等离子体增强化学反应在基片表面沉积氧化硅薄膜的方式。反应气体可以是硅烷或TEOS等,方程式为:
SiH₄ + 2O₂ → SiO₂ + 2H₂O
由于用等离子的方式,反应温度可以大幅度的下降。
热氧化方式与PECVD的性能比较
热氧化的氧化硅具有致密性,均匀性好,缺陷少,与硅基底结合强,应力小,纯度高等优点。
当与化学药剂发生反应时,热氧化硅致密的结构能够更有效阻止药液对本身的侵蚀。PECVD生成的氧化硅应力较大,缺陷多,使刻蚀液更容易渗透和反应,从而提高了刻蚀速率。
-
PECVD
+关注
关注
2文章
25浏览量
10488
原文标题:为什么热氧的氧化硅刻蚀速率比PECVD的慢?
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
PECVD工艺参数对二氧化硅薄膜致密性的影响
什么是MOSFET栅极氧化层?如何测试SiC碳化硅MOSFET的栅氧可靠性?
VirtualLab Fusion应用:氧化硅膜层的可变角椭圆偏振光谱(VASE)分析
VirtualLab Fusion应用:氧化硅膜层的可变角椭圆偏振光谱(VASE)分析
6英寸半导体工艺代工服务
石灰石二氧化硅化验仪器设备系列
用湿化学工艺制备的超薄氧化硅结构

6.3.2 氧化硅的介电性能∈《碳化硅技术基本原理——生长、表征、器件和应用》






 热氧化与PECVD生成氧化硅的方式比较
热氧化与PECVD生成氧化硅的方式比较

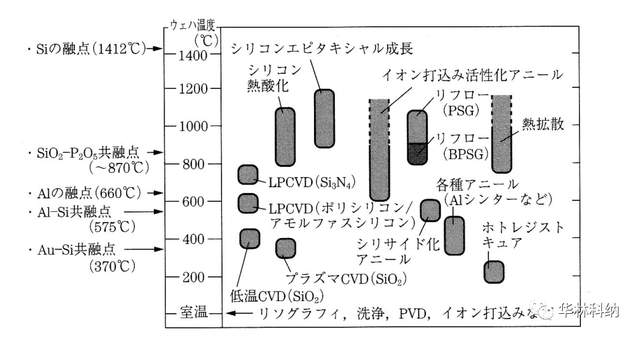


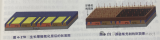











评论