欢迎了解
杨彦章 钟上彪 陈志华
(光华科学技术研究院(广东)有限公司)
摘要
先进封装是半导体行业未来发展的重要一环,是超越摩尔定律的关键技术。本文通过对不同封装材料进行表面金属化处理,发现粗糙度和镀层应力对镀层结合力均有显著影响。选择合适的粗化方法及低应力电镀铜镀液可以在不显著增加封装材料表面粗糙度的情况下提高镀层结合力(剥离强度>0.53 N/mm),从而有利于制作精细线路(线宽/线距=15 μm/15 μm)。
0 引言
先进封装包括PLP、SOC、SIP等封装,是顺应半导体行业向更小尺寸、更高性能发展趋势的新的高技术含量的封装技术 [1]-[4] 。先进封装表面金属化可以实现封装体电磁屏蔽、散热、导电等功能,进一步减小封装器件的尺寸,并且提高封装器件的性能 [5]-[7] 。目前先进封装表面金属化存在粗糙度高、结合力低等问题,面临难以制作精细线路的挑战 [8]-[10] 。针对这一问题,本文通过优化封装材料表面粗化技术和使用低应力电镀铜镀液,成功实现低粗糙度高结合力的镀层,并完成精细线路的制作。
1 粗糙度
粗糙度是表征材料表面形貌的参数(如图1所示),其数值大小对镀层结合力有显著影响 [11] 。一般来讲,粗糙度越大越有利于镀层结合力的增加,因此提高镀层结合力的重要手段在于增加接触面的粗糙度。然而粗糙度过大不利于制作精细线路 [12] 。
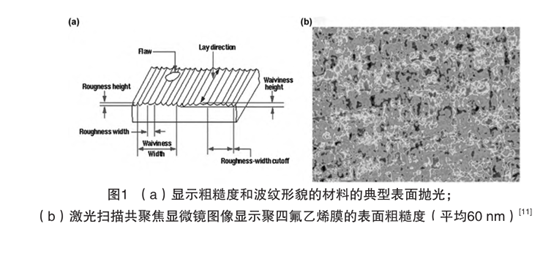
2 镀层应力
应力广泛存在于各种材料中,对材料的机械、化学等性能有重要影响 [13] 。电镀层的镀层应力会影响镀层硬度和开裂,例如应力越大的镀层其镀层机械性能越差。影响镀层应力的因素有很多,如镀液配方、电镀参数等 [14] 。
3 实验方案
3.1 原理
如图2所示,首先对封装材料表面进行粗化,然后使用化学镀在表面镀上种子层金属铜(<1 μm),最后使用电镀铜增加镀层厚度(>10 μm)。
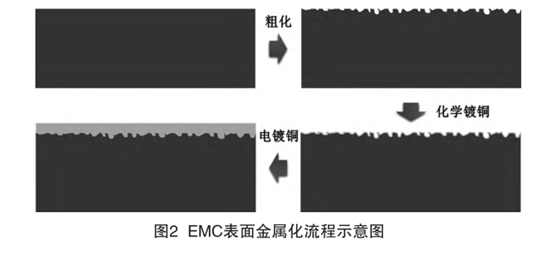
如图3所示,使用粗化方法A对封装材料EMC-1表面的树脂区域进行咬蚀,增大表面的粗糙度,然后使用化学镀在表面镀上种子层金属铜,最后使用电镀铜增加镀层厚度。
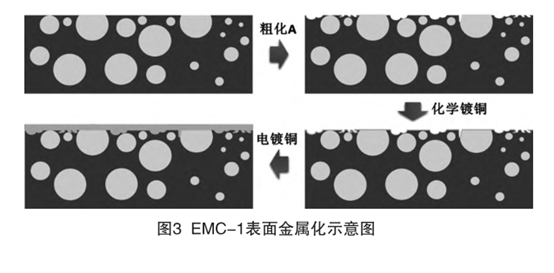
如图4所示,使用粗化方法B对封装材料EMC-2表面的填料区域进行咬蚀,增大表面的粗糙度,然后使用化学镀在表面镀上种子层金属铜,最后使用电镀铜增加镀层厚度。
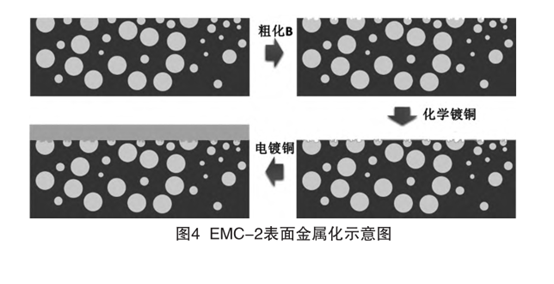
3.2 试验材料及测试设备
本文所使用的封装材料均为环氧树脂塑封料(EMC),这种类型的封装材料占整个电子封装材料的90%以上。EMC材料共有两种,差异主要体现在填料的筛分粒径不同——EMC-1和EMC-2的筛分粒径分别为50 μm和20 μm。测试设备包括激光共聚焦显微镜、电子扫描显微镜、剥离强度测试仪(如图5所示)、应力测试仪(如图6所示)。


4 实验结果及分析
EMC-1和EMC-2粗化前后表面的SEM照片如图7所示。从图中结果可以看出,粗化后的EMC材料表面形貌较粗化前变得更加粗糙:(1)粗化后的EMC-1表面树脂区域被咬蚀的微坑尺寸明显增大;(2)粗化后的EMC-2表面填料区域出现了清晰的咬蚀裂纹。
为进一步分析粗化前后的EMC表面粗糙度,我们使用激光共聚焦显微镜对EMC表面粗糙度进行表征,结果列于表1。从表1可以看出,EMC-1粗化后的表面粗糙度相较于粗化前显著增大,而EMC-2粗化后的表面粗糙度相较于粗化前增加不明显。这与图7的表征结果是一致的。
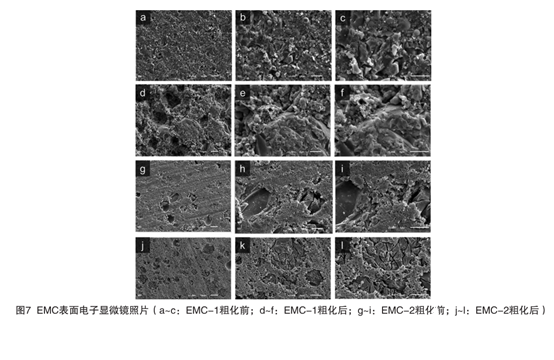

EMC表面电镀铜后的界面结构如图8所示。从图中可以看出,EMC-1/镀层界面起伏较大,这是由于EMC-1粗化后的表面粗糙度大(与图7d-f和表1一致)。EMC-2/镀层界面相较于EMC-1/镀层界面更加平坦,无显著起伏波动(与图7j-l和表1一致),这样的界面更易制作精细线路。
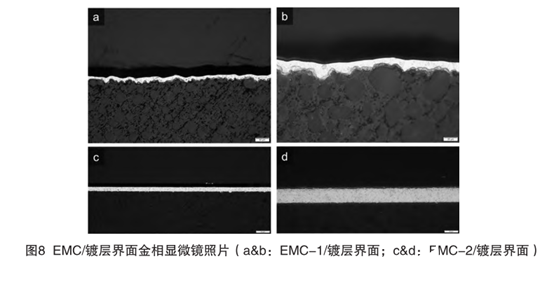
我们使用剥离强度来表征镀层与EMC之间的结合力。从表2可以看出,相较于未经过表面粗化处理的EMC材料,经过表面粗化处理后的EMC材料表面镀层的剥离强度显著增加,这表明EMC表面粗糙度对镀层结合力起重要作用。此外,不同的电镀铜镀液获得的镀层剥离强度不同:在相同前处理条件下,镀液2获得的镀层结合力要优于镀液1。这是由于镀液2的镀层应力更低(如表3所示),所以获得的镀层与基材之间的结合力更高。


在前面实验结果的基础上,我们使用SAP工艺在EMC-2表面制作精细线路。如图9所示,使用SAP工艺成功在EMC-2表面制作出线宽/线距=15 μm/15 μm的精细线路,且未出现线路脱落的现象,这表明该金属化工艺可以满足精细线路的制作要求。
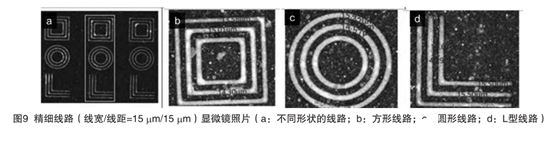
5 结论
环氧塑封料是先进封装常用的封装材料。本文研究了湿化学工艺中前处理和电镀对两种填料粒径不同的EMC封装材料表面镀层结合力的影响,发现增加表面粗糙度和降低电镀铜层镀层应力可以有效提高镀层结合力:最大剥离强度可达0.92 N/mm。选择填料尺寸较小的EMC材料,可以在低的表面粗糙度下(Sz<18 μm)实现0.58 N/mm的镀层结合力,并且使用SAP工艺制作出线宽/线距=15 μm/15 μm的精细线路。这些实验结果为适应未来先进封装金属化更高的要求提供了解决思路,也为电介质-金属互联工艺提供了技术参考。
审核编辑 黄宇
-
半导体
+关注
关注
339文章
31238浏览量
266571 -
封装
+关注
关注
128文章
9330浏览量
149047 -
SAP
+关注
关注
1文章
480浏览量
22835
发布评论请先 登录
深紫外光谱探微与四探针方阻仪实测:先进封装异质结构金属污染的光电协同评估

激光诱导烧火协同无银化Ni/Cu电镀:高性能TOPCon电池金属化应用

TDK金属化聚丙烯薄膜电容器B32714H - B32718H深度解析
TDK B32701P - B32703P 金属化聚丙烯薄膜电容器(MKP)的全面解析
松下汽车用金属化聚丙烯薄膜电容器ECWFJ系列技术分析
汽车级金属化聚丙烯薄膜 EMI 抑制电容器 R4Y 深度解析
探秘Class Y2浸渍金属化纸EMI抑制电容器SMP253
金属化薄膜电容是什么?结构原理、材料分类与应用全面解析

从DBC到AMB:氮化铝基板金属化技术演进与未来趋势

提升工业风机性能:永铭金属化聚丙烯薄膜电容器的优势解析

金属化后进行边缘钝化技术PET:减少硅太阳能电池分切损失,提升组件效率

太阳能电池金属化印刷技术综述:丝网印刷优化、质量控制与新兴技术展望

工业级TOPCon电池的低银量丝网印刷金属化技术,实现降银80%

电子封装中的高导热平面陶瓷基板及金属化技术研究




 先进封装表面金属化研究
先进封装表面金属化研究





评论