《电子时报》报道说,在人工智能(ai)热潮中,cowos等先进封装备受关注,但以3d芯片(小芯片)技术为基础的智能手机用ap(应用处理器)有望在2025年以后大量采用。
随着摩尔定律接近物理界限,在3纳米以下的先进工艺中,能够负担较高费用的顾客受到限制,晶片sip和逻辑芯片的3D堆叠概念正在成为重要的新一代趋势。
据消息人士透露,随着晶圆堆叠技术的成熟,与在单一节点制作整个soc相比,以晶片技术为基础的晶片构建将变得更加容易,具有更高的数量和费用节约效果。除了高端芯片的制造和包装外,soic和oem工厂也可以使用高端制造技术进行芯片制造,fcbga后端包装可以在osat(外包半导体包装和测试)中完成。
采用先进封装的3d芯片预计将在2025年以后大量使用。目前,苹果是tsmc info pop先进封装的唯一顾客。据消息人士透露,在过去的7、8年里,mediatech、qualcomm等ap企业因成本和供应链多元化问题,没有引进tsac的fan out套餐。苹果为了避免在fan out包装中可能发生的电力消耗及发热等潜在的不确定性,计划在以后的系列a中使用inpo。
几年前,联发科正在寻找台积电 info技术的信息。但是,由于担心收益率和大规模生产受到限制,非苹果AP供应商决定不使用先进封装。他们在未来2-3年内采用该技术的可能性尚不确定。
据消息人士透露,用于电脑和笔记本电脑的以soic(单线集成电路小轮廓封装)技术为基础的cpu后端封装需要与基板相关的fc(倒装芯片)包,因此可以委托给osat。但使用soic技术的智能手机ap并非如此。
2020年至2021年,mediatech和qualcomm向tsmc询问是否使用没有d内存的info技术,tsmc根据自己的需求推出了bottom only info_b。但是该技术还处于开发阶段,因此还没有被商用化。
精通移动ap的业界人士表示:“tsmc info和fan-out pop package都是andian、日光、张箭技术已经处于基本成熟的状态,跳跃的空间是有限的。”另外,fc pop封装与fan out封装相比既成熟又具有费用效率。
从osat的情况来看,panout 封装的生产经验和成本竞争力不如英镑工厂,这也是ic设计公司还没有将该技术引进到芯片生产上的原因之一。
-
摩尔定律
+关注
关注
4文章
640浏览量
81151 -
SiP
+关注
关注
6文章
543浏览量
107999 -
3D堆叠封装
+关注
关注
0文章
18浏览量
7604 -
3纳米
+关注
关注
0文章
32浏览量
5382 -
chiplet
+关注
关注
6文章
499浏览量
13646
发布评论请先 登录
估值700亿,国产智能手机芯片第一股冲击IPO!
Omdia:2026年AMOLED智能手机面板出货量预计将大幅下滑
存储涨价倒逼手机需求降温,联发科首当其冲:2月营收同比减少15%


2025年全球AMOLED智能手机面板出货量同比增长4.7%
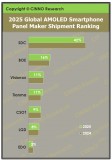
时隔五年再夺冠!IDC:华为手机重登中国TOP1,苹果、vivo紧随其后

傲琪人工合成石墨片: 破解智能手机散热困境的创新解决方案
2025年上半年全球AMOLED智能手机面板出货量公布

华大九天推出芯粒(Chiplet)与2.5D/3D先进封装版图设计解决方案Empyrean Storm

Chiplet与3D封装技术:后摩尔时代的芯片革命与屹立芯创的良率保障

2025年第一季度全球AMOLED智能手机面板需求持续旺盛




 2025年后智能手机芯片将大量采用3D Chiplet封装
2025年后智能手机芯片将大量采用3D Chiplet封装






评论