近期,美国南卡罗来纳大学报道了在AlN单晶衬底上通过MOCVD生长的Al0.87Ga0.13N/Al0.64Ga0.36N金属氧化物半导体异质结场效应晶体管(MOSHFET)器件。与相比之下,单晶AlN基器件的热阻抗降至AlN/蓝宝石基器件的1/3(从31K-mm/W压降至10K-mm/W),与SiC和铜散热器相当,相较于其他半导体器件体现出显著的热电协同设计优势,从而实现峰值漏极饱和电流由410mA/mm增加至610mA/mm,测试得的三端击穿场强为3.7 MV/cm,是迄今为止AlxGa1-xN沟道型器件的最高水平,巴利加优值(BFOM)达到460MW/cm2。
宽禁带III族氮化物高电子迁移率晶体管(HEMT)因为具有高通道迁移率和临界击穿场强及其带来的高通道电流和紧凑型器件的大功率承载能力,已在全球范围内广泛应用于各类电力电子器件。紧凑型器件还具有减少电容和其他寄生效应的额外优势,从而可实现更快的开关。宽禁带III族氮化物的上述优势已被用于制造更加高效的电力电子产品,如消费电子领域的充电器和下一代新能源汽车。然而,功率密度的增加也会导致整体系统性能受到散热能力的限制,例如电流衰减和过早失效,从而限制了宽禁带III族氮化物功率器件的深度拓展。造成散热问题的主要原因在于目前使用的低热导率衬底材料(硅、蓝宝石、Ga2O3等)的散热能力不足。
超宽禁带半导体AlN单晶衬底(禁带宽度> 6eV)具有优异的热导性和高温稳定性,可使深度扩展的下一代紧凑型电源系统实现被动热管理。除了热效益外,AlN衬底还可实现AlxGa1-xN沟道型HEMT器件(Al组分> 60%,禁带宽度> 4.5eV)的假晶外延层结构的生长。这种低位错的假晶外延层结构理论上可以显著降低栅极电流,从而提高器件的稳定性。
此项研究中,科研人员展示了在单晶AlN衬底上的假晶
Al0.87Ga0.13N/Al0.64Ga0.36N金属氧化物半导体异质结场效应晶体管(MOSHFET)器件,其线性欧姆接触通过反向组分梯度排列的AlxGa1-xN层和介电帽层实现,以消除过早的表面击穿。这一创新使得MOSHFET器件的导通状态峰值漏极电流密度达到610mA/mm(在+2V栅极偏压下),通断比(~107),栅极-漏极间距LGD=2.64μm器件的三端关闭状态击穿场强> 3.7 MV/cm。
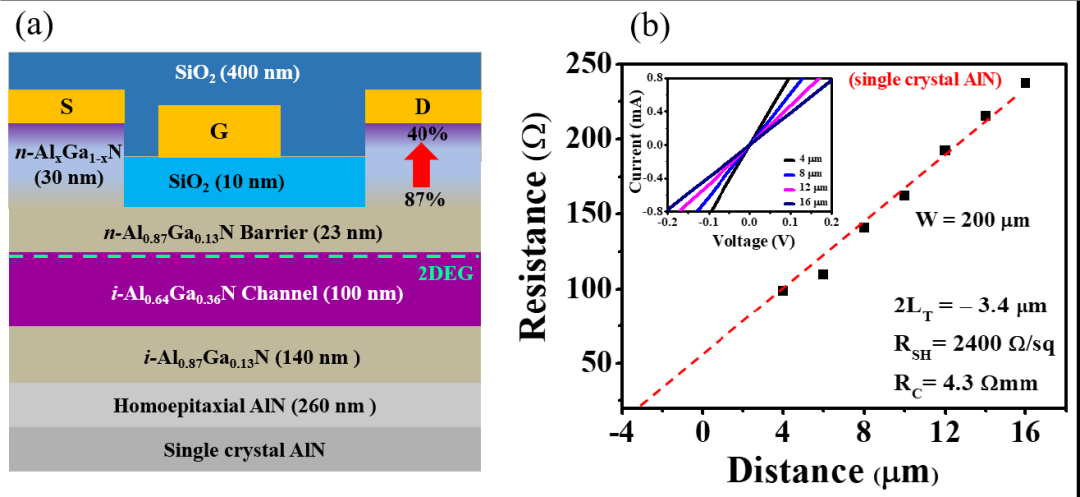
图1:(a)高Al组分Al0.64Ga0.36N沟道型MOSHFET示意图,
(b) AlN单晶衬底基器件(W=200μm,接触间距为4 ~16μm)的TLM测量结果
该MOSHFET器件的外延结构如图1(a)所示。采用低压金属有机化学气相沉积(LP-MOCVD)法在AlN单晶衬底上生长。该结构包括260nm的同质外延AlN层,随后是140nm的i-Al0.87Ga0.13N背势垒层、100nm的i-Al0.64Ga0.36N通道层和23nm的n-Al0.87Ga0.13N势垒层。为了促进欧姆接触的形成,在该结构上覆盖了一层30nm的高硅掺杂的反向梯度AlxGa1-xN(x = 0.87→0.40)层。硅掺杂补偿了反向渐变过程中极化产生的空穴。该器件的制造源于使用Cl2基的电感耦合等离子体反应蚀刻(ICP-RIE)进行台面隔离。
采用电子束蒸发法在源极/漏极触点沉积了Zr/Al/Mo/Au(150/1000/400/300Å)金属层,然后在N2环境下进行30秒950℃的快速退火热处理。然后采用ICP-RIE蚀刻法在通路区除去AlxGa1-xN反向组分梯度层,并沉积10nm的SiO2作为栅氧化层。接下来,栅极和探针板被电子束蒸发。栅极和探针金属层分别由Ni/Au(1000/2000Å)和Ti/Ni/Au (500/700/1500Å)组成。最后,通过等离子体增强化学气相沉积(PECVD)将器件嵌入400nm厚的SiO2薄膜中,以减轻击穿电压测量产生的表面电场。除AlN单晶衬底外,科研人员也通过在AlN/蓝宝石(t=3μm)模板上沉积同样的外延结构制造相同器件。
研究中,欧姆接触的线性度是通过传输线模型(TLM)测量建立的。从中分别提取了AlN单晶衬底和AlN/蓝宝石模板上器件的接触电阻4.3Ω-mm(~7.7×10-5Ωcm2)和4.7Ω-mm(~9.7×10-5Ωcm2)和表面电阻2400Ω/sq和2282Ω/sq。AlN单晶衬底基器件的TLM结果如图1(b)所示。
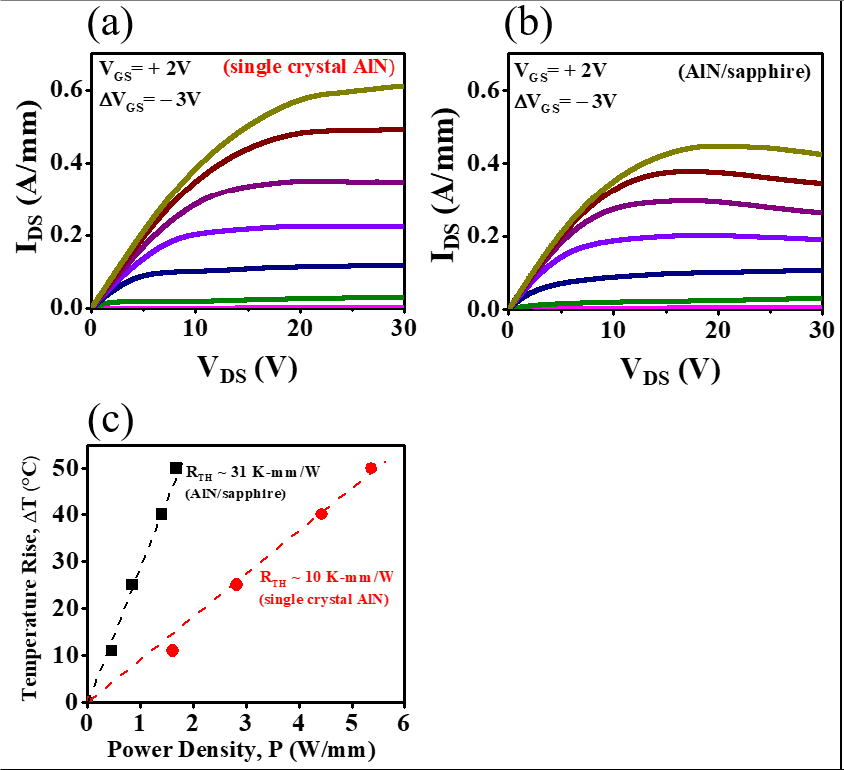
图2:(a) AlN单晶和(b)AlN/蓝宝石上Al0.87Ga0.13N/Al0.64Ga0.36N MOSHFET的IDSvs VDS。(LSD=6μm,LG=1.8μm)。(c)这些相同MOSHFET器件的温升与功率密度的比较,在12μm TLM间距和200μm宽度下测量。
传输(IDSvs VGS)和输出(IDSvs VDS)特性使用参数分析仪测量。电容电压(C-V)的测量使用HP4284A精密LCR计完成。所有的测量都是在没有外部冷却的晶圆上进行的(未封装的器件)。图2(a)和(b)分别显示了AlN单晶基和AlN/蓝宝石模板基AlGaN MOSHFET器件在栅极长度LG=1.8μm,栅极到源极距离LGS=1.2μm,栅极到漏极距离LGD=2.64μm下的输出特性。在VG=+2V和VD=30V时,AlN单晶和AlN/蓝宝石模板器件分别在峰值电流为610mA/mm和410mA/mm时观察到明显的饱和截断。
与基于AlN/蓝宝石的MOSHFET相比,AlN单晶衬底上的MOSHFET在最高栅极和漏极电压处没有出现降温,表明具备更好的热管理性能。为了量化热改进,科研人员测量了器件的热阻抗(RTH)。图2(c)显示热阻抗分别为10K-mm/W(AlN单晶衬底)和31K-mm/W(AlN/蓝宝石)。由于接触电阻和表面电阻几乎与衬底类型无关,器件热阻抗3倍的差异是单晶AlN基器件的峰值漏极电流密度显著提高的主要诱因,其根源在于AlN单晶衬底的导热系数比蓝宝石基板高8倍。AlN衬底的这种同步设计改进使其相对于其他低导热系数衬底材料如蓝宝石、Ga2O3的优势得以量化,如热性能图所示(TFOM)。
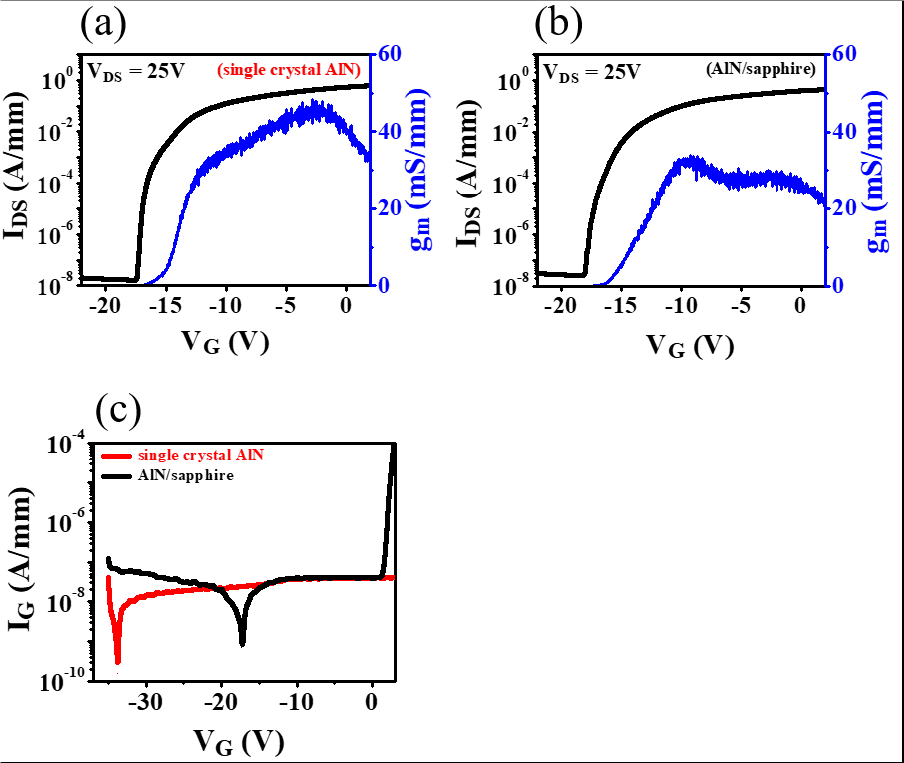
图3:(a) AlN单晶衬底和(b) AlN/蓝宝石模板上的MOSHFET在VDS=25V下的转移特性和跨导。(c)两个器件的归一化栅漏(IG)。
图3比较了AlN单晶衬底和AlN/蓝宝石模板上MOSHFET的传递曲线、跨导和栅漏电流。传递曲线数据中,两种不同衬底类型上的器件显示出了相近的通断比~ 3.6×107和~ 2×107。这对于AlGaN基MOSHFET来说具有典型性。由于两种衬底上的器件都具有SiO2栅极绝缘体,因此可以忽略反向栅极泄漏电流的差异。然而,基于AlN/蓝宝石模板的MOSHFET在正栅极电压下的栅极漏电流明显更高。图3(a) 、(b)获得了几乎相同的阈值电压(VTH)-16.9V(单晶AlN)和-17.3V(AlN/蓝宝石模板)。图3(a)、(b)还凸显了VDS=25V时栅极电压相关的跨导(gm)。单晶AlN在VG=-2.4V时的gm峰值为45mS/mm,AlN/蓝宝石在VG=-9.3V时的gm峰值34mS/mm。
AlN单晶衬底的跨导(gm=通道迁移率μn ×栅电容CG)峰值在更优的栅电压(VG)处,与上文论述一致,即由于热管理的改进,在AlN单晶衬底上可实现更高的电流。在蓝宝石上,加热抑制了通道的迁移,从而导致图2(b)中的热降。在单晶AlN上,热这一瓶颈问题的解决使得器件在热限制抑制跨导之前可实现更高的峰值电流。以下事实进一步支持了这一论断,即两种结构的栅极电容相似,因此通道迁移率是决定峰值附近跨导的主要因素。
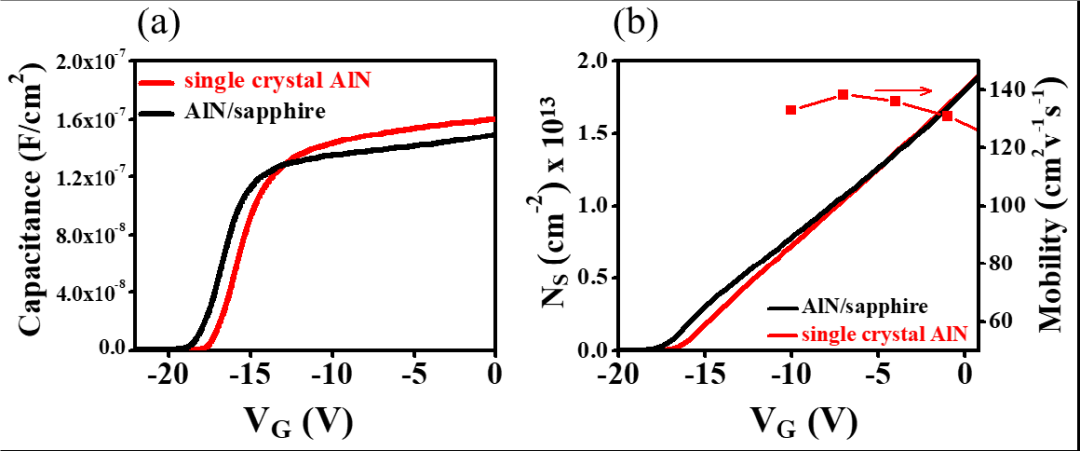
图4:(a) 100μm栅极TLM(GTLM)在1MHz时的电容电压特性,(b)单晶AlN和AlN/蓝宝石模板上MOSHFET的NS和μVG相关性。
对于C-V的测定,选择栅极长度LG=100μm,栅极宽度W=200μm的大面积器件,获得如图4(a)所示的可测量电容值。这里的VTH与图3传输特性中的VTH非常一致。从图4(a)中提取载流子浓度,并将其绘制在图4(b)中作为栅极电压的函数,可以看出,在VG=0V时,载流子浓度为1.79×1013cm-2,与衬底无关。而测得的单晶AlN的通道电子迁移率~130 cm2V−1s−1,这解释了进入区域和接触电阻。
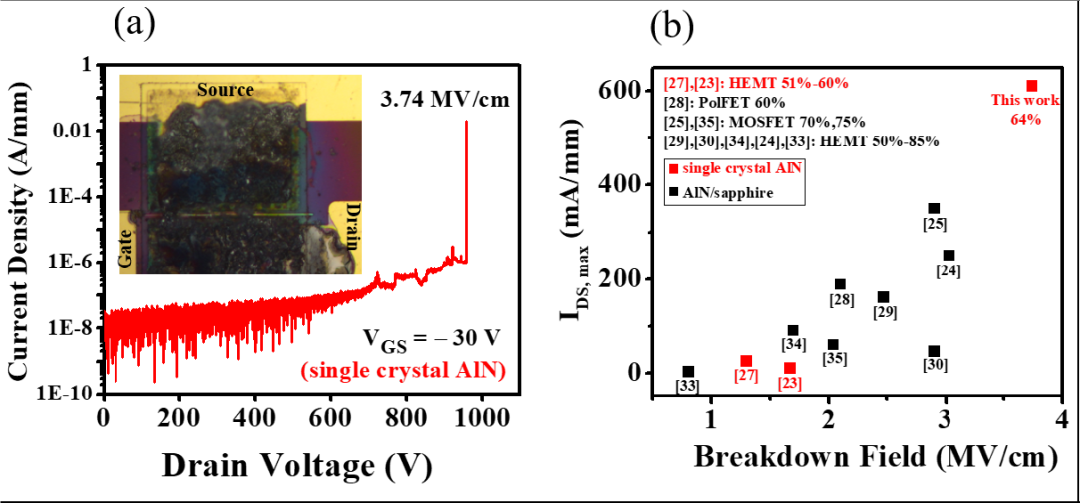
图5:(a) VGS=-30V时单晶AlN上MOSHFET的三端击穿,(插图)器件击穿后的显微照片,(b)本文报导与其他文献报导的所有超宽禁带半导体AlGaN通道单晶AlN基和AlN/蓝宝石基HEMT器件的IDS、max及击穿场比较。图中注明了通道组分。
最后,科研人员测试了MOSHFET在单晶AlN上的击穿电压,以量化其关闭状态性能。当栅极-漏极间距为2.64μm时,VG=-30V下的三端击穿电压为VBR=959V,如图5(a)。通过图2(a)中的三极管区导通电阻,保守估计BFOM~460MW/cm2,包括图1(b)中TLM图的转移长度(LT)的影响。鉴于TLM描述假设了一个各向同性的内面二维电子气体(2DEG),而这在退火欧姆接触下是不可能的,因此我们可以在LT=0时将BFOM > 750 MW/cm2设定为合理的上限。
这比在AlN、Ga2O3和蓝宝石衬底等类似几何形状(见表1)的同级别超宽禁带半导体通道的其他结果高出约10倍,系目前的最高水准。对应于3.7MV/cm的平均击穿场强(EC),测得的击穿电压为959V。这仍然是Al0.64Ga0.36N通道器件约10.0MV/cm理论极限的1/3,并且主要受到表面闪络的限制(如图5(a)的显微照片所示),且未来可以通过优化场板设计来解决这一问题。图5(b)就该器件与其他报导中高质量超宽禁带半导体AlGaN沟道场效应晶体管的峰值漏极饱和电流和击穿场强进行了比较,展示了AlN单晶衬底上反向渐变组分接触层高Al组分MOSHFET的前景。
表1:代表性同类器件的BFOM比较

结语:本文在AlN单晶衬底上展示了高Al组分AlxGa1-xN(x=0.64)沟道型MOSHFET的最先进性能。反向梯度接触层使器件实现线性欧姆接触,接触电阻为4.3Ωmm。峰值漏极电流为610mA/mm(+2V栅偏压),跨导为45mS/mm,通断比为107,三端击穿场强为3.7MV/cm(LGD=2.64μm下),是迄今为止此类器件报道的最高性能。通过与AlN/蓝宝石衬底上相同器件的比较,证实了单晶AlN衬底基MOSHFET的热阻抗降低了3倍,这是形成器件优越导态性能的最主要驱动因素。
译改自原文:Al0.64Ga0.36N Channel MOSHFET on Single Crystal Bulk AlN Substrate
原文作者:Abdullah Mamun*, Kamal Hussain, Richard Floyd, MD Didarul Alam, MVS Chandrashekhar, Grigory Simin, and Asif Khan
Department of Electrical Engineering, University of South Carolina, Columbia, SC29208, U.S.A.
原文发表于:The Japan Society of Applied Physics
原文链接:https://doi.org/10.35848/1882-0786/acd5a4
DOI 10.35848/1882-0786/acd5a4
审核编辑:刘清
-
充电器
+关注
关注
100文章
4369浏览量
121122 -
晶体管
+关注
关注
78文章
10250浏览量
146259 -
场效应晶体管
+关注
关注
6文章
401浏览量
20362 -
SiC
+关注
关注
32文章
3503浏览量
68128 -
HEMT器件
+关注
关注
1文章
3浏览量
6741
原文标题:基于AlN单晶衬底的AlGaN沟道型MOSHFET功率最新进展
文章出处:【微信号:第三代半导体产业,微信公众号:第三代半导体产业】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
风光互补技术及应用新进展
风光互补技术原理及最新进展
DIY怀表设计正式启动,请关注最新进展。
车联网技术的最新进展
VisionFive 2 AOSP最新进展即将发布!
Topic医疗开发平台的最新进展
工业机器人市场的最新进展浅析
基于AlN单晶衬底的AlGaN沟道型MOSHFET最新进展
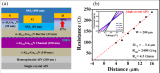





 基于AlN单晶衬底的AlGaN沟道型MOSHFET功率最新进展
基于AlN单晶衬底的AlGaN沟道型MOSHFET功率最新进展

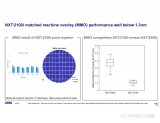










评论