IGBT全称绝缘栅双极型晶体管(Insulated Gate Bipolar Transistor)。其历史可以追溯到1979 年。当时,在美国通用电气公司的 B.J.Baliga 首次在论文中描述了一个四层垂直器件结构,并通过相关实验证明了可以通过调节栅极电压来控制该结构的电流大小,这是工业史上首次有人展示IGBT的工作模式。之后不久,美国的H.W.Becke 和 C.F.Wheatle 在一份专利中首次指出 IGBT 工作时没有出现晶闸管(Thyristor)效应。
1982 年相关文献报道了首个真正可以驱动电流进行工作的IGBT,其具有对称的600V击穿电压性能,并且可以在直流、交流电路中应用。最初出现的对称型 IGBT 采用了混合解决方案,集成在一起的功率 MOS 场效应晶体管部分导通时的沟道电流向 BJT 部分提供工作时的基极电流,同时 BJT 部分发射极向基区注入空穴,使得 MOS 场效应晶体管部分体区附近累积载流子,从而改善导通特性。
MOS 场效应晶体管部分载流子累积又使得此复合结构中 BJT 部分的基极驱动电流显著增加,二者协同工作,从而改善了整个器件的特性。自 1979 年 IGBT 被提出以来,其性能和制造工艺都得到了显著的优化、改进,应用范围也越来越广。工业界一般将其发展趋势按衬底工程和栅工程技术归纳为六代,
如图1,其衬底工程技术经历了从穿通(punch through, PT)型到非穿通型(not punch through, NPT),再到场截止型(field stop, FS)的演变。
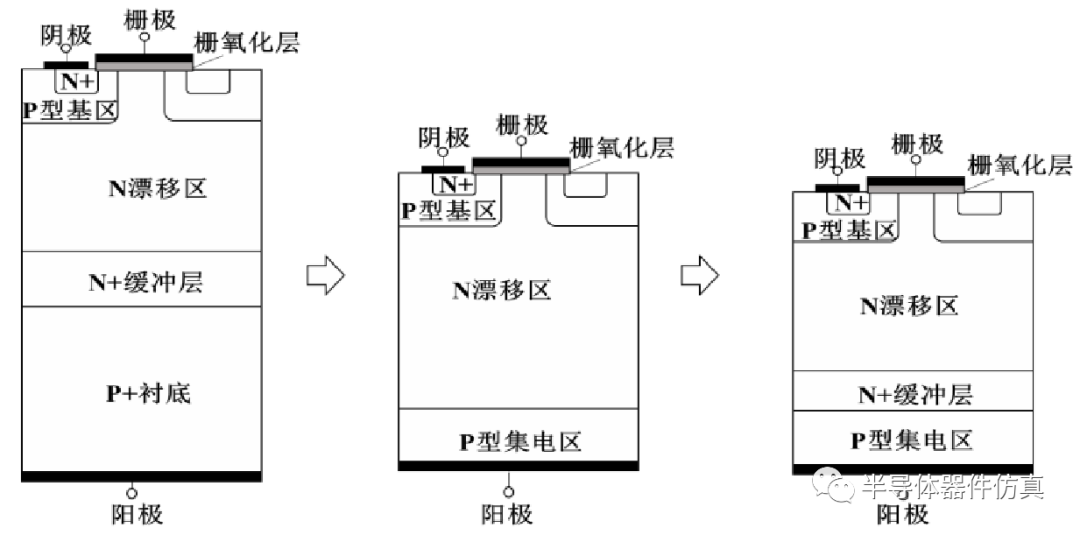
图1 IGBT衬底工程技术发展
穿通型 IGBT 采用厚的 P+衬底,在其上进行两次外延,分别形成器件的缓冲层和漂移区,这种工艺不需要另外的背注工艺,工艺难度低,且可以与 MOS 工艺很好地兼容。但是若要求的器件耐压较高,则需要较厚的外延层,工艺成本较高,且会使得器件导通状态下外延层压降变大,从而增大导通压降。另外,因衬底掺杂较高,在导通期间正向电压的作用下会向漂移区注入大量空穴,器件关断时这些空穴的复合作用使得器件不能立即关断,大大增加了关断损耗。且采用 PT 型衬底工艺的器件,其导通压降随温度升高而降低,在并联应用时电流不能平均分配,限制了其应用。
G.Miller 等人在 20 世纪 80 年代末提出了非穿通型结构,该工艺通过采用高电阻率的区熔单晶片代替昂贵的直拉异质厚外延硅片,降低了工艺成本。该结构集电极通过背注和退火形成,这使得集电极掺杂相对较低,减小关断损耗。与 PT 型衬底工艺相反,采用 NPT 型衬底工艺的器件,其导通压降随温度升高而增加,这增加了 IGBT 的可利用范围。但此结构仍未能改善穿通型 IGBT 在高耐压应用时需要做较厚漂移区的状况。鉴于此,场截止型 IGBT 应运而生。
场截止型结构具有与穿通结构相似的缓冲层,但其缓冲层的掺杂浓度比穿通结构的更低。在耐压相同的条件下,场截止型 IGBT 元胞纵向深度要明显小于穿通型和非穿通型 IGBT,这可以降低器件的导通饱和压降和关断时间。与 NPT 型 IGBT一样,其导通压降也随温度升高而增加,可应用于大电流并联场景。随着工艺的进步,场截止型 IGBT 厚度可持续减薄, 2011 年,英飞凌公司制造出了硅片厚度仅为 40μm 的场截止型 IGBT。
从栅工程技术上来看,IGBT 经历了平面栅到沟槽栅的演变,图2所示是不同栅结构 IGBT 演变示意图。使用 DMOS 工艺制造的平面栅 IGBT 技术上受扩散限制,且因为它具有寄生 JFET 电阻以及水平电流路径,导通压降较高。与之相反,沟槽栅 IGBT(trench gate IGBT, TIGBT)制造时工艺上不受扩散限制,不具有寄生JFET 电阻,并且具有垂直电流路径,因此其导通状态压降要低得多。沟槽栅 IGBT是由 H.R.Chang 和 B.J.Baliga 于 20 世纪 80 年代末提出的。非对称沟槽栅 IGBT在 P 基极和 N+发射区进行扩散后,通过使用反应离子刻蚀蚀刻出栅极沟槽。该槽的深度必须大于 P 基极区的结深,以便在沟槽侧壁上形成的沟道能连接 N+发射区和 N 漂移区,形成 MOS 结构。
接着,在沟槽的表面生长一层牺牲氧化层,随后重新生长栅氧化层、淀积多晶硅填充沟槽、将多晶硅平坦化使栅电极凹进略微低于硅表面。淀积层间介质膜后,形成N+发射极和 P 基极区的接触窗口。在沟槽栅 IGBT 工艺过程中,通常在 P 型基区表面靠近 N+发射区的地方扩散形成一个高掺杂的 P 型接触区,以改善基区的接触和抑制 N+发射区、P 型基区、N 型漂移区和 P+集电极所形成晶闸管结构的闩锁效应。P 型接触区的深度通常比基区小,并且小于沟槽栅的深度以避免产生寄生的结型场效应晶体管。
采用沟槽栅结构的优势在于消除了平面栅结构中的 JFET 电阻,且因沟槽栅将栅极做在 IGBT 内部,在导通时可以形成载流子浓度更高的沟道,提高了器件性能。但沟槽栅 IGBT 结构缺点在于沟槽栅底部电场较高,易发生击穿,因此在应用时需要对其进行结构和工艺上的优化。
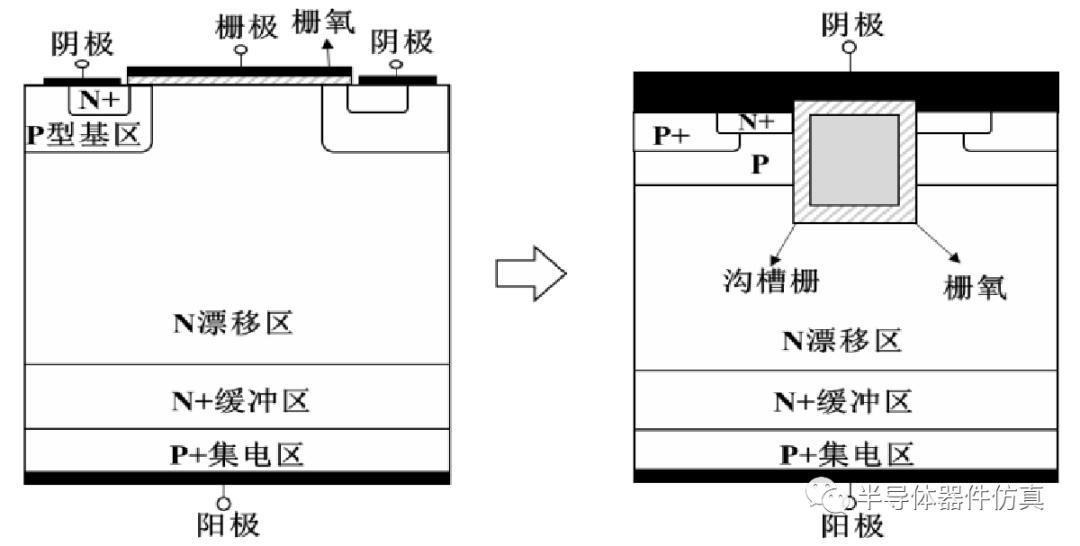 图2 IGBT栅极工程技术发展
图2 IGBT栅极工程技术发展
本文以沟槽栅场截止型IGBT为例进行器件仿真建模介绍。该实例仿真研究了IGBT不同尺寸沟槽栅以及不同N+发射极延伸距离对器件性能的影响。也因为要仿真出N+发射极延伸距离的影响所以本实例构建了三维结构,因为器件实际的延伸距离不会仅仅在一个维度方向。结构建立后,Ic-Vg,Ic-Vc以及BV(Breakdown Voltage)特性被仿真出来。
随后,在Sdevice中,构建IGBT的标准测试电路,在混合模式下跑出IGBT的开关特性,以及在器件开关操作过程中的能量损失(Eon和Eoff)。此外,为了获取器件的失效时间,在短路条件下仿真了该器件结构的电力和热力学特性。器件本身的Eon-Von,BV-Von以及tsc-Von(short-circuit failure time)特性都得到了全面分析。
PROCESS构建IGBT器件结构和掺杂分布
本实例根据图3的版图和图4的器件参数分7个步骤进行了工艺仿真。

图3 IGBT版图示意图

图4 SPROCESS 仿真参数
图4中的参数具体含义如下:
pmesh:过程仿真中的网格控制参数
dthick: IGBT厚度,默认60um
zfac:发射端N+区域与z方向器件整个宽度的比值。本实例中使用的值分别为10、20和30
Xmesa:两个相邻的栅极边缘之间的横向距离。本项目中使用的值分别为2、3和4um
ndriftD:漂移区的掺杂浓度,默认3e14
nbD: 场截止区掺杂浓度默认1e13
pwelD:pwell掺杂浓度,默认5e16
niD:n注入(pwell和n漂移层之间)的掺杂浓度 默认3e14
AnodeD:P+集电极的掺杂浓度 默认3e15
根据图4的参数器件可以分成以下步骤进行工艺仿真:
1.自适应网格划分和衬底的定义
2.气相淀积外延层
3.刻蚀沟槽
4.淀积栅氧和多晶硅
5.发射极掺杂注入和扩散
6.场截止和P+集电极掺杂注入和扩散
7.电极定义
可以获得图5所示的3D模型,为了便于观察图中将器件放倒,其左侧为实际器件的底部,也就是集电极,右侧包括实际器件的沟槽栅以及发射极。图6为图5右侧的二维截面图。可以观察到沟槽栅的深度以及发射极掺杂。

图5 IGBT 3D结构图

图6 IGBT 剖面图
电学仿真1
建立好3D结构后,则可以进行一系列器件特性仿真,得到包括图7,8,9的Ic-Vg,Ic-Vc以及击穿电压特性,以及根据前述曲线算得图10的Vth,Von,BV器件性能。

图7 Ic-Vg曲线

图8 Ic-Vc曲线

图9 BV曲线

图10 提取出的IGBT器件特性
电学仿真2

图11 IGBT开关特性仿真电路
图11中,Q1为IGBT器件,这里通过AreaFactor参数设置为1e5,将整个器件的终端电流倍增系数放大1×10^5^
图12展示了当一个单脉冲VIn输入图11电路时的瞬态响应。其中Vcc为200V。通过将集电极电流和集电极电压的乘积按相应的时间间隔积分,计算出器件开启状态和关闭状态的能量消耗值。对于IGBT器件,器件关闭过程中的集电极尾电流是关闭状态能量优化的一个重要特性。因此,在器件优化过程中,器件设计师需要考虑Eoff与Eon或Eoff和Von的趋势变化进行器件设计。

图12 IGBT开关瞬态曲线
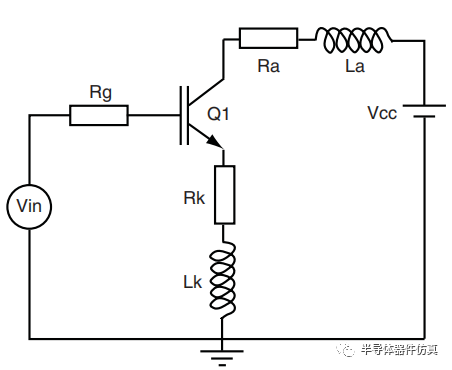
图13 IGBT短路失效特性仿真电路
图13展示了用于仿真短路失效特性的测试电路。测试电路中的器件Q1是IGBT,和前面一样终端电流和电荷乘以比例因子1e5。图14显示了设备在短路下的电气和热特性。在仿真过程中,栅极和集电极端子都保持在相应的最大工作值,并等待器件温度达到其熔点(硅的熔点为1687 K)。最大电压与器件温度达到熔点之间的时间间隔定义为短路失效时间(tsc)。

图14 IGBT短路失效电流、温度曲线

图15 提取IGBT开关和失效特性参数
通过仿真可以得出TG-FS-IGBT器件性能Eoff-Von、BV-Von、tsc-Von强烈依赖于Xmesa和zfac参数的变化。对于击穿电压和短路失效时间,两个参数值都随着Von的减小而减小。zfac值的降低改善了器件的短路失效特性。通过增加Xmesa的值,短路失效特性还可以得到进一步的改进。
本文器件描述参考苗晶晶,姚兆铭,张森硕士学位毕业论文
-
IGBT
+关注
关注
1293文章
4466浏览量
265257 -
MOS
+关注
关注
32文章
1801浏览量
101450 -
场效应晶体管
+关注
关注
6文章
426浏览量
20763 -
BJT
+关注
关注
0文章
238浏览量
19350
发布评论请先 登录



 绝缘栅双极型晶体管IGBT工艺仿真
绝缘栅双极型晶体管IGBT工艺仿真


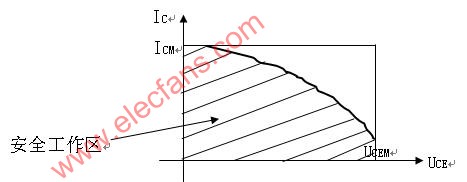
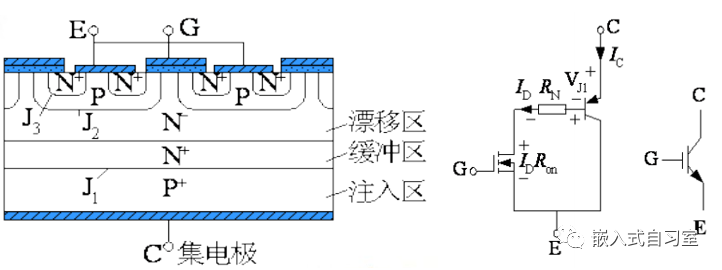




评论