装片又称黏片。广义的装片是指通过精密机械设备将芯片或其他载体,利用粘贴介质将其固定在为达成某种功能而构建的平台、腔体或任意材料组成的器件内。狭义的装片是指IC 封装前的工序,即通过专门的装片设备,利用装片胶、胶膜等材料,将切割后的圆片芯片与不同封装形式的框架或基板进行黏结。
裝片的目的:在芯片与载体之间实现有效的物理性连接;满足电性能的要求,在芯片与框梁之间达到传导性成绝缘性的连孩:作为传导介质特芯片上产生的热能传导到器件外部,达到一定的散热效果。
装片的要求:必领具备永久结合性,在器件应用过程中不应出现在外部环境作用下导致电子产品失效的情况,这对于在应用于很强的物理作用力环境中的产品龙为重要;工艺本身选用的材料应该不含污染物,在余下的流水作业的加热环节中不会释放气体;工艺本身还应该具有较高的应用效率和较低的制造成本。
装片工艺大致分为如下4类。
(1) 银浆装片:又称环氧树脂贴装,是指在液体树脂黏合剂中摻人银粉,用于在芯片和框架之间黏合,从而形成永久性物理连接,并实现导热和导电功能的一种经济实用的装配方法。
(2)共晶装片:用高温熔化金属,使其原子活跃达到熔融状态,利用每个金属组织至少有一个合成物的熔点比其内部其他合成物的熔点低的原理来完成焊接装片的过程。共晶装片采用的材料一般有金一锡、金一硅、金一锗等,
(3)焊料装片:主要使用铅锡丝作为芯片与框架的连接介质,通过轨道高温和压膜的作用,将铅锡丝熔化成既定形状的液态,经过轨道通人氮氢混合气体对框架进行氧化-还原反应后的装片形式。
(4)热超声覆晶倒装焊接:其工艺原理是在一定的压力和温度下,对芯片的凸点施加超声波能量,在一定的时间内,凸点与框架、基板或焊盘产生结合力,从而实现芯片与框架的连接。
装片设备的关键材料和治具及其功用见下表格。

装片的主要步骤如下所述。
(1) 吸片:顶针从蓝膜下方将芯片上顶,使真空吸嘴与芯片接触,通过负压将芯片向上提拉,从而做反向力,使芯片背面挣脱开蓝膜的黏附力,达到剥离蓝膜的目的,如下图所示。
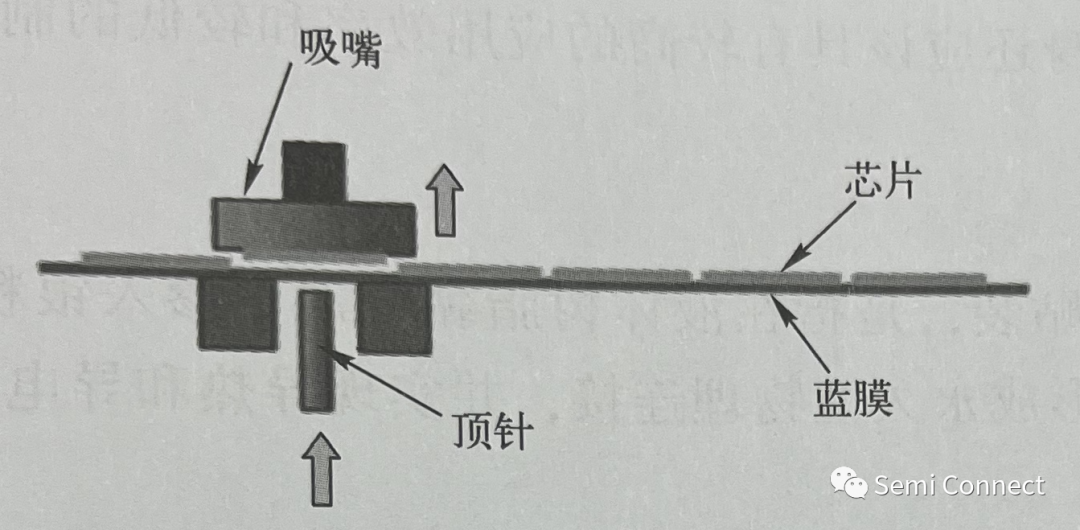
(2)涂胶:将液态环氧树脂 (导电银浆或绝缘胶)涂覆到引线框架的载片台(Lcad-Frame Pad)上,如下图所示。
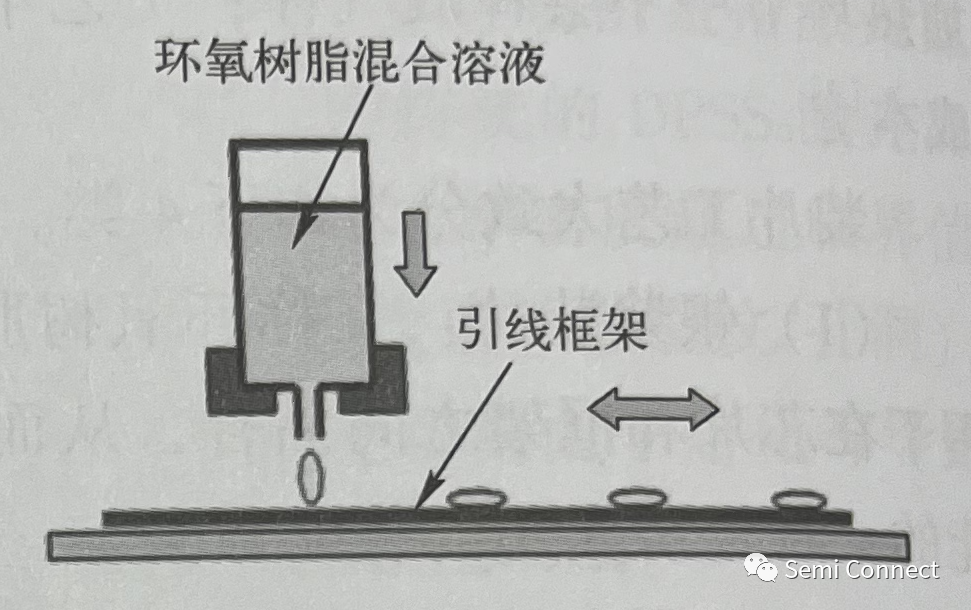
(3)键合:将芯片安装到涂好环氧树脂的引线框架上,如下图所示。
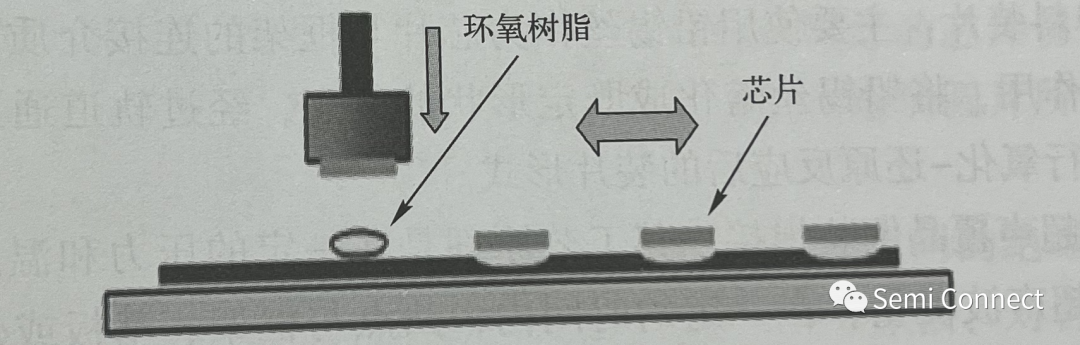
装片工艺需要根据材料的变化及封装产品的特点不断提高工艺要求。随着电子器件的不断小型化,超小超薄芯片的开发将给装片带来前所未有的挑战,并将孕育出更多、更复杂的工艺流程和更高密集度工艺的开发。
审核编辑:汤梓红
-
芯片
+关注
关注
463文章
54662浏览量
471100 -
封装
+关注
关注
128文章
9390浏览量
149229 -
工艺
+关注
关注
4文章
726浏览量
30431 -
焊接
+关注
关注
38文章
3602浏览量
63531
发布评论请先 登录
偏光片磨边工艺设备的开发与研制
SMT工艺---表面贴装及工艺流程
SMT贴装基本工艺流程
PCB化学镍金及OSP工艺步骤和特性分析
使用LED贴片机进行贴装的步骤是怎样的
晶圆减薄工艺的主要步骤

浅谈PCB连接器表面贴装(SMT)技术工艺步骤
氮化镓外延片工艺流程介绍 外延片与晶圆的区别
装片工艺的流程
太阳能电池片的制造工艺原理和注意事项?
简述光刻工艺的三个主要步骤
半导体封装中的装片工艺介绍




 装片工艺的主要步骤
装片工艺的主要步骤

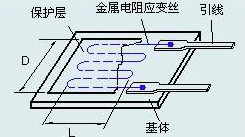




评论