引言
与硅器件、电路和系统相关的研究和制造通常依赖于硅晶片的湿化学蚀刻。使用液体溶液溶解硅需要进行深度蚀刻和微加工、成型和清洗。此外,湿化学材料常用于单晶硅材料的缺陷描述。
实验
一系列的化学反应通常被用于清洁硅晶片。这个序列最初是在RCA实验室开发的,因此通常被称为RCA过程。这种化学序列不会攻击硅材料,而是选择性地去除晶片表面的有机和无机污染。以下是典型的RCA过程;整个行业使用了序列顺序和化学比率的变化。
氢氧化钾蚀刻速率受硅晶体(各向异性)取向的强烈影响。表1将氢氧化钾的硅取向相关的蚀刻速率(µm min-1)与蚀刻温度为70°C时的晶体取向联系起来。表括号中是相对于(110)的标准化值。
(110)平面是最快的蚀刻主表面。理想的(110)表面比(100)和(111)主表面具有更多的波纹原子结构。(111)平面是一个极其缓慢的蚀刻平面,它紧密排列,每个原子有一个悬浮键,整体原子上是平坦的。如上所示,主平面的强阶梯表面和邻近平面是典型的快速蚀刻表面。(江苏英思特半导体科技有限公司)
表2将氢氧化钾的硅取向相关的蚀刻速率与成分百分比、温度和取向联系起来。与所有的湿化学蚀刻溶液一样,溶解速率与温度有很强的函数。在较高的温度下,明显更快的蚀刻速率是典型的,但不太理想的蚀刻行为也常见于更激进的蚀刻速率。此外,重硼掺杂可以使硅硬化,显著降低蚀刻速率。(江苏英思特半导体科技有限公司)
TMAH蚀刻速率的取向依赖性与氢氧化钾相似,并根据晶体平面的原子组织而变化。表3将TMAH(20.0wt%,79.8°C)的硅取向相关的蚀刻率与取向联系起来。
与氢氧化钾相似,TMAH的蚀刻速率随温度呈指数级变化。表4将TMAH的硅取向相关的蚀刻速率与成分百分比、温度和取向联系起来。
结论
有许多湿化学蚀刻配方以蚀刻硅。这些工艺用于各种应用,包括微加工、清洗和缺陷描述。蚀刻剂的详细行为和速率将因实验室环境和确切的过程而不同。(江苏英思特半导体科技有限公司)
-
半导体
+关注
关注
336文章
29977浏览量
258042 -
蚀刻
+关注
关注
10文章
428浏览量
16463 -
蚀刻技术
+关注
关注
0文章
24浏览量
7995 -
晶圆蚀刻
+关注
关注
0文章
22浏览量
6003 -
硅半导体
+关注
关注
0文章
35浏览量
7986
发布评论请先 登录
湿式蚀刻过程的原理是什么
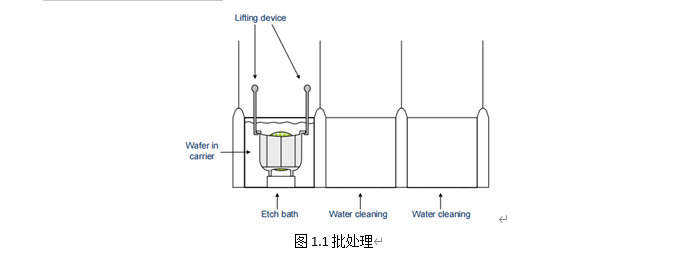
硅和SiO2的湿化学蚀刻机理
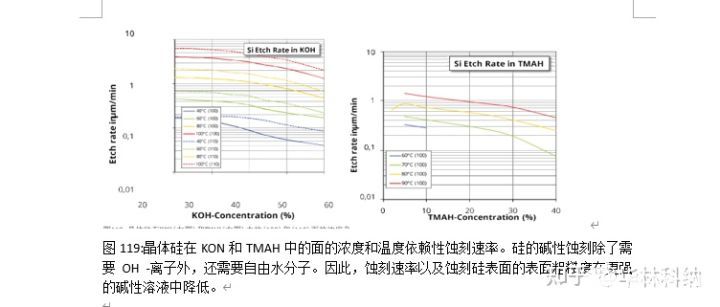
清洗 腐蚀设备
湿蚀刻
《炬丰科技-半导体工艺》光刻前 GaAs 表面处理以改善湿化学蚀刻过程中的光刻胶附着力和改善湿蚀刻轮廓
《炬丰科技-半导体工艺》GaN的晶体湿化学蚀刻
用于化学分析的Si各向异性湿法化学蚀刻

晶圆湿式用于硅蚀刻浴晶圆蚀刻
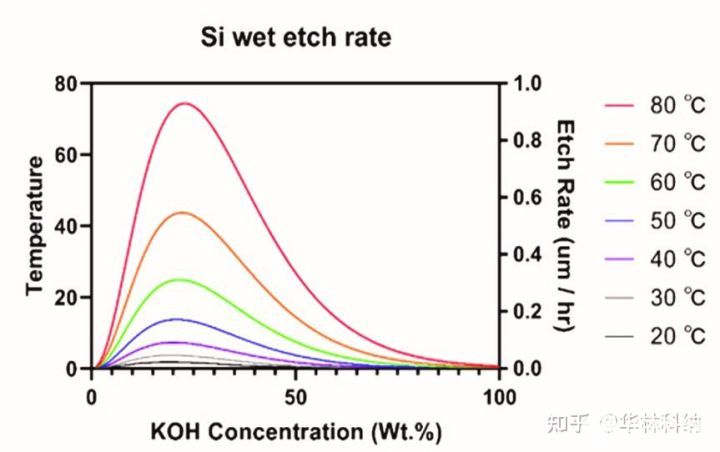
关于HF与HNO3混合物中硅的湿化学蚀刻机理研究报告

晶圆湿式用于硅蚀刻浴晶圆蚀刻
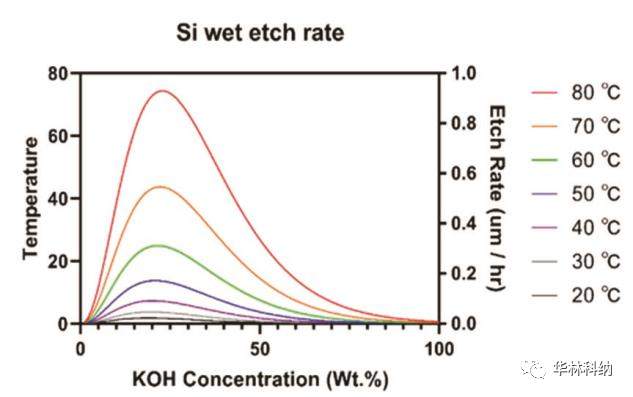
硅和二氧化硅的湿化学蚀刻工艺
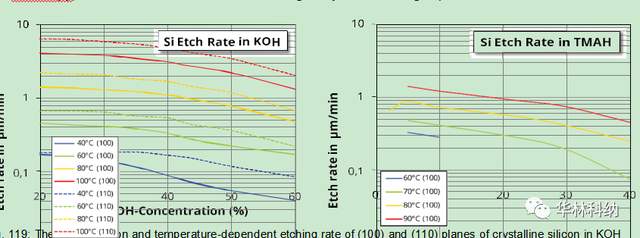
湿式化学清洗过程对硅晶片表面微粒度的影响

湿式化学蚀刻法制备硅片微孔
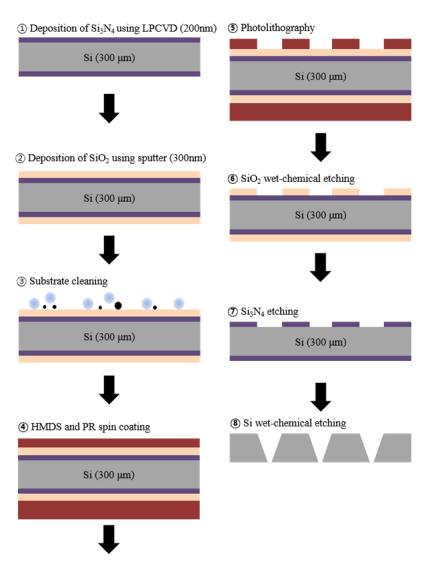





 硅的湿式化学蚀刻和清洗
硅的湿式化学蚀刻和清洗

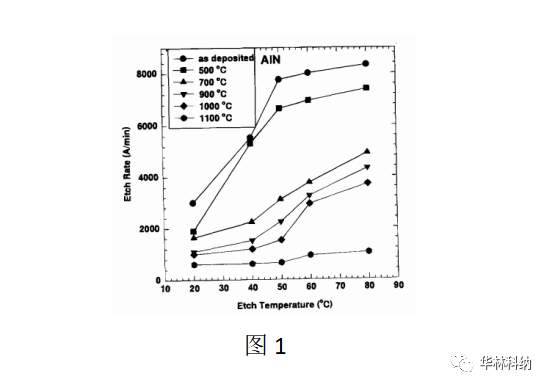











评论