在过去几年中,SiC MOSFET 在高压 (>600V) 和大功率应用中占据主导地位。热导率、高临界场、大大提高的开关效率以及在其表面形成二氧化硅的能力等优势使其能够在关键工艺、设计和可靠性方面得到改进,从而使其能够在一些高增长应用中大规模使用,例如在用于车载充电器、牵引逆变器和直流到直流转换器、光伏逆变器、电机控制、运输系统和电网的电动汽车。
早在 1990 年代,关于 GaN 的大多数研究都集中在蓝色和最终白色 LED 和激光器的制造上。约 3.4 eV 的直接带隙,通过金属有机 CVD (MOCVD) 产生的异质结层形成具有 Al、In、P 和量子限制的四元层的能力为此奠定了基础。然后利用这项工作来利用高电子迁移率晶体管 (HEMT) 中实现的高电子迁移率和饱和速度来制造远优于其硅对应物的射频器件。正是在 RF MMIC 领域,GaN PoweHEMT 工艺和设计技术得到了显着改进,如今,它们构成了一些重要的通信、雷达和电子战设备的主干,其中一些设备的额定频率超过或等于 RF X - 频带频谱(8.5 至 11 GHz)。
这些射频设备的电压范围通常在 <200V 范围内。横向 HEMT 器件相对于垂直 V-DMOS 具有天然的缺点,通常用于SiC MOSFET 以创建 HV 器件(代表性器件横截面见图 1 (a) 和 1(b))。栅极和漏极之间的横向漂移区中的高表面电场通常会限制高电压限制,并且在塑造/降低电场的场板技术方面的一些进步将允许提高该额定值。
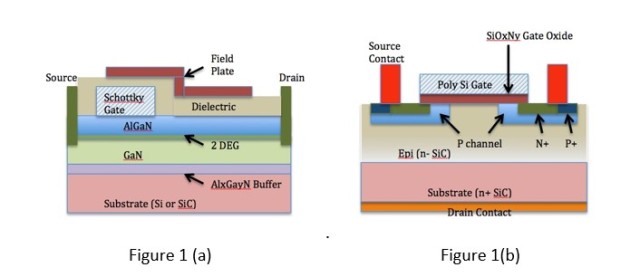
图 1 (a) GaN Power HEMT 器件结构和图 1 (b) SiC VDMOS 器件结构
表 1 列出了 SiC 和 GaN 的一些关键材料特性。
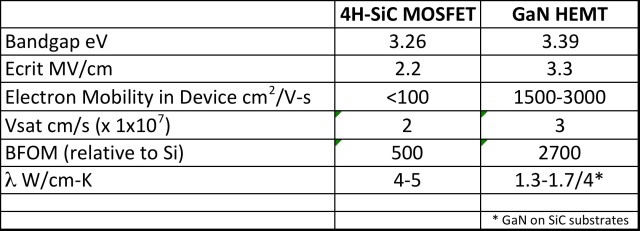
表 1:SiC MOSFET 和 GaN Power HEMT 的一些关键材料特性。BFOM 是 Baliga 品质因数
应该注意的是,尽管文献中引用的体 SiC 迁移率要高得多(~ 700 到 1000 cm2/Vs),但在 MOSFET 中获得的迁移率要低得多,尽管这是由于 SiC/SiO2 处的陷阱位点界面。在形成器件传导通道的 AlGaN/GaN 界面处形成的二维电子气 (2-DEG) 上观察并报告了 GaN Power HEMT 列出的迁移率。
从最初对射频器件的关注开始,在 GaN 晶体管方面取得了巨大进展,以提供 HV 功率 FET 范围内的器件。Transphorm、ST Microelectronics、GaN Systems、Cambridge、Innoscience、GaN Power International 和 Texas Instruments 等多家公司提供额定电压为 650V 或更高的器件。从电压的角度来看,这达到了一些 EV 应用的最佳位置,例如 2 级车载充电器 (OBC) 和其他长期以来被认为属于 SiC 领域的应用。GaN 提供更低的终端电容和更高的迁移率,允许器件缩放和更快、更高效的开关。没有 pn 结也不会导致开关的反向恢复损失。传热和封装成为关键限制,现在很多研究都集中在改善这一点。
下面的图 2 和图 3 说明了 GaN 在这些应用中的扩展空间。
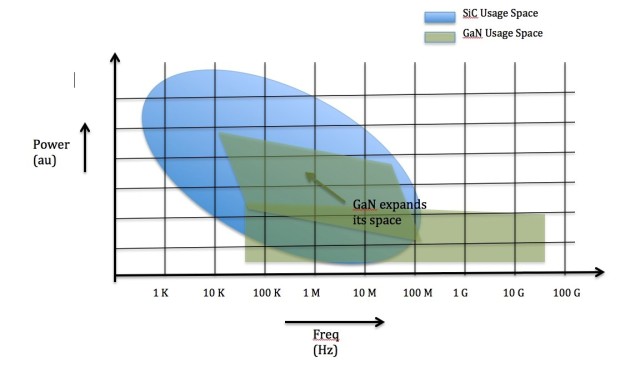
图 2:GaN 在 SiC 功率 FET 领域的成长空间
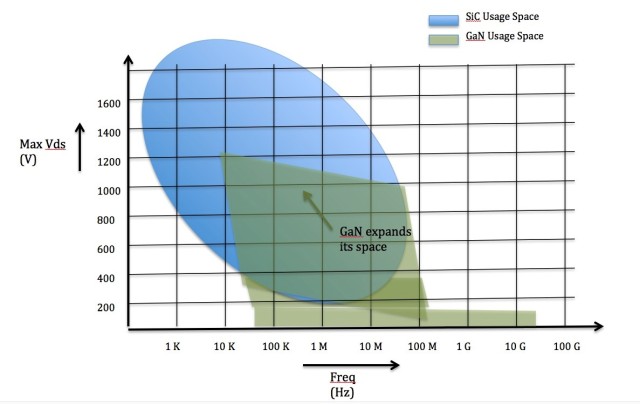
图 3:GaN Power HEMT 的电压与频率空间使用情况
GaN 的生长通常在 SiC 或 Si 衬底上进行。缓冲层有助于缓解晶格失配造成的压力。RF GaN 制造商通常选择 GaN on SiC 方法,以利用 SiC 对高功率密度放大器的卓越热能力。功率 FET 行业选择了 GaN on Si 方法。硅衬底提供了一种更便宜的方法,也为 200 毫米晶圆制造提供了一条更简单的途径。Innoscience 在中国的 8 英寸 GaN on Si Fabs 已经证明了这一点。
GaN Power HEMT 器件自然是耗尽模式器件(或 d 模式:常开,需要负 Vgs 才能关闭)。对于大多数功率 FET 应用,增强模式(或 e 模式:常关,0V 应关闭器件)行为是必不可少的。为此,使用了两种不同的方法。一方面,可以使用 p 型 GaN 或 AlGaN 栅极来修改势垒高度,在该层下方创建一个耗尽区,从而创建一个常关器件。这种方法受到许多人的青睐,用于生产 e-mode HEMT 器件。另一种方法是将 LV Si-MOSFET 与 GaN 器件串联,如图 4 所示。
两种方法之间存在权衡。虽然单 e-mode 器件使用更简单,并联器件的复杂性更低,并提供出色的电容和反向恢复特性,但问题是由于 p-AlxGayN 的特性,很难实现远高于 1.5V 的阈值电压层。这使门容易受到开关噪声和杂散器件行为的影响。

图 4:级联排列的 GaN d 模式 HEMT
使用共源共栅方案获得了更加稳健的栅极,Vt 处于有利的≥ 2.5V 范围内。较高的栅极裕度可以实现更直接的栅极驱动器。
为了比较设备行为以及每种方法的优缺点,下面的表 2 中给出了参数分析。在此分析中,选择了四个器件,两个 SiC MOSFET 和两个 GaN Power HEMT。所有四个都具有大约 650V 的最大 Vds 工作电压和大约 20 mOhms 的 25C Rdson 额定值。两个 GaN 器件标记为 G1 和 G2,而 SiC 器件标记为 S1 和 S2。此外,器件 S2 和 G2 使用相同的封装,因此在这种情况下可以忽略封装引起的某些 AC 特性的差异。

表 2:2 个 SiC 器件 S1、S2 与 2 个 GaN 功率 HEMT 器件 G1、G2 的参数比较
关注的参数以黄色突出显示,有利的参数以绿色突出显示。显而易见的是,具有单一 e 模式器件的 G1 提供了 GaN 的一个关键优势,即没有反向恢复电荷 Qrr。然而,高得多的 I gss栅极泄漏也突出了较差的栅极裕度。另一方面,G2 具有良好的栅极裕度,与 SiC 非常相似,但 Qrr 相应增加。
通常,较低的栅极电荷 Qg 在两种 GaN 功率 HEMT 中都突出显示。这可以显着改进硬开关应用。
表 2 中突出显示的 GaN 的一个明显缺点是 Rdson 的温度系数较差,在 150C 时 ≥ 25oC Rdson 的两倍。也有人认为,如果目标是满足某个 150oC 的 Rdson,则 GaN 器件实际上必须在 25oC 时有多余的裕量,并相应增加芯片尺寸和栅极/输出电容。Rdson 的增加使得更并行的设备方法更加关键。由于寄生元件种类繁多,特别是在级联排列中,并联 GaN 器件可能会带来挑战。具有自适应控制的集成栅极驱动器可能是一种可能的解决方案。
审核编辑 黄昊宇
-
半导体
+关注
关注
339文章
31241浏览量
266587 -
设计
+关注
关注
4文章
828浏览量
71489 -
SiC
+关注
关注
32文章
3863浏览量
70124 -
GaN
+关注
关注
21文章
2385浏览量
84485
发布评论请先 登录
芯塔电子最新推出650V/185mΩ多封装SiC MOSFET

芯塔电子最新推出650V/380mΩ多封装SiC MOSFET

CHA6154-99F三级单片氮化镓(GaN)中功率放大器
快充国产替代新突破!争妍微650V GaN HEMT赋能300W USB-C PD,替代英诺赛科INN650D02

瞻芯电子G2 650V SiC MOSFET的鲁棒性验证试验

PI技术白皮书 1250V/1700V PowiGaN HEMT在800VDC AI数据中心架构中的应用
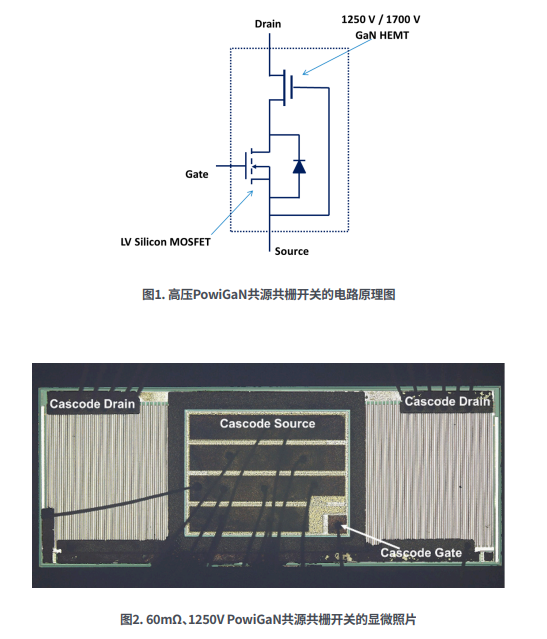
GaN HEMT器件的结构和工作模式

东芝推出三款最新650V SiC MOSFET

功率器件测量系统参数明细
SGK5872-20A 是一款高功率 GaN-HEMT,其内部匹配标准通信频段,可提供最佳功率和线性度。
增强AlN/GaN HEMT
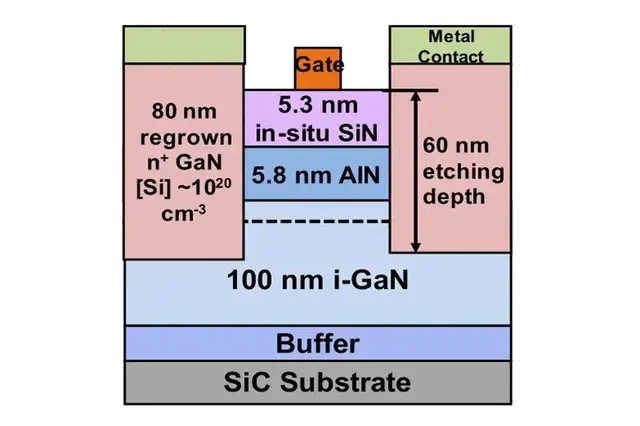
什么是IGBT/SiC/GaN HEMT功率芯片/模块/模组?特性是什么?主要应用哪里?
深度分析650V国产碳化硅MOSFET的产品力及替代高压GaN器件的潜力
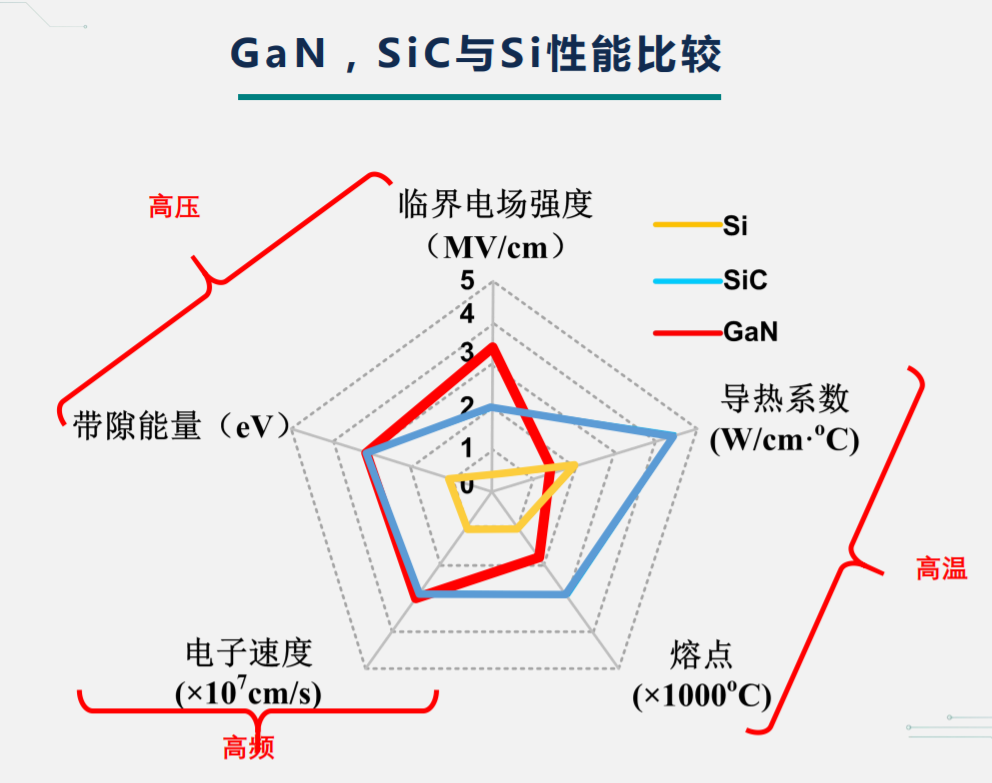



 GaN Power HEMT > 650 V:与 SiC MOSFET 的参数分析和比较
GaN Power HEMT > 650 V:与 SiC MOSFET 的参数分析和比较






评论