摘要
大直径高质量 SiC 衬底对提高 SiC 和 GaN 器件的良率、降低器件成本具有重要意义。然而,随着单晶直径的扩大,如何实现衬底片内单晶质量均匀性是亟需解决的问题之一。使用数值模拟软件构建了两种生长模型并研究其温场分布,模拟结果表明微凸温场生长的晶体外形更加平整。对两个批次的 6 英寸 ( 1 英寸= 2. 54 cm) SiC 单晶衬底分别进行了 ( 004) 面 X 射线摇摆曲线全图扫描,评价了衬底结晶质量,并在衬底上进行了 GaN 外延生长。结果表明,采用结晶质量好且均匀的 SiC 单晶衬底,外延生长的 GaN 质量更高。
0引言
半导体材料作为信息产业的基石,被广泛用于集成电路、电力电子器件和微波射频器件的制备。所谓“一代材料决定一代器件”,以硅 ( Si)、砷化镓 ( GaAs) 为代表的第一、二代半导体材料,其器件特性目前已逼近材料的物理极限。
碳化硅( SiC) 材料具有禁带宽度大、饱和电子速度高、临界击穿电场强度高、热导率高等特性,其品质因子优异,在高温、高频、大功率及抗辐射领域获得了广泛应用。近年来,SiC 产业在国内外均成为科技战略布局热点,极大地促进了 SiC 单晶制备技术的发展。高质量、大直径 SiC 单晶有利于提高器件良率、降低器件成本,是未来 SiC 单晶发展的方向。目前国外 6 英寸 ( 1 英寸= 2. 54 cm) SiC 衬底已成为主流产品,国内商业化 SiC 衬底直径正处于 4 英寸向 6 英寸过渡阶段。
SiC 单晶材料的制备方法主要有物理气相传输( PVT ) 法、溶液法和高温化学气相沉积( HTCVD) 法。其中 PVT 法是技术成熟度最高、应用最广泛的方法。
在该方法中,一般采用中频感应加热系统,SiC 在超过 2 000 ℃的密闭石墨坩埚内进行生长,整个生长体系类似“黑盒子”,无法对坩埚内温度场和生长过程进行直接观察和测量,只能通过晶体的外形推测温场分布情况。随着 SiC单晶直径增大,中频感应的“趋肤效应”使晶体生长前沿径向温度梯度增大,导致大直径 SiC 晶体中的应力增大,晶体结晶质量不均匀,劣化晶体质量。因此生长结晶质量均匀的大直径 SiC 单晶,单晶生长的装配设计工作尤为重要。
本文借助 Virtual Reactor-PVT SiCTM软件开展了6 英寸 SiC 单晶生长温场及流场研究。加入三代半交流群,加vx:tuoke08。采用高分辨X 射线衍射仪研究了两个批次 SiC 单晶质量均匀性,并在制备的 SiC 衬底上进行了 GaN 异质外延,验证了 SiC 结晶质量和均匀性对 GaN 外延层质量的影响。
1工艺实验
1. 1 Virtual Reactor-PVT SiCTM数值模拟
Virtual Reactor-PVT SiCTM是一款基于有限元算法的专门应用于 PVT 生长 SiC 单晶的数值模拟软件。该软件的计算原理是: 根据麦克斯韦方程组,计算感应加热体系内各点的电场强度和磁场强度;根据坡印亭定理,求得坩埚各点的电阻热量。石墨坩埚加热后,其热量会向坩埚内部传递,形成 SiC单晶生长的温度场。热量的传递主要包括: 固态介质中的热传导、气态介质中的热传导和对流、固气界面上的热辐射三部分。图 1 为 SiC 单晶生长模型示意图。通过对生长系统建立模型,设定初始条件及指定某一设定点温度,软件将根据系统配置的物理属性对热量的传递进行自动计算,求得 SiC晶体生长的温度场。
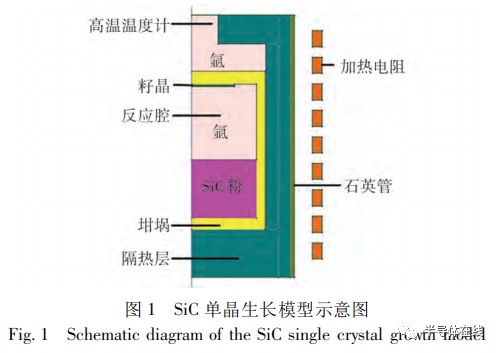
1. 2 6英寸SiC单晶表征及外延实验
采用高分辨 X 射线衍射仪对两个批次 6 英寸4H-SiC 单晶衬底 (004) 面进行摇摆曲线测试,评价其结晶质量。在相同条件下,对 6 英寸 SiC 衬底进行 GaN 异质外延生长,得到 GaN 外延薄膜。采用高分辨 X 射线衍射仪分别对 GaN 外延层的(002) 和 ( 102) 面进行对称衍射和斜对称衍射,比较两个批次的 SiC 衬底外延 GaN 结晶质量,研究衬底结晶均匀性对 GaN 外延质量的影响。
2结果与分析
2. 1不同温场及流场模拟
目前 SiC 单晶生长通常采用中频感应电源的加热模式,生长腔内存在温度梯度。一般而言,生长腔内的轴向温度梯度决定了晶体的生长速率,而籽晶表面的径向温度梯度与晶体中的热应力有关。籽晶表面的径向温度梯度太小,则容易在晶体边缘产生多晶,多晶与单晶竞争生长,不利于单晶尺寸的扩大; 而籽晶表面的径向温度梯度太大,会在晶体生长过程中产生较大的热应力,造成晶体应力偏大,容易开裂。本文中构建了两种不同的生长模型,分别简称模型 A 和模型 B,设定主要初始参数: 籽 晶 温 度 为 2 400 ℃,生 长 压 强 20 mbar( 1 mbar = 100 Pa) ,中频电源频率 10 kHz,生长时间 100 h,分析了两种不同生长模型中的温场分布和晶体生长情况。
为了便于直观比较两种模型的温场分布,将模型 A 和模型 B 的温度刻度线设置为相同的范围和步长,由此可以通过等温线的密集程度判断温场分布。图 2 示出了模型 A 中的温场分布图和晶体生长示意图,图中 t 为生长温度,X 为晶圆直径。从图 2 ( a) 中可以看出,模型 A 生长体系的高温区接近料底部,料内的等温线分布稀疏; 从图 2 ( b)中可以看出,生长的 SiC 单晶中心厚度明显比晶体边缘厚,晶体凸度为 14. 6 mm。晶体凸度较大与生长前沿的温场分布有关。为了进一步量化模型 A 中的温场分布情况,从温场中提取相关数据,描绘出生长前沿径向温度分布、生长腔内轴向温度分布、料内轴向温度分布和料表面径向温度分布,如图3所示,图中x1~x4分别为生长前沿径向距离、生长腔内轴向距离、料内轴向距离以及料表面径向距离。从图 3 ( a) 中可以看出,籽晶中心到籽晶边缘的温度基本呈线性增加,径向温度差约为 12 ℃; 图 3( b) 表明,生长腔内越靠近料表面温度变化越缓慢,越靠近籽晶温度变化越明显,生长腔内的轴向温度差为约 17 ℃; 通过图 3 ( c) 可以看出,料内轴向方向的最高温基本处于料中间位置,这表明晶体生长过程中,一部分料会向生长腔内传输,一部分料会向坩埚底部传输; 图 3 ( d) 展示了料表面径向温度分布,可以看出靠近坩埚壁的温度最高,而位于中心位置的 SiC 料温度最低,料表面径向温度差约为 18 ℃。造成这种差异主要与中频感应的加热模式的趋肤效应有关。

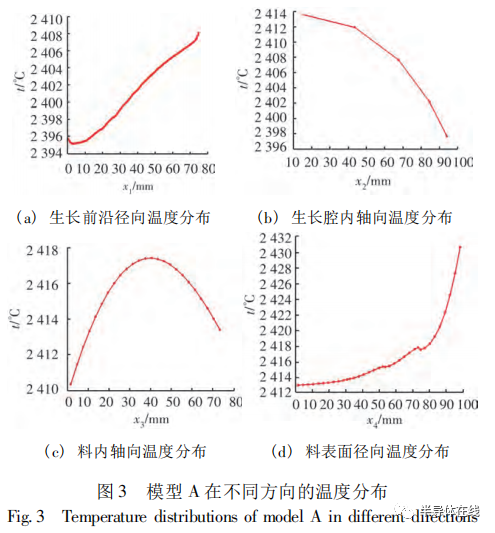
图 4 示出了模型 B 中的温场分布图和晶体生长示意图。从图 4 ( a) 中可以看出,模型 B 生长体系的料内的等温线比模型 A 中的密集,表明料内的温度梯度变大; 从图 4 ( b) 中可以看出,生长的SiC 单晶面形较为平整,晶体凸度为 5. 4 mm。说明籽晶生长前沿的温度场相对较平。图 5 ( a) 中可以看出,籽晶中心到籽晶边缘的温度尽管略有增加,但温度差仅约为 6 ℃,明显小于模型 A 中的籽晶表面径向温度差; 图 5 ( b) 表明生长腔内的轴向温度差约为 14 ℃,基本与模型 A 中的生长腔内温度差一致; 通过图 5 ( c) 可以看出,料内轴向方向的最高温基本处于料底部,高温区位置比模型 A中相对靠下; 图 5 ( d) 表明,料表面径向温度差约为 21 ℃,略大于模型 A 中料表面径向温度差。


通过对比模型 A 与模型 B 中的温场分布,如表 1 所示,可以看出模型 A 生长前沿温度场为典型的凸温场,而模型 B 生长前沿的温度场为典型的***温场。根据晶体生长理论,凸温场会导致晶体生长过程中产生较大的热应力,容易在晶体中产生晶格畸变和位错等缺陷,劣化晶体的质量。因此推测模型 B 中的温场更适合生长高质量 6 英寸 SiC 单晶。

2. 2 6英寸SiC衬底表征
采购了两个批次 6 英寸 SiC 衬底,分别命名为批次 I 和批次 II。为了评价不同批次间的衬底结晶质量,采用高分辨 X 射线衍射仪对两个批次 SiC 衬底分别进行了 (004) 面对称衍射摇摆曲线测试。测试前首先对样品中心点进行优化测试,获得样品中心点的最优俯仰角。然 后 分 别 沿< 1120 >和<1100>两个方向对晶片进行全图扫描,研究晶片不同区域摇摆曲线的衍射角和半峰宽的变化,评价衬底结晶质量均匀性。批次 I 和批次 II 的 SiC 衬底(004) 面摇摆曲线全图扫描结果分别如图 6 和图 7所示。从图 6 中可以看出,批次 I 中的 SiC 衬底<1120>和<1100>方向衍射角度变化分别为0. 880°和0. 577°,半峰宽分别为 84 "和 102 ",说明该晶片 (004) 面衍射角变化大; 半峰宽在不同区域波动大,晶片结晶质量不均匀。从图 7 中可以看出,批次 II 的 SiC 衬底<1120>和<1100>方向衍射角度变化分别为0. 060°和0. 027°,半峰宽分别为 40"和42 ",说明该晶片不同区域的 (004) 衍射角度变化不大,结晶质量高、结晶质量均匀。推测造成两个批次衬底结晶质量不一致的原因可能与 SiC 单晶生长的温场不同有关,凸温场导致晶体中应力大,造成了 SiC 晶面弯曲。

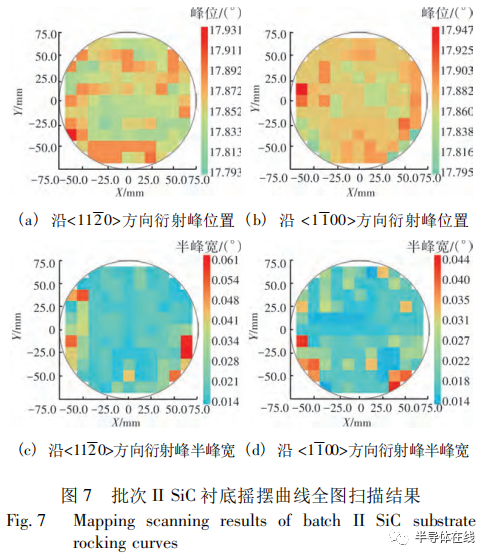
2. 3 6英寸SiC衬底GaN外延表征
对两个批次 SiC 衬底分别在相同条件下进行GaN 异质外延,并对 GaN (002) 和 ( 102) 面进行摇摆曲线全图扫描测试。测试结果如图 8 所示。可以看出批次 I 的 SiC 衬底外延 GaN (002) 和102) 面摇摆曲线半峰宽分别为 235 "~ 260"和293 "~ 333 ",批 次 II 的 SiC 衬 底 外 延 的 GaN(002) 和 ( 102) 面摇摆曲线半峰宽分别为 152 "~160"和 255 "~ 270",批次 II 的 SiC 衬底外延 GaN的晶体质量明显优于批次 I 的 SiC 衬底外延 GaN。由此可以推断 SiC 衬底结晶的均匀性对 GaN 外延层质量有较大影响,衬底结晶质量越高、越均匀,外延层的质量越高。
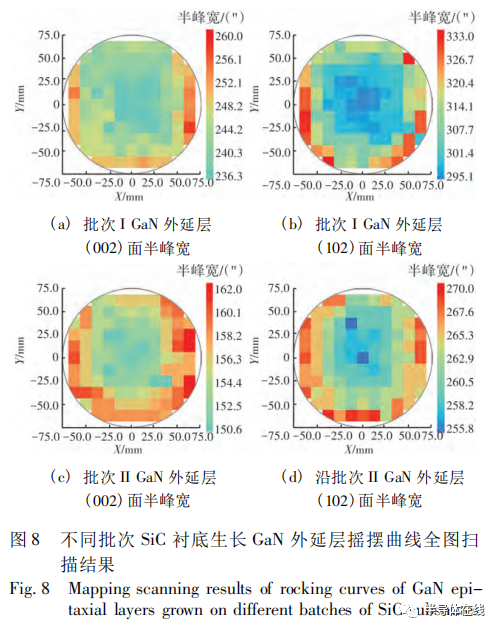
3 结论
本文利用数值模拟软件构建了两种 6 英寸 SiC单晶生长模型,通过理论计算表明平温场中生长的SiC 单晶面形平整,应力较小。对两批次 6 英寸SiC 衬底进行了 X 射线 (004) 面摇摆曲线全图扫描测试,研究了其结晶质量及其均匀性。在 SiC 衬底上外延了 GaN 材料,通过对外延层进行 (002)和 ( 102) 面摇摆曲线测试,表明 SiC 衬底对 GaN外延层质量有重要影响,衬底结晶质量越高、结晶质量越均匀,有助于获得高质量 GaN 外延层。
审核编辑 :李倩
-
半导体材料
+关注
关注
11文章
579浏览量
30909 -
SiC
+关注
关注
32文章
3858浏览量
70123 -
GaN
+关注
关注
21文章
2385浏览量
84484
原文标题:6 英寸 SiC 单晶质量对 GaN 外延薄膜的影响
文章出处:【微信号:cetc45_wet,微信公众号:半导体工艺与设备】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
突破!本土企业成功研制14英寸SiC单晶
士兰微电子迎来双线里程碑:8英寸碳化硅产线通线, 12英寸高端模拟芯片产线同步开工

12英寸碳化硅外延片突破!外延设备同步交付
构建CNN网络模型并优化的一般化建议
AR光波导+先进封装双驱动,12英寸碳化硅静待爆发
两种散热路径的工艺与应用解析
6英寸磷化铟(InP)工艺重大突破,光芯片成本降超30%

台积电战略收缩:两年内逐步关停6英寸晶圆产线
MOCVD技术丨实现6英寸蓝宝石基板GaN基LED关键突破




 利用数值模拟软件构建了两种6英寸SiC单晶生长模型
利用数值模拟软件构建了两种6英寸SiC单晶生长模型

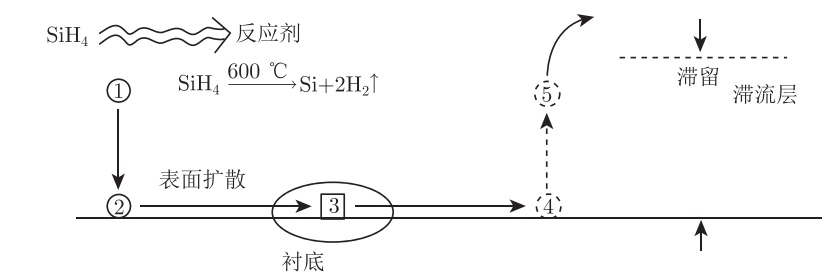




评论