随着芯片不断向微型化发展,工艺制程开始向着更小的5nm、3nm推进,已经越来越逼近物理极限,付出的代价也将越来越大,因此摩尔定律屡屡被传将走到尽头,迫切需要另辟蹊径推动技术进步。
业界普遍认为,先进封装会成为下一阶段半导体技术的重要发展方向。厦门大学特聘教授、云天半导体创始人于大全博士就曾指出,随着摩尔定律发展趋缓,通过先进封装技术来满足系统微型化、多功能化成为了集成电路产业发展的新引擎。 封装技术是伴随集成电路发明应运而生的,主要功能是完成电源分配、信号分配、散热和物理保护。而随着芯片技术的发展,封装正在不断革新,供应链迎来大考。
群雄竞逐先进封装
先进封装技术能够相对轻松地实现芯片的高密度集成、体积的微型化和更低的成本等需求,符合高端芯片向尺寸更小、性能更高、功耗更低演进的趋势。
尤其是CoWoS(Chip On Wafer On Substrate)、FOWLP(扇出晶圆级封装)以及WoW等 高密度先进封装(HDAP) ,它们在提升芯片性能方面展现出的巨大优势,成功吸引了各大主流芯片封测、代工以及设计厂商的关注,开始在该领域持续投资布局。
例如CoWoS,这是台积电推出的2.5D封装技术,被称为晶圆级封装。CoWoS针对高端市场,连线数量和封装尺寸都比较大。
自2012年开始量产CoWoS以来,台积电就通过这种芯片间共享基板的封装形式,把多颗芯片封装到一起,而平面上的裸片通过Silicon Interposer互联,这样达到了封装体积小,传输速度高,功耗低,引脚少的效果。 此外,FOWLP,这是一项被预言将成为下一代紧凑型、高性能电子设备基础的技术。根据Yole数据,FOWLP全球总产值有望在2022年超过23亿美金,2019-2022年间CAGR(复合年均增长率)接近20%。
据悉,第一代扇出型封装是采用英飞凌(Infineon)的嵌入式晶圆级球闸阵列(eWLB)技术,此为2009年由飞思卡尔(Freescale,现为恩智浦)所推出。但是,集成扇出型封装(InFO)在此之前就只有台积电能够生产。 台积电的InFO技术是最引人注目的高密度扇出的例子,三星电子(Samsung Electronics)系统LSI事业部认为正是此技术,导致台积电抢下苹果(Apple)A10处理器代工订单。为此三星电机(Semco)跨足半导体封装市场,与三星电子合作研发FOWLP技术,以期在新一轮客户订单争夺赛中,全面迎战台积电。
Techsearch International指出,这些HDAP技术推动了行业对设备与封装协同设计以及新流程的需求。目前代工厂开始将一部分限制产能用于做先进封测,传统的封测厂商也在逐渐向先进封测提升。 虽然目前为止,代工厂与封测厂商还没有完全交叉的业务,在各自的领域独立为战。但未来双方一定会越来越多地向中间重合领域进军,先进封装将成为兵家必争之地。
HDAP,想说爱你不容易
然而,想要实现类似的HDAP仍然存在一些挑战。
资料显示,首先,HDAP具有异构性。即使上游EDA厂商已经修改了传统工具来处理多种新技术,这些新技术也需要物理验证,例如设计规则检查(DRC)、版图和线路图对照检查(LVS)等。在HDAP中,必须通过一个中介层或某种类型的互连技术做连接,在这种情况下,它会影响系统的互连特性,同时这些特性之间还会相互影响,同时影响可制造性特征的设计。
其次,新的HDAP技术要求设计团队共同努力来优化整个系统,而不仅仅是单个元件。例如芯片和封装/中介层未对齐、元器件和基地之间的连接错误等问题带来的工程成本增加;制造数据的质量或误差导致的制造延迟;以及信号和电源完整性性能不佳、2.5D装配的热稳定性不合格等问题带来的功能故障等问题。
再者,HDAP也让设计复杂度显著提高,需要描述从芯片到基板、从中介层到基板、基板到电路板、基板到测试板的所有互连。这在传统的封装行业来看非常难以控制,目前有许多要靠手工集成,夹杂一些零碎的检查。
HDAP作为一个全新的方向,也开始给半导体的设计流程带来影响。这些新技术能够对整体设计做分区,就像一种具有芯片外部特征的互连,这与芯片的内部特征非常相似。先进封装使厂商有了集成不同技术(工艺)的能力,但同时也为传统的设计工具带来了相关挑战。
在此基础上,传统的封装设计已经无法满足市场日益变化的需求,如何高效的完成设计并得到验证,这将给EDA工具带来全新的挑战。市场迫切需要更为高效的全新流程、方法和设计工具。
Mentor的利器
Mentor是一家极为关注先进封装技术的EDA厂商, Mentor 亚太区技术总监Lincoln Lee提到,作为一家EDA厂商,其产品本身就贯穿设计和封装的各个方面。
早在10多年前(2007年),Mentor就看见了封装市场的潜在机遇,并开始为领先客户设计应对方案。他强调,半导体行业发展很快,先进封装正在逐渐成为主力,如果不能很快适应客户的要求,就将被抛在身后。发力先进封装领域,对于Mentor与其客户来说是双赢。
2013年,Mentor正式推出了Xpedition Package Integrator(XPI) 高密度先进封装(HDAP)流程,该流程是业内率先针对当今先进的 IC 封装设计和验证的综合解决方案。
资料显示,XPI产品已经具有高集成度,但基于整个设计过程中的分工需要, Mentor将XPI的两个功能拆分为Xpedition Substrate Integrator工具和 Xpedition Package Designer技术。独特的Xpedition Substrate Integrator(xSI)工具可快速实现异构基底封装组件的定义和优化。针对物理封装实施的新型 Xpedition Package Designer(xPD)技术可确保设计Signoff与验证的数据同步。Calibre 3D Stack技术可针对各种2.5D和3D叠层芯片组件进行完整的Signoff DRC/LVS验证。
在不断优化的过程中,Xpedition可以多人协同工作,无需拆分,避免多次合并,从而实现最大限度地提高团队工作效率。目前,Mentor正在全力解决多晶片封装的功耗、散热、性能问题。Lincoln解释道,大家都希望将更多功能“塞”到同一颗芯片里,但这么多高效能的芯片放在一起,将产生极高的热密度。因此,热分析是非常关键的步骤。
目前做芯片的公司数量正在不断减少,很大程度上是由于先进工艺行列所需要的成本十分昂贵,因此先进的设计工具就显得尤为重要。Lincoln提到,Mentor的优势在于拥有非常全面的工序,全新的解决方案能够为IC设计厂商提供便利,可以在一定程度上满足其需求。
Mentor与中国
现在,中国大陆市场中已经有不少厂商开始关注先进封装,尤其是封测企业。近几年,海外并购让中国封测企业快速获得了技术、市场,弥补了一些结构性的缺陷,极大地推动了中国封测产业的向上发展。
中国半导体协会数据显示,大陆封测市场规模从2012年的1034亿元增长至2018年的2196亿元。在2019年封测市场,中国大陆占比达到28%,仅次于中国台湾。
Lincoln指出,早在1989年,Mentor就已经进入中国大陆。尽管当时市场主要以PCB板级设计为主,中国大陆本土的IC产业仍在襁褓之中,整个市场的体量也没有现在这么庞大,但Mentor丝毫没有轻视中国市场和其未来的发展潜力。 此外,Mentor还跟地方政府、孵化平台、高校和研究所合作,降低创新和创业的成本,积极地扶持未来的明星企业。
这些年来,Mentor见证了中国本土IC产业不断强大,尤其是封测领域。Lincoln表示,近年中国本土先进封测厂商通过自主研发和兼并收购,已基本形成先进封装的产业化能力,但从先进封装营收占总营收的比例和高密度集成等先进封装技术发展上来说,中国总体先进封装技术水平与国际领先水平还有一定的差距。
在此基础上,Mentor正在不断支持中国厂商在先进封装领域的发展,助力中国厂商在性能以及功耗等方面提升。同时,Lincoln也提到,在同等级的芯片中,使用Mentor HDAP设计环境的产品,异构集成能助力其效能更优化。
总结
在2020年,围绕先进封装的战火继续升级,先进芯片制造商正在不断加码,探索更广阔的芯片创新空间。 尽管这些技术方法的核心细节有所不同,但大家各展谋略,都是为了持续提升芯片密度、实现更为复杂和灵活的系统级芯片,以满足客户日益丰富的应用需求。
这种情况下,随着制程工艺逼近极限,成本无限提升,Mentor凭借在此领域丰富的经验,其作用将越来越大,更加不可或缺。
责任编辑:tzh
-
芯片
+关注
关注
462文章
53550浏览量
459286 -
半导体
+关注
关注
336文章
29999浏览量
258470 -
IC
+关注
关注
36文章
6267浏览量
184296 -
封装
+关注
关注
128文章
9146浏览量
147908
发布评论请先 登录
告别容量与体积的妥协:永铭固态电容助力移动电源实现“小体积大容量”

突破!华为先进封装技术揭开神秘面纱
3C消费电子智能化浪潮下,PD+(MCU)如何成为厂商“必争之地”?
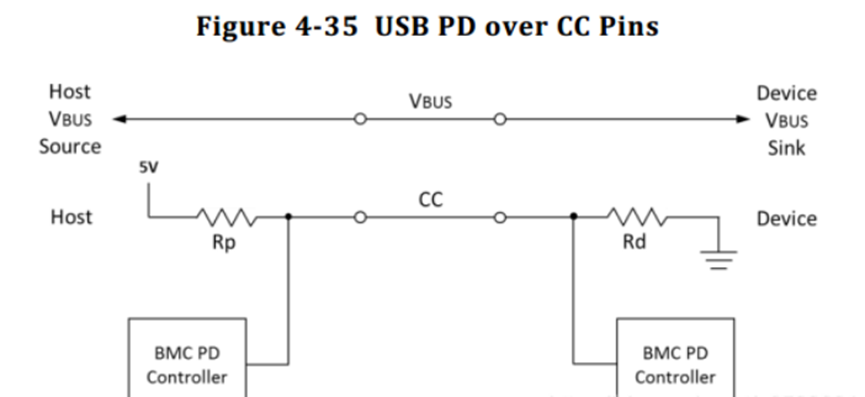
千视P3系列重大升级!直连USB Camera功能上线,USB相机秒变专业直播机

先进封装成为AI时代的核心技术发展与创新






 先进封装技术将成为兵家必争之地
先进封装技术将成为兵家必争之地



















评论