在消费电子、医疗电子、可穿戴设备等领域,柔性电路板(FPCB)凭借 “轻薄、可弯曲、耐弯折” 的特性,成为实现产品小型化与结构创新的核心载体。但 FPCB 的基材(如 PI 膜、PET 膜)耐热性差(耐温通常≤150℃)、铜箔线路薄(厚度多为 12-35μm),传统焊接工艺(如烙铁焊、热风焊)因热影响区大(HAZ≥200μm)、局部温度高(超 200℃),易导致基材收缩变形、铜箔剥离、线路断裂等问题,不良率普遍高达 8%-12%,严重制约 FPCB 产品的可靠性与使用寿命。
大研智造深耕精密激光焊接领域 20 余年,自主研发的激光锡球焊解决方案,以 “局部精准加热 + 低热影响区控制” 为核心,通过激光光源优化、能量闭环控制、非接触焊接三大技术创新,将 FPCB 焊接的热影响区严格控制在 50μm 以内,基材温升≤30℃,铜箔剥离率降至 0.1% 以下,同时实现 0.15mm 微型焊点良率稳定在 99.6% 以上。本文将从 FPCB 焊接的基材保护痛点、激光锡球焊的低热影响区技术细节、实际应用案例三个维度,详解如何通过精密焊接技术守护 FPCB 的柔性特性。
一、FPCB 焊接的基材保护痛点:传统工艺的热损伤困境
FPCB 的结构特性与材质局限,使焊接过程中的 “热控制” 成为核心难题,传统焊接工艺在热影响区、温度精度、机械压力三个维度均存在难以突破的局限,直接威胁基材安全。
(一)热影响区过大:基材变形与铜箔剥离的主要诱因
传统焊接工艺的加热方式无法聚焦能量,导致热影响区覆盖范围远超 FPCB 的耐受极限:
烙铁焊:烙铁头与 FPCB 直接接触,热量通过传导扩散至周边区域,热影响区可达 300-500μm,PI 膜在高温下易发生不可逆收缩(收缩率超 5%),导致线路间距缩小,甚至引发短路;同时,高温使基材与铜箔间的粘结剂失效,铜箔剥离率超 10%,严重影响电路导通性;
热风焊:热风为面状加热,热影响区≥200μm,且热风温度波动可达 ±15℃,即使设定温度为 180℃,局部热点温度仍可能超 200℃,导致 FPCB 的覆盖膜(如覆盖膜耐温≤160℃)起泡、脱落,失去绝缘保护作用;
(二)温度控制失准:局部高温引发的线路损伤
FPCB 的铜箔线路薄、散热快,传统工艺的温度控制精度不足,易出现 “局部过热” 或 “加热不足” 的双重问题:
局部过热:为确保锡料充分熔化,传统工艺常需提高焊接温度(如烙铁温度设定 280-320℃),高温集中在焊点周边,导致铜箔线路氧化(氧化层厚度≥1μm),阻抗升高 30% 以上,影响信号传输效率;部分细线路(线宽≤50μm)甚至会因高温熔断,直接造成产品报废;
加热不足:若降低温度避免热损伤,又会导致锡料熔化不充分,焊点润湿性差,虚接率超 8%,后期在 FPCB 弯折过程中,焊点易因应力集中出现断裂,产品返修率居高不下。
(三)机械压力损伤:柔性基材的物理性破坏
FPCB 的基材柔软、抗机械压力能力弱,传统接触式焊接工艺的机械压力会直接造成基材损伤:
烙铁焊的接触压力:烙铁头需施加 50-100g 的压力确保导热,FPCB 在压力作用下易产生凹陷(凹陷深度≥20μm),破坏基材的柔性结构,降低耐弯折性能;
送丝焊的送丝压力:送丝机构将锡丝送至焊点时,会产生 20-30g 的侧向压力,薄型 FPCB(厚度≤0.1mm)易发生变形,导致焊点位置偏移,桥连风险提升 5%;
夹具固定压力:为防止焊接过程中 FPCB 移位,传统设备需通过夹具施加固定压力,压力不均易导致基材局部褶皱,影响后续组装精度。
二、激光锡球焊的低热影响区技术:三大创新守护 FPCB 基材
针对 FPCB 焊接的基材保护痛点,大研智造激光锡球焊解决方案从 “能量聚焦、温度精准、无接触操作” 三个维度突破,构建低热影响区的技术体系,在确保焊点质量的同时,最大限度守护 FPCB 的柔性特性。
(一)激光光源优化:短波长激光实现 “表面聚焦加热”
激光光源的波长直接决定能量的吸收与穿透深度,大研智造通过选择适配 FPCB 的激光波长,从源头减少热量向基材内部扩散:
激光的表面加热优势:短波长激光的能量主要集中在 FPCB 表面(穿透深度≤1μm),仅作用于锡球与铜箔焊盘,避免热量向 PI 膜基材传导;其中,紫外激光的光子能量高,可直接作用于锡料表面,实现 “冷焊” 效果,热影响区可控制在 30-40μm,是红外激光的 1/3-1/4;
激光光斑精准聚焦:通过自主研发的光学聚焦系统,将激光光斑直径最小压缩至 50μm,配合 500 万像素亚像素视觉定位(定位精度 ±0.003mm),确保激光能量仅覆盖焊盘区域,不波及周边线路与基材;例如焊接 0.15mm 焊盘时,光斑直径控制在 80μm,热量完全集中在焊盘内,周边 PI 膜无明显温升;
多波长适配不同 FPCB 类型:针对厚铜箔 FPCB(铜箔厚度≥35μm),选用 450nm 蓝光激光(铜对蓝光吸收率达 65%),确保焊盘充分加热;针对薄铜箔 FPCB(铜箔厚度≤12μm),选用 355nm 紫外激光,以更低的能量实现锡料熔化,进一步缩小热影响区。
(二)能量闭环控制:脉冲加热与实时温控避免过热
激光能量的精准调控是控制热影响区的关键,大研智造通过 “脉冲加热 + 实时温度反馈” 的闭环系统,实现能量的精细化分配,避免热量累积:
脉冲间隔加热工艺:采用脉冲模式,每次加热仅熔化锡球,冷却阶段热量快速扩散,FPCB 基材有充足时间降温,避免热量累积导致的温度攀升;例如焊接 SAC305 锡球(熔点 217℃)时,单次加热脉冲能量控制在 5-8J,确保锡料熔化的同时,基材温升不超 30℃;
实时红外测温反馈:搭载高灵敏度红外温度传感器(采样频率 10000 次 / 秒,测温精度 ±1℃),实时监测 FPCB 焊盘周边的温度变化,若检测到基材温度接近 120℃(PI 膜的安全临界温度),立即降低激光功率或延长冷却时间,确保基材温度始终处于安全区间;
(三)非接触焊接:无机械压力守护 FPCB 柔性结构
FPCB 的抗机械压力能力弱,激光锡球焊的非接触焊接方式,从根本上避免了传统工艺的机械损伤:
锡球喷射式焊接:通过氮气压力将熔化的锡球喷射至 FPCB 焊盘,无需任何机械接触,避免烙铁头或送丝机构的压力导致基材凹陷;喷射压力可精准调节(0.2-0.5MPa),针对薄型 FPCB(厚度≤0.1mm)采用低压力(0.2-0.3MPa),确保锡料充分润湿焊盘的同时,不造成基材变形;
悬浮式定位设计:采用视觉定位替代传统夹具固定,通过 500 万像素相机捕捉 FPCB 的基准点,实时调整焊接位置,无需夹具施加压力,避免基材褶皱;针对大面积 FPCB(尺寸≥100mm×100mm),配合真空吸附平台(吸附压力≤0.05MPa),实现柔性固定,既防止移位,又不损伤基材;
立体焊接适配弯曲结构:激光锡球焊的多轴运动平台(X/Y/Z 轴重复定位精度 ±0.002mm)可实现多角度焊接(0-90°),避免机械外力导致的基材疲劳损伤,焊接后 FPCB 的弯曲性能保持率达 98% 以上。
三、实际应用案例:激光锡球焊在 FPC领域的基材保护实践
大研智造激光锡球焊解决方案已在消费电子、医疗电子、可穿戴设备三大领域的 FPC 焊接中实现规模化应用,通过实际生产数据验证了低热影响区对基材的保护效果,以下为典型案例。
案例一:可穿戴设备 FPC焊接 —— 解决基材收缩与线路断裂
案例二:汽车柔性传感器 FPCB 焊接 —— 满足低热损
四、结语:以低热影响区技术,解锁 FPCB 焊接的柔性价值
FPCB 的核心优势在于 “柔性与轻薄”,而焊接过程中的热损伤与机械损伤,正是制约这一优势发挥的关键瓶颈。大研智造激光锡球焊的低热影响区技术,通过激光光源优化、能量闭环控制、非接触焊接的协同创新,既解决了传统工艺的热损伤难题,又守护了 FPCB 的柔性特性,为消费电子的小型化、医疗电子的植入化、可穿戴设备的轻量化提供了精密焊接支撑。
-
焊接
+关注
关注
38文章
3604浏览量
63537 -
柔性电路板
+关注
关注
12文章
122浏览量
30106
发布评论请先 登录
松盛光电桌面式高精密激光锡球焊接系统的应用领域
焊锡激光器如何选择?揭秘锡球与锡丝、锡膏焊接的波长差异

3C精密焊接新标杆:大研智造激光锡球焊在触控笔领域的应用实践
紫宸激光锡球焊接机在微声电传感器中的微米级控制艺术

激光焊锡三大核心工艺助力PCB电子工业发展

激光锡丝焊接与激光锡膏焊接的区别
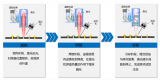



 柔性电路板(FPCB)焊接:激光锡球焊的低热影响区如何保护基材?
柔性电路板(FPCB)焊接:激光锡球焊的低热影响区如何保护基材?








评论