文章来源:学习那些事
原文作者:前路漫漫
本文介绍了激光划片的原理与设备工艺。
技术原理与核心优势
激光划片作为新兴材料加工技术,近年来凭借非接触式加工特性实现快速发展。其工作机制是将高峰值功率激光束经扩束、整形后,精准聚焦于蓝宝石基片、硅片、碳化硅(SiC)基片或金刚石等硬脆材料表面,通过高温汽化或升华效应实现材料分离。
该技术具备四大核心优势:
1.无损加工特性:采用非接触式划切,避免机械应力作用,可完全消除崩角缺陷,切口表面光滑无裂纹,显著提升产品切割质量与成品率;
2.高精度微加工能力:凭借微米级划切精度与极窄切缝,可实现无缝切割效果,使晶圆排布密度提升,有效降低基底材料消耗成本;
3.异形加工灵活性:支持线段、圆弧等复杂几何图形划切,在同等晶圆尺寸下可增加有效晶粒数量,最大化基底空间利用率;
4.绿色制造优势:无需刀具更换与冷却液消耗,既降低耗材成本,又避免加工废液污染,契合环保生产需求。上述特性使其成为高精度声波器件等可靠性要求严苛产品的首选加工工艺。
核心设备与系统参数
激光器作为激光划片设备的核心组件,通常占设备总成本的40%左右。按工作物质分类,工业级激光器主要包括固体激光器、CO₂激光器、准分子激光器、半导体激光器及光纤激光器。其中,脉冲固体激光器因易维护、长寿命(部分型号保修期达10万小时)等优势,成为划片设备的主流选择。
激光束质量直接影响划切效果,基模光束(光斑直径≤1.3μm)可实现最佳切割精度。精细划片常用的脉冲固体激光器波长涵盖1064nm、532nm、355nm、266nm四档。受技术发展限制,当前激光脉冲宽度多在 1~100ns区间,重复频率范围为几千赫至几百千赫。
光束传递系统利用高斯光束高方向性与功率密度特性,但需克服光束发散(毫弧度量级)及出口光斑(直径约1mm)限制。通过聚焦透镜优化,可按需调节光斑直径、焦深及功率密度参数:光斑越小则功率密度越高,材料去除能力越强。实际应用中需结合材料特性(硬度、热导率等)进行参数匹配,以获得理想划切效果。
工艺控制与应用案例
激光划切采用 “光束固定-工件运动” 模式,工作台承载材料按预设路径移动完成图形加工。需特别注意工作台启停时序与激光触发的协同控制 —— 若二者匹配失准,将导致加工边缘畸变、良率下降,甚至造成废片。
以蓝光LED蓝宝石晶圆划切为例:针对微米级切缝、20~30μm深度加工需求,优选355nm或266nm紫外脉冲固体激光器,通过工艺优化可实现最高20片/小时的加工产能。此类应用充分验证了激光划片在硬脆材料微加工领域的技术优势。
不同材料体系(如硅基半导体、陶瓷封装基板)需通过大量工艺实验确定激光波长、功率、脉冲宽度、重复频率及工作台运动参数的最优组合。该动态匹配过程是实现高精度、高效率划片的关键环节。
应用挑战与技术瓶颈
尽管具备显著技术优势,激光划片在产业化应用中仍面临三大核心难题:
1.热效应影响:高能量激光作用导致划切区域温度骤升,引发材料边缘化学相变(如碳化、氧化)与物理结构损伤(晶格畸变),尤其在蓝宝石、碳化硅等热导率低的材料加工中更为显著。
2.回焊与重铸缺陷:瞬间高温使熔融态材料在冷却时重新附着于切口边缘,形成不规则凸起或熔渣残留,影响后续封装精度。
3.粉尘污染风险:汽化材料形成的微米级颗粒易吸附于晶圆表面,若未及时清除将造成键合不良、短路等失效隐患。
理论研究表明,皮秒级(ps)超短脉冲激光可通过 “冷加工” 机制规避热效应,但当前商用皮秒激光器成本达纳秒级设备的3-5倍,使中小企业难以承受。行业数据显示,采用皮秒激光虽可将热影响区缩小至5μm以内,但设备投资回收期延长至2-3年。
工艺优化解决方案
针对上述瓶颈,设备厂商开发四大创新工艺体系:
1.表面保护膜涂覆技术采用水溶性高分子材料(如 PVA 薄膜)在晶圆表面形成 10-20μm防护层,通过物理阻隔捕获切割粉尘。加工后经DI水超声清洗(40kHz,5min)即可完全剥离,异物附着率从传统工艺的12%降至1.5%以下。该技术特别适用于倒装芯片(Flip Chip)制程,可将键合不良率降低 37%。
2.多光束阵列划片工艺基于衍射光学元件(DOE)将单束激光分解为16-64束平行子光束,通过相位控制实现同步加工。相比单光束,该技术可使切割效率提升4倍(如蓝宝石划切速度从80mm/s增至320mm/s),切缝宽度缩至35μm,且热影响区减小60%。
3.微水导激光切割系统利用10-50MPa高压水流形成 “光导纤维”效应,将激光束约束在直径50-200μm的水柱内传输。技术实测显示,该工艺可使碳化硅晶圆划片的热影响深度从80μm降至15μm,同时通过水流冲刷实现实时除尘,粉尘浓度控制在0.1mg/m³以下。其设备支持0.1-3mm厚度材料加工,切割精度达±2μm。
4.隐形切割(TLS)工艺通过红外激光(如1064nm)聚焦至材料亚表层(深度 50-200μm),利用多光子吸收效应形成改性层,后续经扩张膜机械应力实现晶粒分离。该技术彻底消除表面损伤,尤其适用于超薄芯片(<50μm)加工,韩国三星已将其应用于3D堆叠封装制程,良品率提升至99.2%。
行业应用拓展
凭借工艺优化带来的技术突破,激光划片已形成三大核心应用领域:
第三代半导体加工:在SiC功率器件划片中,微水导工艺使裂片良率从78%提升至95%;
光伏产业革新:多光束技术实现半片电池切割,硅片损耗率降低至0.3%;
先进封装领域:隐形切割支撑2.5D/3D封装中的超薄晶圆处理,助力HBM芯片量产。
-
激光器
+关注
关注
18文章
2882浏览量
64219 -
晶圆
+关注
关注
53文章
5345浏览量
131690 -
激光划片
+关注
关注
1文章
4浏览量
1185
原文标题:激光划片
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
蓝鹏测控的激光测径仪有哪些技术优势
GPP二极管、可控硅的激光划片工艺
激光传感器测量距离的方法及技术优势
“魔法”激光划片 - MAHOH
美JPSA公司在中国获得激光划片专利
未来一、二年内博捷芯划片机将推出激光划片机系列设备
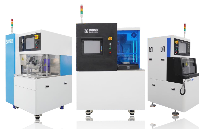
全自动晶圆划片机的应用产品优势






 激光划片的技术原理与核心优势
激光划片的技术原理与核心优势


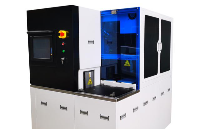
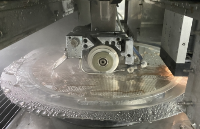










评论