01
引 言
随着微电子技术日新月异的发展,作为传统半导体材料的硅(Si)与砷化镓(GaAs)在半导体器件中表现出的电学性能已逐渐接近其理论极限。作为第三代半导体材料,碳化硅(SiC)材料以其比硅材料更为优良的物理及电学特性,吸引了众多功率器件业内人士的关注。与传统半导体材料相比,SiC材料具有宽禁带、高热导率、高临界击穿场强和高载流子饱和速度等优势,因此已成为国际上普遍公认的新一代电力电子器件材料,已被应用于输配电系统、轨道交通、新能源汽车、光伏逆变器可再生能源发电、军工国防等前沿科技领域。其中,SiC材料在功率开关器件中的应用引起了国内外学者的广泛关注;SiC功率器件最突出的性能优势在于其高压、高频和高温工作特性,可以有效地降低电力电子系统的功率损耗。
随着航空航天事业向深空探测方向迅速发展,电子器件面临的工作环境越来越多样,在复杂空间环境中保证器件工作的稳定性显得尤为重要。空间辐射环境中充斥着大量的高能电子、质子、γ射线和重离子等粒子,对航天器中的半导体元器件造成威胁。对于多数半导体材料而言,产生一对电子空穴对需要的平均能量为其禁带宽度的3~5倍,SiC材料的禁带宽度比传统Si材料大得多,因此辐照引入的电子空穴对更少。材料的临界位移能反映其抗位移辐照能力,因此SiC材料临界位移能是Si材料的近2倍,可有效减少位移缺陷的产生。
本文主要介绍了国内外针对SiC基SBD、JBS、MOSFET器件空间辐射效应的研究成果,阐述了几种常用SiC功率器件在高能粒子辐射下的性能变化规律与损伤机理,并对SiC功率器件抗辐射性能的发展与面临的挑战进行了展望。
02
SiC器件发展现状
经过近60年的持续发展,硅基功率器件已成为当今社会各种电能转换接口设备的主流选择。20世纪50年代末,硅基晶闸管(Thyristor)的成功研制标志着功率半导体器件的开端;80年代中期开始,可关断晶闸管(GTO)开始广泛应用于高压大功率变换器;而从90年代开始,绝缘栅双极型晶体管(IGBT)突破了阻断电压偏低的限制,成功应用于3.3 kV及以上电压等级场合,并以其较好的动静态性能在中压应用场合逐渐取得了优势地位。进入21世纪后,大功率变流装置对功率器件提出了更高的需求:阻断电压更高,导通压降更低,开关损耗更低,温度特性更好。然而硅基功率器件经过了60年的发展后,性能已经趋近于体二极管的材料极限(109~1010 WHz),通过器件原理的创新、结构的改良及工艺的进步已经难以明显提升其总体性能,这已成为制约电力电子技术进一步发展的瓶颈之一。
近二十年来,SiC单晶生长技术又取得了很大突破,在SiC晶片质量和尺寸上都有了稳步提高,促进了SiC外延、器件、封装等整个产业链的发展。目前,国外研究和生产SiC单晶的研究机构、高校和企业集中在美国、日本、德国等国家。与此同时,SiC外延技术的不断发展进一步推动了SiC功率器件的研发与产业化。增大SiC外延晶片尺寸是降低SiC功率器件成本的关键,随着SiC衬底制造技术的不断提高,SiC外延晶片己从过去的2、3英寸,逐渐发展到目前主流的4、6英寸。另一方面,随着SiC功率器件耐压等级要求的不断提高,SiC外延晶片的厚度也从过去的十徵米量级发展到目前的百微米量级,最高达到了250 μm以上。另外,降低SiC外延层表面缺陷是提高SiC功率器件成品率、降低制造成本的关键途径,因此降低外延层表面缺陷是外延工作的重中之重。目前表面缺陷密度已从过去的毎平方厘米几个缺陷,降低到每平方厘米小于一个缺陷的水平,最低达到了每平方厘米0.05个缺陷。
随着SiC外延生长技术的不断进步,主要发达国家竞相发展SiC功率器件制造技术,近来多家国际大公司向以使用6英寸外延晶片为主导的6英寸SiC功率器件制造工艺转移,SiC器件产品也在向高压端扩展,如3300 V级,目前己实现10 kV的SiC肖特基二极管、PiN二极管、MOSFET、IGBT、GTO晶体管的生产,其中单管器件的最高电压达到了27 kV。
SiC功率器件主要包括SiC二极管、SiC开关管和SiC功率模块。其中SiC二极管又分为SBD二极管和JBS二极管;SiC开关管分为SiC MOSFET、SiC JFET和SiC IGBT等;SiC功率模块分为全SiC功率模块和混合SiC功率模块。SBD采用4H-SiC的衬底及高阻保护环终端技术,并用势垒更高的Ni和Pt金属改善电流密度,适用于阻断电压在0.6 ~1.5 kV范围内的应用;JBS二极管兼具SBD二极管导通压降低和PiN二极管阻断电压高、反向电流小的优点,阻断电压范围为1.5~3 kV;MOSFET等功率开关器件是电力电子系统中的重要组成部分,主要应用于中低压领域。目前在深空探测领域航天器用电子设备中应用的主要为SiC二极管与SiC开关管,因此本文针对SiC SBD、SiC JBS与SiC MOSFET器件进行了研究。
03
空间辐射效应
随着航空航天事业向深空探测方向迅速发展,电子器件面临的工作环境越来越多样,在复杂空间环境中保证器件工作的稳定性显得尤为重要。特别是对于太阳系中冰冷天体的探索,例如火星和木星,辐射环境和空间低温环境对电子元器件的正常使用有着重要的影响。空间辐照及核辐照环境存在着诸多辐射源。在长期辐照过程中,高能射线、粒子入射会在半导体材料内产生大量的电荷累积,从而引起器件性能的退化甚至失效,产生总剂量效应。在航天器和空间系统的应用中,总剂量效应的影响主要分为电离作用和原子位移作用。电离作用是指辐照材料的原子通过电离吸收入射粒子的能量,产生电子空穴对;原子位移作用是指辐照材料的原子被高能粒子击中脱离原有位置,造成晶格损伤。相较于原子位移损伤,电离损伤的影响更加显著,且更易于发生。其中,电离损伤又根据高能粒子的作用数量分为单粒子效应(SEE)与电离总剂量效应(TID)。国内外研究结果表明,SiC功率器件的抗总剂量效应和位移损伤效应能力较强,单粒子效应则远不如预期。航天器上的单粒子效应主要是由重离子和质子引起的,质子通过与半导体材料的核相互作用产生重离子进而由重离子诱发单粒子效应。单粒子效应包括单粒子翻转、单粒子瞬态等软错误,单粒子锁定、单粒子烧毁、单粒子栅穿等硬错误。
在航天以及核应用中,辐照对器件性能的影响会扩大到整个系统的正常运行上,美国和前苏联早年发射的卫星曾发生多次故障,甚至失效。我国至今已发射了几十种各类用途的卫星,其中有的卫星也发生了故障,缩短了工作寿命,造成很大的损失。故障结果分析表明,其主要是由于空间高能带电粒子对航天器上电子系统产生的辐射效应造成的,这些效应引起的故障占卫星故障的绝大部分。因此,空间系统中电子器件的抗辐照性能直接关系到航天器的使用寿命、稳定性以及安全。
空间粒子辐射环境具有能谱宽、粒子成分多、全方位立体角分布、不同时期不同种类粒子的注量率不同且注量率较低等特点。然而,半导体器件的空间辐射效应评估主要是通过实验室的各种辐射模拟装置或辐射源开展地面模拟试验。地面模拟试验环境与真实的空间粒子辐射环境存在差异。地面试验时,能谱较窄,一般达到几百兆电子伏;辐照粒子单一,一般采用单一粒子对被测器件进行辐照;入射角度范围小,一般采用单向入射;注量率较高,因成本限制采用加速试验方法。因此,为在地面准确评估半导体器件的空间辐射效应,需要充分考虑上述差异对单粒子效应的影响,以免出现过于保守或过于低估的情况。
04
SiC基SBD器件的辐射效应研究
半导体晶格在受到高能粒子轰击的过程中会通过库仑散射将高能粒子能量的一部分转移给晶格原子。临界位移能(Ed)就是表征转移给晶格原子并使晶格原子离开其原始晶格位置所需要的最小能量。在抗辐照方面,材料的临界位移能越高,其抗位移辐照的特性就越好,SiC因其较高的临界位移能,在高能带电粒子辐照的条件下产生位移辐照缺陷的几率较小。
早在2002年,SHERIDAN等对Ni、Ti、Mo/4H-SiC SBD的射线辐照效应进行了报道,研究结果表现在经过总剂量为4 Mrad(Si)的射线辐照后,所采用的3种肖特基接触的SiC SBD的直流正向和反向特性均无明显退化线性,该研究结果表明在高辐射环境下SiC在极端环境电子学中的特殊潜力,此外,与未经过辐照的器件相比,经过辐照后的SiC SBD的击穿电压增加了约200 V,并通过数值模拟确定了负极氧化电荷的增加是反向击穿电压提高的原因。2002年,NIGAM等人研究了Ni/4H-SiC SBD的40 MeV高能质子辐照效应,在辐照后,Ni/4H-SiC SBD的整流特性有较为轻微的下降,反向击穿电压也下降了50 V。研究结果表明Ni/4H-SiC SBD反向漏电流的增加原因是辐照在材料中产生了复合中心。
2019年,SHENG等人针对4H-SiC SBD进行了中子与60Co-γ射线辐照实验。如图1所示,在经过1×1013 cm-2的中子辐照后,SiC SBD的正向和反向特性几乎没有变化,这意味着在这种低通量快中子辐照下,SiC SBD的电性能没有表现出明显的退化。此外实验还采用了总剂量为300 krad的60Co-γ射线对样品进行辐照,辐照前后正向与反向I-V曲线如图2所示,与中子辐照结果类似,60Co-γ射线对SiC SBD电性能影响并不明显,正向与反向I-V曲线基本不变。为进一步评估中子位移损伤对SiC SBD造成的影响,实验将快中子的辐射通量提升至1.3×1015 cm-2,得到图3中的结果,可以看到此时SiC SBD在辐照前后的I-V曲线发生了明显的变化,除正向电流减小外,正向I-V曲线的斜率也产生了很大变化;通过计算得知高通量的快中子辐照后,SiC SBD的理想因子数值增加,表明器件内形成了高密度的缺陷。与此同时,在图3中还可以看到阻断电压显著降低,造成SiC SBD性能的严重劣化。因此,中子引起的位移损伤会在SiC SBD中引入大量缺陷,从而极大地改变载流子运输性质,影响器件的基本运行。
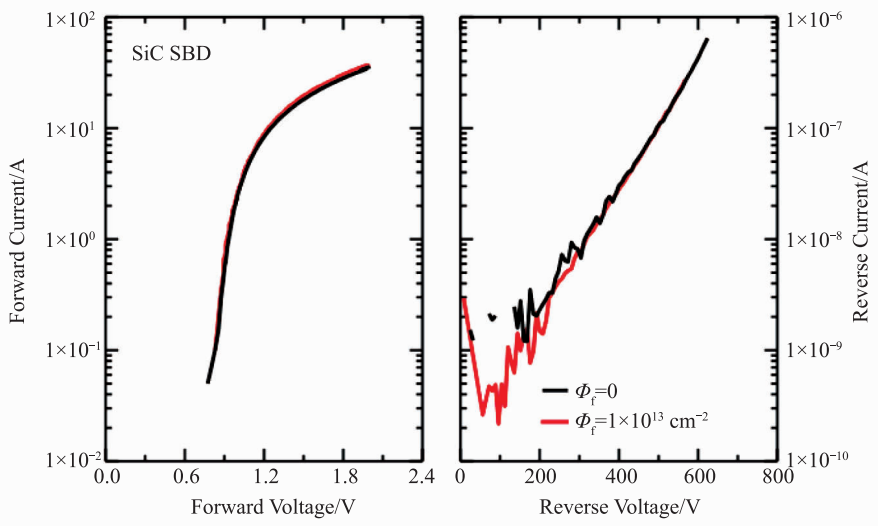
图11×1013 cm-2的中子辐照前后SiC SBD正向与反向I-V曲线
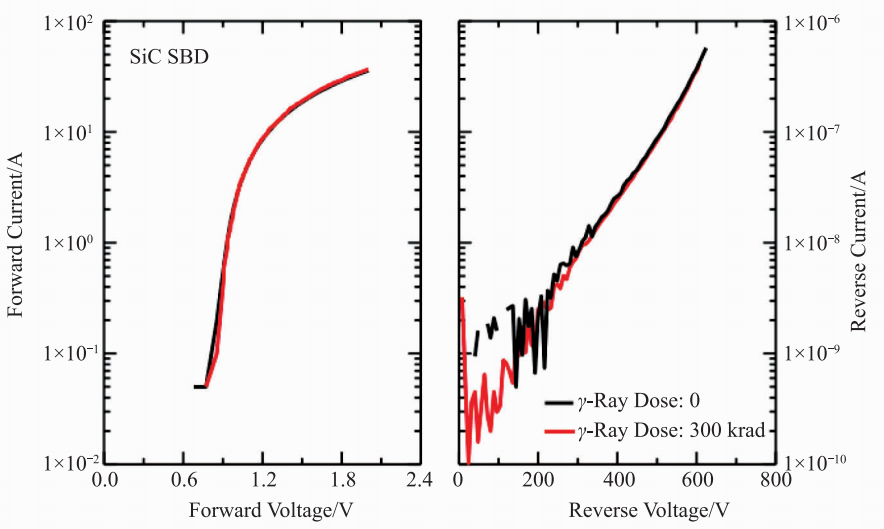
图2300 krad 60Co-γ射线辐照前后SiC SBD正向与反向I-V曲线
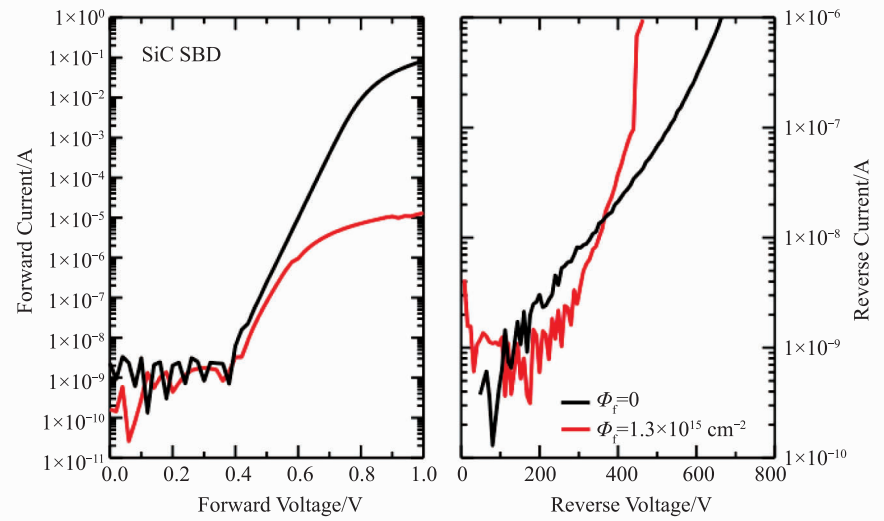
图31.3×1015 cm-2的中子辐照前后SiC SBD正向与反向I-V曲线
同一时间,国内的杨桂霞等人选取了能量为1.8 MeV、通量为9.62×1012 cm-2s-1、总注量为9.05×1017 cm-2的电子对4H-SiC SBD进行辐照试验。如图4所示,随着电子注量的增加,器件的感应电流不断减小;当电子注量达到1×1015 cm-2时,电流减小到1.24×10-5 A,可以认为SiC SBD足以抵抗通量低于1×1015 cm-2的电子辐照。然而随着电子注量的进一步增加,器件的感应电流开始急剧下降,辐照结束时,电流达到1.82×10-6 A,相比于初始值降低了85%,同时SiC SBD的感应电流波动也急剧增大。这是由于SiC SBD受到高注量电子辐照时,在SiO2层、SiC层以及金属和SiC之间的界面内会产生大量缺陷,这些缺陷会在1.8 MeV电子辐照时对电荷载流子产生去除效应,导致感应电流的减小。

图4感应电流随电子注量的实时变化曲线
HEMMINGSSON等人利用深能级瞬态谱(DLTS)研究了电子辐照化学气相沉积生长的4H-SiC外延层中的深能级缺陷。在100~750 K温度范围内对电子辐照的p-n结进行的测量显示,电子陷阱和空穴陷阱的热电离能范围为0.35~1.65 eV,这是导致器件性能恶化的主要原因。实验中常采用I-V、C-V与DLTS分析研究缺陷对SiC SBD性能的影响。研究发现,DLTS缺陷能级(EH1、EH3和Z1/2)极有可能是电子辐照后电荷收集效率降低的原因之一,其中EH1和EH3与碳间隙有关,Z1/2与碳空位有关。研究表明,当辐照电子能量超过100 keV时会在SBD中引入Z1/2和EH6/7,Z1/2和EH6/7的浓度随着辐照注量的增大而提高。OMOTOSO等的研究表明,电子辐照会导致Ni/4H-SiC SBD自由载流子浓度降低。SiC SBD经电子辐照后,会在半导体/金属界面附近形成缺陷,显著增加理想因子并出现瞬态非稳态电流。
针对SiC SBD工艺的改进,叶毅等研究了表面电场降低(D-Resurf)技术,可提高反向击穿电压,改善正向导通特性,还通过仿真对参数进行了一系列的优化;陈刚等则制备了Ni/SiC SBD,Ni/SiC作为终端放置在SBD边缘,在反向击穿电压为1100 V时,Ni/SiC SBD依然保持较小的漏电流,且正向导通特性表现良好。
05
SiC基JBS器件的辐射效应研究
随着电力电子技术的迅速发展,以肖特基二极管(SBD)和PiN二极管为主的传统二极管已无法满足高频率、大功率及低功耗的市场需求,前者击穿电压低、反向漏电大,而后者高频特性较差。因此结势垒肖特基二极管(JBS)应运而生,该结构将SBD结构和PiN结构巧妙地结合在一起,结合了SBD良好的开关特性和PiN二极管高击穿电压和低漏电流特性,具有高耐压、低压降、小漏电、高频特性好及强抗过压和浪涌电流能力。与SBD相比,JBS中有P-N结存在,辐照效应更加复杂,包括了在SBD中不存在的少子效应。因此,在研究分析JBS辐照效应的过程中不仅要考虑半导体-金属肖特基结的辐射效应,还要考虑P-N结的辐照效应。
2014年,HAZDRA等人针对1700 V SiC JBS功率二极管进行了注量分别为1.3×1013、6.6×1013、1.7×1014、4×1014 cm-2的中子辐照实验,通过电容深能级瞬态光谱、电容-电压(C-V)曲线和电流-电压(I-V)曲线测量对辐射缺陷、热稳定性和对二极管特性的影响进行表征。由图5可知,不同注量下SiC JBS所有正向I-V曲线在低偏压下都呈线性变化,而在较大的正向电压下,串联电阻决定其变化趋势;随着辐照注量的增加,I-V曲线的线性区域变小,在较高电压下的电流也有所下降,这与辐照后JBS串联电阻增加的趋势相符,此时在较低偏压下器件的肖特基结势垒高度基本保持不变,这正是由于随着辐照注量的增加,引入了类受体辐射缺陷或氮掺杂剂失活,导致JBS低掺杂N外延层中自由载流子数目减少。同时随着辐照剂量的增加,外延层中掺杂数目的减少可能与迁移率的降低相结合。图5中的反向I-V特性表明中子辐照对SiC JBS在低反向电压下的泄漏电流不会造成太大影响,这是由于碳化硅的宽带隙抑制了辐照引入的深能级电荷载流子的产生,引入的深能级则表现为电荷陷阱,而非产生中心;引入缺陷的受主特性降低了外延层中的N型掺杂水平,从而降低了反向偏置JBS结的空间电荷区(SCR)中的电场强度,因此辐照后二极管的击穿电压保持不变甚至略有增加。
而在高中子注量辐照下,二极管的反向I-V特性在低电压下表现为泄漏电流迅速增长,并随着中子注量的增加而增加,这种异常现象是由深能级或表面态捕获的电子的热释放引起的,此后测试电流与SCR延伸的速度成正比关系变化。在辐照后的二极管中,有效氮掺杂减少;并且在低电压(大于40 V)时SCR比未辐照的样品扩展得更快。当SCR延伸率相等时,电流过冲在较高的电压下停止。应该注意的是,随着中子辐照剂量的增加,肖特基结势垒高度的增加抑制了受辐照二极管在高电压(大于1000 V)区域的反向电流;在高电压(大于1000 V)区域,泄漏是由结势垒上的热离子发射给出的。因此我们可以得出结论,中子辐照对工作在关闭状态下的SiC二极管基本不会产生影响。
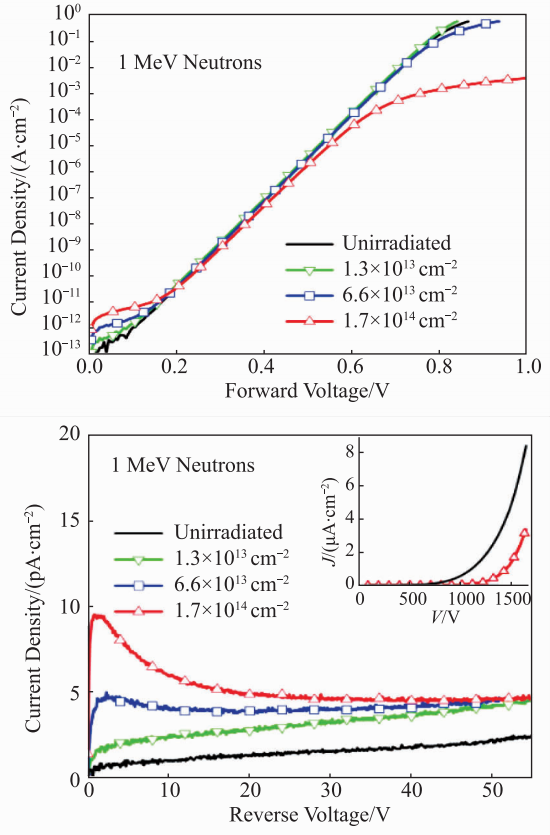
图5 中子辐照前后4H-SiC JBS的正向与反向I-V特性
哈尔滨工业大学的刘超铭等人采用注量为5×1014 cm-2和5×1015 cm-2的1 MeV电子对4H-SiC JBS进行了电子辐照实验,研究了不同注量电子对4H-SiC JBS的I-V特性、C-V特性和缺陷的辐照效应。如图6所示,随着电子注量的增加,正向电流减小;根据计算可得辐照后,串联电阻由49.8 mΩ增长到81.2 mΩ。辐照产生的缺陷可以俘获SiC中的自由载流子,使净载流子浓度降低并产生补偿效应,从而导致串联电阻增加。而漏电流随辐照注量先增加后降低,载流子浓度随辐照注量的增加而降低,载流子去除率为0.37 cm-1。较低注量下漏电流的增加原因可能是辐照引起原子位移产生“形成-复合中心”;较高注量下漏电流的降低原因可能是电子辐照对SiC JBS注入退火效应,也可能是电子辐照引入补偿缺陷导致载流浓度的降低。图7中的PL研究结果表明,辐照后VC、VSi显著增加。辐照引起缺陷浓度增加并捕获载流子导致载流子浓度降低,这是4H-SiC JBS器件的I-V特性、C-V特性退化的主要原因。同时载流子浓度降低和辐照产生的非辐射复合中心可能引起了淬灭效应。总体来说,电子辐照强烈影响SiC的晶格结构和周期势场,并能在禁带内引入缺陷能级,降低材料中的载流子迁移率和载流子浓度。此外,由电子辐照引起的深能级缺陷常常充当非辐射复合中心,抑制发光效率,从而导致发光强度降低。缺陷浓度的增加也会导致4H-SiC JBS的I-V和C-V特性变化。
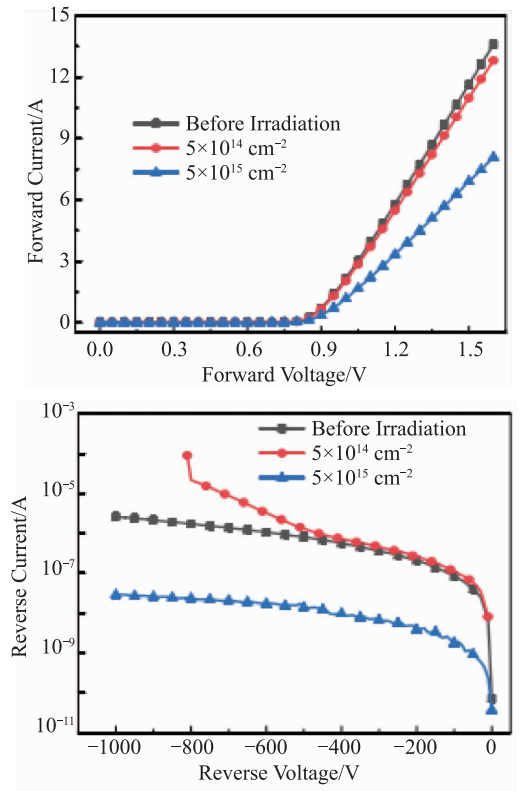
图6电子辐照前后4H-SiC JBS的正向与反向I-V特性
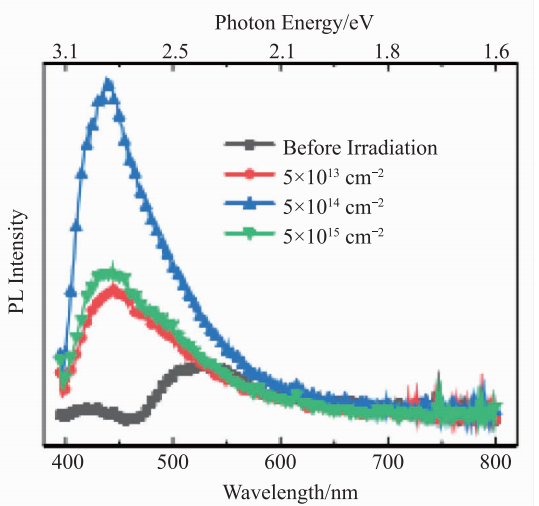
图7 电子辐照前后4H-SiC JBS的PL光谱图
06
SiC基MOSFET器件的辐射效应研究
2014年,ALEXANDRU等人研究了质子与电子辐照对MOSFET电学参数的影响,实验主要针对4H-SiC nMOSFET器件进行了带电粒子辐照与分析。辐照部分选取了基于4种不同注量下的5 MeV质子辐照:5×1011 p/cm2、5×1012 p/cm2、5×1013 p/cm2与5×1014 p/cm2;以及基于4种不同吸收剂量的15 MeV电子辐照:100 krad(Si)、1 Mrad(Si)、2 Mrad(Si)与3 Mrad(Si)。辐照前后4H-SiC MOSFET重要电学参数变化如表1、2所示。
表15 MeV质子辐照后4H-SiC MOSFET电学参数
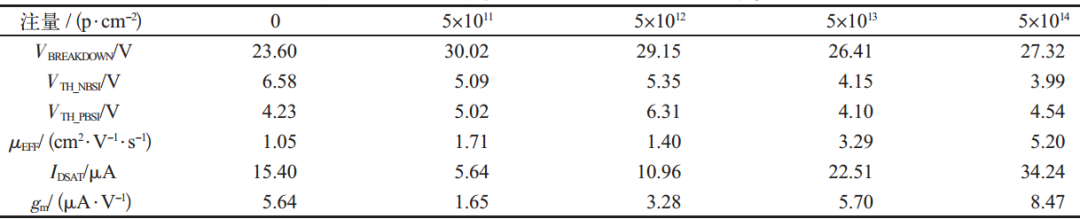
表215 MeV电子辐照后4H-SiC MOSFET电学参数
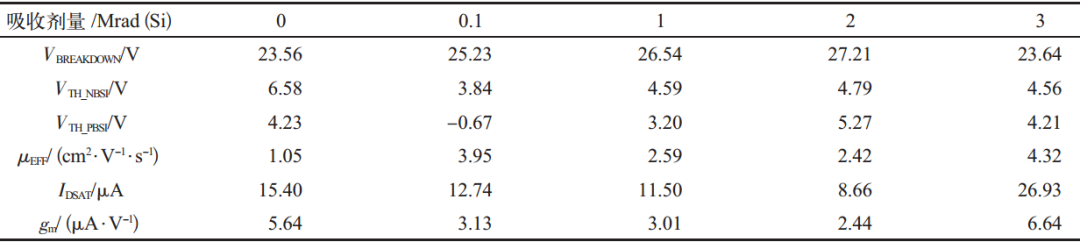
由实验可知,不同注量辐照前后4H-SiC MOSFET的阈值电压、沟道迁移率与栅漏电流都发生了较为明显的变化。阈值电压变化如图8所示,可以看出在经过质子辐照后,阈值电压降低并且随时间增长而趋于稳定,随着质子注量的增加,阈值电压呈现逐渐减小的趋势;电子辐照前后变化与质子辐照相似;同时我们还可以看到,即使在最高通量的质子辐照与最大注量的电子辐照下,其栅极漏电流仍几乎保持不变。

(a)5 MeV不同注量质子辐照

(b)15 MeV不同剂量电子辐照
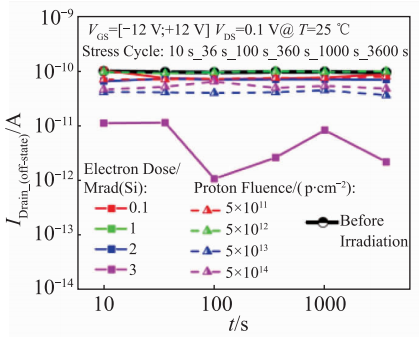
(c)不同质子和电子辐照通量/剂量下的平均漏电流随时间的变化
图8 不同辐照剂量下阈值电压和栅漏电流变化
国内的梁晓雯等人为探究SiC MOSFET在空间辐射环境下的性能稳定性,选取了60Co-γ射线为辐照源,采用1.74 Gy(SiO2)/s的剂量率对36 A 1200 V SiC MOSFET进行总剂量辐射实验。器件转移特性曲线随辐射剂量变化趋势如图9所示,在较低的外加电场条件下,随着辐射总剂量的增加,转移特性曲线基本没有变化;图10(a)显示了在高电场下辐照的器件的IDS-VGS曲线,从中我们可以发现,当剂量小于58 krad(SiO2)时,曲线几乎没有变化,当剂量大于58 krad(SiO2)时,曲线向负方向移动;图10(b)给出了从图9和图10(a)中提取的阈值电压的变化情况,如图所示,当在0 V和5 V偏压下照射时,阈值电压变化量ΔVth很小,而当在20 V偏压下照射时,阈值电压变化量ΔVth显著降低。
这种现象主要是由氧化物中正电荷的积累所导致的。γ射线辐照在氧化物中产生电子-空穴对,SiO2中电子的迁移率远高于空穴的迁移率,因此在20 V的辐照偏压条件下,强电场会导致电子向栅极快速漂移,空穴向SiC/SiO2界面缓慢漂移。在此过程中,部分空穴会被氧空位俘获,形成正的氧化物陷阱电荷。而在-5 V和0 V偏压配置下,空穴的动能很小,大部分空穴被电子复合,氧化物中无法形成正电荷。

(a) VGS=0 V@RT

(b)VGS=-5 V@RT
图9 不同偏置条件下的转移特性曲线与辐射剂量关系
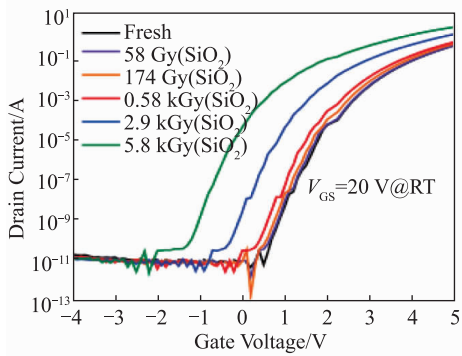
(a)VGS=20 V下的转移特性曲线与辐射剂量关系

(b)不同偏置条件下阈值电压变化量ΔVth与辐射剂量关系
图10 辐照后SiC MOSFET转移特性与阈值电压变化曲线
相比于辐照总剂量效应,单粒子会对SiC MOSFET造成更为严重的损伤,其中单粒子烧毁(SEB)作为一种破坏型的SEE,在N型沟道功率晶体管中极易发生。为探究SiC MOSFET器件的单粒子烧毁效应,哈尔滨工程大学的于成浩等人仿真分析了功率MOSFET的单粒子烧毁效应,图11给出了LET=0.01 pC/μm的离子在颈区位置入射后,功率MOSFET漏源电流随时间的变化曲线。可以看到,当VDS=260 V时,器件的瞬态电流随时间不断增加,从初始较低的数值变为一个高稳态电流值,最终造成器件烧毁;而当VDS=250 V时,初始一段时间内瞬态电流随时间不断增加,在1 ns左右开始下降,并在10 ns时降低为零,没有发生单粒子烧毁效应。我们定义触发SEB所需要的最低漏源电压为SEB阈值电压。若将不同LET值下功率MOSFET的SEB阈值电压绘制成图可得图12中的曲线,如图所示,SEB阈值电压随LET值的增加而不断减小,直到达到SEB阈值电压饱和值,该饱和值即为功率MOSFET器件的安全工作区(SOA)。SOA是表征功率MOSFET器件SEB性能的一个重要参数,用来定义对SEB效应免疫的漏源电压工作区域,通常用SEB阈值电压随LET值的变化曲线来定义。
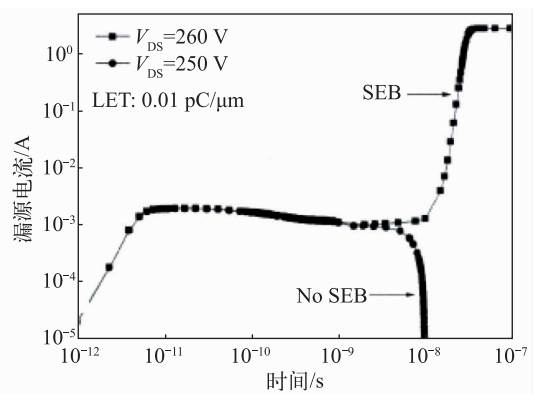
图11 离子入射后,功率MOSFET漏源电流随时间的变化曲线
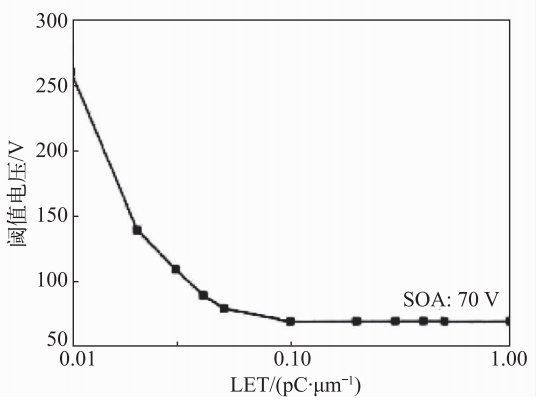
图12 离子入射后,功率MOSFET SEB阈值电压随LET的变化曲线
于庆奎等人选取了不同厂家的SiC功率器件进行单粒子效应的研究,实验结果表明在重离子辐照后,在器件发生单粒子烧毁失效前的更低电压下,SiC MOSFET的漏电流快速增加。由此可知,重离子辐照会引起SiC MOSFET单粒子烧毁,而漏电流增加和单粒子烧毁与入射粒子LET和偏置电压有关;同时漏电流还会随入射离子注量的增加而增大,因此具有一定的累积效应。
为验证SiC MOSFET在空间复杂辐照环境下的电性能可靠性,哈尔滨工业大学的刘超铭等人针对SiC MOSFET在低温与辐照耦合环境下性能的变化规律与损伤机理进行了深入分析。实验选取了1200 V商用SiC MOSFET为研究对象,分别在300 K、200 K、40 K的温度环境下对样品进行了60Co-γ射线辐照,辐射剂量分别为50 krad、100 krad、500 krad与1 Mrad。图13为不同温度下SiC MOSFET的转移特性曲线,可以很明显地看出随着辐射剂量的增加,转移特性曲线负向漂移。若从图13中提取器件的阈值电压,可得到阈值电压Vth在不同温度下随辐射剂量的变化曲线。如图14所示,在同一辐射剂量下阈值电压随着温度的降低而增大,在温度为40 K时,阈值电压达到极大值。
之前的研究结果表明,界面态密度随温度的降低而迅速增加,由于假定界面态为负电荷,因此低温下阈值电压产生图中所示的正向偏移;与此同时,随着温度的降低,表面费米能级向导带边缘Ec移动,界面态密度迅速增大,导致大量的电子在低温下将被捕获在界面态,得到更高的阈值电压;而60Co-γ射线辐照诱导产生了大量的电子-空穴对,空穴由于迁移速率较慢易被栅氧层中的氧空位捕获,形成带正电的氧化物陷阱电荷,造成了辐射后阈值电压的负向偏移。
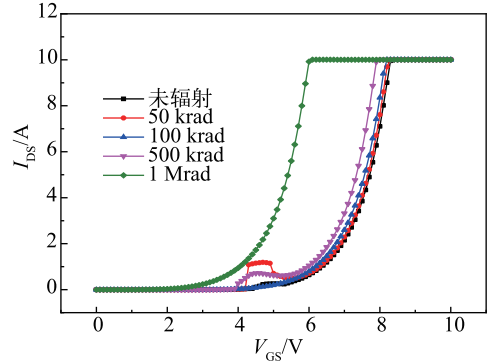
(a)T=300 K

(b)T=200 K
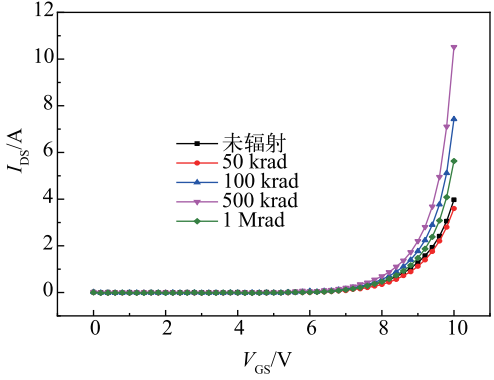
(c)T=40 K
图13不同温度下SiC MOSFET辐射后转移特性曲线
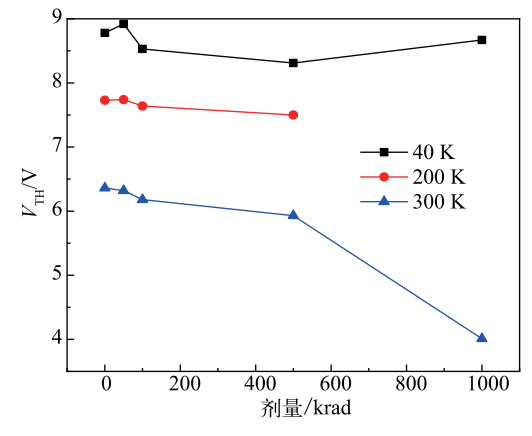
图14不同温度下SiC MOSFET阈值电压Vth与辐射剂量的关系
07
结 论
随着半导体功率器件工艺与深空探测技术的不断发展,我国将不断加快向更深更远深空领域迈进的步伐。由于深空环境中充斥着大量的高能粒子,严重威胁到在轨航天器的使用寿命与测量数据的准确性,因此对SiC功率器件在空间辐射环境下可靠性的研究显得尤为关键。由国内外学者对SiC功率器件空间辐射效应的研究可知,高能粒子主要是通过在SiC SBD中造成高密度的缺陷,并且在材料中诱导复合中心的产生,降低了自由载流子浓度,从而影响其正向与反向泄漏电流,造成器件性能的退化;针对SiC JBS器件,电子辐照影响了SiC的晶格结构,在禁带内部引入了缺陷能级,使得材料中的载流子迁移率和载流子浓度降低,同时辐照造成的深能级缺陷常常充当非辐射复合中心,抑制了发光效率;SiC MOSFET的SiO2/SiC界面与栅氧层对空间辐射环境较为敏感,辐照在氧化层中产生大量的电子-空穴对,由于迁移速率较慢,导致大量的空穴被栅氧层内的氧空位俘获成为带正电的有效氧化物陷阱电荷,导致了MOSFET阈值电压的正向漂移。因此,SiC功率器件在空间辐射环境下的可靠性是SiC功率器件工艺发展与深空探测技术推进的重要保障,改进SiC功率器件工艺结构以充分发挥SiC宽禁带材料抗辐射性能的优势,对我国未来航空航天科技的发展具有关键作用。
审核编辑:刘清
-
新能源汽车
+关注
关注
141文章
11468浏览量
105481 -
MOSFET
+关注
关注
151文章
10805浏览量
234898 -
功率器件
+关注
关注
43文章
2221浏览量
95470 -
SiC
+关注
关注
32文章
3855浏览量
70099 -
光伏逆变器
+关注
关注
10文章
585浏览量
33645
原文标题:SiC功率器件辐照效应研究进展
文章出处:【微信号:CloudBrain-TT,微信公众号:云脑智库】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录



 SiC功率器件辐照效应研究进展概述
SiC功率器件辐照效应研究进展概述







评论