共读好书


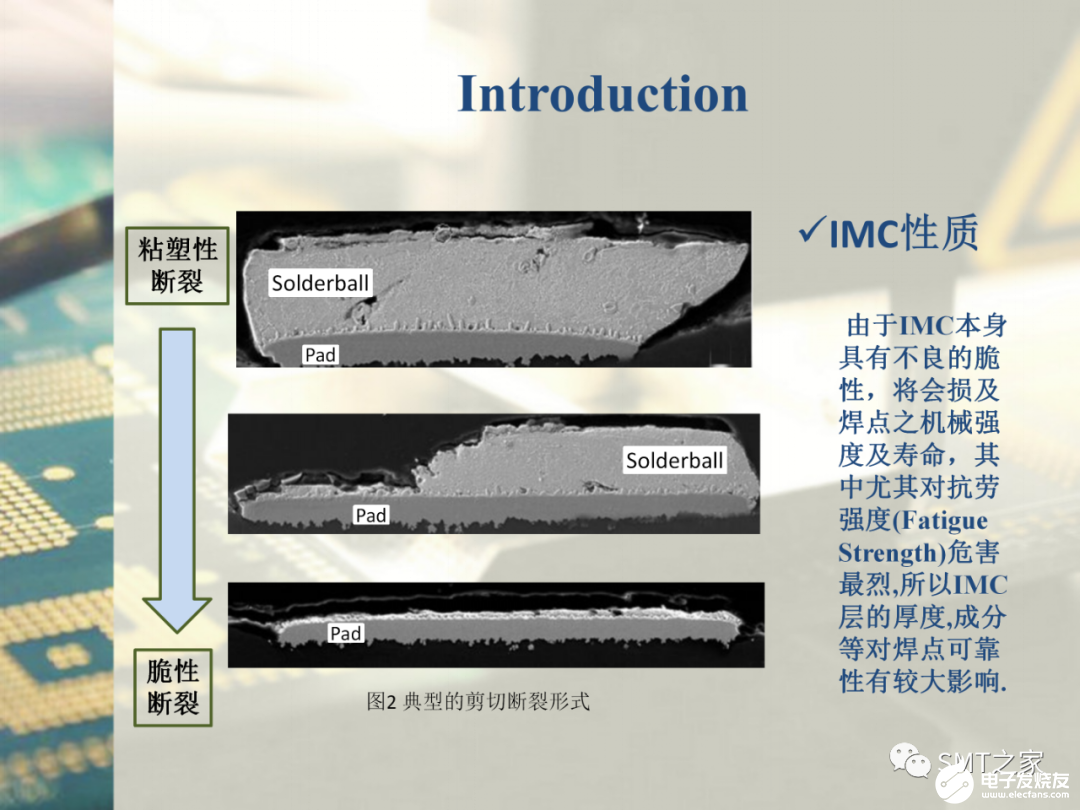








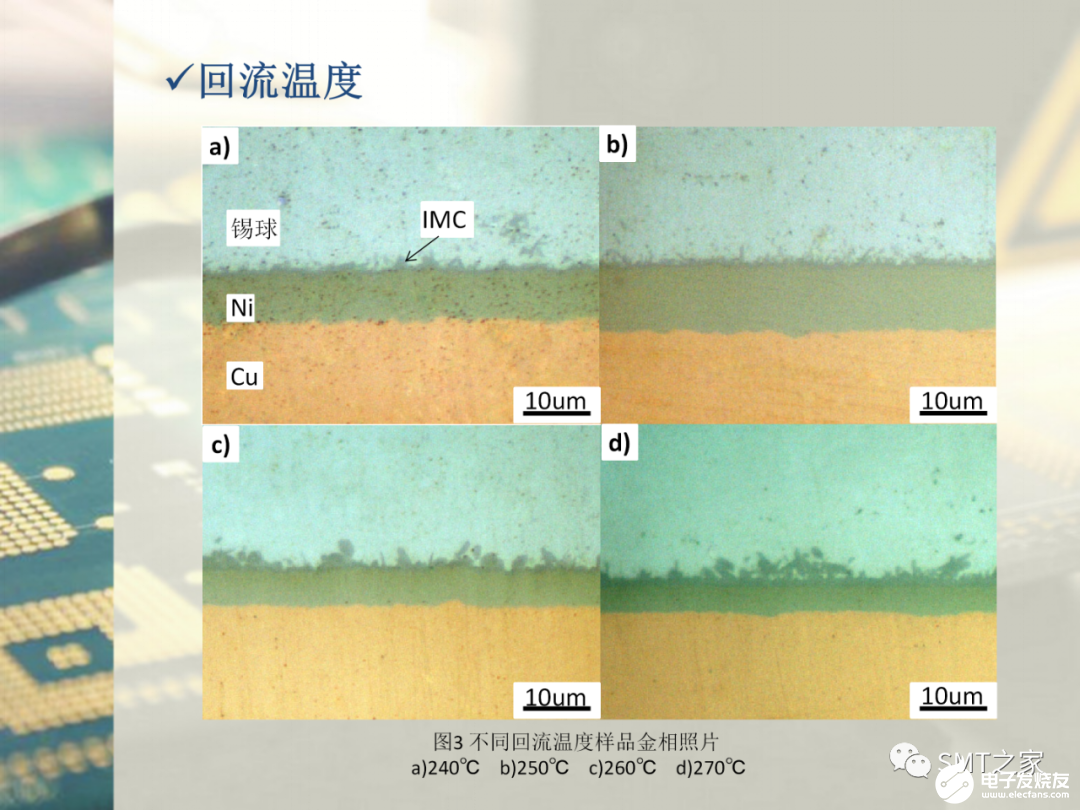
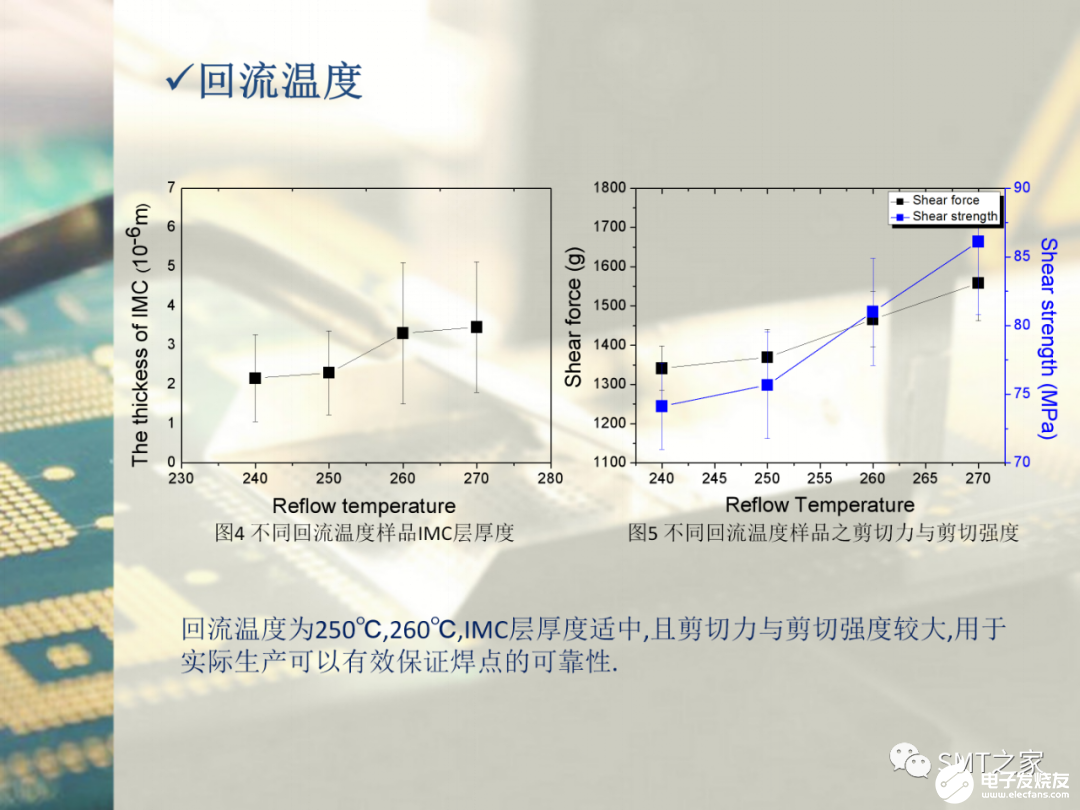
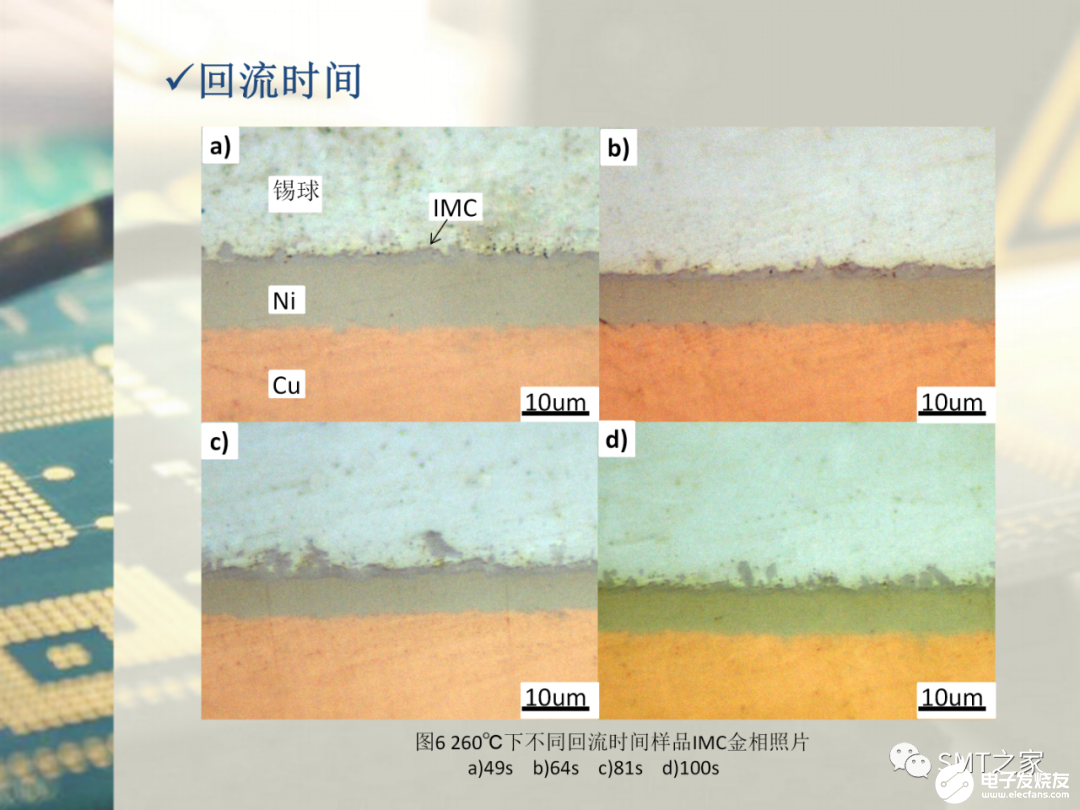
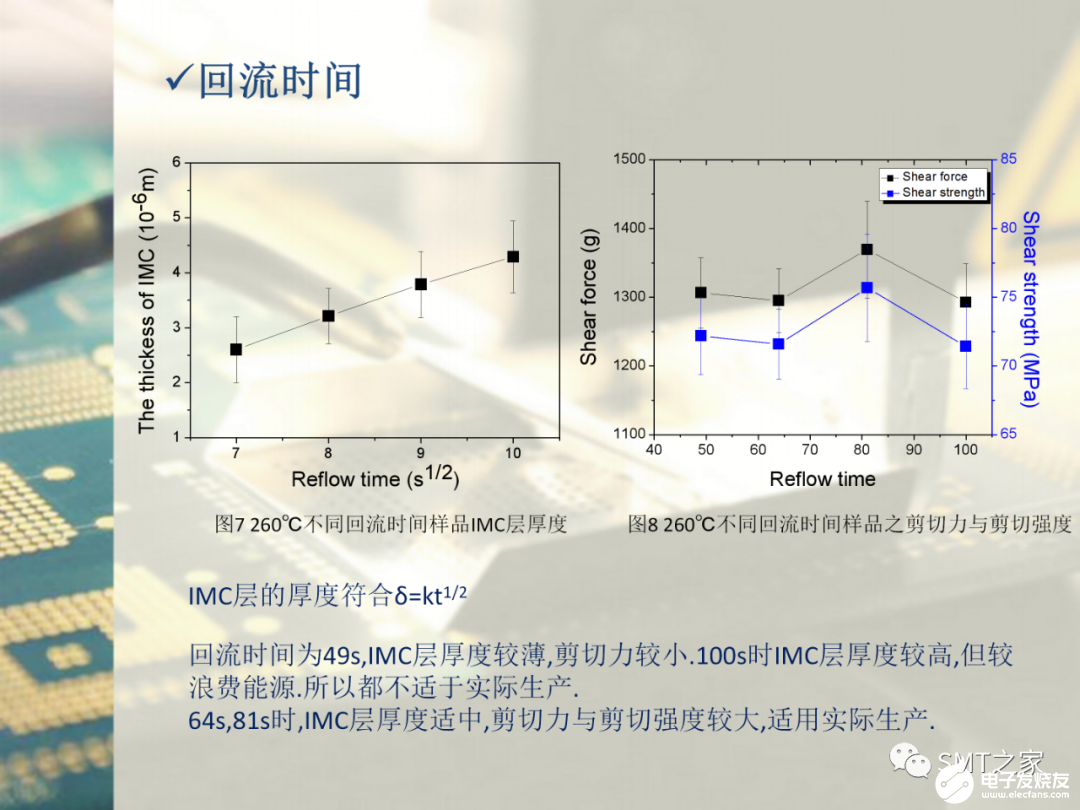
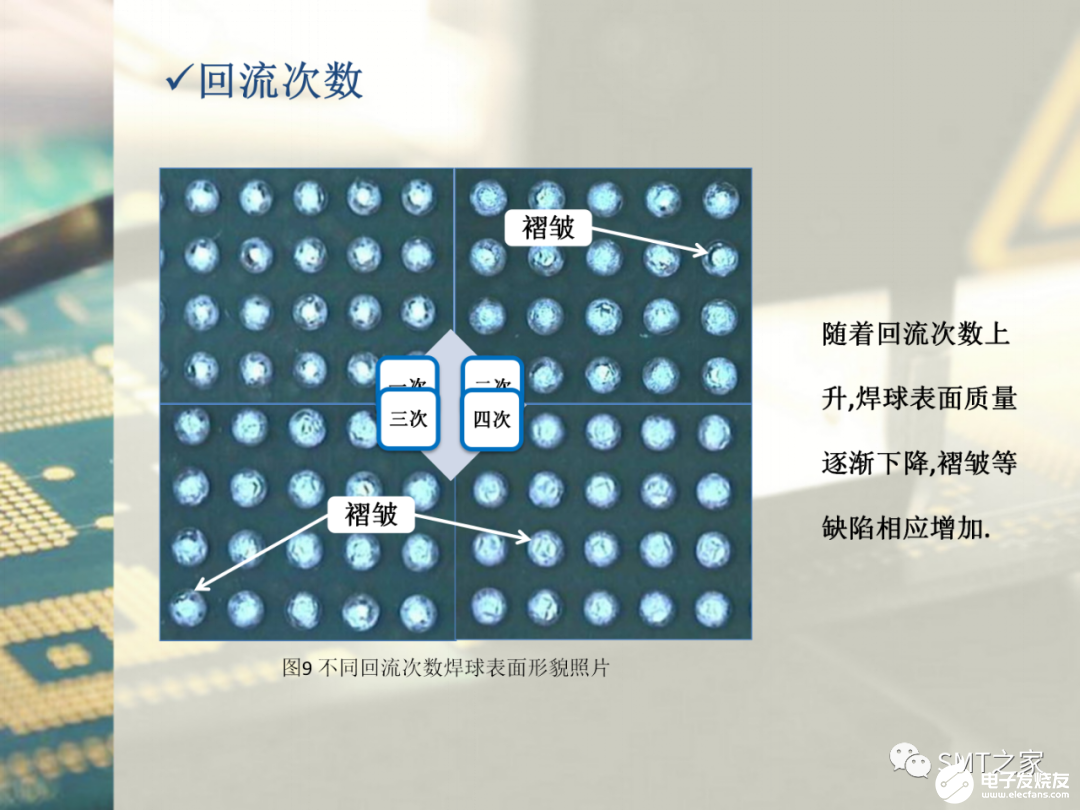
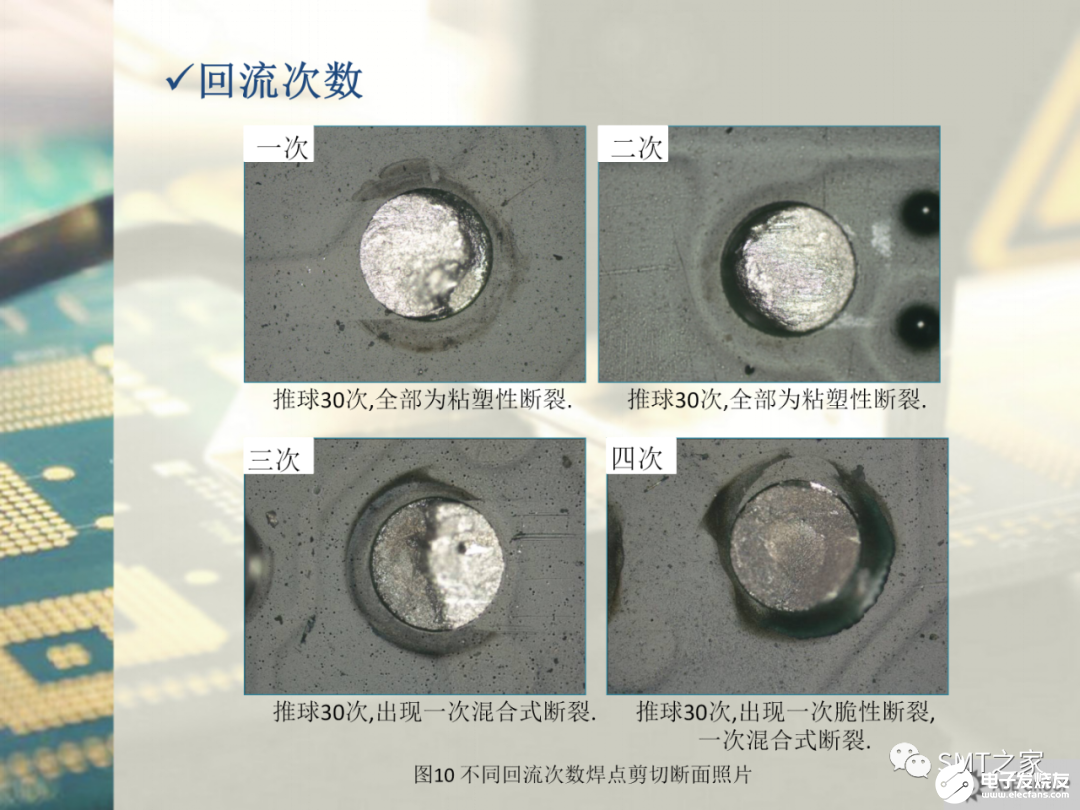
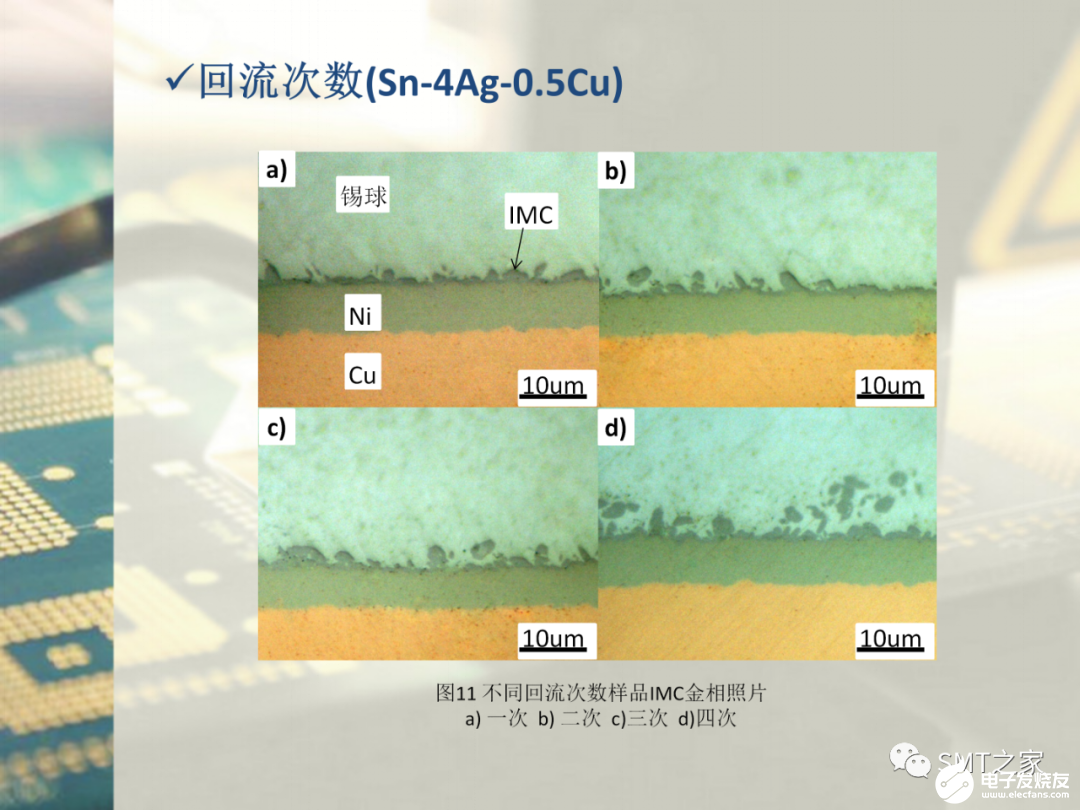
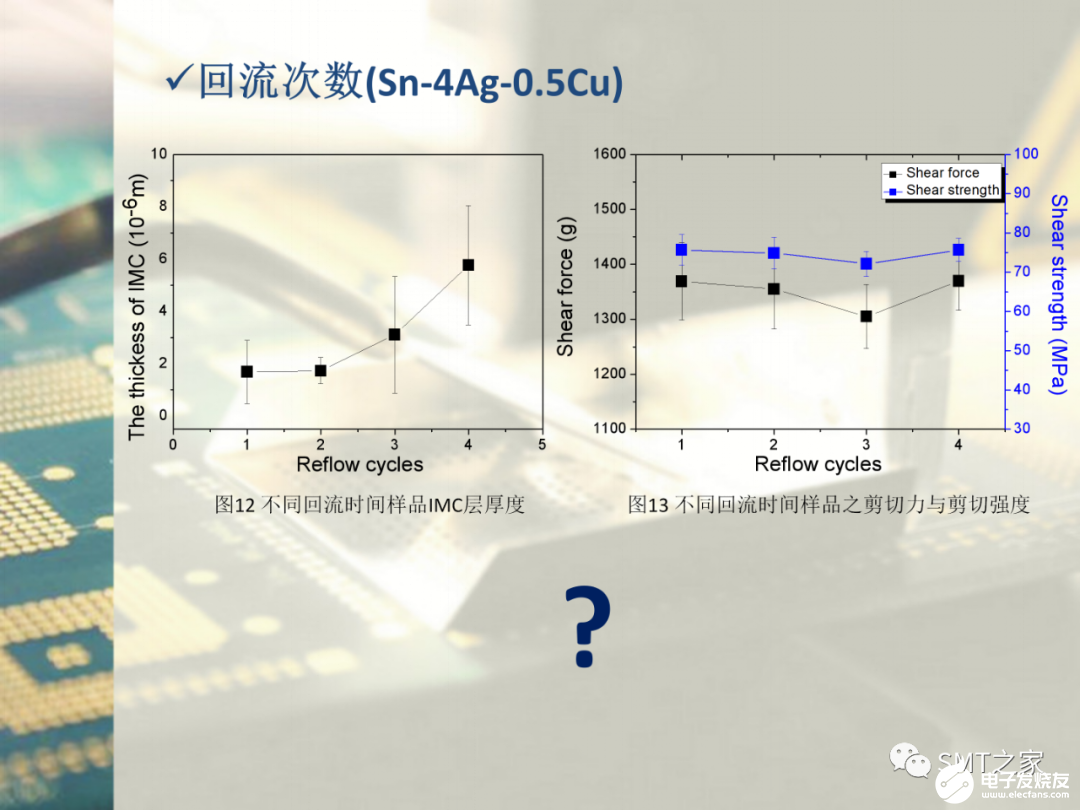
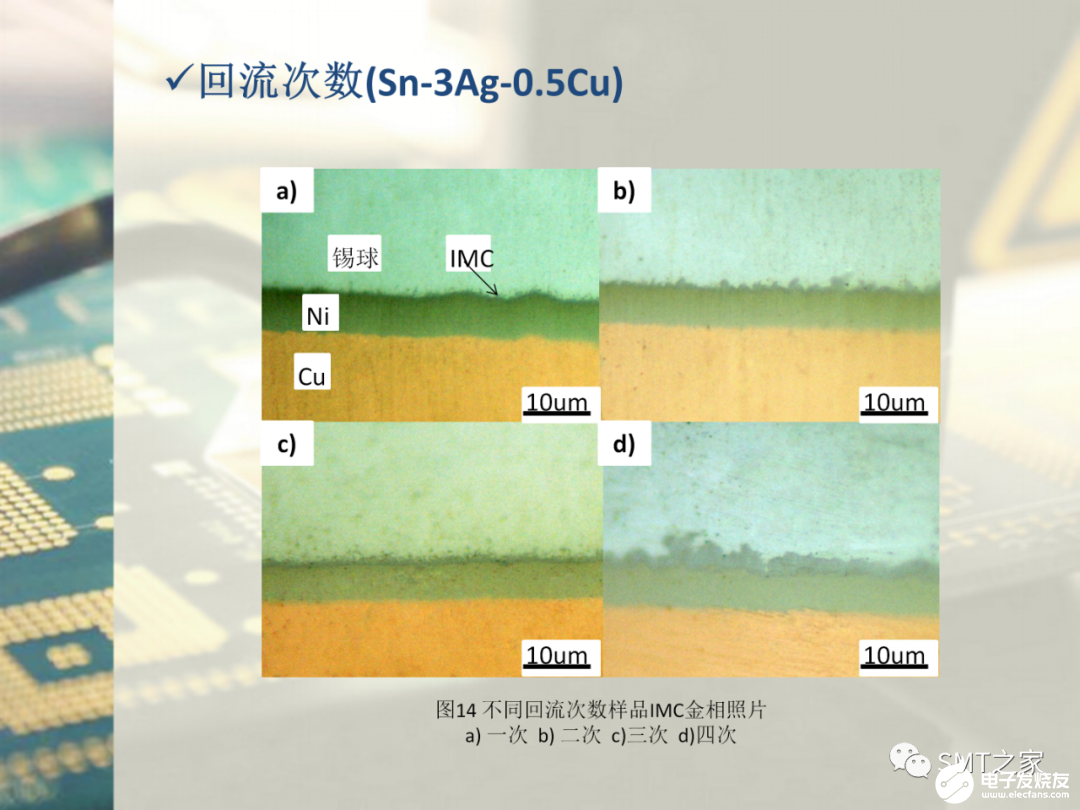
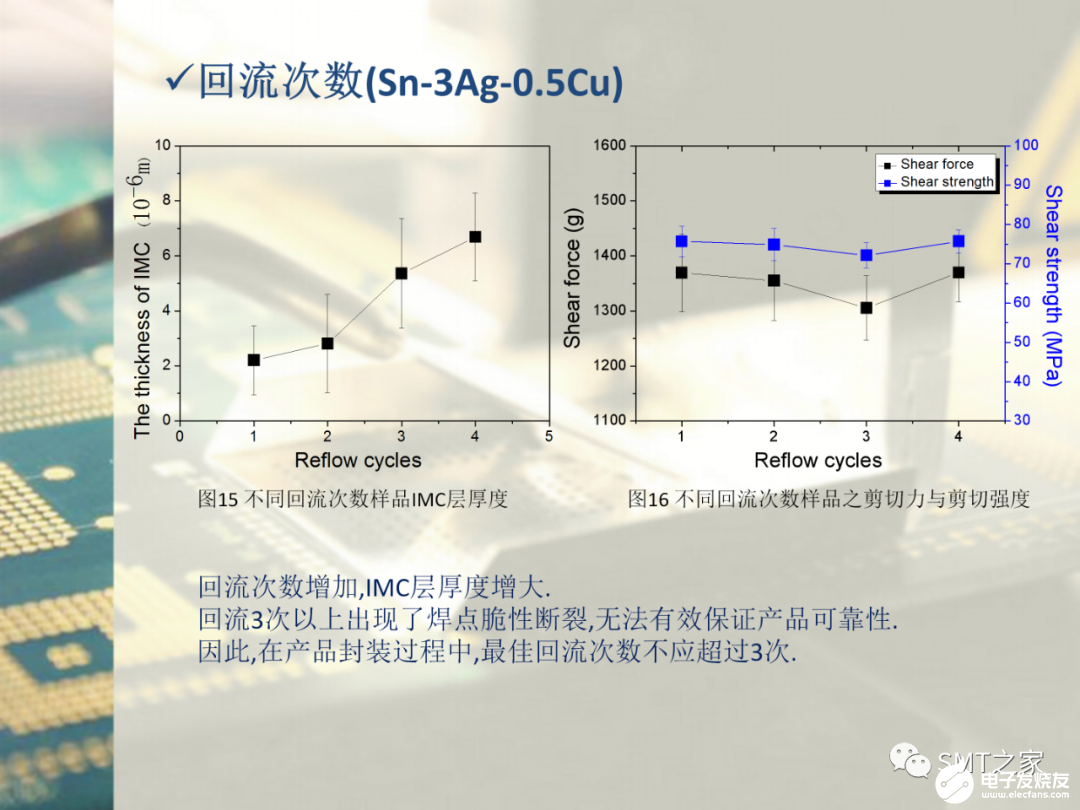
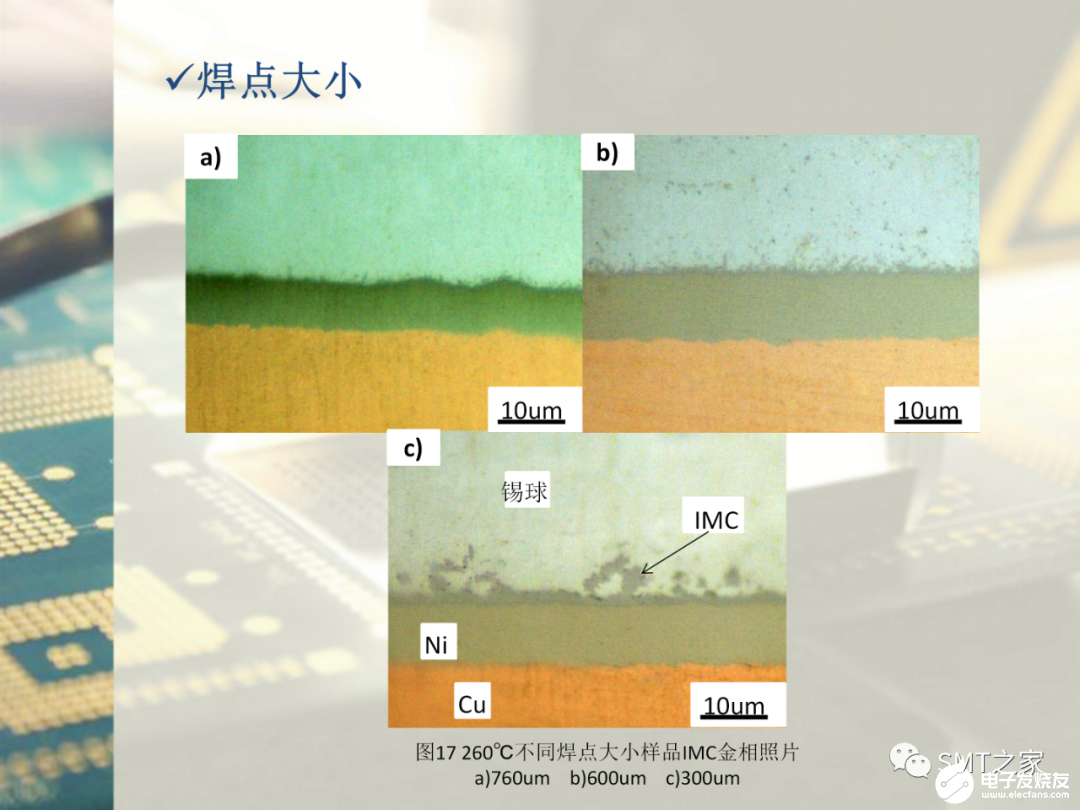
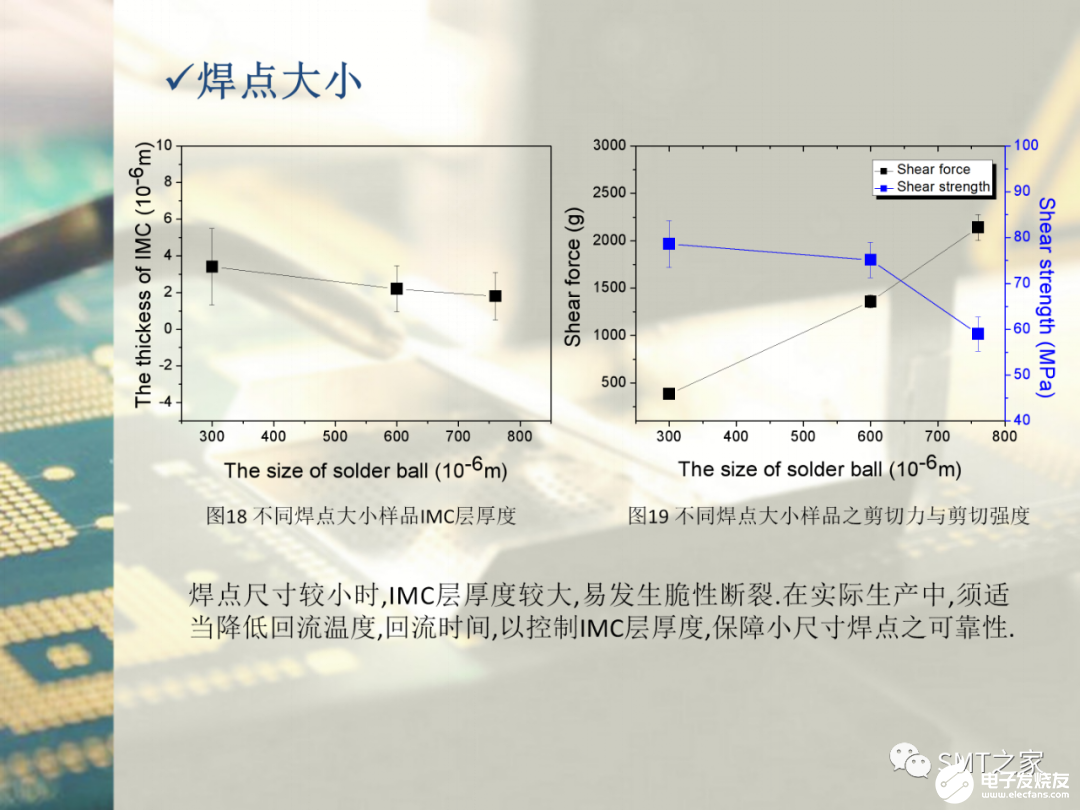



审核编辑 黄宇
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
焊锡
+关注
关注
0文章
325浏览量
19609 -
BGA
+关注
关注
5文章
581浏览量
50964 -
IMC
+关注
关注
1文章
31浏览量
5103
发布评论请先 登录
相关推荐
热点推荐
BGA芯片阵列封装植球技巧,助力电子完美连接
紫宸激光焊锡应用ApplicationofVilaserSoldering高效节能绿色环保行业领先BGA(BallGridArray,球栅阵列封装)芯片植球是电子元器件焊接领域中的一项

紫宸激光锡球焊锡机:点亮芯片0.07mm激光植球新征程
、核心需求、及技术突破等角度,解析激光微植球技术的应用。一、芯片植球行业背景芯片植球行业主要涉及半导体制造中的高密度表面安装封装技术,包括晶圆植球机和BGA(

紫宸激光植球技术:为BGA/LGA封装注入精“芯”动力
LGA和BGA作为两种主流的芯片封装技术,各有其适用的场景和优势。无论是BGA高密度植球还是LGA精密焊接,紫宸激光的植球设备均表现卓越,速度高达5点/秒,良率超99.98%,助力您大


基于硅基异构集成的BGA互连可靠性研究
在异构集成组件中,互连结构通常是薄弱处,在经过温度循环、振动等载荷后,互连结构因热、机械疲劳而断裂是组件失效的主要原因之一。目前的研究工作主要集中在芯片焊点可靠性上,且通常球形栅格阵列(Ball

影响激光焊锡膏较佳状态的因素
激光焊锡膏的较佳温度和时间对于焊接质量有着至关重要的影响。根据我们的实验和研究,较佳的激光焊锡膏温度和时间取决于多个因素,如焊锡膏的成分、被焊接材料的种类和厚度,以及焊接环境的条件等。

BGA封装焊球推力测试解析:评估焊点可靠性的原理与实操指南
成为评估焊接质量的重要手段。科准测控小编将详细介绍BGA焊球推力测试的原理、标准、仪器及测试流程,帮助工程师和研究人员掌握科学的测试方法,确保产品的可靠性。 一、检测原理 BGA焊

BGA焊盘翘起失效的六步修复法与干胶片应用指南
1. BGA焊球桥连的常见原因及简单修复方法 修复方法: 热风枪修复:用245℃热风枪局部加热桥连区域,再用细尖镊子轻轻分离焊球。 吸锡线处理:若桥连较轻,可用吸锡线配合
X-Ray检测助力BGA焊接质量全面评估
BGA焊接质量评估的挑战 BGA是一种高密度封装技术,其底部排列着众多微小的焊球,焊接后焊球被封装材料覆盖,传统光学检测难以发现内部缺陷。这使得BG
深度解析激光锡焊中铅与无铅锡球的差异及大研智造解决方案
。大研智造作为激光焊锡行业的领军企业,深入了解这些差异,并凭借先进的激光焊锡机技术,为不同客户需求提供精准的焊接解决方案。本文将详细剖析有铅锡球和无铅锡球的区别,并结合大研智造激光
罗彻斯特电子针对BGA封装的重新植球解决方案
BGA焊球的更换及转换, 以实现全生命周期解决方案的支持 当BGA封装的元器件从含铅转变为符合RoHS标准的产品时,或者当已存储了15年的BGA产品在生产线上被发现存在焊

铜线键合IMC生长分析
铜引线键合由于在价格、电导率和热导率等方面的优势有望取代传统的金引线键合, 然而 Cu/Al 引线键合界面的金属间化合物 (intermetallic compounds, IMC) 的过量生长将增大接触电阻和降低键合强度, 从而影响器件的性能和可靠性。

从原理到检测设备:全方位解读球栅阵列(BGA)测试流程
近期,小编接到一些来自半导体行业的客户咨询,他们希望了解如何进行球栅阵列(BGA)测试,包括应该使用哪些设备和具体的操作方法。 球栅阵列(BGA)作为电子封装技术的一种,具有高密度、高

BGA芯片底填胶如何去除?
BGA芯片底填胶如何去除?BGA(BallGridArray,球栅阵列)芯片底填胶的去除是一个相对复杂且需要精细操作的过程。以下是一些去除BGA芯片底填胶的详细步骤和注意事项:一、准备






 BGA小焊锡球与IMC生长研究(PPT)
BGA小焊锡球与IMC生长研究(PPT)

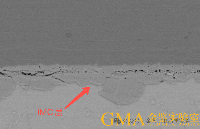










评论