半导体消耗的功率会产生热量,必须从器件中去除热量,但如何有效地做到这一点是一个越来越大的挑战。
热量是半导体的废物。它是在设备中和电线上的功率耗散时产生的。当设备切换时会消耗电力,这意味着它依赖于活动,并且功率不断被不完善的设备和电线浪费。设计很少是完美的,一些热量来自执行不需要的功能的活动。但在某些时候,设计团队必须弄清楚如何摆脱热量,因为如果他们不这样做,产品的使用寿命将非常短。
只有三个过程控制着热量的传递——传导、对流和辐射。简单来说,传导适用于固体,对流适用于液体和气体,辐射适用于真空,这在半导体中很少。
“热量有三个步骤,”Ansys半导体部门营销总监Marc Swinnen说。“有生产、传导和耗散。你产生热量,你把它传导到某个地方,然后消散它。功率分析告诉您热量的产生位置。传导和耗散是一种物理分析,包括流体学。这三者都必须包含在系统分析中,因为它们之间存在反馈。
随着晶体管密度的增加,这变得更加困难。“大多数人都可以改变导电路径,”Cadence 多物理场系统分析小组摄氏热求解器产品工程师 Karthick Gopalakrishnan 说。“有可能改进材料和设计本身,通过散热设备的传导带走更多的热量。有一个挑战,因为除非我们使用大型服务器,否则这些设备周围的热空间非常小。您必须考虑材料改进,智能地利用芯片、封装或 PCB 周围的热空间。你真正想做的是提高你的传导传热率。
如果不进行适当的分析,仅仅在设备上放置一个大散热器就会导致额外的问题。要做到这一点,需要考虑气流及其所在空间的机械设计,以便考虑对其他设备的影响。
即使是散热器也有局限性。“有很多方法可以消除系统中的热量,例如强制液体冷却,”Synopsys EDA Group 产品管理总监 William Ruby 说。“我们看到一些更先进的封装取得了许多进步。借助 3D-IC 设计,可以实现强制气流和液体冷却。有一些更新的概念,能够通过特殊的通孔来减轻热量,以帮助传播热量。
与导体和绝缘体之间存在数量级差异的电导率不同,导热性在某种程度上受到限制。“硅的电导率为每米开尔文 (W/(m x K) 100 至 120 瓦,作为导热材料还不错,”Siemens Digital Industry Software 旗下 Simcenter 产品组合电子和半导体行业总监 John Parry 说。“铜只有400,而铜通常被用作经济上最好的热导体。
还有其他经济考虑。“数据中心的主要成本驱动因素不是散热方法的成本,而是管理数据中心级传热的运营成本,”Arm 系统集成与开发研究员兼高级总监 Javier DeLaCruz 说。“进入数据中心的电力量是有限的,这些电力在为计算系统供电和提取热量之间共享。因此,每瓦性能必须是衡量指标,而不仅仅是性能。
热量会对性能产生重大影响。“即使遵循最佳散热策略,每个芯片在电路运行期间也会以不同的方式发热,从而降低性能,”Keysight EDA 产品经理 How-Siang Yap 说。“动态温度可以改变器件的电气特性,如增益、阻抗和负载牵引失配,以及更高级别的波形特性,如数字调制信号射频电路中的误差矢量幅度(EVM)和邻道漏电比(ACLR)。在模拟系统中,冲击损失可能更高。
分析并不容易。Ansys的Swinnen表示:“当今的芯片非常复杂,很难定义如何创建活动来显示最坏的情况。“当你看到由温度引起的计时误差时,你看到的是纳秒,最多几微秒。其次,电参数和热参数的时间常数非常不同,至少两个数量级。当你得到开花的热量时,它会慢慢地通过芯片和隔壁消散,所以你会看到热量增加,因为两秒钟前在隔壁街区发生的事情。
芯片
内的热量分布 热量倾向于向各个方向传播。“你无法真正阻止热量蔓延到任何地方,”西门子的帕里说。“你可以哄骗它,但它与电气世界非常不同,在电气世界中,导体和绝缘体之间的电导率差异可能是20、21个数量级。在电气上,你可以让电流流向你想要的地方,但在热上,你真的不能。
由于热量取决于活动,因此芯片表面的温度不恒定、均匀分布。“你可能有一个热点,由设计的计算密集型部分创建,比如硬件加速器,”Synopsys的Ruby说。“芯片的另一部分可能不太活跃,或者只用于特定的操作模式。芯片上的温度梯度取决于工作负载或活动。
散热在理论上很简单,但在实践中却要困难得多。“你希望通过尽可能多地将热量分散到任何层来最大限度地减少热点,”Cadence 的 Gopalakrishnan 说。“你必须考虑东西放在哪里。将某些东西移动到模具的边缘并不总是可行的,因为在那里你不会让热量向一个方向扩散。
虽然你可能无法控制热量,但你可以理解它是如何传播的。“如果你对流过芯片上电线的电流进行建模,并观察由此产生的热通量,那么在它们合并在一起之前,它不会走得太远,”Parry说。“你可以看看温度曲线,这并没有真正显示出走线和它们之间的绝缘体之间的差异。如果您查看温度曲线,您将几乎无法检测到金属痕迹的位置。但如果你看一下热通量,金属中的热通量比绝缘体中的热通量高出几个数量级。
这让事情变得容易一些。“在对很多这些东西进行建模时,它使事情变得更容易,”Parry补充道。“你可以得到相当准确的结果,而不是对芯片表面的单个导线、金属化层进行建模,而只是使用平均的材料属性,这是一件非常普遍的事情。”
一种有效的技术是利用热感知的楼层规划和单元放置。“基本思想是进行放置以最小化峰值温度和温度梯度,”Ruby说。“使用物理感知的 RTL 功耗分析工具,您可以分析初始布局,然后将该功耗曲线数据输入到热分析中。也就是说,从基于最终签核或完成的物理实施进行分析向左移动,这可能为时已晚,无法开始更改宏观平面图。我们还可以查看通孔密度、凸块密度和不同的金属密度等因素。
对于 3D-IC,TSV 已被讨论为创建热走廊的一种方式。“更好的 TSV 放置会有所帮助,”Gopalakrishnan 说。“但这是有限度的,因为它们确实占用了宝贵的房地产。在平面规划方面,无论是在芯片层面,还是在芯片层面,无论是在讨论瓷砖、电源块或功能单元时,还是在尝试添加 TSV 的路由层面,都有很大的潜力。对他们来说,最大的优势之一是,当你在靠近芯片或电源的地方工作时,你可以瞄准热点。
但影响是有限的。“它们在某种程度上被用作热走廊,但如果你认为它们是铜,它们的导电性只有它们所穿过的硅的四倍,”帕里说。“考虑一个 10×10 的单元,每个角落都有一个 TSV。这是 4/100。由于 TSV 的电导率仅为它们所通过的硅的四倍,因此芯片的有效电导率可能增加了 16%。它在热上没有太大的影响,虽然它们确实有帮助,但它不是灵丹妙药。
另一种新兴技术是背面供电。“背面电源有助于供电,但使散热更具挑战性,”DeLaCruz 说。“块状硅以前是局部散热的绝佳机制,现在已经从大约800微米的厚度发展到只有一微米的厚度,这使得局部热点更难管理。TSV 并没有使热管理更容易,它们只是让它变得不同,因为 TSV 以一种非常局部的方式提供帮助,并且仅在垂直于晶体管的轴上提供帮助。TSV周围的氧化物衬里也阻碍了横向热能耗散。
3D 增加了新的热问题。“如果你想到模具之间的胶层,这是很常见的,它们的目的是将模具机械地固定在一起,”Parry说。“你需要一定的厚度。否则,芯片之间互连的剪切力太高,并且会出现电气破损。不幸的是,与硅芯片相比,这些胶层是一种相对较软的材料,并且往往具有相对较低的导热性。您需要在热和机械之间进行权衡。在热学上,您希望该层尽可能薄,以使通过该层的热传导尽可能有效。从机械上讲,你希望有一个厚层,因为这样可以让你承担两个模具之间位移的不匹配,而中间的材料剪切相对较少。
芯片
外部的热量分布 热量可以通过封装顶部逸出,然后可能进入散热器,或者通过底部和它所连接的PCB逸出。“如果你有一个塑料包覆成型的BGA,那么你将把绝大多数(80%到90%)的热量投入到电路板中,”Parry说。“如果你有一个包装,有一个非常好的传导路径到盖子,你可能会安排80%到90%的热量以这种方式传播。您可以控制它,具体取决于您采取的打包方法,但不能完全控制它。有些人总是走另一条路。
您希望热量流向何处是特定于应用的。“在服务器中,软件包周围有很多空间可以利用,”Gopalakrishnan说。“你倾向于用主动或被动散热器来填充它,以及有助于散发大量热量的风扇。PCB本身不会在散热方面发挥重要作用。当您使用移动设备时,这不是一个解决方案,因为可能大约一半的热量通过底部,其余一半到达顶部。在这种情况下,PCB将在将热量从芯片上散发出来方面发挥重要作用。
当空间有限时,它变得更加困难。“根据具体市场的不同,有不同的方法可以实现这一目标,”Arm 的 DeLaCruz 说。“例如,在智能手机中,石墨或石墨烯薄膜等高导电薄膜的使用很普遍,因为系统中的体积最小且散热有效。在基础设施领域,使用主动和被动3D均热板可以运行到数百瓦的功率范围内。
液体冷却是另一种可能性。“对流是我们最近看到很多进展的地方,”Gopalakrishnan说。“你有风扇、液体冷却和两相系统。我们还拥有先进的系统,例如数据中心级别的浸没式冷却。你会看到很多设计工程师和制造设备和系统的公司的路线图,他们正在将液体冷却作为路线图的一部分。这是因为,如果您只是在设备上添加一个散热器并期望它冷却,那么当您的散热量超过每平方米 1 千瓦时,它就会达到该限制。使用风扇,每平方米约 10 千瓦。但是现在我们有每平方米1兆瓦的先进服务器设备芯片。你真的必须探索这些策略。
不是每个人都认为它会很快被采用。“虽然我们预计液体冷却将发生在超级计算集群等专业部署中,但它不太可能广泛扎根,”Ampere Computing产品副总裁Madhu Rangarajan说。“对于芯片设计人员来说,在创造新技术时,必须考虑到实际的基础设施限制,并与系统设计人员和数据中心设计人员合作,推动他们进行广泛部署。我们预计,未来五年部署的大多数 CPU 仍将需要以有效的 TCO 方式进行风冷。
模型和分析
热可能是第三方小芯片市场的绊脚石之一,因为小芯片需要热模型。“单个小芯片实际上不能彼此孤立地设计,”Parry说。“每个人都需要了解其邻居模具上的热源。在开发这些高密度先进封装设计时,需要更多的协作。这些东西的开发方式必须改变,以使设计易于处理。
创建模型并不简单。“在芯片热模型中,有很多事情是你真的不想透露的,”Gopalakrishnan说。“有人试图以降阶模型的形式添加自热效应、芯片的热阻特性,或者某种近似值,不一定涉及知道芯片中存在的每一个几何细节的人。目前,其中一些芯片模型就是这样生成的。
工具也需要改变。“3D-IC的世界是综合模型的世界,需要进行基于模型的分析,”Ruby说。“你不能像我们今天那样把所有事情都做平。在单芯片上,我们在网表级别进行时序签核和电源签核。在3D-IC环境中,它可能变得不切实际,因此我们需要开始研究对各种组件进行建模。
最终,它将设计和包装结合在一起。“您需要将芯片设计工作流程与封装设计工作流程相结合,”Parry说。“你不能把它们看作是先于另一个发生的,即芯片被交给一个封装组,特别是在3D-IC中。但它在某种程度上适用于2.5D。挑战在于采用我们所拥有的仿真技术类型,这种技术传统上由封装工程师使用,可能来自机械背景,并将其作为IC设计流程的一部分提供给进行IC验证的人员。他们可能不习惯使用机械工程师使用的工具集。这是一个采用技术并重新包装的案例,以便需要在设计流程中使用它的人可以使用它。
结论
许多芯片面临热障,解决问题并不容易。“不幸的是,热是集成密度的限制因素,”Swinnen说。“我们可以设计和制造令人难以置信的芯片,只是它们会熔化。这不是制造限制,也不是设计限制。这是一个物理限制,我们无法获得更多的热量。
虽然在某些应用中可以使用异国情调的解决方案,但大多数市场必须找到事半功倍的方法,这意味着每瓦特的功能更多。与此相关的成本比过去的解决方案要大得多。
审核编辑:黄飞
-
芯片设计
+关注
关注
15文章
1128浏览量
56429 -
晶体管
+关注
关注
78文章
10245浏览量
146209 -
数据中心
+关注
关注
16文章
5515浏览量
74627 -
BGA
+关注
关注
5文章
581浏览量
50867 -
射频电路
+关注
关注
36文章
445浏览量
44578
发布评论请先 登录
浅析FPGA芯片中丰富的布线资源
如何吧项目实现在FPGA芯片中

芯片中的CP测试是什么?






 如何助力摆脱芯片中的热量
如何助力摆脱芯片中的热量

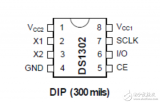


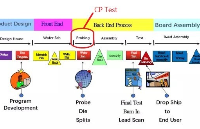











评论