有图晶圆关键尺寸及套刻量测系统可对Wafer的关键尺寸进行检测,对套刻偏移量的测量,以及Wafer表面3D形貌、粗糙度的测量,包括镭射切割的槽宽、槽深等自动测量。300*300mm真空吸附平台,最大可支持12寸Wafer的自动测量,配置扫描枪,可实现产线的全自动化生产需求。
一.系统的布局结构1. 上料/下料区:Robot自动抓取Wafer至寻边器平台;2. 定位区:寻边器对Wafer自动轮廓识别,旋转校正到设定姿态;3. 测量区:自动测量平台,包含2D和3D测量模组,内部有温湿度监控及除静电装置。 1.上下料区:Robot自动上下料
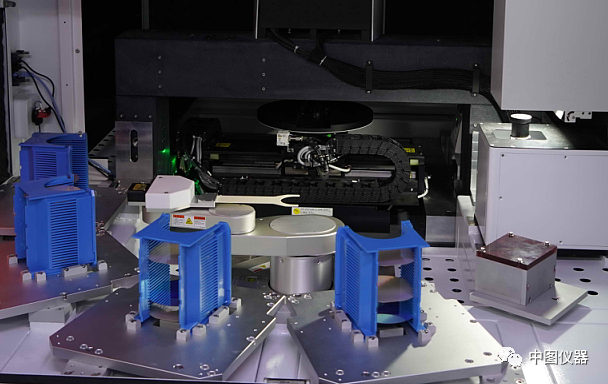
Robot自动上下料
2.定位区:寻边器自动识别出wafer轮廓,旋转校正到设定姿态
 Robot将Wafer放在寻边器上
Robot将Wafer放在寻边器上

自动识别出wafer轮廓
3. 测量区:自动测量平台
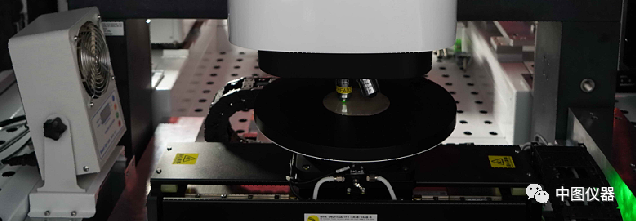
自动测量平台
二.应用案例
1.Wafer关键尺寸、套刻偏移量测量
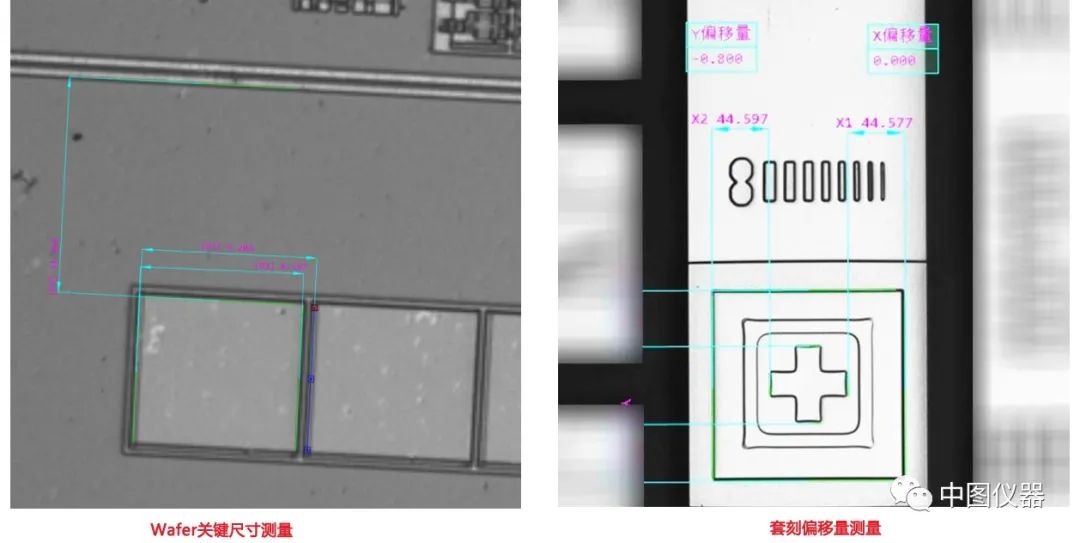
2.镭射切割槽测量
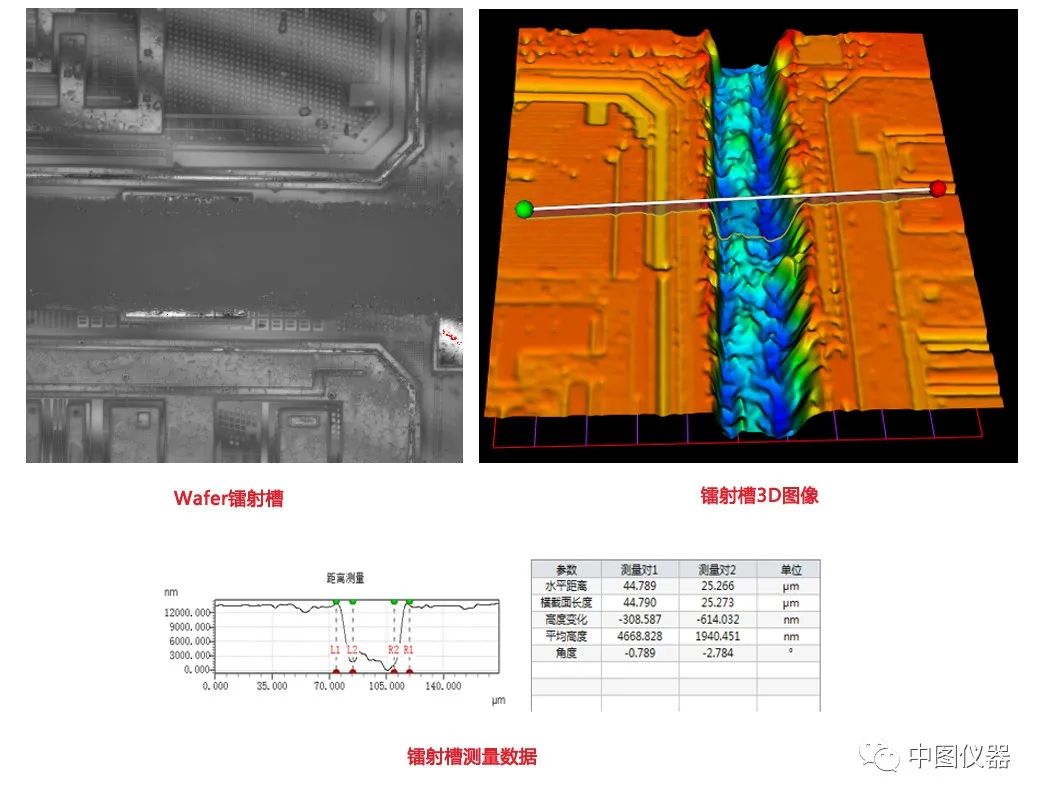
3.表面粗糙度测量

声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
监测系统
+关注
关注
8文章
3112浏览量
84709
发布评论请先 登录
相关推荐
热点推荐
半导体制造中晶圆清洗设备介绍
在半导体制造过程中,晶圆清洗是一道至关重要的工序。晶圆经切割后,表面常附着大量由聚合物、光致抗蚀剂及蚀刻杂质等组成的颗粒物,这些物质会对后续工序中芯片的几何特征与电性能产生不良影响。随

EV Group实现在芯粒集成混合键合套刻精度控制技术重大突破
全新EVG®40 D2W套刻精度计量系统实现每颗芯片100%测量,吞吐量达行业基准15倍 2025年9月8日,奥地利圣弗洛里安 ——全球领先的先进半
瑞乐半导体——TC Wafer晶圆测温系统在半导体行业的应用场景
TCWafer晶圆测温系统凭借其卓越的性能指标和灵活的配置特性,已在半导体制造全流程中展现出不可替代的价值。其应用覆盖从前端制程到后端封装测试的多个

wafer晶圆厚度(THK)翘曲度(Warp)弯曲度(Bow)等数据测量的设备
测量。
(2)系统覆盖衬底切磨抛,光刻/蚀刻后翘曲度检测,背面减薄厚度监测等关键工艺环节。
晶圆作为半导体工业的“地基”,其高纯度、单晶结构
发表于 05-28 16:12



 有图晶圆关键尺寸及套刻量测系统助力半导体产业发展
有图晶圆关键尺寸及套刻量测系统助力半导体产业发展















评论