划片刀(Wafer Saw) 主要由电铸镍基结合剂、金刚石/类金刚石等硬质颗粒组成。切割时由主轴带动刀片高速旋转获得高刚性,从而去除材料实现切割。由于刀片具有一定的厚度,要求划片线宽较大。金刚石划片刀能够达到的最小切割线宽为 25~35um。切割不同材质、厚度的晶圆,需要更换不同的刀具。在旋转砂轮式划片过程中,需要采用去离子水对刀片进行冷却,并带走切割后产生的硅渣碎屑。
今天__【科准测控】__小编就来详细科普一下半导体集成电路划片刀知识!
半导体划片刀示意图
1、划片刀结构特点
划片刀表面粗粘,有凸起的硬质颗粒和刀口,如图 2-15 所示。普通刀具,刀尖表面较为光滑,刃部尖锐,刀尖与水平面的夹角 较大;而划片刀的刀尖表面粗糙,刃部近似矩形,与水平面的夹角日接近0°,如图 2-16 所示。
2、高速转动
普通刀具利用锋锐尖端在物体表面施加集中应力,可直接分裂物体进行切割。划片刀与普通刀具不同。因为本身结构、材质特性,在静态或低速转动时,划片刀无法实现切割,必须高速旋转获得高刚度,从而以碾碎去除材料的形式实现切割(见图2.17)。在这种切割方
式下,金刚石刀片以3000~40000r/min的高转速切割晶圆划片槽。同时,承载着晶圆的丁作台以一定的速度沿刀片与晶圆接触点的切线方向呈直线运动,切割晶圆产生的硅屑被去离子水冲走。
3、刀口
刀口是经磨刀后在刃部形成的,由顺刀方向硬质颗粒及其与结合剂尾端间的细微凹槽或空洞组成(见图2-18),其根据刀片配方不同而变化。刀口具有排屑和冷却的作用,刀口的存在使刀片切割能力得以维持。
表2-3给出了3种划片刀刀刃材质参数,包括刀刃的磨料粒度号、浓度和结合剂强度。图2-19给出了基于镍基结合剂的金刚石划片刀刀刃扫描电镜(SEM)图。
4、划片刀切割机理
图 2-20 给出了划片刀切割机理示意。
1.撞击
切割硅等硬脆性材料时,刀片依靠高速旋转使金刚石等硬质颗粒高频撞击晶圆,在表面形成微裂纹,压碎后利用刀口将碎屑带走。
- 刮除
切割延展性金属材料时,刀口持续刮擦物体表面,将表面拉毛,刮除,并将碎屑排除。
硬质颗粒的撞击和刀口的刮擦使材料能够从物体表面剥离,同时刀口能够将碎屑及时排除。这两者协同作用以保持物体表面材料被持续剥离,达到切割的效果。
为了使去除的材料尽可能少,那么使用的划片刀越薄越好。但是,如果划片刀太薄,在切削过程中又很容易变形,导致加工质量变差甚至损坏工件。一般切割硅晶圆的刀片突出刃长度与硅晶圆厚度关系如表2-4所示。
5、刀刃与线宽
划片线宽指的是使用划片刀切割晶圆所需破坏的线条宽度尺寸,是划片工艺的特征尺寸,表征着划片工艺的技术水准。影响线宽的主要因素有以下三个∶
- 刀片厚度。
- 崩边尺寸。
3)扩展尺寸。
图2-21给出了划片刀具与划片线宽的关系图。划片线宽与主要因素之间的关系如下:
W=t刀片+2W崩边+2W扩展
式中,W为划片线宽;t刀片为刀片尺;W崩边为崩边尺寸;w扩展为毛刺扩展区域尺寸。
6、刀片磨损
基于刀片切割运动形式(高速旋转、水平进给)及工作环境(去离子水及添加剂),刀片主要受以下作用影响:
- 机械应力,法向、切向压力及切屑的摩擦力。
2)热应力,摩擦导致的温升热应力。
3)化学腐蚀,切割水酸碱度(pH值)及化学物质反应。
在一般情况下刀片连续切割,主要考虑机械应力导致的磨损。划片刀的组成、结构特点、运动模式和工作环境,决定刀片磨损主要为硬质颗粒断裂和结合剂磨耗两种模式。
1.断裂
硬质颗粒在长期的撞击之下,某些颗粒会破裂而磨损,如图2-22所示。
- 磨耗
切割时,硬质颗粒外包裹的结合剂也会因磨损而越来越少,当结合剂减少到某种程度,不足以再承受切割物体和切屑的作用力时,硬质颗粒会自然脱落(见图2-23),暴露出新的颗粒,形成新的刀口。
可以说,刀片在磨损的同时也是再生的过程。硬质颗粒断裂可在断裂面形成一些锐角,使刀片能够继续维持在锋利的状态,硬质颗粒会自然脱落,暴露出新的颗粒,形成新的刀口。在刀片和被切物之间,通过参数维持适当的磨损可使刀片保持相对稳定的切屑力。
研究表明,刀具在划片过程中的磨损可以分为两个阶段。第一个是过渡阶段,切割距离在0300m,划片缝宽度、刀具磨损率和表面粗糙度迅速增加。第二个是稳定阶段,切割距离在3002000m,刀具磨损率缓慢增长,划片缝宽度和表面粗糙度缓慢降低。这是由于,在过渡阶段,金刚石与刀片粘结较少的砂粒首先脱落,留下空穴,刀具表面粗糙度上升,并导致较大的切屑尺寸。在稳定阶段,大多数砂粒均匀地嵌入结合剂中,因此磨损均匀。因此,叶片的粗糙度趋于稳定。这两个阶段的划片机制是不同的,在过渡阶段,金刚石砂粒的冲击和摩擦力主导切割在稳定阶段,晶圆靠金刚石摩擦力切割。图2-24~图2-26分别给出了划片缝宽度、刀具磨损率、刀具表面粗糙度与切割距离的关系。
以上就是小编给大家分享的半导体集成电路划片刀的科普知识了,包含划片刀原理、特点、划片刀切割机理、刀片磨损原因等,十分详细!如果您对半导体集成电路、芯片,推拉力测试机等存在疑惑,欢迎给我们私信或留言,科准测控的技术团队会免费为您解答疑惑!更多精彩内容,我们下一期再见!
审核编辑 黄宇
-
半导体
+关注
关注
339文章
31203浏览量
266364 -
测试机
+关注
关注
1文章
274浏览量
14261
发布评论请先 登录
晶圆划片机怎么选?半导体切割必看这 5 点

划片机是什么?工作原理、应用行业与选购要点全解

6-12 英寸晶圆切割|博捷芯划片机满足半导体全规格加工

打破国外垄断:微米级精密划片机撑起半导体后道封装“国产化脊梁”

硅片划片机破解硬脆材料崩边难题,助力半导体器件封装降本增效
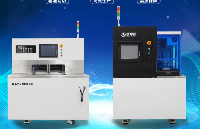
半导体精密划片机:QFN封装切割工序的核心支撑

博捷芯精密划片方案赋能MEMS传感器与光电器件制造




 半导体划片刀原理、特点以及刀片磨损原因等知识分享!
半导体划片刀原理、特点以及刀片磨损原因等知识分享!








评论