平面互补场效应晶体管替代金属栅工艺流程从平面 CMOS 45nm/ 32nm 节点开始,Intel 公司率先成功使用替代金属栅(Replacement - Metal - Gate, RMG) 工艺(又称后栅工艺),实现了高K氧化铪栅介质 ( 减小栅泄漏电流) 和金属栅(较低栅电阻),如图所示。

该工艺是指在形成层间介质层(ILD)后,插入工序以形成高k介质和金属栅叠层,即在化学机械抛光(露出多晶硅栅叠层)后,刻蚀掉硬掩模(氮化硅/氧化硅),利用干法或湿法刻蚀清除多晶硅;然后形成高k介质(IL-ox/氧化铪),接下来进行退火 一 沉积 TiN 覆盖层 一 退火 一 沉积非晶硅覆盖层 一 尖峰退火 一 湿法清除非晶硅 一 沉积 TaN(刻蚀阻挡层)和p型功函数层(p-WF, TiN) 一 掩模(开nFET) 一 刻蚀 P-WF (TiN) 一 光刻胶去除 一 沉积n型功函数层(TiAI) 一 栅金属层填充(CVD 或溅射钛,铝或钨)。其他工序与文章-1的相同。
审核编辑 :李倩
-
CMOS
+关注
关注
58文章
6190浏览量
241594 -
多晶硅
+关注
关注
3文章
249浏览量
30527 -
晶体管
+关注
关注
78文章
10264浏览量
146327 -
场效应晶体管
+关注
关注
6文章
401浏览量
20364 -
刻蚀
+关注
关注
2文章
217浏览量
13684
原文标题:CMOS工艺 - 2
文章出处:【微信号:Semi Connect,微信公众号:Semi Connect】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
一文让你秒懂场效应晶体管的所有参数
场效应晶体管的选用经验分享
MOSFET和鳍式场效应晶体管的不同器件配置及其演变
场效应晶体管的分类及使用
什么是场效应晶体管
功率场效应晶体管的工作特性
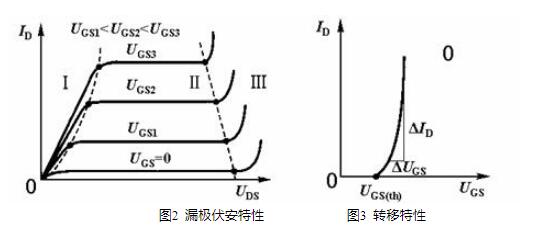
如何进行场效应晶体管的分类和使用






 平面互补场效应晶体管替代金属栅工艺流程
平面互补场效应晶体管替代金属栅工艺流程














评论