日月光半导体宣布FOCoS(Fan Out Chip on Substrate)扇出型基板上芯片封装技术的最新进展,FOCoS为业界创新的系统级封装整合技术,是VIPack垂直互连整合封装平台的6大核心封装技术之一员,包含两种不同的工艺流程:Chip First (FOCoS-CF)和Chip Last(FOCoS-CL),提供卓越的板级可靠性(board level reliability)和电气性能,可以满足网络和人工智能应用整合的需求,提供更快、更大的数据吞吐量以及更高效能的运算能力。FOCoS产品组合(FOCoS-CF和FOCoS-CL)这两种解决方案都可将不同的芯片和覆晶组件封装在高脚数BGA基板上,从而使系统和封装架构设计师能够为其产品战略、价值和上市时间,设计出最佳的封装整合解决方案,满足市场需求。
随着高密度、高速和低延迟芯片互连的需求不断增长,FOCoS解决方案突破了传统覆晶封装的局限性,可将多芯片或多个异质小芯片(Chiplet)重组为扇出模块(Fan Out Module)后,再置于基板上,实现封装级的系统整合。其中FOCoS-CF解决方案利用封胶体(Encapsulant)整合多个小芯片再加上重布线层RDL(Redistribution Layer)的工艺流程,有效改善芯片封装交互作用(Chip Package Interaction , CPI),在RDL制造阶段降低芯片应力上的风险及提供更好的高频信号完整性,还可改善高阶芯片设计规则,通过减少焊垫间距提高到现有10倍的I/O密度,同时可整合来自不同节点和不同晶圆厂的芯片,把握异质整合的商机。FOCoS-CL方案则是先分开制造RDL,再整合多个小芯片的工艺流程,有助于解决传统晶圆级工艺流程因为RDL的不良率所造成的额外芯片的损失问题,数据显示FOCoS-CL对于整合高带宽内存(High Bandwidth Memory, HBM)特别有效益,这也是极其重要的技术领域,能够优化功率效率并节省空间,随着 HPC、服务器和网络市场对 HBM 的需求持续增长,FOCoS-CL提供的性能和空间优势会越来越明显。
值得强调的是FOCoS封装技术的小芯片整合,可整合多达五层的重布线层(RDL)互连,具有L/S 为1.5/1.5µm的细线/距以及大尺寸的扇出模块(34x50mm²)。还提供广泛的产品整合方案,例如整合高带宽内存(HBM)的专用集成电路(ASIC),以及整合串化器/解串化器(SerDes)的ASIC,可广泛应用于HPC、网络、人工智能/机器学习(AI/ML)和云端等不同领域。此外,由于不需要硅中介层(Si Interposer)并降低了寄生电容,FOCoS展现了比 2.5D硅通孔更好的电性性能和更低的成本。
日月光研发副总洪志斌博士表示:"FOCoS-CF/-CL的特殊处,在于能够通过扇出技术扩展电性连接来优化多芯片互连整合,同时实现异质和同质整合,将多个独立小芯片整合在一个扇出型封装中。这是业界首创的创新技术,为我们的客户在满足严格的微型化、高带宽、低延迟和陆续发展的设计和性能需求上,提供相当大的竞争优势。"
日月光销售与营销资深副总Yin Chang说:"小芯片的架构是目前半导体产业发展趋势,这种架构需要变革性的封装技术创新来满足关键的功率和性能要求。作为产业领导者,日月光通过VIPack平台提供包括FOCoS-CF和FOCoS-CL在内的系统整合封装技术组合,协助实现 HPC、人工智能、5G和汽车等重要应用。"
FOCoS-CF和FOCoS-CL是日月光在VIPack平台提供的先进封装解决方案系列之一, VIPack是一个根据产业蓝图协同合作的可扩展平台。
-
封装
+关注
关注
128文章
9139浏览量
147862 -
COS
+关注
关注
1文章
24浏览量
20344 -
日月光
+关注
关注
0文章
157浏览量
20078
原文标题:日月光VIPack™平台系列最新进展FOCoS技术
文章出处:【微信号:ASE_GROUP,微信公众号:ASE日月光】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
芯科科技分享在物联网领域的最新进展
强强合作 西门子与日月光合作开发 VIPack 先进封装平台工作流程

东风汽车转型突破取得新进展
日月光最新推出FOCoS-Bridge TSV技术
英特尔持续推进核心制程和先进封装技术创新,分享最新进展

百度在AI领域的最新进展
谷歌Gemini API最新进展
京东方华灿光电氮化镓器件的最新进展
翱捷科技在5G领域的最新产品进展
汽车结构件焊接技术进展与应用分析
日月光2024年先进封测业务营收大增
垂直氮化镓器件的最新进展和可靠性挑战
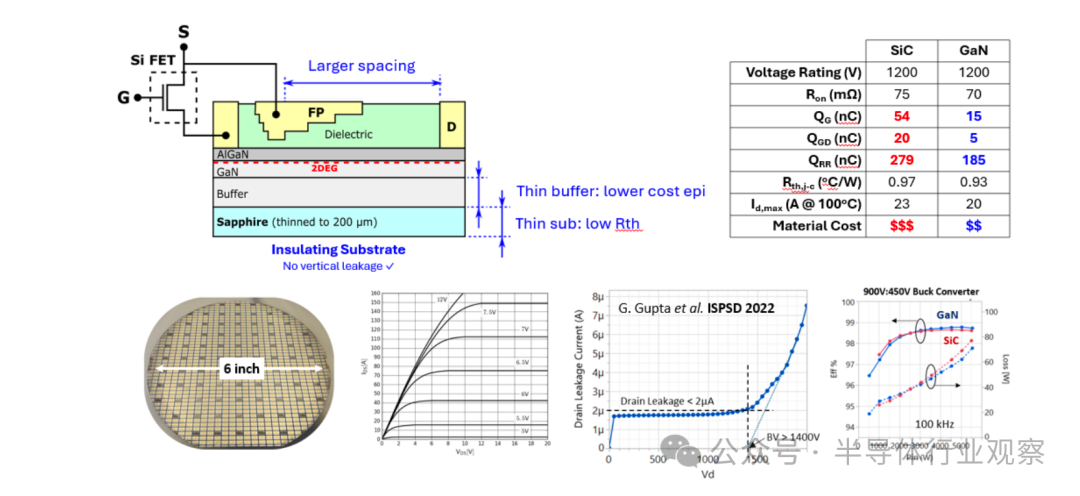





 日月光VIPack™平台系列最新进展FOCoS技术
日月光VIPack™平台系列最新进展FOCoS技术











评论