为什么封装现在很重要
封装曾经是半导体制造过程中的事后想法,不被大家重视。当你创造了这一小块神奇的硅片之后,然后把他用某种方法封装起来,同时引出管脚,一颗芯片就诞生了。但是随着摩尔定律的延伸,工程师们意识到,他们可以利用对芯片的所有部分,包括封装在内进行优化和创新,来制造出最好的产品。
更令人惊讶的是,过去没有一家封装公司被认为像传统的前端制造工艺那样重要。封装供应链通常被认为是"后端",并被视为成本中心,类似于银行业的前台和后台。但现在,随着前端难以更好的缩小芯片尺寸,一个全新的关注领域已经出现,这就是对先进封装的重视。
接下来我们讨论一下封装的发展简史,从简单的DIP封装一直到先进的2.5D或3D封装。
封装发展简介
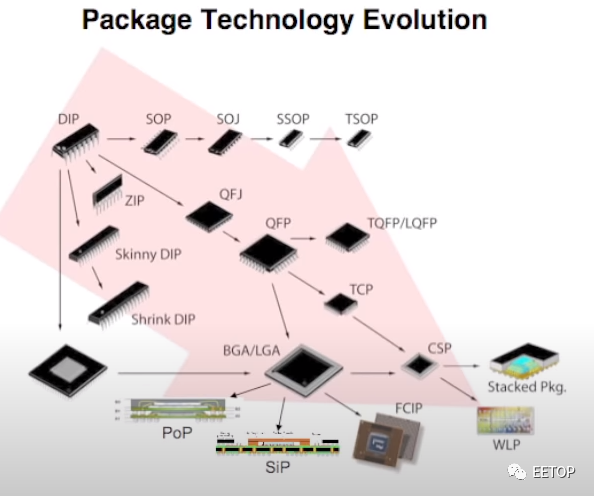
这是我从这个精彩的视频座中发现的封装技术的简要层次结构。如果你有一些时间,可以看一下。(视频发表于2012年,但是当时已经提到了现在最新的3D封装技术,所以并不过时)
封装技术一个简化的演变过程是:DIP>QFP>BGA>POP/SiP>WLP
显然,有很多不同的封装技术,但我们要讨论的是大致能代表每种类型的简单技术,然后慢慢将其带到现在。我也非常喜欢下图这个高层次的概述(不过它已经过时了,但仍然正确)。

在封装的最初阶段,裸片通常采用陶瓷或金属罐封(气密),以实现最大的可靠性。这主要适用于航空航天和军事应用,这些功能需要最高水平的可靠性。然而,对于我们的大多数日常用例来说,这并不是真正可行的,所以我们开始使用塑料封装和双列直插封装(DIP)。
DIP封装(1964-1980年代)
最早的DIP包装元件是由仙童半导体司的Bryant Buck Rogers在1964年时发明,在表面贴装技术问世之前的十年里,它被广泛应用。DIP在实际的裸片周围使用塑料封装外壳(编辑注:实际上陶瓷封装的军品芯片也大批采用了DIP封装),并有两排平行的突出的引脚,称为引线框架,与下面的PCB(印刷电路板)相连。
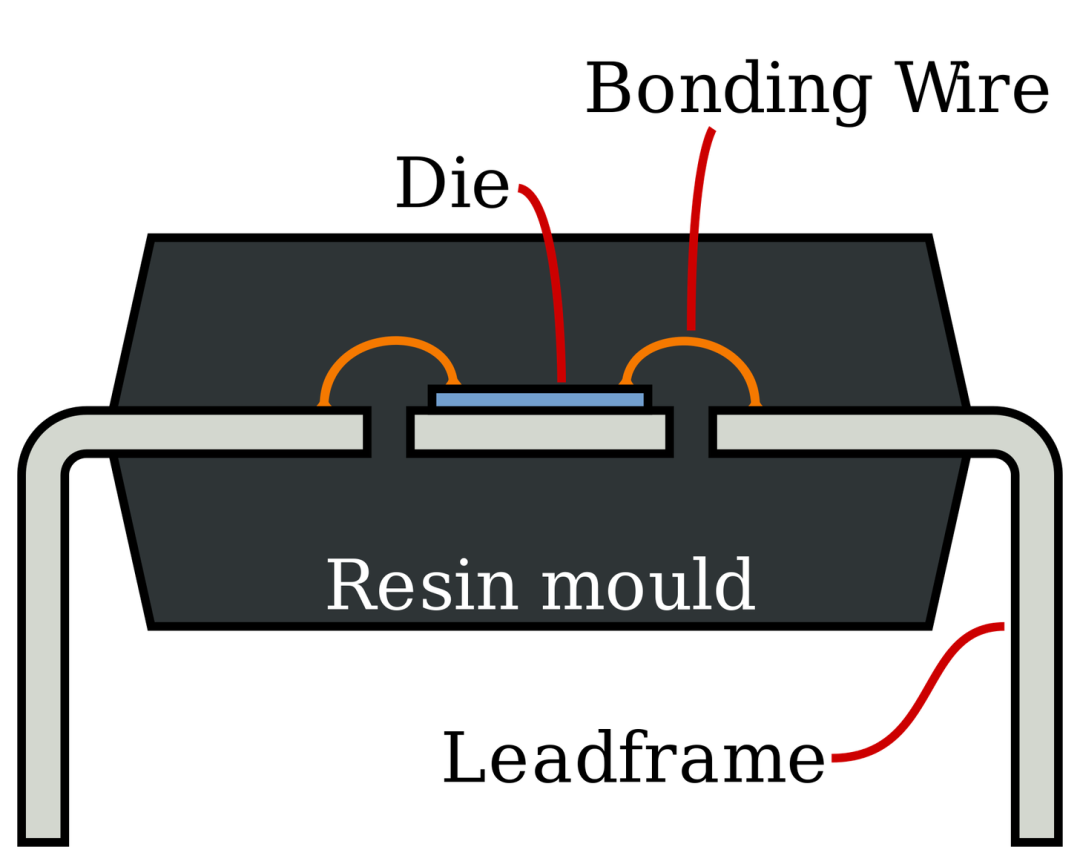
实际的芯片通过键合线连接到两个引线框架,两个引线框架可以连接到印刷电路板(PCB)。DIP封装以复古的方式具有标志性,设计选择是可以理解的。实际的裸片将完全密封在树脂中,因此它带来了高可靠性和低成本,并且许多首批标志性的半导体都是以这种方式封装的。请注意,芯片通过导线连接到外部引线框架,这使其成为一种"引线键合"封装方法。稍后将对此进行详细介绍。
下面是英特尔8008--实际上是第一批现代微处理器之一。注意它的标志性DIP封装。因此,如果你看到那些看起来像小蜘蛛的半导体的时髦照片,这只是一个DIP封装类的半导体。

英特尔的原始微处理器,8008 家族
然后,这些小金插针中的每一个都被焊接到PCB上,在那里它与其他电气元件和系统的其余部分接触。以下是封装如何焊接到PCB板上。
PCB本身通常是由铜或其他电气元件由非导电材料层压而成。然后,PCB板可以将电信号从一个地方输送到另一个地方,并让个元件相互连接和通信。
虽然DIP还有其他演绎版,但实际上是时候转向始于20世纪80年代的下一个封装技术范式或表面贴装封装了。
表面贴装封装(1980-1990年代)
下一步的变化不是通过DIP安装产品,而是引入表面贴装技术(SMT)。正如所暗示的那样,封装直接安装在PCB的表面上,并允许在一块基板上使用更多的元件并降低成本。下图是典型的表面贴装封装。
这种封装有许多变体,在半导体创新的鼎盛时期,这一直是很长一段时间的主力。值得注意的是,大部分芯片都是4个侧面都有引脚。这遵循了封装的一般愿望,即占用更少的空间并增加连接带宽或I / O。每一项额外的进步都会考虑到这一点,并且是一种值得关注的模式。
这个过程曾经是手动的,但现在是高度自动化的。此外,这实际上为PCB创造了相当多的问题,如popcorning。封装爆裂是指在焊接过程中,塑料封装内的水分被加热,由于快速加热和冷却,水分在PCB上造成问题。另一件需要注意的事情是,随着封装工艺的每一次提升,复杂性和故障也会随之增加
球栅封装和芯片级封装(1990年代至2000年代)
随着对半导体速度的需求不断提高,对更好封装的需求也在不断增加。虽然出现了QFN(四方扁平无引线)和其他表面贴装技术,但我想向你介绍一种我们在未来必须了解的封装设计的开端,这就是广泛使用的球栅阵列(BGA)封装的开始。

这些焊球或凸起被称为焊料凸起/球
这就是球栅阵列的外观,可以从下面直接将一块硅片安装到PCB或基板上,而不是像以前的表面贴装技术那样简单地将所有4端的角落贴上胶带。
因此,这只是我上面列出的趋势的另一个延续,占用更少的空间,有更多的连接。现在,我们不再是用电线细细地连接每一侧的封装,而是直接将一个封装连接到另一个。这导致了密度的增加,更好的I/O性能,以及现在增加的复杂性,即你如何检查BGA封装是否工作。在这之前,封装主要是通过视觉检查和测试。现在我们无法看到封装,所以没有办法进行测试。我们可以X射线进行检查,以及更复杂的技术。
现代封装(2000-2010年代)
我们现在走进了现代封装的时代。
上面描述的许多封装方案今天仍在使用,但是,您将开始看到越来越多的封装类型,并且这些封装类型将来会变得更加相关。公平地说,许多这些即将到来的技术是在过去几十年中发明的,但由于成本原因,直到后来才被广泛使用。
倒装芯片
这是你可能会读到或听到的最常见的封装之一。我很高兴能为你定义它,因为到目前为止,我读过的入门书中还没有一个令人满意的解释。倒装芯片是IBM很早就发明的,通常会被缩写为C4。就倒装芯片而言,它确实不是一种独立的封装形式,而是一种封装风格。它几乎就是只要在芯片上有一个焊接凸点就可以了。芯片不是用线粘合互连,而是翻转过来面对另一个芯片,中间有一个连接基板,所以叫 "倒装芯片"。
从维基百科上的解释内容可以更好的理解什么是倒装芯片:
1. 在晶圆上创建集成电路
2. 芯片表面的焊盘被金属化

3. 每个焊盘上都沉积一个焊点

4. 芯片被切割
5. 芯片被翻转和定位,以便焊球面向电路


6. 然后将焊球重新熔化
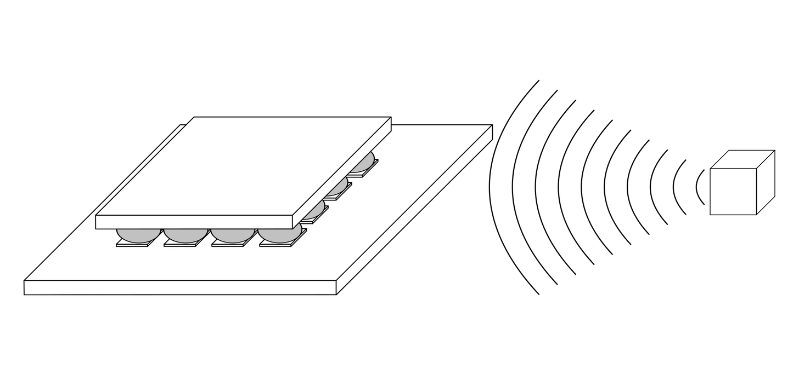
7.安装好的芯片用电绝缘胶进行底部填充
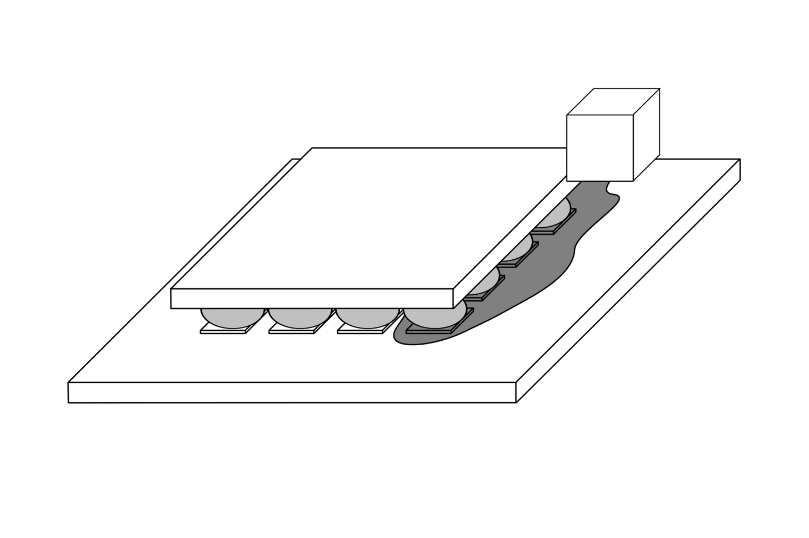
引线键合请注意倒装芯片与引线键合有何不同。上面介绍的DIP封装这就是引线键合,其中芯片使用导线键合到另一种金属上,然后焊接到PCB上。引线键合不是一种特定的技术,而是一套较旧的技术,涵盖了许多不同类型的封装。引线键合是倒装芯片的前身。
先进封装(2010年代至今)
我们一直在缓慢地进入"先进封装"半导体时代,我现在想谈谈一些更高级的概念。实际上,有各种层次的"封装"适合这个思维过程。我们之前讲过的大多数封装,都集中在芯片封装到PCB上,但先进封装的开始其实是从手机开始的。
手机在很多方面都是先进封装诸多方面的巨大前奏。这是有道理的!对于手机需要在尽可能小的空间内集成大量的芯片,比笔记本电脑或台式电脑密度大得多。所有东西都必须被动冷却,当然也要尽可能薄。这将封装推向了新的极限。我们讨论的许多概念都是从智能手机封装开始的,现在已经将自己推向了半导体行业的其他部分。
芯片级封装(CSP)
芯片级封装实际上比听起来要宽一些,最初意味着芯片大小的封装。技术定义是封装尺寸不超过芯片本身的1.2倍,并且必须是单芯片且可连接的。实际上,我已经向您介绍了CSP的概念,那就是通过倒装芯片。但CSP确实通过智能手机提升到了一个新的水平。
这张照片中的所有东西都是芯片芯片的1.2倍大小,并且专注于节省尽可能多的空间。CSP时代有很多不同的风格,包括倒装芯片、右基板和其他技术,都属于这一类。
晶圆级封装(WLP)
但还有一个更小的级别--这就是 "终极 "芯片规模的封装尺寸,或在晶圆级封装。这几乎就是把封装放在实际的硅片本身。封装的就是硅片。它更薄,具有最高水平的I/O,而且显然会非常热,很难制造。先进的封装革命目前是在CSP的规模上,但未来将集中在晶圆上。
这是一个有趣的演变,封装被实际的硅本身所包含。芯片是封装,反之亦然。与仅仅将一些球焊接到芯片上相比,这真的很昂贵,那么我们为什么要这样做呢?为什么现在对先进封装如此痴迷?
先进封装:未来
这是我长期以来一直在描述的趋势的一个顶峰。异构计算不仅是专业化要做的事,而且是我们如何将所有这些专业化的碎片放在一起的事。先进的封装是使这一切发挥作用的关键推动因素。
让我们来看看苹果M1 - 一种经典的异构计算配置,特别是其统一的内存结构。对我来说,M1的诞生不是一个 "哗众取宠 "的时刻,而是异构计算即将爆发的一个奇特时刻。
M1正在敲响未来的样子,许多人很快就会效仿苹果的做法。请注意,实际的SOC(片上系统)不是异构的--但是将内存靠近SOC的定制封装是异构的。
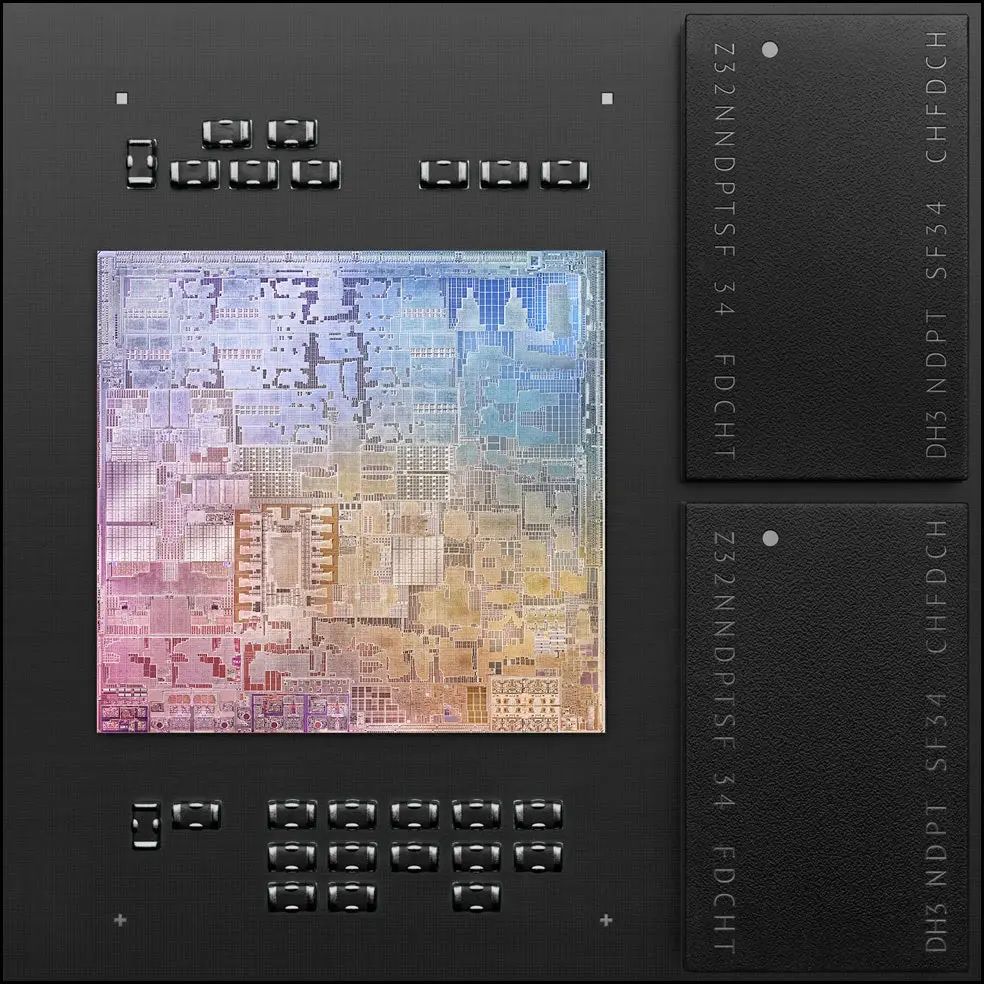
M1采用2.5D封装将内存直接封装到处理旁边,不需要PCB连线,
另一个非常好的高级封装的好例子是Nvidia的新款A100。再次注意到PCB上没有电线。

HBM2 不像传统的 GDDR5 GPU 板设计那样需要围绕 GPU 的大量离散内存芯片,而是包括一个或多个多个内存芯片的垂直堆栈。存储芯片使用微小的导线进行连接,这些导线由硅通孔和微凸起形成。一个 8 Gb HBM2 芯片包含 5,000 多个硅通孔。然后使用无源硅中介层连接内存堆栈和GPU芯片。HBM2 堆栈、GPU 芯片和硅中介层的组合封装在单个 55mm x 55mm BGA 封装中。有关 GP100 和两个 HBM2 堆栈的图示,请参见图 9;有关具有 GPU 和内存的实际 P100 的显微照片,请参见图 10。
这里的结论是,世界上最好的芯片都是用一种方式制造出来的,而且这种革命不会停止。接下来介绍高级封装的两个主要类别,2.5D和3D封装。
2.5D封装
2.5D有点像我们上面提到的倒装芯片的turbo版,但不是将单个裸片堆叠到PCB上,而是将裸片堆叠在单个中介层的顶部。我想这张图很好地说明了这一点。
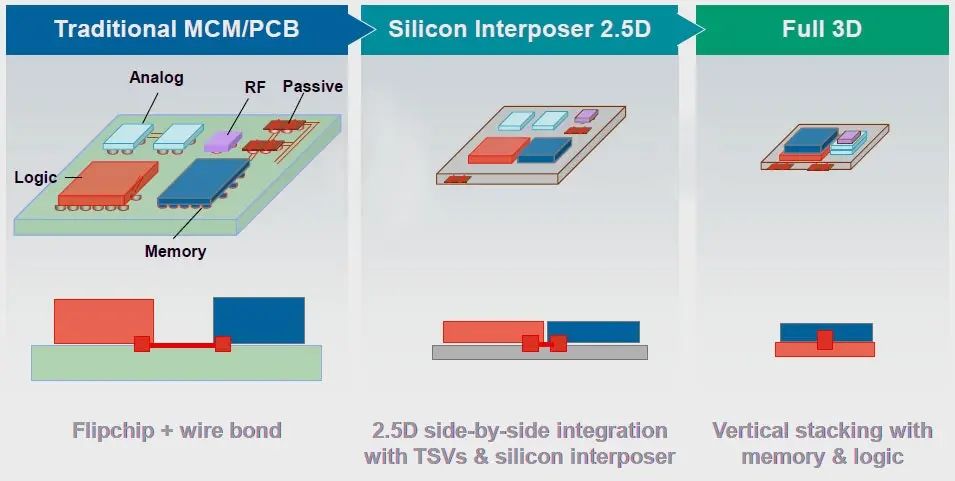
2.5D就像有一个地下室的门进入你邻居的房子,物理上是一个凸点或TSV(通过硅通孔)进入你下面的硅插板,这就把你和你的邻居连接起来。这并不比你实际的片上通信快,但由于你的净输出是由总的封装性能决定的,降低的距离和增加的两个硅片之间的互连超过了没有在一个单一的SOC上的所有缺点。
这样做的好处是你可以使用 设计好的“小芯片”来快速拼凑更大更复杂的封装。如果能在一块硅片上完成就更好了,但这种工艺使制造变得更容易,特别是在较小的尺寸上。
“小芯片”和2.5D封装可能会使用很长时间,它比3D封装更容易制造,也便宜得多。此外,它可以很好地扩展,并且可以与新的小芯片一起重复使用,从而通过更换小芯片来制造相同封装格式的新芯片。AMD的新的Zen3改进就是这样的,其中封装相似,但一些小芯片得到了升级。
3D封装
3D封装是一个“圣杯”圣杯,是封装的终极终结。可以这样比喻,现在,与其在地面上拥有所有1层楼高并由地下室连接的独立小房子,不如拥有一座巨大的摩天大楼,该摩天大楼是用适合功能所需的任何工艺定制的。这是3D封装 - 现在所有的封装都是在硅片本身上完成的。它是驱动更大、更复杂结构的最快、最节能的方法,这些结构是为任务而构建的,并将显著延长摩尔定律。未来我们可能无法获得更多的芯片尺寸收缩,但现在有了3D封装,我们仍然可以在未来改进我们的芯片,类似于以前的摩尔定律。
而有趣的是,我们有一个整个半导体市场走向3D的明显例子--内存。存储器向3D结构的推进是对未来发展的一个很好的说明。NAND不得不采用3D结构的部分原因是它们在较小的几何尺寸上难以扩展。想象一下,内存是一座大型的3D摩天大楼,每一层都由一个电梯连接起来。这些被称为 "TSV "或通硅孔。
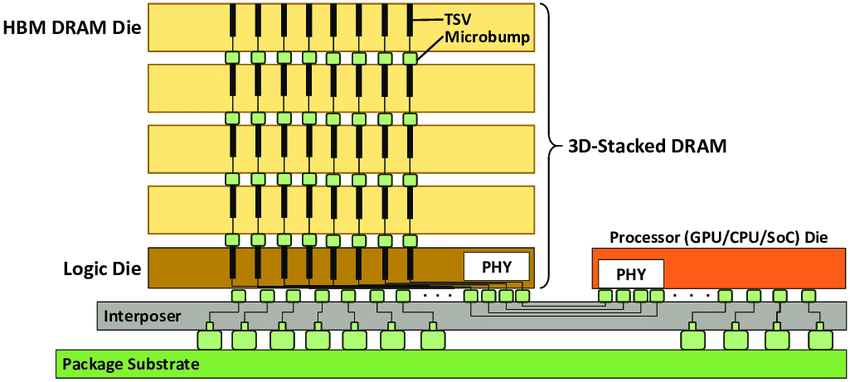
这就是未来的样子,我们甚至有可能将GPU / CPU芯片堆叠在彼此上或在CPU上堆叠内存。这是最后的边疆,而现在我们正在迅速接近的边疆。在接下来的5年里,你可能会开始看到3D封装一遍又一遍地出现。
2.5D/3D 封装解决方案快速概述
我认为,与其进一步了解3D和2.5D封装,不如直接介绍一些正在使用的、你可能已经听说过的工艺。我想在这里重点谈谈晶圆厂所做的工艺,这些工艺是推动了3D/2.5D集成发展的。
台积电的CoWoS
这似乎是 2.5D 集成工艺的主力,由 Xilinx 率先推出。
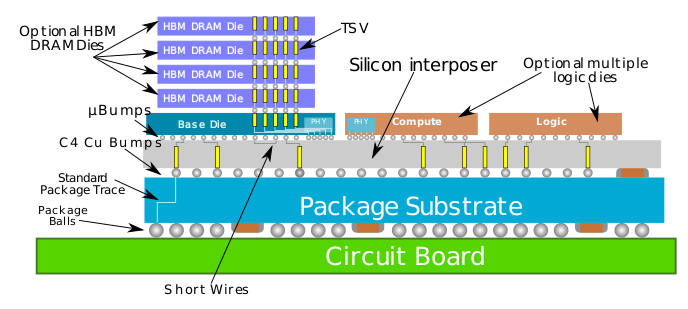
该过程主要集中在将所有逻辑芯片放入硅中介层上,然后放到封装基板上。一切都通过微凸起或球连接。这是一个经典的2.5D结构。
台积电SOIC
这个台积电的3D封装平台, 是一个相对较新的技术。。
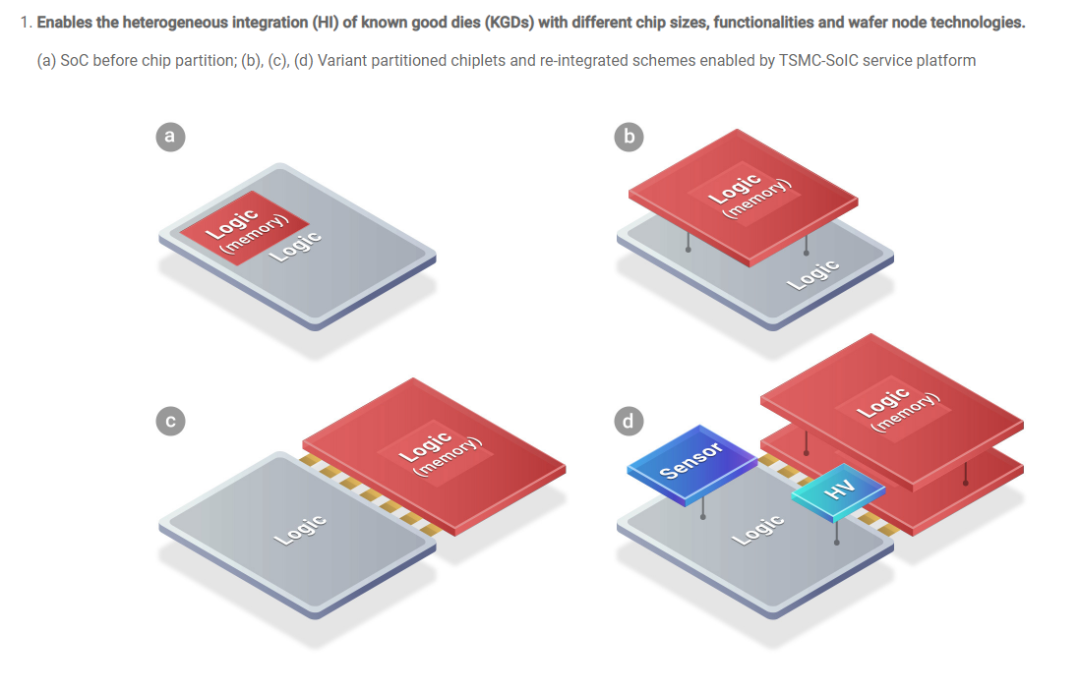
注意这个关于凸点密度和接合间距的惊人图表,SoIC在尺寸上甚至没有接近Flipchip或2.5D,而是在密度和特征尺寸方面几乎是一个前端工艺。
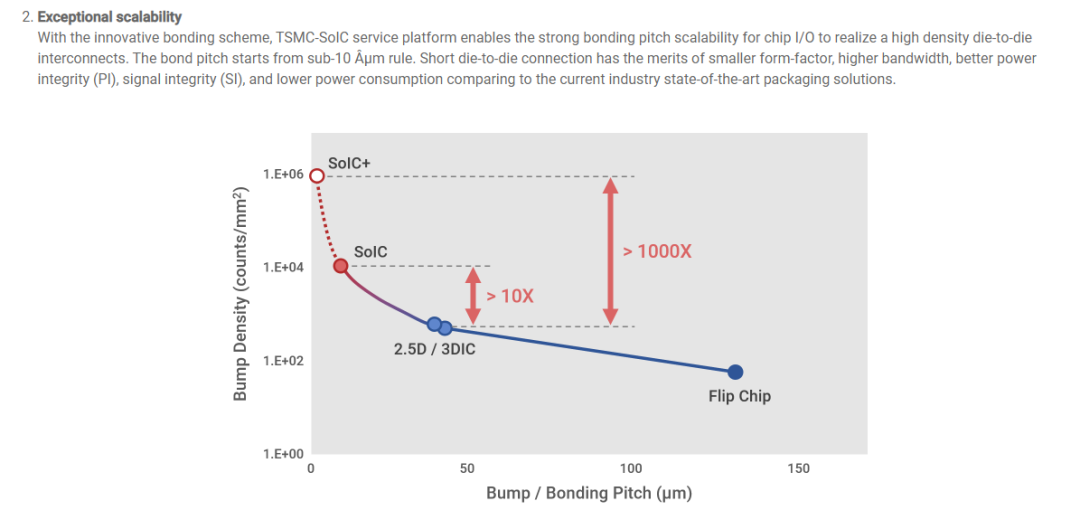
这是对他们技术的一个很好的比较,但请注意,SoIC实际上有一个类似于3D堆叠的芯片堆叠,而不是中阶层2.5D集成。
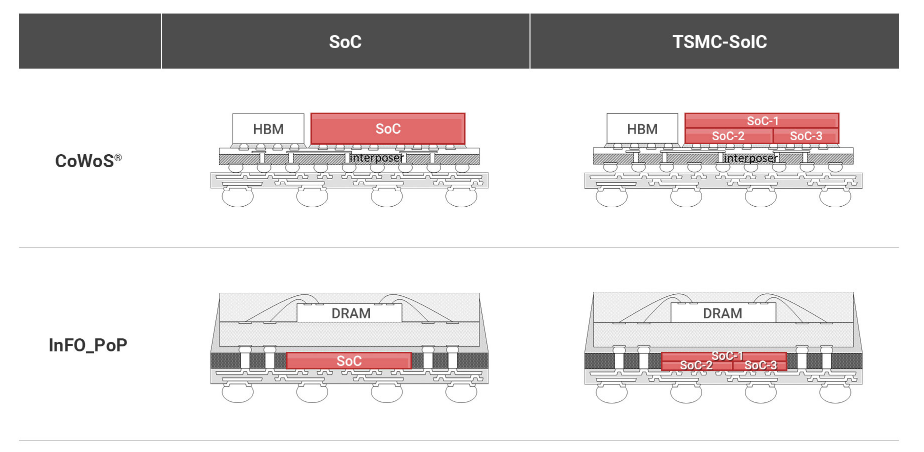
三星 XCube
近年来,三星已成为更重要的代工厂合作伙伴,当然,为了不被超越,三星拥有了新的3D封装方案。在下面查看他们的XCube的视频。
这里没有太多的信息,但我想强调的是,A100是在三星工艺上制造的,所以这可能是为Nvidia最近的芯片提供动力的技术。此外,在这里所有的公司中,三星可能有最丰富的tsv经验。
英特尔 Foveros
最后是英特尔的Foveros 3D封装。我们可能会看到英特尔在未来7nm及以后的"混合CPU"工艺中实现更多。他们在架构日已经非常明确地表示,这是他们前进的重点。
有趣的是,在3D封装过程中,三星,台积电或英特尔之间并没有太大的区别。
审核编辑 :李倩
-
芯片
+关注
关注
462文章
53535浏览量
459132 -
半导体
+关注
关注
336文章
29980浏览量
258267 -
封装
+关注
关注
128文章
9140浏览量
147893
原文标题:芯片封装简史
文章出处:【微信号:HXSLH1010101010,微信公众号:FPGA技术江湖】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
支付宝“碰一下”的革新背后:国民技术MCU的隐形力量

一文读懂京东技术发展简史
国民技术MCU芯片护航支付宝碰一下设备创新
分享一下多点电极液位开关的特点与优势

奥比中光助力支付宝碰一下落地电梯场景
“碰一下”支付终端应用在酒店:智能无卡入住与客房控制

上电时GPIO控制的LED偶尔诡异地亮了一下
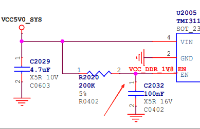
碰一下终端,让自助售货机秒变 “家里的冰箱”

人形机灵巧手求推荐
你家也有“隐形守护者”?Rd-03雷达模组了解一下

初始化AFE4400的时候,哪些控制字是必须最先写的?






 讨论一下封装的发展简史
讨论一下封装的发展简史












评论