GaN(氮化镓)器件由于具有诸如高开关速度,更高的功率密度和效率之类的能力而在设计电源转换器时变得越来越流行[2],[3],但是GaN器件的一个缺点是电流损耗会导致电流崩溃。器件关闭和热电子效应时会捕获的电荷。因此,GaN器件提供了RDSon(动态导通状态电阻),这使得GaN半导体中的传导损耗无法预测。捕获的电荷通过偏置电压Voff,偏置时间Toff以及开关状态下电压和电流之间的重叠来测量[4]。当设备打开时,处于关闭状态的俘获电荷被释放,因此诸如打开状态时间Ton之类的参数[5],硬开关或软开关[6],开关损耗[7]和温度[8]将影响设备动态RDSon从其静态RDSon值[1]变化。研究人员试图观察电压,电流和温度变化对动态RDSon的影响[9]-[12],可以得出结论,RDSon比静态RDSon增加了50%。动态RDSon实际上可帮助工程师准确确定功率转换器中的损耗。本文将重点介绍为GaN器件测量动态RDSon的模型价值。所提出的模型将在高频和稳定状态下进行验证。将使用软开关,因为它具有消除热电子效应的优点,并且还具有较小的开关损耗。
GaN-HEMT动态RDSon
图1示出了用于测量RDSon的电路图。它由设备开关电路(DSC),被测设备(DUT)和电压钳位电路(VCC)[1]组成。图2显示了测量电路的原型。DUT和DSC结合在一起形成H桥,因此可以通过控制四个开关的信号来设置DUT的开和关。VCC用于提高分辨率。在关断状态下,M1上的电势将为VDC,而VDS(m)= -VTh,而在DUT的开通状态下,∆V = 0,因此VDS(m)= VDSon。因此,代替测量VDS,VDS(m)应该被测量。齐纳二极管Z1和肖特基二极管S1不允许负载电流流过VCC。建议的VCC将使我们能够计算DUT的RDSon[1]。
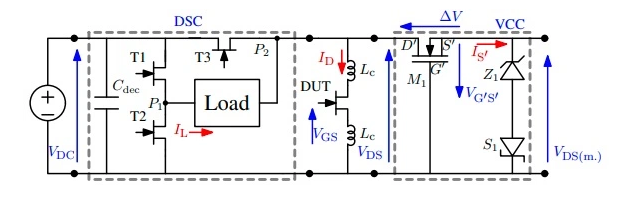
图1:测量电路的电路图
图2:测量电路的原型
测量方法
GaN半导体器件的动态RDSon值取决于Ton和Toff[13],[14]。为了获得由于电荷的俘获和去俘获所引起的时间常数,RDSon被表征为具有不同的Ton和Toff。使用的负载为RL,空载时间为τ。测量过程分为四个阶段,如图3所示。在从0-T1开始的第一阶段,DUT和T2处于导通状态,因此IL为0。第二阶段是T1-T2,其中T2和T3处于导通状态,在这种情况下,对IL进行充电在反向循环中。待测物off是在此阶段计算的。第三阶段是T2-T3,在此阶段T2接通并且DUT在T2的ZVS处接通,并开始反向导通,直到IL达到0。在第四阶段T3-T4DUT和T1都为ON和IL改变方向,并开始朝正方向导通。因此,DUT的Ton由第三和第四间隔定义。因此,将RDSON在反向传导模式可迅速在纳米第二从第三级和将R获得微秒DSON从第四阶段开始,可以在微秒到几秒的时间内获得正向传导模式下的导通。
对于该实验的GaN晶体管是焊料进入子板,以确定它的RDSON在VDC=200V和我d= 1个A.通过验证Ť关闭和T上,RDSON可以得到[1]。当栅极电压达到6V时,我们的设备开启,我们将在50ns内迅速获得RDSon。在RDSon值上观察到了陷获效应,它在100us内增加了静态RDSon值的25%[1]。然后直到1s,它以缓慢的速率增加,从1-10s开始,动态RDSon迅速增加70%,而在30s之后,它稳定下来。如果发生去陷效应,则RDSon的值下降直到10us,然后在10ms后稳定下来,然后再次下降直到Ton达到50s。

图3:在单脉冲控制信号下的四个工作阶段
实验结果
在瞬态和稳定状态下
首先,H桥在RL负载下工作,其中T1为OFF,T2为ON,VDC= 200V,IL= 1.3A,f = 100kHz,D = 50%[1]。DUT在反向传导和软开关模式下工作。可以控制功率转换器工作期间的RDSon变化。RBDSon代表在ON周期开始时测得的RDSon值,REDSon代表在ON周期结束时测得的RDSon值[1]。结果表明,当电源转换器工作时,RDSon的值缓慢增加直到3s,然后迅速增加直到30s,并且RDSon的值100秒后稳定下来。在图2中也观察到了这种转变。3.因此,该模型可用于表示功率转换器工作期间GaN器件的瞬态RDSon值。
在不同的开关频率下
在这种情况下,将改变功率转换器的开关频率,以检查对RDSon值的影响。为了提高功率转换器的开关频率,我们必须减少附着在GaN晶体管上的损耗,为此,如果不使用RL负载,我们将使用LC负载。TZCM(梯形电流模式)用于软开关并实现相移。在TZCM中,RDSon是在恒定电流幅度[1]期间测量的。频率从100kHz增加到1MHz。当DUT和T2处于导通状态且处于反向导通模式时,可以测量RDSon的值。RDSon的该值将被视为RBDSon。在正向传导模式下,DUT和T1将导通,并且IL由VDC充电。然后T1将变为OFF状态,并且RDSon的值将在恒定电流幅度下测量,该电流幅度实际上是REDSon。结果表明,当电源的开关频率增加时,RBDSon和REDSon之间的差异减小[1]。测量值与模型之间的差异约为10%[1]。
结论
本文提出了一个模型来计算功率转换器应用中GaN-HEMT器件的动态RDSon值。示出了测量电路,以在不同的ON和OFF状态下获得RDSon值。根据提出的模型,设计人员可以成功预测功率转换器中的传导损耗和开关损耗。还对该电路进行了瞬态响应和不同开关频率的测试。两个RDSon的差小于10%。已经观察到,在功率转换器操作期间,RDSon的值在100秒后趋于稳定。
参考
[1]在高频功率转换器中对GaN-HEMT动态导通态电阻建模在英国诺丁汉大学的科力电力电子,机器和控制(PEMC)组中,英国诺丁汉大学
[2] Huang Q,AQ Huang,R。Yu,P。Liu和W. Yu,“具有GaN AC开关的高效,高密度单相双模级联降压-升压多电平无变压器PV逆变器, ”《 IEEE电力电子交易》,第1卷。34,第7474-7488页,2019年8月。
[3] M. Fu,C。Fei,Y。Yang,Q。Li和FC Lee,“铁路应用中基于gan的dc-dc模块:设计考虑和高频数字控制”,IEEE工业学报电子,卷。67,第1638–1647页,2020年2月。
[4] S. Yang,S。Han,K。Sheng和KJ Chen,“ gan电力设备中的动态导通电阻:机制,特性和建模”,《 IEEE电力电子新兴和精选主题》,第1卷。7,页1425-1439,2019年9月。
[5] D. Jin和J. Del Alamo,“高压GaN场效应晶体管中动态导通电阻研究的方法论”,电子设备,IEEE Transactions60,第3190–3196页,2013年10月。
[6] R. Li,X。Wu,S。Yang和K. Sheng,“通过双脉冲和多脉冲在硬开关和软开关条件下对GaN功率器件进行动态导通电阻测试和评估”,《 IEEE交易》关于电力电子学,第一卷。34,第1044–1053页,2019年2月。
[7] F. Yang,C。Xu和B. Akin,“开关瞬态对GaN HEMT中动态导通电阻的影响的实验评估和分析”,《 IEEE电力电子学报》,第1-1页,2019年。
[8] R. Hou和J. Lu,“基于gan的硬开关应用中动态导通态电阻对系统损耗的影响”,在PCIM Europe 2019上;电力电子,智能运动,可再生能源和能源管理国际展览和会议,2019年5月,第1至7页。
[9] BJ Galapon,AJ Hanson和DJ Perreault,“以MHz频率测量GaN晶体管的动态导通电阻”,在2018年第19届电力电子控制与建模研讨会(COMPEL)上,第1-8页,2018年6月。 。
[10] N. Badawi,O。Hilt,E。Bahat-Treidel,J。Bocker,J。W urfl和S. Dieck-erhoff,“研究600 V常关状态的动态导通电阻和GaN-HEMTs,” IEEE工业应用学报,第1卷。52,第4955–4964页,2016年11月。
[11] Y. Cai,AJ Forsyth和R. Todd,“ GaN HEMT动态导通态电阻对转换器性能的影响”,在2017年IEEE应用功率电子会议暨展览会(APEC)中,第1689-1694页,3月2017。
[12] F. Yang,C。Xu和B. Akin,“ EnhancedMode GaN HEMT中不同工作条件对动态导通电阻的影响的定量分析”,在2018年IEEE第6届宽带隙功率器件和应用研讨会(WiPDA) ),第134-140页,2018年10月。
[13] MJ Uren,S。Karboyan,I。Chatterjee,A。Pooth,P。Moens,A。Banerjee和M. Kuball,““漏电”模型用于抑制碳掺杂AlGaN / GaN中的动态Ron HEMTs”,《电子设备上的IEEE交易》,第1卷。64,第2826-2834页,2017年7月。
[14] K. Li,PL Evans和CM Johnson,“氮化镓功率半导体器件动态导通态电阻的特性和建模”,关于电力电子的IEEE交易,第1卷。33,页5262-5273,2018年6月。
编辑:hfy
-
功率转换器
+关注
关注
0文章
79浏览量
19299 -
测量电路
+关注
关注
2文章
136浏览量
29569 -
GaN
+关注
关注
19文章
1767浏览量
68050 -
半导体器件
+关注
关注
12文章
531浏览量
31533
发布评论请先 登录
相关推荐
同是功率器件,为什么SiC主要是MOSFET,GaN却是HEMT
GaN HEMT在电机设计中有以下优点
GaN HEMT可靠性测试:为什么业界无法就一种测试标准达成共识
SGNE010MK GaN-HEMT
SGK7785-60A GaN-HEMT
SGM6901VU GaN-HEMT模块
基于GaN HEMT的半桥LLC优化设计和损耗分析
红外显微镜用于测量高性能微波GaN HEMT器件和MMIC的有什么局限性?

在高频电源转换器中演示基于GaN-HEMT的动态Rds电阻
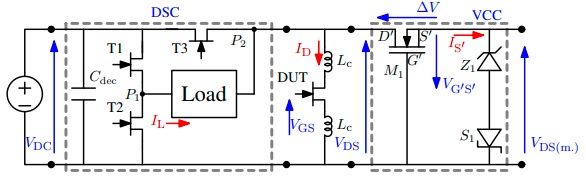
分析毫米波GaN器件热电效应
高功率GaN HEMT的可靠性设计
实测干货分享!1200V GaN HEMT功率器件动态特性测试
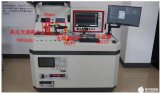




 GaN-HEMT器件的动态R DSon值测量实验分析
GaN-HEMT器件的动态R DSon值测量实验分析
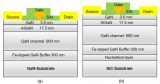











评论