先进封装技术是高性能芯片的重要基础之一。在过去几年中,扇出型封装是成长最为快速的先进封装技术,其发展受到了业界的关注。扇出型封装又分为扇出型晶圆封装(FOWLP)以及扇出型板级封装(FOPLP),扇出型晶圆封装已经被许多消费电子产品所采用,扇出型板级封装也即将进入到量产阶段。
FOPLP被视为是延伸FOWLP、并可高整合度IC封装的突破性技术。FOPLP可通过更大面积的方型载板来提高生产效率,成本比FOWLP更具竞争力,所以引起了市场的重视。
5G时代下的FOPLP市场情况
就最新的情况来看,5G和AI的到来,推动了手机、电脑、汽车以及物联网等多个领域的发展。从手机方面来看,由于5G的发展促生了大量IC需求,在此期间,封装技术也在5G的推动下发生了演进,越来越多的IC会采用扇出型封装。透过扇出型封装可将不同的IC整合在一起,从而提高整体的效率。
5G、AI和IoT的发展,也同样推动了对扇出型板级封装的需求。根据Yole的报告,扇出型板级封装未来全球5年的年复合成长率可高达30%,2024年全球产值预期可达457百万美元。此外,还有报告分析称,如果FOPLP能够进入到量产阶段,就会使先进封装的成本就会有所下降,而这将冲击FOWLP的市场的份额。
原由FOWLP所占有的中低端市场,可能会首先转向FOPLP。根据Manz资深销售处长简伟铨介绍,未来将会出现越来越多的异质整合IC,FOPLP技术可通过微细铜重布线路层(RDL) 连结的方式将这些芯片整合在单一封装体中,从而实现更高密度重布线层(RDL)、更精细线宽/线距,达到与采用FOWLP封装技术一样的效果。在此基础上,FOPLP具有显着的成本及效能优势(FOWLP面积使用率较低<85%,FOPLP面积使用率>95%),这也是未来FOPLP可与FPWLP进行竞争的优势之一。简伟铨表示:“如今的扇出封装一般是将芯片封装在200或300毫米的圆形晶圆内,而未来扇出型板级封装将在500毫米或600毫米的方形晶圆中进行,两者之间在可使用面积、可封装面积的使用率上相差4倍之多。由此成本的原因,会使得越来越多的异质整合IC,选择扇出型板级封装。”
根据这种市场趋势,也有一些厂商开始涉足FOPLP领域。根据麦姆斯咨询去年发布的报告显示,三星电机、力成科技、日月光(ASE/Deca)和纳沛斯(Nepes)现正在利用现有设施和工艺能力,投资面扇出型板级封装技术,以实现规模经济生产。但就当前形势来看,由于良率的限制,只有三星电机和力成能够启动量产。
简伟铨强调,虽然FOPLP还未出现明显的市场规模,但其成本效益相当诱人,面对未来可能持续扩大的下游IC市场。
发展FOPLP所面临的挑战与机会
在技术上,FOPLP要面临着漂移的问题、热翘曲以及工艺平台检测等问题。除此之外,尺寸、制程等细节还尚未有共同的标准,整体FOPLP制程设备也有着非常高的定制化需求,因此,也为FOPLP的量产化制造了难度。这些都是FOPLP发展阶段的挑战。
FOPLP的发展为相关设备和材料带来了新的机遇。针对FOPLP发展的需求,2017年Manz就宣布跨入半导体领域,为扇出型板级封装提供各式相关生产设备解决方案。Manz结合自身30多年化学湿法制程设备的自主研发能力,掌握了先进封装的关键黄光制程、电镀等设备,能够实现高密度重布线层等自身优势。其中,RDL是实现FOPLP的重要环节:
Manz掌握的RDL电镀及铜蚀刻技术的独特优势如下:
开创业界无治具垂直电镀线,具备优异的电镀均匀性(>90%)及填孔能力(孔径小于20um)
直电镀铜线不需使用治具,减少维修成本
模块化设计操作及维护具备便利性
适用于不同基板:FR4铜箔基板、钢板及玻璃基板。其中玻璃基板的应用,可让计划跨入先进封装领域的显示器面板制造商,补足其对于在线性电镀的工艺经验
铜蚀刻线:Manz的装备具有化学药液和工艺的最佳结合,可确保完全去除铜种子层并有选择性地进行铜蚀刻,铜蚀刻均匀性达93%.
以Manz 软硬件的整合实力,可提供传输设备及CIM系统(Computer Integrated Manufacture-计算机制程整合)为进一步走向工业4.0
Manz与佛智芯合作,助力FOPLP发展
全球FOPLP都处于待发展的阶段,我国本土的一些厂商也抓住了这一时机。为了促进国内FOPLP产线的落地,佛智芯与Manz进行了合作。
佛智芯是半导体创新中心依托中科院微电子所、广东工业大学省部共建精密电子制造技术与装备国家重点实验室资源,并汇聚了华进半导体、安捷利、上达电子、丰江微电子在内的17个企业和高校科研机构共同成立的。佛智芯副总经理林挺宇博士介绍,佛智芯成立的目的是通过开发低成本大板级扇出型封装新型工艺,推进国内首条板级扇出型封装示范线建设,为板级扇出设备、工艺、材料改进及升级换代提供有力参考依据。
林挺宇表示:“由于FOPLP的尺寸和工艺标准尚未规范,通过佛智芯FOPLP示范线的建立,可以提前发现一些问题,从而能够帮助相关企业更快地实现量产。”
根据启信宝的消息显示,华进半导体也是佛智芯的股东之一。据林挺宇介绍,华进半导体很早就参与到了FOPLP的发展中来。如果佛智芯FOPLP示范产线建成,将有利于国内相关封测厂商发展FOPLP业务。同时,林挺宇还表示,由于国内封测企业所经营的产品有所区别,所以在发展FOPLP业务时,这些企业之间暂时不会处于竞争的关系,而是一种互补的关系。
根据佛智芯发展FOPLP的计划中看,在今年第3季度,所有的装备将进入佛智芯的厂房,在第4季度所有的设备将能联动起来。在尺寸上,公司计划以300×300为突破点,在一两年内切换到600×600上。林挺宇表示:“FOPLP首先要实现300×300封装,达到与现在扇出型晶圆级封装的同等水平。在这一过程中,佛智芯将在材料和设备上进行规范,以便能够更好地向前发展。从效应角度上看,FOPLP在600×600板级上将凸显优势。”同时,林挺宇也强调了,佛智芯旨在为能够量产的企业提供total solution,按照计划,佛智芯将在明年初能够为产业提供相关解决方案。
根据佛智芯的发展规划中看,设备对于FOPLP的发展至关重要。此次,佛智芯选择了与Manz联手同图国内FOPLP产线的落地。佛智芯方面表示,Manz在FOPLP领域中积累了多年的经验,在对接过程中,Manz能够更加清楚FOPLP设备的痛点,从而能够提供更加完善的解决方案。
据悉,Manz此次交付于佛智芯的装备线,包括了为其工艺开发中心导入黄光制程设备。据介绍,该设备的导入完善了佛智芯在公共服务平台中至关重要的设备验证环节,可以让不同的客户依据其制程及材料在装备线得到产前打样验证,以此推动封装领域中制造成本相对较低的扇出型板级封装产业化解决方案。
根据此前的报道显示,大板级扇出型封装示范线预计在2019年下半年开始运作。同时为了使该条示范线得到更充分的利用,佛智芯还推出了多种运营模式以助力国内FOPLP的发展:
示范线将依托设备开放成果及封装成套技术,为产业界提供封装和测试服务;
将开发如汽车雷达、智能家居、消费电子等固定产品,并可为中小企业直接提供此类产品的小规模封装代工量产服务;
将提供封测材料的评估验证服务,包括工艺评估、可靠性评估以及小批量量产评估等服务。
责任编辑:tzh
-
芯片
+关注
关注
462文章
53534浏览量
459034 -
IC
+关注
关注
36文章
6258浏览量
184214 -
封装
+关注
关注
128文章
9139浏览量
147887 -
5G
+关注
关注
1366文章
49067浏览量
590038
发布评论请先 登录
开发无线通信系统所面临的设计挑战
TC Wafer晶圆测温系统当前面临的技术挑战与应对方案

AI 时代来袭,手机芯片面临哪些新挑战?

B10 BMS技术知识初探(上、下)
智慧路灯的推广面临哪些挑战?
全面剖析倒装芯片封装技术的内在机制、特性优势、面临的挑战及未来走向
如今AI在不断发展,做连接器行业的更应该注意什么?
芯片封装中的FOPLP工艺介绍
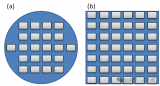





 发展FOPLP技术所面临的挑战与机会
发展FOPLP技术所面临的挑战与机会













评论