电子封装是集成电路芯片生产完成后不可缺少的一道工序,是器件到系统的桥梁。封装这一生产环节对微电子产品的质量和竞争力都有极大的影响。按目前国际上流行的看法认为,在微电子器件的总体成本中,设计占了三分之一,芯片生产占了三分之一,而封装和测试也占了三分之一,真可谓三分天下有其一。
封装研究在全球范围的发展是如此迅猛,而它所面临的挑战和机遇也是自电子产品问世以来所从未遇到过的;封装所涉及的问题之多之广,也是其它许多领域中少见的,它是从材料到工艺、从无机到聚合物、从大型生产设备到计算力学等一门综合性非常强的新型高科技学科。
什么是封装
封装最初的定义是保护电路芯片免受周围环境的影响(包括物理、化学的影响)。
芯片封装是利用(膜技术)及(微细加工技术),将芯片及其他要素在框架或基板上布置、粘贴固定及连接,引出接线端子并通过可塑性绝缘介质灌封固定,构成整体结构的工艺。
电子封装工程是将基板、芯片封装体和分立器件等要素,按电子整机要求进行连接和装配,实现一定电气、物理性能,转变为具有整机或系统形式的整机装置或设备。
集成电路封装能保护芯片不受或者少受外界环境的影响,并为之提供一个良好的工作条件,以使集成电路具有稳定、正常的功能。
芯片封装能实现电源分配;信号分配;散热通道;机械支撑;环境保护。
封装技术的层次:
第一层次,又称为芯片层次的封装,是指把集成电路芯片与封装基板或引脚架之间的粘贴固定电路连线与封装保护的工艺,使之成为易于取放输送,并可与下一层次的组装进行连接的模块元件。
第二层次,将数个第一层次完成的封装与其他电子元器件组成一个电子卡的工艺。
第三层次,将数个第二层次完成的封装组成的电路卡组合成在一个主电路版上使之成为一个部件或子系统的工艺。
第四层次,将数个子系统组装成为一个完整电子厂品的工艺过程。
他们依次是芯片互连级(零级封装)、一级封装(多芯片组件)、二级封装(PWB或卡)三级封装(母板)。
封装的分类
按照封装中组合集成电路芯片的数目,芯片封装可分为:单芯片封装与多芯片封装两大类;
按照密封的材料区分,可分为高分子材料和陶瓷为主的种类;
按照器件与电路板互连方式,封装可区分为引脚插入型和表面贴装型两大类;
按照引脚分布形态区分,封装元器件有单边引脚,双边引脚,四边引脚,底部引脚四种。
常见的单边引脚有单列式封装与交叉引脚式封装;
双边引脚元器件有双列式封装小型化封装;
四边引脚有四边扁平封装;
底部引脚有金属罐式与点阵列式封装。
封装的名词解释
SIP:单列式封装 SQP:小型化封装 MCP:金属鑵式封装
DIP:双列式封装 CSP:芯片尺寸封装 QFP:四边扁平封装
PGA:点阵式封装 BGA:球栅阵列式封装 LCCC:无引线陶瓷芯片载体
封装技术的发展阶段
半导体行业对芯片封装技术水平的划分存在不同的标准,目前国内比较通行的标准是采取封装芯片与基板的连接方式来划分,总体来讲,集成电路封装封装技术的发展可分为四个阶段:
第一阶段:20世纪80年代以前(插孔原件时代)。
封装的主要技术是针脚插装(PTH),其特点是插孔安装到PCB上,主要形式有SIP、DIP、PGA,它们的不足之处是密度、频率难以提高,难以满足高效自动化生产的要求。
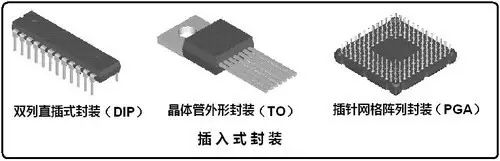
第二阶段:20世纪80年代中期(表面贴装时代)。
表面贴装封装的主要特点是引线代替针脚,引线为翼形或丁形,两边或四边引出,节距为1.27到0.4mm,适合于3-300条引线,表面贴装技术改变了传统的PTH插装形式,通过细微的引线将集成电路贴装到PCB板上。主要形式为SOP(小外型封装)、PLCC(塑料有引线片式载体)、PQFP(塑料四边引线扁平封装)、J型引线QFJ和SOJ、LCCC(无引线陶瓷芯片载体)等。
它们的主要优点是引线细、短,间距小,封装密度提高;电气性能提高;体积小,重量轻;易于自动化生产。它们所存在的不足之处是在封装密度、I/O数以及电路频率方面还是难以满足ASIC、微处理器发展的需要。
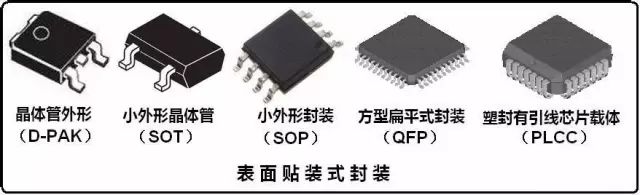
第三阶段:20世纪90年代出现了第二次飞跃,进入了面积阵列封装时代。
该阶段主要的封装形式有焊球阵列封装(BGA)、芯片尺寸封装(CSP)、无引线四边扁平封装(PQFN)、多芯片组件(MCM)。BGA技术使得在封装中占有较大体积和重量的管脚被焊球所替代,芯片与系统之间的连接距离大大缩短,BGA技术的成功开发,使得一直滞后于芯片发展的封装终于跟上芯片发展的步伐。CSP技术解决了长期存在的芯片小而封装大的根本矛盾,引发了一场集成电路封装技术的革命。
第四阶段:进入21世纪,迎来了微电子封装技术堆叠式封装时代,它在封装观念上发生了革命性的变化,从原来的封装元件概念演变成封装系统。
3D晶片堆叠技术
堆叠式存储模块
目前,以全球半导体封装的主流正处在第三阶段的成熟期,PQFN和BGA等主要封装技术进行大规模生产,部分产品已开始在向第四阶段发展。
封装工艺流程
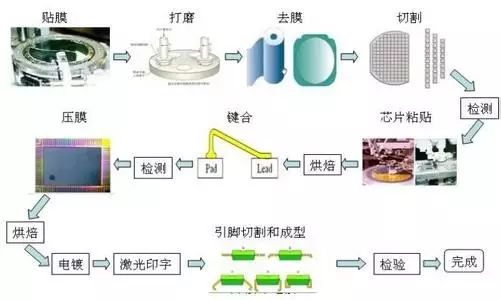
1.封装工艺流程一般可以分为两个部分,用塑料封装之前的工艺步骤成为前段操作,在成型之后的工艺步骤成为后段操作
2.芯片封装技术的基本工艺流程 硅片减薄 硅片切割 芯片贴装,芯片互联 成型技术 去飞边毛刺 切筋成型 上焊锡打码等工序
3.硅片的背面减薄技术主要有磨削,研磨,化学机械抛光,干式抛光,电化学腐蚀,湿法腐蚀,等离子增强化学腐蚀,常压等离子腐蚀等
4.先划片后减薄:在背面磨削之前将硅片正面切割出一定深度的切口,然后再进行背面磨削。
5.减薄划片:在减薄之前,先用机械或化学的方式切割处切口,然后用磨削方法减薄到一定厚度之后采用ADPE腐蚀技术去除掉剩余加工量实现裸芯片的自动分离。
6.芯片贴装的方式四种:共晶粘贴法,焊接粘贴法,导电胶粘贴法,和玻璃胶粘贴法。
共晶粘贴法:利用金-硅合金(一般是69%Au,31%的Si),363度时的共晶熔合反应使IC芯片粘贴固定。
7.为了获得最佳的共晶贴装所采取的方法,IC芯片背面通常先镀上一层金的薄膜或在基板的芯片承载座上先植入预芯片
8.芯片互连常见的方法有,打线键合,载在自动键合(TAB)和倒装芯片键合。
9.打线键合技术有,超声波键合,热压键合,热超声波键合。
10.TAB的关键技术:1芯片凸点制作技术2TAB载带制作技术3载带引线与芯片凸点的内引线焊接和载带外引线焊接技术。
11.凸点芯片的制作工艺,形成凸点的技术:蒸发/溅射涂点制作法,电镀凸点制作法置球及模板印刷制作,焊料凸点发,化学镀涂点制作法,打球凸点制作法,激光法。
12.塑料封装的成型技术,1转移成型技术,2喷射成型技术,3预成型技术但最主要的技术是转移成型技术,转移技术使用的材料一般为热固性聚合物。
13.减薄后的芯片有如下优点:1、薄的芯片更有利于散热;2、减小芯片封装体积;3、提高机械性能、硅片减薄、其柔韧性越好,受外力冲击引起的应力也越小;4、晶片的厚度越薄,元件之间的连线也越短,元件导通电阻将越低,信号延迟时间越短,从而实现更高的性能;5、减轻划片加工量减薄以后再切割,可以减小划片加工量,降低芯片崩片的发生率。
14. 波峰焊:波峰焊的工艺流程包括上助焊剂、预热以及将PCB板在一个焊料波峰上通过,依靠表面张力和毛细管现象的共同作用将焊剂带到PCB板和元器件引脚上,形成焊接点。
波峰焊是将熔融的液态焊料,借助于泵的作用,在焊料槽液面形成特定形状的焊料波,装了元器件的PCB置于传送链上,经某一特定的角度以及一定的进入深度穿过焊料波峰而实现焊点的焊接过程。
再流焊:是通过预先在PCB焊接部位施放适量和适当形式的焊料,然后贴放表面组装元器件,然后通过重新熔化预先分配到印制板焊盘上的焊膏,实现表面组装元器件焊端或引脚与印制板焊盘之间机械与电气连接的一种成组或逐点焊接工艺。
15.打线键合(WB):将细金属线或金属带按顺序打在芯片与引脚架或封装基板的焊垫上形成电路互连。打线键合技术有超声波键合、热压键合、热超声波键合。
载带自动键合(TAB):将芯片焊区与电子封装外壳的I/O或基板上的金属布线焊区用具有引线图形金属箔丝连接的技术工艺。
倒装芯片键合(FCB):芯片面朝下,芯片焊区与基板焊区直接互连的一种方法。
16. 芯片互连:将芯片焊区与电子封装外壳的I/O或基板上的金属布线焊区相连接,只有实现芯片与封装结构的电路连接才能发挥已有的功能。
先进封装技术SIP
随着物联网时代和全球终端电子产品渐渐走向多功能整合及低功耗设计,因而使得可将多颗裸晶整合在单一封装中的SiP技术日益受到关注。除了既有的封测大厂积极扩大SiP制造产能外,晶圆代工业者与IC基板厂也竞相投入此一技术,以满足市场需求。
SIP的定义
根据国际半导体路线组织(ITRS)的定义:SiP 为将多个具有不同功能的有源电子元件与可选无源器件,以及诸如 MEMS 或者光学器件等其他器件优先组装到一起,实现一定功能的单个标准封装件,形成一个系统或者子系统。
因此,从架构上来讲, SiP 是将多种功能芯片,包括处理器、存储器等功能芯片集成在一个封装内,从而实现一个基本完整的功能。
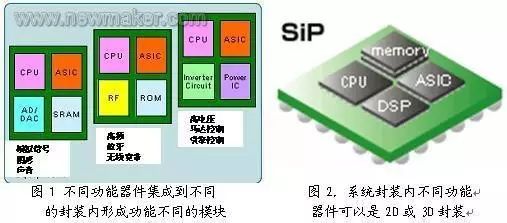
SOC的定义
将原本不同功能的 IC,整合在一颗芯片中。藉由这个方法,不单可以缩小体积,还可以缩小不同 IC 间的距离,提升芯片的计算速度。SoC称为系统级芯片,也有称片上系统,意指它是一个产品,是一个有专用目标的集成电路,其中包含完整系统并有嵌入软件的全部内容。同时它又是一种技术,用以实现从确定系统功能开始,到软/硬件划分,并完成设计的整个过程。
随着封装技术持续演进,加上终端电子产品朝向轻薄短小趋势,因此,对SiP需求亦逐渐提升。
SiP生产线须由基板、晶片、模组、封装、测试、系统整合等生态系共同组成,才能够顺利发展。反之,若缺乏完整生态系,便难以推动SiP技术具体实现。
由于SiP技术可将多种晶片封装于单一封装体内而自成系统,因此具有高整合性与微型化特色,适合应用于体积小、多功能、低功耗等特性的电子产品。
以各种应用来看,若将原本各自独立的封装元件改成以SiP技术整合,便能缩小封装体积以节省空间,并缩短元件间的连接线路而使电阻降低,提升电性效果,最终呈现微小封装体取代大片电路载板的优势,又仍可维持各别晶片原有功能。因此,高整合性与微型化特色,使SiP成为近年来封装技术发展趋势。
此外,因SiP是将相关电路以封装体完整包覆,因此可增加电路载板的抗化学腐蚀与抗应力(Anti-stress)能力,可提高产品整体可靠性,对产品寿命亦能提升。
相较于SoC来说,SiP毋须进行新型态晶片设计与验证,而是将现有不同功能的晶片,以封装技术进行整合 。
大致上来说,现阶段SiP常用的基本封装技术,包括普遍应用于智慧型手机的Package on Package(PoP)技术,将逻辑IC与记忆体IC进行封装体堆叠。将主动与被动元件内埋于基板的嵌入式技术(Embedded),以及多晶片封装(MCP)、多晶片模组(MCM)、Stacking Die、PiP、TSV 2.5D IC、TSV 3D IC等,也属于SiP技术范畴。
智慧型手机扮演SiP成长驱动主力
与个人电脑时代相比,行动装置产品对SiP的需求较为普遍 。就以智慧型手机来说,上网功能已是基本配备,因此与无线网路相关的Wi-Fi模组便会使用到SiP技术进行整合。
基于安全性与保密性考量所发展出的指纹辨识功能,其相关晶片封装亦需要SiP协助整合与缩小空间,使得指纹辨识模组开始成为SiP广泛应用的市场;另外,压力触控也是智慧型手机新兴功能之一,内建的压力触控模组(Force Touch)更是需要SiP技术的协助。
除此之外,将应用处理器(AP)与记忆体进行整合的处理器模组,以及与感测相关的MEMS模组等,亦是SiP技术的应用范畴。
穿戴装置/物联网驱动SiP需求上扬
全球终端电子产品的发展不断地朝向轻薄短小、多功能、低功耗等趋势迈进, SiP的成长潜力越来越大。2015年Apple Watch等穿戴式产品问世后,SiP技术扩及应用到穿戴式产品。
此外, 在万物联网的趋势下,必然会串联组合各种行动装置、穿戴装置、智慧交通、智慧医疗,以及智慧家庭等网路,多功能异质晶片整合预估将有庞大需求,低功耗也会是重要趋势。
封装技术作为信息产业的重要基础在在产品中发挥着很大的作用。具体来说有封装市场巨大,决定产品性能、可靠性、寿命、成本等。现代电子信息产业的竞争在某种意义上主要就是电子封装业的竞争,它在一定程度上决定着现代工业化的水平。
-
集成电路
+关注
关注
5446文章
12469浏览量
372696 -
半导体
+关注
关注
336文章
29985浏览量
258351 -
封装技术
+关注
关注
12文章
595浏览量
69153
原文标题:半导体制造之封装技术
文章出处:【微信号:WW_CGQJS,微信公众号:传感器技术】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
半导体制冷机chiller在半导体工艺制程中的高精度温控应用解析

2025年半导体制造设备市场:前景璀璨还是风云变幻?

麦科信获评CIAS2025金翎奖【半导体制造与封测领域优质供应商】
最全最详尽的半导体制造技术资料,涵盖晶圆工艺到后端封测
静电卡盘:半导体制造中的隐形冠军

芯和半导体将参加重庆半导体制造与先进封测产业发展论坛
半导体封装的主要类型和制造方法
半导体制造里的ALD工艺:比“精”更“精”!

日本半导体制造设备销售额预期上调,创历史新高!

镓在半导体制造中的作用
无尘车间半导体制造设备的振动标准

【「大话芯片制造」阅读体验】+ 半导体工厂建设要求
半导体制造行业MES系统解决方案






 半导体制造之封装技术
半导体制造之封装技术













评论