如果说摩尔定律预言了前50年的半导体工艺技术发展路线,那么近两年以来半导体工艺可谓被智能手机等智能终端设备的军备竞赛疯狂驱动着向前。从28nm到22nm、14nm、10nm甚至7nm,在先进半导体工艺激烈竞争下,对数字电路越来越高的性能要求使半导体供应商面临着更多的挑战,基于这些要求,全行业的合作将成为一种必然,而EDA厂商、设备厂商等产业链均卯足全力因应客户需求。
先进设计/工艺带来的寄生提取挑战
一代又一代的半导体晶圆工艺提升使不断增加的IC设计密度、性能提升和功耗节省得以实现,但也为电路设计工程师带来了许多新兴的挑战。包括创新的工艺特性,诸如FinFET晶体管等代表着向低功耗设计模式的转变,这就需要EDA软件在性能和精度方面也要有相应的飞跃提升。
在整个设计周期内,电路设计工程师必须在性能和精准度之间权衡取舍。寄生电路参数提取也不例外。在使用较为复杂的FinFET组件的先进工艺节点上,设计工程师始终致力于追求更为严苛的精准度,也需要更高的性能和容量来实现十亿级晶体管设计。事实上,在现代 IC 中,所有制程节点都随着内存、模拟电路、标准单元库以及定制化数字内容的混合变得日益复杂,当工艺尺寸缩小到低于.35u或深亚微米(DSM)以下时,物联连线所产生的互连寄生(电阻、电容等)变得越来越普遍的。这种复杂性为电路参数提取工具带来了一系列不同的挑战,设计人员需要必须平衡精度、性能和复杂性等多重因素。
Mentor Graphics代工厂项目总监Shu-Wen Chang解释说:“在前段制程中,例如FinFET的推出标志着CMOS晶体管进入真正的三维器件时代。由于其源漏区以及与其周围连接的三维结构方式(包括本地互连和接触通孔),导致了复杂性和不确定性。更新更复杂的制造工艺以及更严格的设计规则,使得设计师和代工厂在建模时精确地捕获FinFET器件内部的寄生电阻、电容,以及器件之间的相互作用是至关重要的。”她补充到,“又例如在后段制程,双重乃至多重曝光工艺在先进节点工艺中发挥越来越重要的作用,互连corners的数量也将显著增多。在28纳米节点,可能存在5个互连corners,但在16纳米节点,会看到11至15个corners。多层掩膜版之间对不准产生误差,漂移等更多复杂情况,要求设计人员评估更多寄生参数提取的corners,以验证集成电路的时间选择和性能,为寄生参数提取工作带来了更大的挑战。”
为了应对这些挑战,Mentor Graphics推出了全新 Calibre xACT寄生电路参数提取平台。Shu-Wen Chang表示,Calibre xACT平台可满足包括 14nm FinFET 在内广泛的模拟和数字电路参数提取需求,同时最大限度地减少 IC 设计工程师的猜测和设置功夫。 Calibre xACT 平台可借由自动优化电路参数提取技术,针对客户特定的工艺节点、产品应用、设计尺寸大小及电路参数提取目标,实现精准度和周转时间 (TAT) 的最佳组合。采用 Calibre xACT 平台进行电路寄生参数提取在满足最严格的精准度要求的同时,还让客户体验到了减少高达 10 倍的周转时间。“xACT平台采用了Mentor独特的算法,拥有一个可扩展架构,能在现代化的计算环境中充分利用多个 CPU,在不同的情况下降计算分配到不同的CPU内核进行并行运算。”她解释说,“然而,对于全芯片而言,我们需要处理数十亿晶体管的设计,还包括顶层的数千万条内部互连。经过客户使用验证,在使用8个CPU的情况下,通常每小时可提取4~8百万个网表,比其他竞争产品快2~3倍。”
同时Shu-Wen Chang强调,CalibrexACT电路参数提取平台与整个Calibre产品线整合,实现了无缝验证流程,其中包括用于完整晶体管级模型的CalibrenmLVS 产品,以及用于针对极高精准度电路参数提取应用的CalibrexACT 3D 产品。此外,它还纳入了第三方设计环境和格式,以确保与现有的设计和仿真流程相兼容。
用于先进封装技术的检测设备
物联网和移动消费电子的爆发驱动了半导体市场的增长,而电子行业的最终驱动力来自于客户对终端产品的需求。“消费类移动电子产品持续不断地推动着生产更小、更快,且更强大的设备,消费者要求产品具有更长的续航能力,更低的价格,更丰富多彩的功能,以及更便捷的网络连接。这对半导体技术提出了更多技术挑战和风险。例如EUV等先进的光刻工艺,新材料存储技术,2D到3D工艺转换,工艺视窗控制以及先进封装技术等挑战。” KLA-Tencor(科天)销售总经理任建宇表示。“对先进封装技术而言,它可以带来设备性能优势,例如增加带宽以及改善能效。但是,封装生产方法则更为复杂,这涉及典型的前端 IC 生产工艺的实施如化学机械抛光和高纵横比蚀刻,以及独一无二的工艺如临时焊接和晶圆再造。例如,在封装中,最初的键合尺寸是100微米,后来逐渐发展到今天的10微米。同时,线宽和间距也在不断的缩小,由之前的10微米一直发展到今天的1微米。更多新的封装技术仍在不断的涌现,比如TSV,3D封装等。封装复杂度在提升,导致封装的成本在提高。诸如缺陷、良率等问题,‘找到才能解决’,‘能量测才能控制’,因此,在封装技术中,检测和量测也变得越来越重要。结合科天在前端半导体工艺控制中的专业技术,以及在与世界级的先进封装研发公司和产业联盟合作过程中取得的经验,科天开发出了灵活而高效的缺陷检测解决方案,可帮助解决从晶圆级至最终组件所遇到的封装挑战,例如提升良率,降低成本,缩短上市周期,降低风险等等。”
科天资深营销总监Prashant Aji认为,在封装技术领域面临着如下转折:由移动设备驱动的缩小尺寸,晶圆级封装的出现,转向OSAT(外包半导体封装测试),采用工艺前端IC步骤,封装成本等等。“消费电子产品一直朝着轻薄短小演进,这就要求硬件电路连线和空间、焊球尺寸和间距、产品封装等尺寸等都要更小,而晶圆上做TSV越来越多,传统的封装过程被打破,复杂性提高,先进封装被引入到中端制成过程。尺寸要求和封装要求都越来越小,线宽越来越窄,硅片堆叠层数越来越多,在高成品率的要求下,检测良测成了重中之重。他表示,KLA-Tencor是目前唯一一家拥有全线检测装置的厂商,晶圆级到RDL、TSV直到最后的封装,KLA-Tencor都有相应的检测设备可以使用。
为了满足封装市场逐渐上升的需求,科天推出两款新产品CIRCL-AP和 ICOST830以支持先进半导体封装技术检测。据Prashant Aji介绍,CIRCL-AP 针对晶圆级封装中多种工艺制程的检测与工艺控制而设计,不仅拥有高产量,还能进行全表面晶圆缺陷检测、检查和测量。ICOS T830 可提供IC 封装的全自动化光学检测,利用高度灵敏的 2D 和 3D 来测量广范的器件类型和不同尺寸的最终封装品质。这两款系统都可以帮助 IC 制造商和封测代工厂 (OSAT) 在采用创新的封装技术时应对各类挑战,例如更细微的关键尺寸和更紧密的间距要求。
这两款系统都可以帮助 IC 制造商和封测代工厂在采用创新的封装技术时应对各类挑战,例如更细微的关键尺寸和更紧密的间距要求。Prashant Aji表示,中国已经成为世界最大的电子市场,未来也具有无限的潜力。”虽然现在中国封装技术仍较落后,但是也看到一些封装企业在快速成长,例如长电、南通富士通、天水华天等,我们与他们也有合作。整体封装技术水平虽然仍有差距,但是我认为他们最大的挑战是在取得市场方面。因为后进者意味着目前的市场已经被占有,而他们要经过客户的测试验证还需时间。但是对他们而言,反而更容易采用更先进的技术。未来,科天将与客户一起,持续不断的努力提升良率,改进技术,帮助客户降低成本,更好的面对新的技术挑战。
责任编辑:tzh
-
半导体
+关注
关注
339文章
31471浏览量
267634 -
IC
+关注
关注
36文章
6497浏览量
186747 -
eda
+关注
关注
72文章
3162浏览量
184103
发布评论请先 登录
安森美半导体产品/工艺变更通知解读
半导体制造中的侧墙工艺介绍

半导体先进封装“Bumping(凸点)”工艺技术的详解;

目前最先进的半导体工艺水平介绍
【「AI芯片:科技探索与AGI愿景」阅读体验】+半导体芯片产业的前沿技术
AI驱动半导体测试变革:从数据挑战到全生命周期优化

国内最大!长飞先进武汉基地投产,明治传感助力半导体智造升级
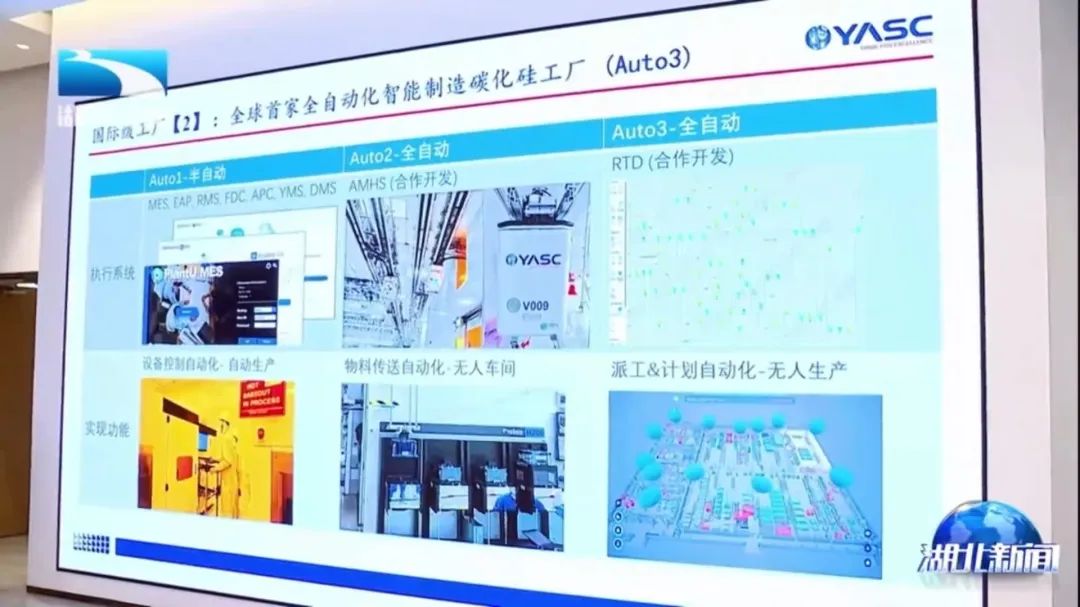
高精度半导体冷盘chiller在半导体工艺中的应用




 先进半导体工艺面临哪些挑战?
先进半导体工艺面临哪些挑战?










评论