随着HDI(高密度互连)PCB市场需求的增加,市场的需求也随之增加。然而,传统的工艺流程具有一些缺点,包括复杂性,高成本,长生产周期和低OTD(准时交付)。为了降低成本,减少工艺流程,缩短生产周期,盲孔填充技术从以前的点镀盲孔填充发展到现在的镀层盲孔填充技术。这种新型的盲孔电镀技术既可以降低生产成本,又可以提高HDI板的质量。此外,它甚至可以促进OTD的增加,为制造商提供服务更多不耐烦的客户的机会。
不同的HDI PCB客户有不同的设计要求,必须遵循合理的生产工艺流程控制成本,确保质量。本文将通过分析不同类型的HDI板来展示和讨论HDI PCB的一些类型的工艺流程。
点镀盲孔填充工艺流程的比较面板电镀盲孔填充
与点镀裸眼填充工艺相比,面板电镀盲孔填充的工艺复杂程度要低得多通过电镀专业解决方案填充盲孔。这里是点镀盲孔填充工艺:
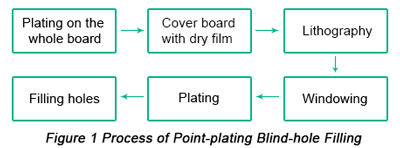
基于段之间的比较对于点镀盲孔填充和镀层盲孔填充的数据(图2),很明显表明前者盲孔上的铜比后者厚得多。额外的铜需要用砂带擦拭,砂带对铜帽有很大的拉力,导致电路松动甚至报废。
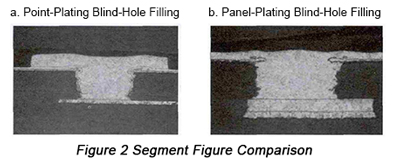
然而,在电镀盲孔填充后,盲孔上的铜是如此均匀,可以省略三个步骤,包括盲孔电镀图形,薄膜剥离和摩擦通过砂带,减少了工艺流程,降低了生产成本,避免了砂带引起的废料。
面板电镀盲孔填充技术
面板电镀盲孔填充技术基于超级填充模块。对于镀铜,盲孔底部的电沉积速率大于表面的电沉积速率。盲孔底部和表面上的三种发光剂的分布如图3所示。

根据电镀发光剂的属性和电化学原理,这些发光剂的作用原理是:
a。由于流平剂具有正电流,因此在孔的边缘容易被吸收,负电最多,并且消散缓慢。因此,孔底部的流平剂浓度会降低。
b。流平剂能够减少极化,促进铜沉积,细化晶粒。它在密度较小的区域聚集在一起,电流消耗速度快,因此加速剂的浓度在孔底逐渐增大。
c。在具有负电力并具有最强对流的孔的边缘处,流平剂将停止孔的边缘而不是抑制剂。
面板电镀的应用HDI板内平面的盲孔填充
面板电镀盲孔填充技术广泛应用于HDI板的盲孔。但是,不同类型的HDI板应与不同的工艺流程配对,以便根据不同客户的要求选择合适的工艺流程。
根据HDI的定义电路板订单,每个盲孔制造都可以视为HDI板的订单。基于现有技术,HDI板中每个订单的生成需要堆叠,这意味着只要涉及最终的堆叠,它就被称为HDI板内层的面板电镀盲孔填充。
•内部平面只有盲孔的HDI板
内部平面只有盲孔的HDI板是指仅有HDI板的HDI板盲孔与其他飞机的其他电路连接。堆叠如图4所示。
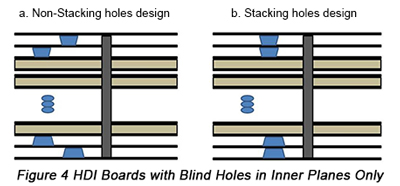
对于设计A的电路板,盲当完成足够的电镀铜时,孔不需要完全填充或平整。对于设计B的电路板,盲孔必须完全填满并平整。
当盲孔不需要填充或平整时,使用的电镀参数能够使盲目 - 孔铜符合相应的要求,并确保内青铜的厚度在17.1μm至34.3μm的范围内。当盲孔需要填充和平整时,使用的电镀参数既能确保填充和平整的完成,又能使内部青铜的厚度超过34.3μm。因为盲孔不需要填充或平整以用于非堆叠孔,因此不需要铜消除的工艺流程,当内部铜的厚度需要为34.3μm时,内部平面中的盲孔制成填充孔。基于上述两种类型的HDI板,根据内铜的不同厚度的工艺流程如下所示:
(1)非堆叠盲孔设计:内部铜的厚度为17.1μm
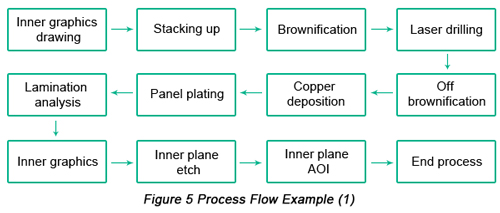
(2)堆叠盲孔设计:内部铜厚17.1μm
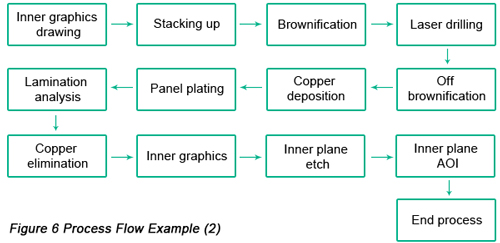
(3)当内部铜厚度达到17.1μm时,在内部堆叠孔设计和非堆叠孔设计中填充盲孔并使其平整。
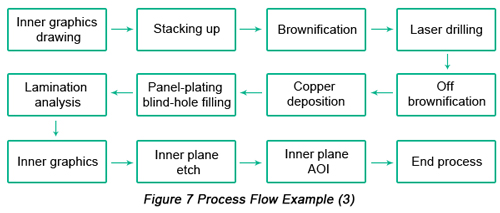
根据以上分析,当内盲孔采用堆垛设计时,必须使用相对较大的填充参数,使盲孔填满并平整,以确保盲孔填充和平整。然后必须将铜切割成所需的厚度。因此,在上述三种工艺流程中,通过调整孔填充参数,可以控制表面铜的厚度。
•内部平面内有盲孔和埋孔的HDI板
此类HDI板可分为:非堆叠盲孔和埋孔,堆叠盲孔和非堆叠埋孔,堆叠埋孔和非堆叠盲孔,堆叠盲孔和埋设
对于这种类型的HDI板,必须考虑盲孔的填充和平整程度,并且必须满足埋孔铜的要求。通常,这种类型的内部铜厚度为34.3μm。
面板电镀盲孔填充只能用于生产厚度与半径小于6:1的电路板。但是,对于厚度半径大于6:1的电路板,必须采用电镀工艺,以满足盲孔铜的相应要求。因此,应分别制作盲孔和埋孔,即应首先填充盲孔并将其打平,然后通过电镀孔对埋孔进行电镀。
由于盲孔全部产生无论是否堆积盲孔都与工艺流程设计无关,使它们充满和平整。只要确定埋孔是堆叠还是非堆叠,就可以了。具体流程如下所示:
(1)埋孔的厚度与半径小于6:1,埋孔不堆叠。

(2)埋孔的厚度与半径小于6:1埋设孔堆叠。
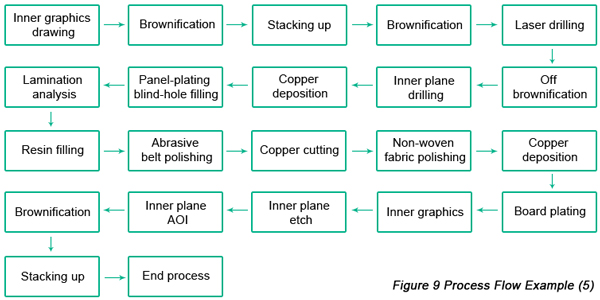
(3)埋孔的厚度与半径大于6:1,埋孔非堆叠。

(4)埋孔的厚度与半径大于6:1,埋设孔堆叠。

根据上面显示的工艺流程,可以使用凝胶填充的堆叠代替树脂填充。在使用凝胶填充技术的堆叠中需要具有大量凝胶的PP。虽然这种PP比普通PP贵得多,但可以节省生产工艺,所用的树脂也可以。考虑到成本,该技术可以帮助降低HDI PCB的生产成本和时间。
-
微盲孔填充
+关注
关注
0文章
2浏览量
5859 -
PCB打样
+关注
关注
17文章
2977浏览量
23328 -
华强PCB
+关注
关注
8文章
1831浏览量
29128 -
华强pcb线路板打样
+关注
关注
5文章
14629浏览量
44374
发布评论请先 登录
芯片底部填充工艺流程有哪些?






 点镀盲孔填充工艺流程简介
点镀盲孔填充工艺流程简介













评论