关键词:垫圈, 止动垫圈, 垫圈类型, 锁定
人们说的止动垫圈是什么?垫圈是螺母、螺栓或紧固件下面的金属或非金属材料。主要用于阻止泄漏或仅阻止振动松动。除此之外, 它们还有助于分散施加在孔或接头上的压力。
止动垫圈是为紧固件制造的, 这些紧固件往往会因振动或摩擦而松动。虽然止动垫圈有许多不同的类型, 但它们都试图实现相同的目的, 即将紧固件锁定到位。垫圈尺寸可以是英制或公制单位。如果您没有特定的尺寸, 大多数制造商都能够定制一个适合您使用的垫圈。也可以依据ANSI、SAE、USS和JIS尺寸制造垫圈。
我们目前常见的垫圈类型有开口销、密封、内齿、外齿、平面和平面固定型。下面将介绍每种垫圈的特点及其用途。
开口销 - 开口销也称为螺旋弹簧止动垫圈。它们由切割或分开的弹簧线圈制成。这使得线圈的两端向外推到配合面。因此, 当垫圈固定时, 线圈的每一端都会咬入螺丝头部的表面以及您固定的表面上。
密封型- 密封垫圈使用硅胶材料, 并粘合在垫圈的钢上。它们可与螺丝、螺栓和螺母一起使用。它们是满足任何密封需求的简单解决方案。它们是在垫圈的底部带有密封垫圈表面的密封件, 顶部的密封件包住柄部, 并且在紧固件的头部下方形成从顶部到底部的完全密封。
内齿型 - 内齿型垫圈在内侧上具有倒齿, 并且垫圈的外侧是光滑的。它们适用于头部较小的紧固件。当紧固件的头部固定到孔中时, 内齿将有助于抓住表面, 同时抵抗被压缩的垫圈的力。
外齿型-外齿在垫圈的外圈上具有齿, 使得它们实际上可以咬入其所放置的表面, 而其内圈仍然是圆柱形孔。它们专为头部较大的紧固件而设计。当头部被固定到孔中时, 外齿将有助于抓住表面, 同时抵抗被压缩的垫圈的力。
平面固定型1 -这些垫圈有多个孔, 因此您可以拧紧或固定垫圈, 第二个孔用于将电线连接到螺丝或螺栓上。
更多垫圈相关的技术信息,请参阅:
提示点击菜单设计支持:工程师锦囊,获取更多工程师小贴士
好东西,要分享
如果小伙伴觉得这个内容不错
请点下右下角「在看」或分享到朋友圈
如有任何问题, 欢迎联系得捷电子Digi-Key的客服团队。
中国(人民币)客服
- 400-920-1199
- service.sh@digikey.com
-QQ在线实时咨询(QQ号:4009201199)
中国(美金)/ 香港客服
- 400-882-4440
- 852-3104-0500
- china.support@digikey.com
关注Digi-Key得捷电子官方微信,定时接收工程师信息和秘籍分享。
原文标题:小垫圈,里面还有这么多名堂……
文章出处:【微信公众号:得捷电子DigiKey】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
ADL5545 ADL5521 为什么2个一样的布局前一级增益和后一级增益相差这么多?



为啥现在这么多人学物联网?
为什么学校、高校、校园都在使用预付费电能表?原来有这么多好处!

工业上面为什么有这么多通讯协议?


今日看点丨台积电开除多名违规获取2纳米芯片信息的员工,苹果脑控实机视频曝光
只是加减速和转弯,为啥自动驾驶这么难实现?

不止是测光谱,地物光谱仪在农业和环保中还有这些用处




 小垫圈,里面还有这么多名堂……
小垫圈,里面还有这么多名堂……



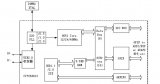



评论