去除表面钝化层、金属化层和层间介质后有时依然无法观察到失效点,这时候就需要对芯片进行进一步处理,对于多层布线的芯片干法腐蚀或者湿法腐蚀来逐一去除,直至最后一层金属化和介质层。
去玩所有的金属化层和介质层后,有时候还需要去除多晶硅层、氧化层等直至露出硅本体。
芯片失效分析
由于层间介质的材料与钝化层材料种类基本相同,因此层间介质的去除也是类似的,也是主要分为干法腐蚀和湿法腐蚀两种。这里值得注意的是,FIB同样可以运用到失效分析的局部去层处理中。
聚焦离子束系统是利用电子透镜将离子束聚焦成很小尺寸的纤维精细切割仪器,它由聚焦状态的离子探针对物体表面进行点状轰击。由于FIB也具有成像功能,所以在进行局部剥层之后也便于对失效点进行观察。
FIB技术的运用
FIB技术如今十分活跃在半导体集成电路领域。因为它在材料的刻蚀、沉积、注入、改变物化性能等方面具有显著优势,所以被很多内行人期待成为半导体集成电路领域最主要的加工手段。
FIB技术
现阶段FIB技术主要应用在以下方面:
1.光掩模的修补;
2.集成电路的缺陷检测分析与修整;
3.TEM和STEM的薄片试样制备;
4.硬盘驱动器薄膜头的制作;
5.扫描离子束显微镜;
6.FIB的直接注入;
7.FIB曝光(扫描曝光和投影曝光)
8.多束技术和全真空联机技术;
9.FIB微结构制造(材料刻蚀、沉积)
10.二次离子质谱仪技术。
审核编辑:刘清
-
集成电路
+关注
关注
5446文章
12469浏览量
372696 -
半导体
+关注
关注
336文章
29985浏览量
258341 -
芯片失效分析
+关注
关注
0文章
14浏览量
259
原文标题:聚焦离子束与芯片失效分析
文章出处:【微信号:zhixinkeji2015,微信公众号:芯片逆向】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
FIB聚焦离子束电路修改服务
失效分析:离子束剖面研磨
Dual Beam FIB(双束聚焦离子束)
聚焦离子束显微镜(FIB-SEM)
聚焦离子束应用介绍
聚焦离子束双束系统在微机电系统失效分析中的应用
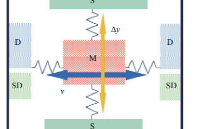
聚焦离子束技术:纳米加工与分析的利器






 聚焦离子束与芯片失效分析与运用
聚焦离子束与芯片失效分析与运用




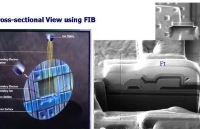
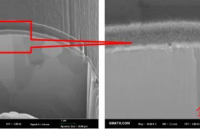











评论