目前存在的两种主要类型的场效应管是:JFET和MOSFET。
MOSFET可进一步分为耗尽型和增强型。这两种类型都定义了MOSFET的基本工作模式,而术语MOSFET本身是金属氧化物半导体场效应晶体管的缩写。
由于这两种类型具有不同的工作特性,我们将在不同的文章中分别评估它们。
增强型和耗尽型MOSFET之间的区别
基本上,与增强型MOSFET不同,耗尽型MOSFET即使在栅源端两端存在0 V电压时也处于导通状态(V一般事务人员)。
对于增强型MOSFET,栅源电压(VGS)必须高于其栅源阈值电压(VGS(th))才能使其导通。
但是,对于N沟道耗尽MOSFET,其VGS(th)值高于0 V。这意味着即使V一般事务人员= 0
V,耗尽型MOSFET能够传导电流。要关闭它,V一般事务人员的耗尽MOSFET需要降低到VGS(th)(负)以下。
在本文中,我们将讨论耗尽型MOSFET,据说其特性与JFET相匹配。相似性是I附近的截止和饱和之间DSS。
基本建设
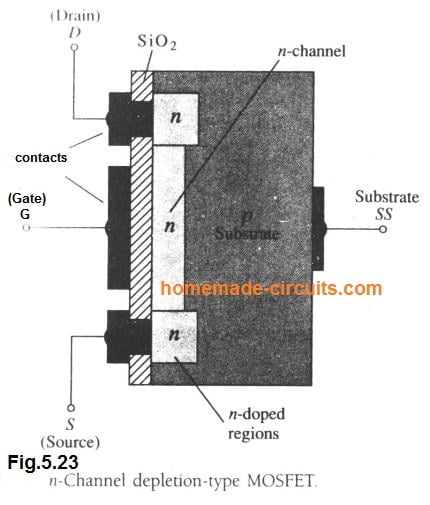
图5.23显示了n沟道耗尽型MOSFET的基本内部结构。
我们可以找到一块使用硅基创建的p型材料。该块称为基板。
基板是构建MOSFET的基座或基础。对于某些MOSFET,它与“源极”端子内部连接。此外,许多器件以SS的形式提供额外的输出,具有4端子MOSFET,如图5.23所示。
漏极和源极端子通过导电触点连接到n掺杂位置,并通过n通道连接,如图所示。
栅极也连接到金属层,尽管它通过一层细小的二氧化硅(SiO)与n沟道绝缘2)。
二氧化硅2具有一种称为电介质的独特形式的绝缘性能,它响应外部施加的电场,在自身内部产生相反的电场。
作为绝缘层,材料SiO是2为我们提供以下重要信息:
使用这种材料在栅极端子和MOSFET沟道之间实现了完全隔离。
而且,这是因为SiO2,MOSFET 的栅极能够具有极高的输入阻抗。
由于这种至关重要的高输入阻抗特性,栅极电流IG对于任何直流偏置 MOSFET 配置,电流几乎为零。
基本操作和特点

如图5.24所示,通过将两个端子连接在一起,栅极到源极电压已配置为零伏,而电压VDS应用于漏极和源极。
通过上述设置,漏极侧通过n沟道自由电子建立正电位,以及通过JFET沟道的等效电流。此外,产生的电流V一般事务人员= 0V 仍被标识为
IDSS,如图所示。5.25

我们可以看到,在图5.26中栅极源电压V一般事务人员以-1V的形式被赋予负电位。
这种负电位试图迫使电子朝向p沟道衬底(因为电荷排斥),并从p沟道衬底上拉出空穴(因为相反的电荷吸引)。
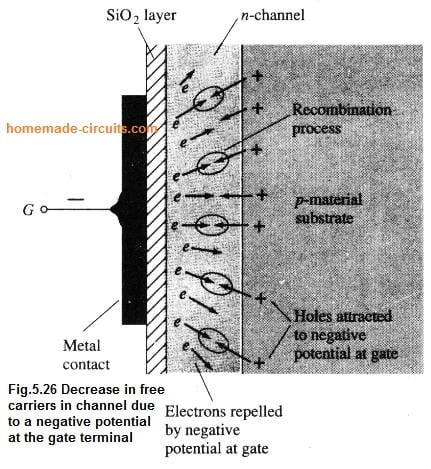
取决于这个负偏置 V 的大小一般事务人员是,空穴和电子的复合发生,导致可用于传导的n通道中的自由电子减少。负偏差水平越高,复合率越高。
因此,随着上述负偏置条件的增加,漏极电流会降低,图5.25证明V的漏极电流一般事务人员V 的水平一般事务人员= -1、-2 等,直到 -6V
的夹断标记。
因此,漏极电流以及传输曲线图与JFET一样进行。
现在,对于正 V一般事务人员值,由于反向漏电流,栅极正极将从p型衬底吸引多余的电子(自由载流子)。这将通过加速粒子之间的碰撞来建立新的载流子。
由于栅源电压趋于以正速率上升,漏极电流会迅速增加,如图5.25所示,原因与上述相同。
V曲线之间的差距一般事务人员= 0V 和 V一般事务人员= +1 清楚地显示了由于 V 的 1 - V 变化而导致电流增加的量一般事务人员
由于漏极电流的快速上升,我们必须注意最大额定电流,否则可能会超过正栅极电压限制。
例如,对于图5.25中描述的设备类型,应用V一般事务人员= +4V会导致漏极电流上升至22.2 mA,可能超过器件的最大击穿限值(电流)。
上述条件表明,使用正栅源电压对通道中自由载流子的数量产生增强的影响,而不是当V一般事务人员= 0V。
这就是为什么漏极或传输特性上的正栅极电压区域通常称为增强区域的原因。该区域位于I的截止值和饱和度之间DSS或耗尽区域。
解决示例问题

优势与应用
与增强型MOSFET相比,我们发现漏极电流在栅源电压为零时降至零,而现代耗尽模式FET具有明显的电流,栅极电压为零。确切地说,漏源电阻在零电压下通常为100欧姆。

如上图所示,导通电阻
rds(开)与模拟信号范围相比,响应几乎是平坦的。这一特性与这些高级耗尽型器件的低电容水平相结合,使其成为音频和视频切换应用模拟开关的理想选择。
耗尽模式 MOSFET 的“常导通”属性使该器件非常适合单个 FET 电流稳压器。
下图中可以看到一个这样的示例电路。

Rs 值可以使用以下公式确定:
Rs= VGS关闭[ 1 - ( ID/我DSS)1/2] / ID
哪里我D是输出端所需的调节电流量。
耗尽型MOSFET在电流源应用中的主要优点是其最小的漏极电容,这使得它们适合低输入漏电流、中速(》50 V/us)电路中的偏置应用。
下图显示了采用双低漏电功能FET的低输入漏电流差分前端。

一般来说,JFET的任一侧都会在ID = 500 uA时偏置。因此,充电补偿和杂散电容可获得的电流被限制为2ID,在这种情况下,限制为1.0
mA。JFET的相应功能经过生产验证,并在数据表上得到保证。
Cs
表示输入级“尾部”电流源的输出电容。该电容在同相放大器中至关重要,因为输入级在整个网络中经历大量的信号交换,并且Cs中的充电电流可能很大。如果使用正常电流源,该尾电容可能是导致同相电路中明显压摆率下降的原因(与反相应用相比,其中Cs中的充电电流往往很小)。
压摆率的下降可以表示为:
1 / 1+ (铯/铈)
只要Cs低于Cc(补偿电容),压摆率几乎不会有任何变化。使用DMOS FET,Cs可以达到2 pF左右。这种策略极大地改善了压摆率。如果需要高于 1
至 5 mA 的电流不足,可将器件偏置至增强模式,以产生高达 20 mA 的电流,最大 V一般事务人员+2.5 V,最小输出电容仍然是关键方面。
下面的下一个应用展示了一个合适的增强模式电流源电路。

可以构建“常导”模拟开关,以满足在电源电压故障期间需要标准条件的要求,例如自动校准测试工具或确保在开关导通时准确启动逻辑电路。
该器件降低的负阈值电压提供了基本的驱动先决条件,并允许以最小电压工作。
下面的电路演示了任何耗尽模式DMOS模拟开关的常见偏置因素。
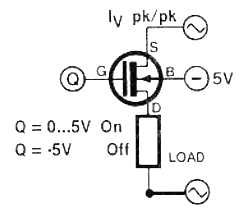
为了使器件关断,栅极上必须有一个负电压。话虽如此,当FET使用正栅极电压额外增强时,导通电阻可以最小化,使其专门用于增强模式区域和耗尽模式区域。
下图中可以看到此响应。
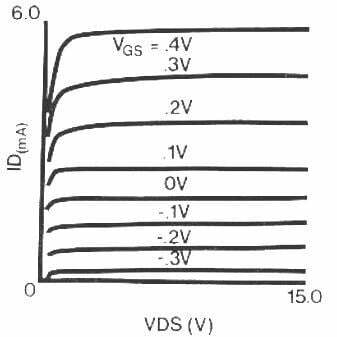
该器件的高频增益及其低电容值提供了更高的“品质因数”。它确实是VHF和UHF放大中的关键元件,它指定了FET的增益带宽积(GBW),可以描述为:
GBW = gfs / 2π(C在+ C外)
p沟道耗尽型MOSFET
p沟道耗尽型MOSFET的结构与图5.23所示的n沟道版本完全相反。这意味着,基板现在采用n型的形式,通道变为p型,如下面的图5.28a所示。
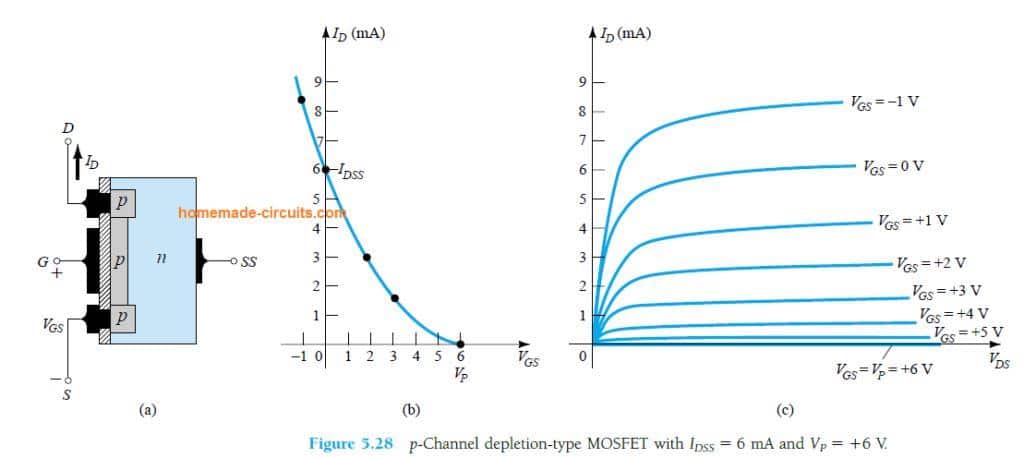
端子标识保持不变,但电压和电流极性相反,如图所示。漏极特性与图5.25所示完全相同,但V除外DS符号,在这种情况下将获得负值。
漏极电流ID在这种情况下也显示出正极性,那是因为我们已经颠倒了它的方向。V一般事务人员显示相反的极性,这是可以理解的,如图5.28c所示。
因为V一般事务人员反转产生传输特性的镜像,如图5,28b所示。
这意味着,漏极电流在正V中增加一般事务人员从V处的截止点开始的区域一般事务人员= Vp 直到我DSS,然后它继续上升为 V
的负值一般事务人员上升。
符号

n沟道和p沟道耗尽型MOSFET的图形符号可以在上图中看到。5.29.
观察所选符号旨在表示设备真实结构的方式。
栅极和通道之间没有直接互连(由于栅极绝缘)由栅极和符号的不同端子之间的间隙表示。
代表沟道的垂直线连接在漏极和源极之间,并由基板“固定”。
上图中为每种类型的通道提供了两组符号,以强调在某些设备中,基板可以从外部访问,而在另一些设备中可能看不到。
场效应管(增强型)
虽然耗尽型和增强型MOSFET的内部结构和功能模式看起来相似,但它们的特性可能大不相同。
主要区别在于漏极电流取决于用于切断动作的特定栅源电压水平。
确切地说,n沟道增强型MOSFET可以在正栅极/源极电压下工作,而不是通常会影响耗尽型MOSFET的一系列负电位。
基本建设
您可以在下图
中可视化n沟道增强型MOSFET。5.31.
p型材料部分是通过硅基创建的,并且在将其称为衬底之前所了解的。
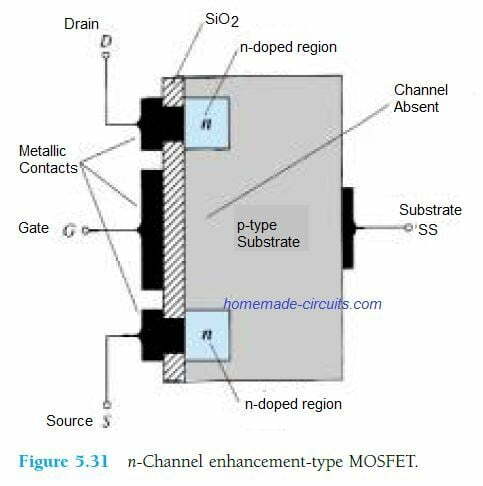
在某些情况下,该基板在耗尽型MOSFET中与源极引脚内部连接,而在某些情况下,它作为第四根引线端接,以实现对其电位电平的外部控制。
源极和漏极端子像往常一样使用金属触点连接到n掺杂区域。
但是,在图中将其可视化可能很重要。5.31 两个N掺杂区域之间的通道缺失。
这可以被认为是耗尽型和增强型MOSFET内部布局之间的根本区别,即缺少本应是器件一部分的固有通道。
碳化硅2可以看到层仍然普遍存在,这确保了栅极端子的金属基座与漏极和源极之间的区域之间的隔离。然而,在这里可以看到它与p型材料部分分开站立。
从上面的讨论中,我们可以得出结论,耗尽和增强MOSFET的内部布局可能有一些相似之处,除了增强型MOSFET的漏极/源极之间缺少通道。
基本操作和特点
用于增强型MOSFET,当在其V处引入0
V时一般事务人员,由于缺少n沟道(已知携带大量自由载流子)导致电流输出为零,这与耗尽型MOSFET完全不同,具有ID= IDSS.
在这种情况下,由于漏极/源极的路径缺失,大量电子形式的载流子无法在漏极/源极积聚(由于n掺杂区域)。
在V处应用一些正电位DS,带
V一般事务人员设置为零伏,SS端子与源极端子短路,我们实际上在n掺杂区域和p基板之间发现了几个反向偏置的p-n结,以实现任何明显的导通,通过漏极到源极。
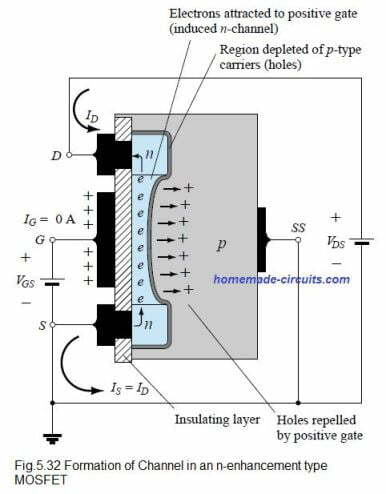
在图内。5.32 显示 V 的条件DS和 V一般事务人员施加一些高于 0 V 的正电压,使漏极和栅极相对于源极处于正电位。
栅极处的正电位推动p基板上沿SiO边缘的孔2层离开该位置并更深入地进入p基底的区域,如上图所示。发生这种情况是因为相互排斥的类似电荷。
这导致在SiO附近产生耗尽区域2无孔的绝缘层。
尽管如此,作为材料的少数载流子的p衬底电子被拉向正栅极并开始聚集在靠近SiO表面的区域。2层。
由于SiO的绝缘性能2层负载流子允许负载流子在栅极端子处被吸收。
随着我们增加 V 的水平一般事务人员,电子密度接近SiO2表面也增加,直到最终诱导的n型区域能够允许跨漏极/源极的可量化传导。
五世一般事务人员导致漏极电流最佳增加的幅度称为阈值电压,用符号VT表示。在数据表中,您将能够将其视为 V总(千)。
如上所述,由于 V 处没有通道一般事务人员= 0,并且随着正栅源电压应用的“增强”,这种类型的MOSFET被称为增强型MOSFET。
您会发现耗尽型和增强型MOSFET都具有增强型区域,但术语增强用于后者,因为它专门使用增强工作模式。
现在,当V一般事务人员被推超过阈值,自由载流子的浓度将在诱导它的通道中提高。这会导致漏极电流增加。
另一方面,如果我们保持
V一般事务人员常数并增加VDS(漏源电压)水平,这将最终导致MOSFET达到其饱和点,这通常也会发生在任何JFET或耗尽MOSFET上。

如图所示。5.33 漏极电流ID借助夹断过程趋于平稳,由朝向感应通道漏极端的较窄通道指示。
通过将基尔霍夫电压定律应用于图中MOSFET的端电压。5.33,我们得到:

如果 V一般事务人员保持恒定为特定值,例如 8 V 和 VDS从 2 V 升高到 5 V,电压 V危险品方程5.11从-6 V下降到-3
V,栅极电位相对于漏极电压越来越小。
这种响应禁止自由载流子或电子被拉向感应通道的该区域,这反过来又导致通道的有效宽度下降。
最终,通道宽度减小到夹断点,达到类似于我们在之前的耗尽MOSFET文章中已经学到的饱和条件。
意思是,增加 VDS任何进一步的固定 V一般事务人员不影响 I 的饱和度D,直到达到故障情况。
查看图 5.34,我们可以确定图 5.33 中的 MOSFET 具有 V一般事务人员= 8 V,饱和发生在 VDS电平为 6
V。准确地说,VDS饱和度与应用的 V 相关联一般事务人员级别依据:

毫无疑问,它因此意味着当 VT值是固定的,增加V的水平一般事务人员将成比例地导致 V 的饱和度更高DS通过饱和水平的轨迹。
参考上图所示的特性,VT电平为2 V,漏极电流已降至0 mA这一事实就可以看出这一点。
因此,通常我们可以说:
当VGS值小于增强型MOSFET的阈值电平时,其漏极电流为0 mA。
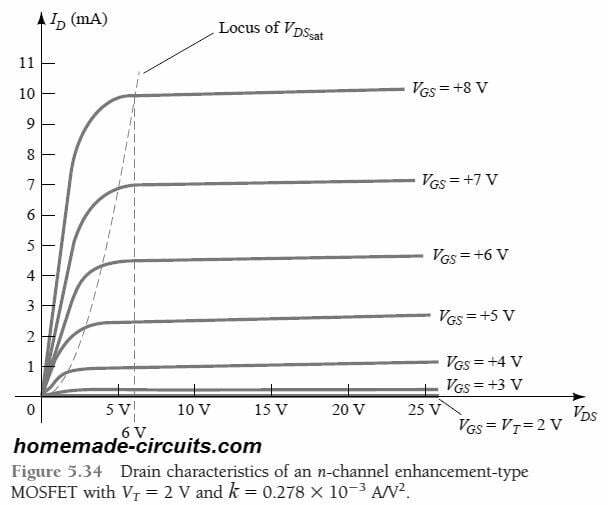
从上图中我们也可以清楚地看到,只要V.一般事务人员从 V 提高到更高T至 8 V,I 的相应饱和水平D也从 0 增加到 10 mA 电平。
此外,我们可以进一步注意到 V 之间的空间一般事务人员水平随着 V 值的增加而增加一般事务人员,导致漏极电流无限上升。
我们发现漏极电流值与V的栅源电压有关。一般事务人员通过以下非线性关系大于 VT 的水平:

方括号所示的项是负责I之间非线性相关性的项D和 V一般事务人员。
术语k是一个常数,是MOSFET布局的函数。
我们可以通过以下等式找出这个常数 k 的值:
其中 ID(开)和 V广东(上)每个值都专门取决于设备的特性。


在下图中。5.35 下面我们发现漏极和转移特性一个并排排列,以阐明彼此之间的转移过程。
基本上,它类似于前面解释的JFET和耗尽型MOSFET的过程。
但是,对于本例,我们必须记住,V的漏极电流为0 mA一般事务人员VT.
在这里我D可能会看到明显的电流量,根据公式 5.13 确定,电流会增加。
请注意,在从漏极特性定义传递特性上的点时,我们只考虑饱和度水平。这会将操作区域限制为高于方程 (5.12) 确定的饱和水平的 VDS 值。
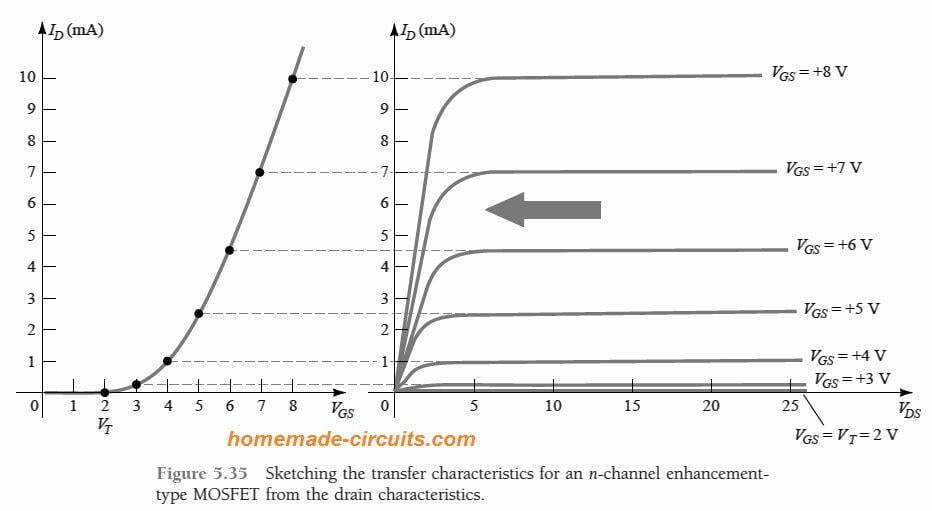


p沟道增强型MOSFET
p沟道增强型MOSFET的结构如图所示。5.37a 与图 中显示的正好相反。5.31.
这意味着,现在你会发现n型基板和p掺杂区域在漏极和源极接头下方。
端子继续保持既定状态,但每个电流方向和电压极性都相反。
漏极特性如图所示。5.37c,具有不断增加的电流量,由V的连续更负的幅度引起一般事务人员。
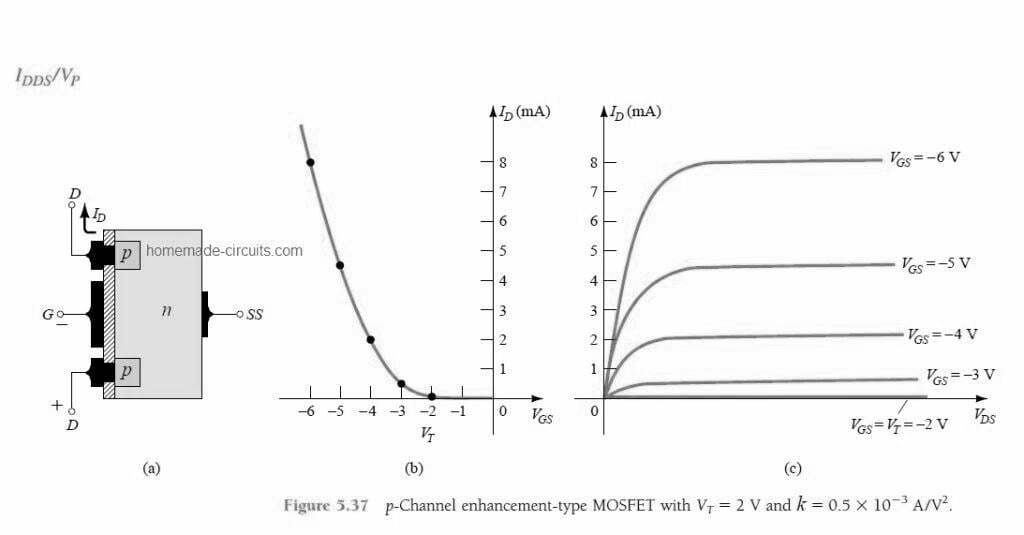
转移特性将是镜像印象(围绕 ID轴)的传递曲线。5.35,有我D随着 V 的负值越来越多而增加一般事务人员以上 VT,如图所示。5.37b. 公式
(5.11) 至 (5.14) 同样适用于 p 沟道器件。
-
MOSFET
+关注
关注
150文章
9428浏览量
229677 -
晶体管
+关注
关注
78文章
10262浏览量
146311 -
场效应晶体管
+关注
关注
6文章
401浏览量
20364
发布评论请先 登录
Multisim10.0元件库没P沟道耗尽型MOSFET管,为什么
高手进来看看这个电路图是不是画错了 是耗尽型还是增强型
耗尽型MOSFET的基本概念及主要类型
N沟道和P沟道MOSFET的区别是什么
增强型MOS晶体管,增强型MOS晶体管是什么意思
增强型和耗尽型MOSFET的区别
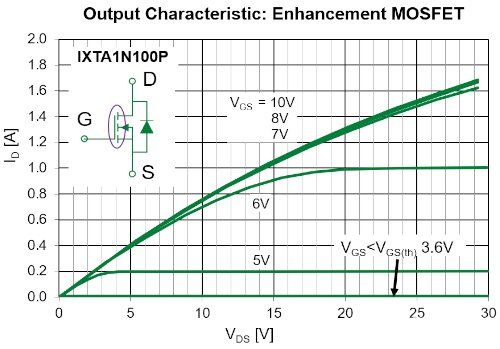
增强型和耗尽型MOS管的区别
mos管增强型与耗尽型的区别是什么
mos管怎么区分增强型和耗尽型
CoolGaN和增强型GaN区别是什么
增强型和耗尽型MOS管的应用特性和选型方案
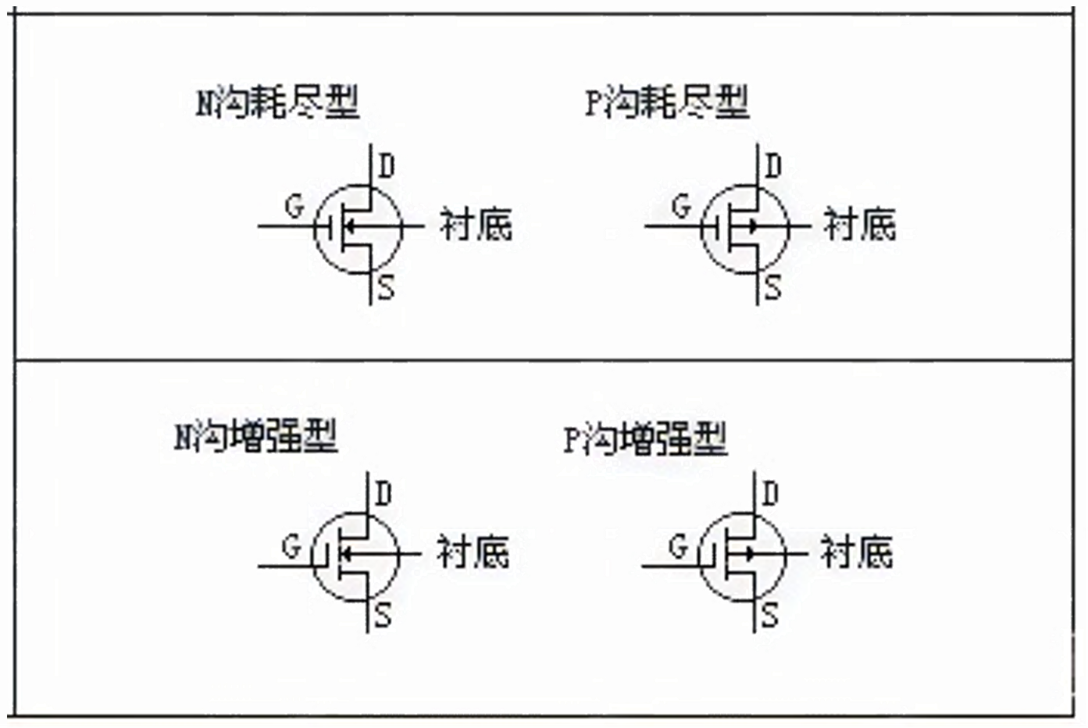





 增强型和耗尽型MOSFET之间的区别是什么?
增强型和耗尽型MOSFET之间的区别是什么?

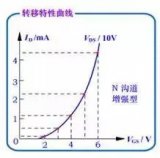










评论