散热问题一直是制约笔记本电脑发展的一大技术瓶颈,并且也严重阻碍了高性能电子芯片的发展,本文通过对散热路径中绕不开的热界面材料分析仿真与优化设计,促进笔记本电脑朝轻薄化方向发展,改善笔记本电脑的散热效果,也将有效地改善发展笔记本电脑的稳定性。
1. 热界面材料
热界面材料(thermal interface materials,TIMs)广泛应用于电子元件散热领域,其主要作用为填充于芯片与热沉之间和热沉与散热器之间,以驱逐其中的空气(空气是热的不良导体,热导率只有 0.025 W/m·K),使芯片产生的热量能更快速地通过热界面材料传递到外部,达到降低工作温度、延长使用寿命的重要作用。

图 1 散热器与发热元器件之间的导热界面材料
1.1分类应用及性能指标
导热界面材料主要有:
(1)导热灌封胶,用于模块的整体封装;
(2)导热硅脂(导热膏),具有一定流动性或呈黏稠状的膏状物,用于填充微小间隙,比如将膏体涂覆在CPU和散热器之间,发热堆和壳体之间,将空气挤压出去,形成散热通道;
(3)导热胶垫,是一种柔性可压缩的弹性材料,在施加一定压力的情况下,能很好地顺应接触不规则的表面,填补固体间的空隙,而又不会对元器件造成污染,用于电子电器产品的控制主板、LED散热、电机内外部垫脚、锂电池热管理等;
(4)导热相变材料,在常温时处于固态,在吸收功率器件热量后,达到一定温度才融化为液态,因此可以很好地浸润固体界面,从而减少热阻,它既能吸收热量,又有良好的传热性,综合了导热硅脂和导热胶垫的优势,既解决了硅脂涂抹操作难的问题,也解决了导热胶垫因为厚度和界面热阻带来的导热效果的问题。
导热界面材料性能指标:
(1)物理指标:密度、颜色、阻燃等级、挥发等级、锥入度、游离度等;
(2)导热性能:热导率、热阻等;热阻与材料的厚度正相关,厚度越大,热阻也越大。因此,在研究导热界面材料的导热性能时,除了关注其导热系数外,还需考虑材料的厚度(影响热阻)、界面接触热阻。导热系数越大、热阻越小,界面材料的导热性能越高。
(3)机械强度:一般针对导热胶垫类产品,通常以拉伸强度、硬度等表示;拉伸强度和硬度用来衡量导热硅胶片的柔软度,导热硅胶片越柔软,填充在间隙中的热阻才越小,因此,必须综合考虑其硬度和强度。
(4)电气性能:体积电阻率、击穿电压等;体积电阻率是每单位体积材料对电流的阻抗,体积电阻率越高,材料用作电绝缘部件的效能越高。
其他导热界面材料:
如导热硅凝胶则是一种凝胶状态的导热材料,通过把有机硅凝胶和导热填料复合在一起形成的一种具有导热性能的有机硅凝胶。它具有较高的导热系数和较低的压缩变形应力,容易操作,可实现应用时的可连续性自动化生产。它能解决导热硅脂性能可靠性差的问题,起到导热垫片的作用,且在某些性能方面,更优于导热垫片。其与导热垫片的比较如表1所示。
表 1 导热硅凝胶与导热垫片的比较

1.2 导热机理及导热填料
导热界面材料一般由聚合物复合导热填料制备,其导热机理最主流的理论为导热通路学说,由于聚合物本身的热导率很低,因此需要填充热导率较高的填料作为导热粒子,而这些导热粒子相互接触构成通路或网络,从而使热流沿着通路由高温向低温传递。因此,导热界面材料的导热性能主要是由填充其中的导热填料所决定。
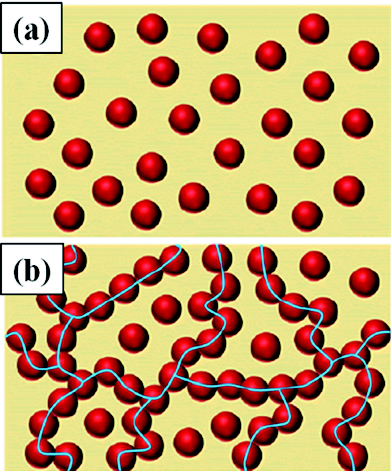
图 2 填料构成的导热粒子网络(通路)
由于导热界面材料大多用于电子散热,因此一般要求其既绝缘又有较好的导热性。常用于导热填料的粉体材料有:Al2O3、AlN、BN、Si3N4、MgO、ZnO、SiC等,其导热系数如表2所示。
表 2 常用导热填料的导热系数(20℃)
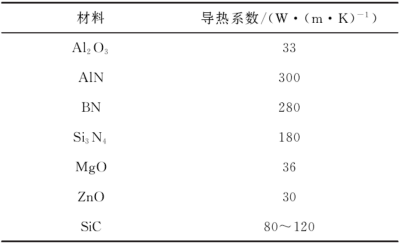
尽管氮化物较氧化物的导热系数更高,但氮化物价格昂贵,同时在填充时黏度较大,填充量受到一定限制。尽管Al2O3导热系数相对不是太高,但其化学性质稳定,绝缘性能好,填充到聚合物中的黏度较低,可以得到很高的填充率,最重要的是价格相对较低,具有极高的性价比,因此 Al2O3是导热填料中用量最多、用途最广泛的一种填料。 随着电子集成技术的高速发展,电子元器件越来越趋于小型化,而功率器件随着运行速度的提升发热量则在不断增加,这就需要用更好的导热界面材料来满足散热要求。作为最大用量的导热填料Al2O3,目前制备的导热界面材料热导率基本在 2~6 W/(m·K)之间,要提高材料的热导率,势必从填充率和导热网络通道方面开发应用潜力,因此,Al2O3导热填料可在如下几个方面进行进一步研究以提高其应用性能。
(1)进一步研究超细亚微米及更细的高导热填料Al2O3,亚微米颗粒可以更好地填充到颗粒之间,不但有利于形成颗粒之间的导热通道,而且还可以降低界面接触热阻。
(2)提高结晶程度和颗粒形貌规整程度,不但有利于颗粒本身热导率,还可以降低黏度,增加填充率。
(3)研究复配工艺提高填充率和导热性能,即不同颗粒大小级配、不同形貌的复配。
(4)通过有效的表面改性,改善Al2O3和有机聚合物直接的浸润性,从而提升 Al2O3填充率。
1.3 国内外产业现状
Laird(莱尔德)、Chomerics(固美丽)、Bergquist(贝格斯,汉高收购)、Fujipoly(富士高分子工业株式会社)、SEKISUI ( 积水化学工业株式会社)、Dow Corning(道康宁-陶氏)、ShinEtsu(信越化学工业株式会社)和 Honeywell(霍尼韦尔)等占据了全球热界面材料 90% 以上的高端市场。我国高端热界面材料基本依赖从日本、韩国、欧美等发达国家进口,国产化电子材料占比非常低,大大阻碍了我国的电子信息产业发展和限制终端企业的创新活力。
热界面材料在电子等行业应用广泛,我国也出台了相关扶持政策促进国内热界面材料产业的发展。例如,2016 年国家科技部启动“战略性先进电子材料”专项,布局了“高功率密度电子器件热管理材料与应用 ”,其中研究方向之一为“用于高功率密度热管理的高性能热界面材料”。
表 3 我国热界面材料产业相关政策

近期(2023年5月)汉高推出符合汽车级可靠性标准的超高导热无压烧结芯片粘接剂Ablestik ABP 8068TI,导热系数为165 W/m-K。汉高粘合剂电子事业部半导体封装材料全球市场部负责人表示:“目前,铅锡膏即将被淘汰且无法满足某些半导体器件的散热需求, 烧结银(Ag)是唯一可以替代铅锡膏的芯片贴装材料。Ablestik ABP 8068TI可在175摄氏度或以上的温度下完全固化,并在界面和环氧树脂本体中建立刚性烧结银网络。对功率半导体而言,烧结芯片贴装是目前实现所需芯片贴装强度、完整性以及导热性和导电性的最主要且最可靠的解决方案。”
1.4 全球市场份额
传统的聚合物基热界面材料在所有产品中占比接近 90% ,相变热界面材料和金属基热界面材料占比较少,但份额逐步扩大。

图 3 全球热界面材料的市场规模(单位:百万美元)
流动态的导热油脂用作导热材料,有利于使用过程中的自动化,并且其热阻很小,是当前市场份额最大的导热界面材料。

图 4 全球热界面材料各组分市场规模(单位:百万美元)
5G 时代下的物联网应用,除了手机和电脑,5G 终端还扩展到了汽车、家用电器、智能穿戴、工业设备等,终端设备的丰富也将直接拉动对导热材料和器件的需求,利好导热材料行业。
表 4 全球热管理市场规模(单位:百万美元)

1.5 国内市场分析
我国本土企业早期缺乏核心技术,主要高端导热材料生产基材还是需要国外生产制作商提供,产品性能指标以及研发积累与欧美企业仍存在一定差距。对比国外知名的热界面材料生产厂商,如日本信越、美国道康宁、德国汉高、美国固美丽等,我国热界面材料生产厂商的性能较差,无法满足高端芯片的封装要求。其主要问题是,我国热界面材料生产的原材料(如有机硅、氧化铝、铝和氮化铝)纯度不够,热界面材料复合工艺水平有待提高。
1.6 研究进展情况
热界面材料主要是由导热填料与聚合物复合而成。导热填料的加入提高了聚合物的导热系数,同时保留了聚合物良好的柔韧性、低成本以及易于加工成型的优点。但是,如何制备出导热系数超过 20 W/mK,且界面热阻值低于 0.01 Kcm2/W仍然是一巨大挑战。针对此难点,在国家重点研发计划——战略性先进电子材料重点专项的资助下,由中国科学院深圳先进技术研究院孙蓉研究员牵头,联合上海交通大学、东南大学、同济大学、中国科学院苏州纳米技术与纳米仿生研究所、中国科学院宁波材料研究所和上海大学,开展高性能热界面材料分子学设计、界面热阻微纳米尺度测量以及界面处声-电子耦合机制计算模拟,从而开发出高性能热界面材料。在此基础上,将制备的热界面材料应用于高功率密度电子器件中,验证其在高功率密度电子器件中的典型应用。
1.6.1 陶瓷
陶瓷同时具有高热导率和优异的电绝缘性,特别适用于要求电绝缘领域。在已报道过的陶瓷材料填料中,氮化硼(BN)具有非常高的热导率,正成为热管理应用中最有吸引力的研究对象。
1.6.2 碳材料
碳材料,如石墨烯、金刚石、碳纳米管已经被证具有高的导热系数,因此采用碳材料作为导热填料有望大幅提高聚合物的导热系数,制备出高性能热界面材料,受到了国内外学者的广泛而深入的研究。
近年来,石墨烯由于其优异的力学性能和导热系数(理论值达到5000 W/m·K),成为热界面材料最为理想的填料,受到了国内外学者广泛研究。
1.6.3 金属
金属由于采用电子作为热载体,具有高的本征导热系数,成为热界面材料常用的导热填料。金属基热界面材料还有一个重要的研究方向—连续金属基热界面材料。例如,Sn-Ag-Cu 基合金或者 Sn-Bi 即可以作为电子封装中的标准无铅焊料,也常被用作热界面材料,其优势在于具有高的导热系数、低的界面热阻值、高可靠性以及低的成本。液态金属是近年来备受关注的热界面材料,其主要成分为金属镓(Ga)及其合金,其具有熔点低、与芯片润湿性好、界面热阻低的优点。但是如何防止其溢出是液态金属基热界面材料最大的难题与挑战。
1.6.4 杂化填料
将两种不同种类、不同尺寸的导热填料进行复配,制备杂化填料,可以比一种导热填料更能提高聚合物的导热系数。例如,鉴于石墨烯与氮化硼具有良好的声子匹配性,孙蓉研究员课题组采用石墨烯与氮化硼进行复配,制备了一种石墨烯/氮化硼杂化填料。研究结果表明,这种杂化填料比单一的石墨烯或者氮化硼具有更高提高聚合物导热系数的能力。此外,也有其他研究者进一步证明了,氮化硼/石墨烯比单一填料具有更高的提高聚合物复合材料导热系数的能力。
1.6.5 三维导热网络
在聚合物体系中形成三维导热网络是提高聚合物导热系数的关键。近年来,研究者采用相关技术,如冰模板和冷冻干燥,首先形成三维导热网络,然后在三维导热网络中灌注树脂,制备高性能聚合物复合材料。
2. 界面热阻
自然界中任何能量的转移过程都存在动力和阻力,热传递是常见的能量转移 过程,温度差是传热的内在动力类似于导电过程中的电势差,热流量类似于导电 过程中的电流,热阻等效导电过程中的电阻,根据欧姆定律的数学表达式,人们 定义了热阻的理论计算公式,单位为K/W:热阻= 温度差 /热流量。
2.1 界面热阻影响因素
引起界面热阻产生最根本的原因是由于两个试件表面的粗糙体造成接触不完 整,界面热阻的大小与试件的实际接触面积有关,主要影响因素有加载压力、界面温度、表面粗糙度、试件材料的机械特性和热界面材料性质等。
(1)表面粗糙度:接触表面的粗糙度对界面热阻有很大的影响,表面粗糙度越大,表面越不平整,实际接触面积越小,热量流经接触界面时收缩越严重,界面热阻越大。
(2)加载压力:当对接触试件施加压力时,接触界面的微凸体会产生变形, 界面间隙变小,会增大试件的实际接触面积,载荷越大,微凸体的变形越大,界面热阻越小。
(3)材料的机械特性:在研究界面热阻时,主要考虑的是材料的硬度、弹性 模量等机械特性。这些特性直接影响试件变形过程中实际接触面积的大小,从而 对界面热阻产生影响。
(4)界面温度:界面温度主要影响接触试件的热导率、弹性模量和硬度等, 从而影响界面热阻。
(5)界面材料:接触界面填充热界面材料能够减小接触空隙,增大实际接触 面积,从而减小界面热阻。
2.1.1 界面温度对界面热阻的影响
下图为两组不同粗糙度Al6061试件的界面热阻测试值随界面温度的变化关系。由图中可以看出,随着界面温度的增加,界面热阻逐渐减小。对于粗糙度较大的一组试件,当界面温度为30℃时,界面热阻为6.53x10- 4m 2K/W,粗糙度较小时的界面热阻为4.44x10- 4m 2K/W,相对于前者增大了32%。随着界面温度的增加,界面热阻缓慢下降,当界面温度达到80℃时,界面热阻随温度的增加变化幅度增大,当界面温度为100℃时,两组试件界面热阻分别为4.78x10- 4m 2K/W和3.42x10- 4m 2K/W,相对于30℃时的测试值分别减小了26.8%和22.9%。由于随着温度的升高,接触试件的热导率逐渐增大,并且材料的弹性模量和硬度等机械特性也将发生改变,另外随着加热时间及界面温度的增加,两个试件的接触表面上会发生相互扩散,使得两个表面接触更加完整,从而减小它们之间的界面热阻。在实验条件相同的情况下,粗糙度较小一组试件的界面热阻要小于粗糙度较大的,且界面温度对界面热阻的作用效果稍弱于前者,整体趋势大致一样,因为粗糙度越小,热量流经接触界面时收缩程度较粗糙度大的试件要弱一些,另一方面由于试件接触表面真实面积小,材料热变形量要小。
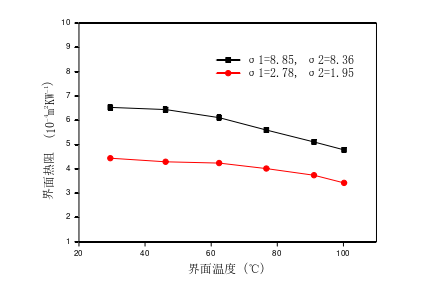
图 5 界面热阻随界面温度的变化曲线
2.1.2 加载压力对界面热阻的影响
载荷是影响界面热阻的另一个重要因素,界面热阻一般与加载压力成幂指数 关系,其中幂指数的大小表明了加载压力对界面热阻的影响程度。
下图为两组不同粗糙度Al6061试件的界面热阻测试值随载荷的变化关系。从图中可以看出,载荷是影响界面热阻的一个重要因素,界面热阻的大小随载荷 的增加明显地发生变化,载荷越大,界面热阻越小,因为载荷会使接触面上相互接触的粗糙体发生变形,随着界面压力的增大,接触表面发生弹性变形的粗糙体 数逐渐增加,并且已经发生变形的粗糙体变形程度继续增大,两试件的实际接触 面积也随之增大,从而导致界面热阻的减小。
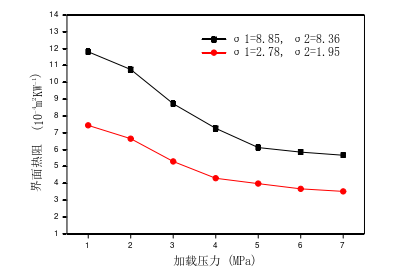
图 6 界面热阻随加载压力的变化曲线
从图中可以看出,不同均方根粗糙度的试件组合,粗糙度较大的界面热阻较 大。随着界面压力的增大,界面热阻逐渐减小,但不同粗糙度试件的界面热阻测试值随载荷的变化趋势基本一致。加载压力小于2MPa时,界面压力对界面热阻 的影响较小,表明此阶段的加载压力不足让大多数的微凸体产生变形,随着加载 压力增大,试件表面发生弹性变形的粗糙体数逐渐增加,界面热阻随载荷的变化 较显著,在2MPa到5MPa之间界面热阻与加载压力大致成线性关系,两组实验界面热阻测试值分别从10.77x10- 4和6.65x10 -4m 2K/W减小到6.13x10 -4和3.98x10- 4m 2K/W,变化幅度分别为43.1%和40.2%。随着加载压力的进一步增大界面热阻对载荷的敏感性有所下降,界面热阻与界面压力并非一直成线性关系,当载荷从5MPa增加到7MPa时,界面热阻的变化幅度分别为7.5%和11.5%。界面传热是一个比较复杂的过程,当界面压力达到一定程度时,接触表面的粗糙体将产生塑性变形,塑性变形会导致接触表面硬化,随着加载压力的逐渐增加粗糙体的硬化程度越来越高,导致粗糙体接触数目会逐渐趋于稳定,从而引起在较大加载压力时界面热阻值逐渐趋于平缓。
2.1.3 石墨材料对界面热阻的影响
为了提高电子设备的热可靠性,除了使用散热性能优异的散热器外,为了减 小传热过程中的界面热阻,一般会在芯片与基板、基板与散热器之间填充具有高 导热系数的热界面材料。
下图为加入石墨材料后,粗糙度较小接触试件界面热阻测试值随载荷的变化关系,从图中可以得知,随着载荷的增加,界面热阻逐渐减小,载荷与界面热阻大致成线性关系,随着压力的增加,界面热阻对载荷的敏感程度下降。当加载压力为1MPa时,其界面热阻为1.25x10- 4m 2K/W,对比上图中无界面材料时的 界面热阻7.44x10- 4m 2K/W,减小了83.2%。当加载压力达到7MPa时,界面热阻随着载荷的逐渐增加变化很小,其界面热阻为0.76x10- 4m 2K/W,相对于没有添加石墨材料时的界面热阻3.52x10- 4m 2K/W,减小了78.4%。主要原因是石墨具有较独特的晶粒取向,片层状结构可很好地适应任何表面,导热系数高达400W/(m· K),其面内导热系数和垂直导热系数都优于绝大多数界面材料。石墨材料有效填补了接触界面的间隙,增加了实际的接触面积,从而导致了界面热阻的减小。
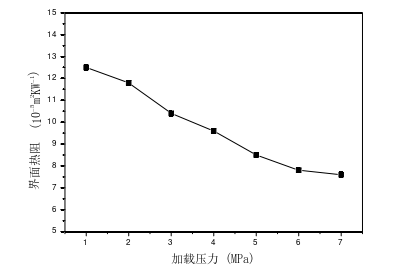
图 7 添加石墨片后界面热阻随加载压力的变化曲线
2.1.4 导热硅脂对界面热阻的影响
导热硅脂是用来填充芯片与散热器接触间隙的一种界面材料,其作用是用来向散热器传导芯片所产生的热量,使传热过程更加顺畅,保证芯片的热可靠性和 稳定性。本实验所采用的是厚度为0.1mm的相变导热硅脂。
下图为加入导热硅脂后,粗糙度较小试件界面热阻测试值在不同加载压力下随界面温度的变化关系,从图中可以看出,加入导热硅脂可以显著的减小界面热阻,从实验结果中还可以得知在界面加入导热硅脂后,界面热阻随界面温度的变化几乎不变。载荷为4MPa且加热温度为60℃时,相比于无中间介质时界面热阻为4.3x10- 4m 2K/W,加入石墨片后界面热阻为0.96x10 -4m 2K/W,当热界面材料为导热硅脂时,其界面热阻为0.38x10- 4m 2K/W,相对于使用石墨材料,界面热阻减小了60.4%,说明具有流体性质的相变材料可以有效地减小界面热阻,主要原因是随着加热温度的升高,硅脂会发生相变,在接触界面流动,从而能有效的填充界面间隙。因此加入相变界面材料可以有效减小界面热阻,并且界面热阻对温度的敏感程度下降。
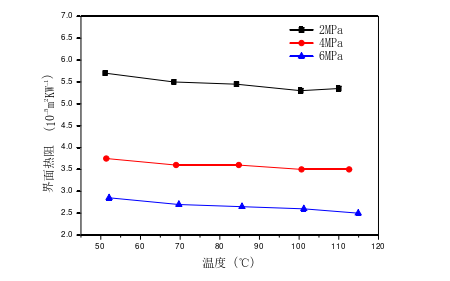
图 8 加入导热硅脂后界面热阻的变化曲线
2.2 界面热阻理论建模
从微观角度来说,固体真实的表面并不是绝对光滑,而是包含许多微小的波 峰波谷,当两个物体相接触时,真实的接触只发生在小部分离散的粗糙体上,中间间隙部分为真空或空气。热量流经这些接触界面时会产生热流收缩的现象,从 而会引起界面热阻的产生。随着电子器件的热流密度急剧增加,界面热阻会降低 器件的传热效率,从而影响芯片的可靠性。
本章由单点接触热阻模型的基础上,应用接触力学的分析方法,推导界面热阻的计算公式,以及根据表面形貌理论和理想气体定律推导出带界面材料的界面热阻,对工程实践和科学实验中的界面热阻进行预测。
热量流经真实接触表面如图所示。

图 9 真实接触表面的热流收缩线
2.2.1 单点接触建模
热量流经接触界面时,热流线收缩只通过一些离散的接触点,整个接触面的 热流可看作由许多相互平行的通过这些接触点对的单热流通道并联而成。对实际 的接触界面做以下假设:(1)各单热流通道相互之间没有热量交换;(2)所有 单热流通道处于相同的界面温差之下;(3)两个接触面的实际界面热阻是所有单 点接触热阻并联的结果。热流通过固体表面单个微观粗糙体时,会产生收缩,如图所示。
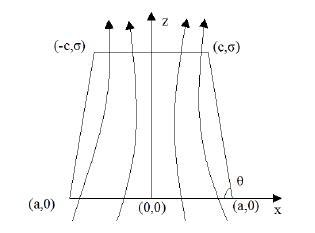
图 10 单个粗糙体热流示意图
2.2.2 基于界面材料建模
由于芯片产生的热量传递到外部环境中需要经过数层接触面,为了减小导热 过程中的界面热阻,一般会在芯片与基板、基板与散热器之间填充具有高导热系 数的热界面材料,如粘合剂、相变材料和焊料等。通过建立含界面材料的界面热阻理论模型来预测界面热阻也是一种重要手段,具有流动性质的界面材料对界面热阻的作用规律,界面材料在两固体间的分布如图所示。
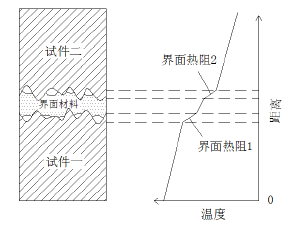
图11 含界面材料的界面热阻示意图
3. 笔记本电脑散热系统
笔记本电脑内部空间狭小,其散热是一个非常系统和复杂的工程技术性问题。国内外大量学者对笔记本电脑整机进行了仿真分析,但没有考虑笔记本电脑内部组件接触传热时的界面热阻和界面材料对系统散热性能的影响,导致现有的笔记本电脑数值模型不够准确,并且提出的优化方案不够全面。因此,通过以上方法建立合理的界面热阻模型,对界面热阻进行准确的预测,逐渐成为工程设计中十分重要的环节。
3.1 CPU的不同工作条件对热阻的影响
由于CPU、显卡和桥芯片产生的热量依次经过散热板、热管及翅片传递到外部环境中,本节主要考虑散热板与芯片的界面热阻。
下图为CPU在不同工作条件的热阻比较图,热阻随CPU功率的增加有轻微降低的趋势,因为热管具有较好的均温性能和导热能力。当CPU功率较小时, 热管内部只有少量的介质参与相变传热,均温优势体现不明显。随着CPU功率的增加,参与相变的介质增加且蒸汽传递的距离也越远,能够有效减小热管内部介质的扩散热阻。中央处理器满负载运行时,考虑界面热阻时,热阻大小为1.98K/W,相对于理想接触下热阻值为1.43K/W时,增大了38.7%。
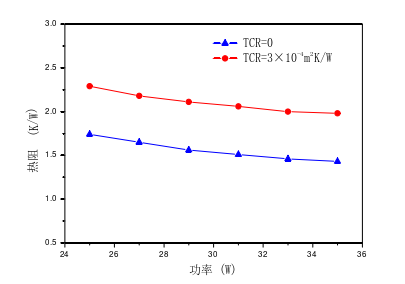
图 12 热阻随CPU功率的变化关系
3.2 界面热阻对CPU散热特性的影响
下图为风扇在不同转速下(5.94m3/h、7.92 m 3/h及9.96 m 3/h),中央处理器的最高温度随CPU与散热板界面热阻的变化关系。由图得知,界面热阻在芯片的散热过程中有着重要的影响,随着界面热阻的增加,中央处理器的温度成线性增大。在风扇的转速为7.92m3/h,CPU与均热板的界面热阻从1x10 -4m 2K/W增 加至5x10- 4m 2K/W时,CPU的最高温度从88.2℃增大至119.9℃,增加了31.7℃。CPU的最高温度随离心风扇转速的增加而逐渐降低,风扇转数越快,单位时间内提供的风量越大,空气与翅片的对流换热系数h的之就越大,但转速越快,笔记本电脑内部空气流动速度越快,容易产生涡流,系统内噪音也就越大。不同风速下,CPU总的热阻差别也较大,在界面热阻为 1x10- 4m 2K/W时,风扇出口处空气流量为9.96m 3/h比5.94m 3/h情形下热阻大约可降低23%。因此,在对笔记本进行热设计时,芯片向散热板传热是散热过程中的第一个环节,散热板与芯片的界面热阻会使芯片温度和热阻都有比较大的影响, 一般会选用高导热系数、低弹性模量和性能稳定的材料用作接触面上的热界面材料,提高整体的散热效果。
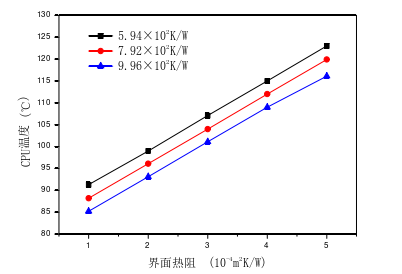
图 13 CPU最高温度随界面热阻的变化关系
3.3 界面材料对系统散热特性的影响
从前面的分析可以得知,不考虑CPU与散热板的界面热阻时, CPU的最高温度为79.6℃,当界面热阻从1x10- 4m 2K/W增加至5x10 -4m 2K/W时, CPU的最高温度从88.2℃增大到119.9℃,相对于理想接触情形下,增加了 50.6%。为了提高中央处理器、显卡和北桥芯片的散热效率,本节考虑在CPU、显卡和北桥芯片与散热板之间添加导热硅脂,降低传热过程中的界面热阻,提高芯片的散热特性,其中界面材料的厚度为0.1mm,导热系数为5W/(m·K)。加入热界面材料后CPU的最高温度为81.5℃,相 对于无中间介质界面热阻为1x10- 4m 2K/W时,最高温度降低了6.7℃,相对理想接触情况下最高温度增大了1.9℃,主要是中间介质填补接触面的间隙从而减小界面热阻,但材料在传递热量过程中存在导热热阻。
表 5 不同工作条件下的温度分布

上表为系统在不同工况下组件的热耗和温度分布,其中工况Ⅰ为笔记本电脑的标准工作状态;工况Ⅱ为标准工作状态下考虑电池的热耗散;工况Ⅲ为标准工作状态下考虑光驱的使用;工况Ⅳ为CPU、显卡和北桥芯片在满负荷的工作状态;工况Ⅴ为笔记本电脑所有组件都满负荷运行。从表中可以看出,笔记本电脑在标准状态运行,内部组件的温度都比较低,当使用笔记本的电池和光驱时,两者的功耗对笔记本电脑内部功耗较高的组件温度有比较大的影响。工况Ⅴ相对于工况Ⅳ,CPU、显卡和北桥的温度分别上升了1.7、1.1和1.2℃,这是因为使用电池和光驱会导致系统内部的空气温度上升,从而降低空气与翅片的换热效率。
下图为所有组件都满负载运行时笔记本电脑内部的热流转移路径,主要有 两种散热方式:主动散热和被动散热。图中主动散热路径为红线标示部分,中央处理器、显卡和北桥,三个芯片产生的热量绝大部分通过热管转移至散热片,通过离心风扇的强迫对流换热带走散热片上的热量。被动散热路径为图中黑线部分 所示,主要的散热途径为热传导和自然对流,笔记本电脑内部的内存、网卡、电池、硬盘盒光驱等组件主要通过此种方式来冷却,CPU、显卡和北桥芯片也有少部分的热量通过热传导和对流换热被带走,蓝色环形箭头为笔记本电脑内部的发 热器件。从图中的热流传递路径可以得知CPU的86.6%热量主要通过热管和风扇 的强制对流被带走,将近10.9%的热量传导至PCB板,通过PCB板与空气的自然对流被带走。在对笔记本进行热设计时,保证主板的温度低于允许的工作温度, 可以通过主板带走一部分芯片产生的热量,提高组件的散热效率。

图 14 工况Ⅴ的热流传递路径
3.4 PCB板与CPU的界面热阻对系统散热特性的影响
后面的数值仿真,其边界条件以加入热界面材料后为基础。下图为CPU的最高温度随CPU与PCB板界面热阻的变化关系,从图可以看出,随着CPU与PCB板界面热阻的增大,CPU的最高温度逐渐上升,主板的最高温度逐渐下降。当界面热阻从0.5x10- 4m 2K/W增加至5x10 -4m 2K/W时,CPU的最高温度从81.7℃ 增大到82.9℃,PCB板的最高温度从65.9℃下降至64.9℃,两者整体的变化趋势比较小。这是因为CPU的86.6%热量主要通过热管和风扇对流换热被带走,只有10.9%的热量传导至PCB板,经自然对流被带走,所以CPU与PCB板的界面热阻对CPU的温度分布影响较小。
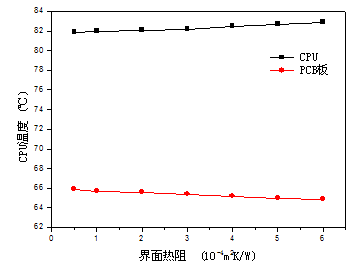
图 15 CPU最高温度随CPU与PCB板界面热阻的变化关系
结束语
笔记本电脑内部空间狭小,其散热在工程实践中是一个比较复杂、系统的技 术性问题,并且制约着更轻、更薄和性能更高的笔记本电脑的发展。如何通过选择新型合适的热界面材料,从而有效降低界面热阻,提高系统散热效率,对研究工程中传热问题有着重要的现实意义。
文章来源:移动室技术交流平台
审核编辑:汤梓红
-
元器件
+关注
关注
113文章
5055浏览量
100478 -
笔记本电脑
+关注
关注
9文章
1493浏览量
52547 -
散热
+关注
关注
4文章
622浏览量
33369 -
热导率
+关注
关注
0文章
45浏览量
9585
原文标题:基于笔记本电脑散热设计的热界面材料及界面热阻研究
文章出处:【微信号:gh_e972c3f5bf0d,微信公众号:艾邦加工展】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
导热界面材料对降低接触热阻的影响分析
[原创MST笔记本电脑(数星笔记本电脑) 山寨笔记本代理加盟MST笔记本
笔记本电脑CPU知识
笔记本知识:笔记本电脑的外壳材料
拯救笔记本电脑 把热赶出去是关键
笔记本电脑品质好坏散热是关键
笔记本电脑散热技术简介
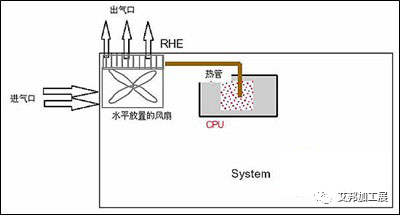



 基于笔记本电脑散热设计的热界面材料及界面热阻研究
基于笔记本电脑散热设计的热界面材料及界面热阻研究



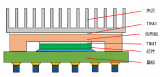



评论