在 PCT 期间,当 DUT 开启时,由于电流从漏极流向源极,DUT 温度会升高(图 1a)。当 DUT 关闭时,通过从源极到漏极的感测电流测量体二极管压降。通过应用图 1b 中所示的 V SD -T 校准曲线,可以在知道体二极管压降的情况下估算结温 T J 。
(a) PCT 程序 - (b) VSD-T 校准曲线。

图 1:(a) PCT 程序 – (b) V SD -T 校准曲线
根据文献 [5],在测量阶段应使用负栅极电压。通常情况下,感测电流小于 200 mA,这可以防止在温度测量阶段自热,也可以摆脱封装相关劣化的影响。
调查中使用的设备
为了完成对 PCT 相关体二极管可靠性的比较研究,选择了不同的商用 SiC MOSFET(见表 I)。将进行静态和动态表征以查询体二极管特性。 DUT 的关键参数。

表 I:DUT 的关键参数
在静态表征阶段,体二极管正向电压 V SD与 T J特性的关系是通过曲线跟踪器和带有气压热流的气候室确定的,施加负栅极电压 V GS = -5V。
对于静态 I D -V SD测量,将温度传感器放置在与 DUT 接触的位置以测量确切的外壳温度,该温度以 15°C 的间隔从 25°C 逐渐变化到 130°C。由于 MOSFET 的 V SD的反向压降与温度有关,并且在低电流 (200mA) 和高电流 (800mA) 下都表现出很强的线性,图 2 和图 3 表明该压降是TJ测量的良好候选者。 所有供应商在 200 mA 时的 VSD-T 曲线。
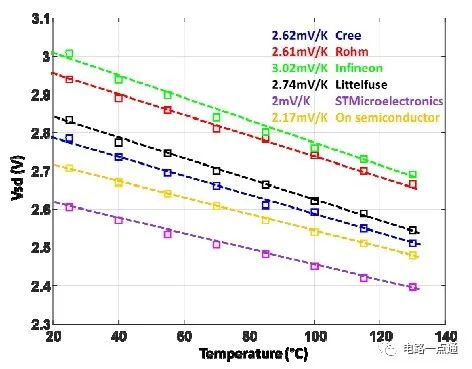
图 2:所有供应商在 200 mA 时的V SD -T 曲线 所有供应商的 VSD-T 曲线均为 800 mA。
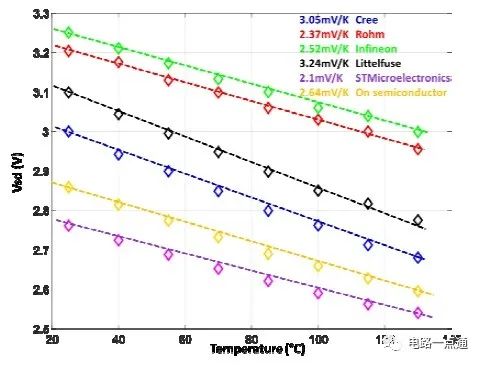
图 3:所有供应商在 800 mA 时的V SD -T 曲线
为了测量开关参数和评估DUT的动态行为,使用了双脉冲测试方法。设置如图 4 所示。三个 IsoVu 探头用于使用平面分布式分流方法测量 V GS、V DS和 I DS 。 双脉冲测试装置。
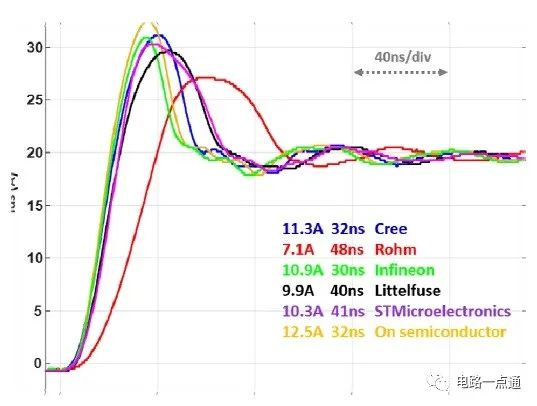
图 4:双脉冲测试设置
通过该测试,可以测量反向恢复时间 (trr) 和峰值反向恢复电流 (Irrm) 等动态特性。这些参数是在限制带宽 200 MHz 时测得的,如图 5 所示。 开启时的 ID 波形。
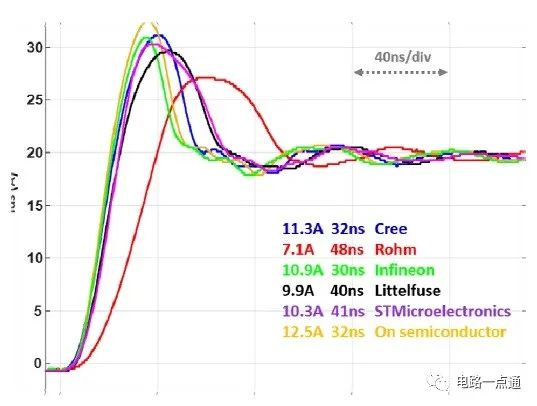
图 5:开启时的I D波形
测试条件
为了检验 SiC MOSFET 在功率循环测试下的可靠性,对每个 DUT 的体二极管进行了压力测试。为防止亚阈值效应,保证MOS通道完全夹断,测试时采用了-5V的栅源电压。每个制造商的总共三个 DUT 在以下测试条件下测试约 50 小时:
I SD1 =200mA,外壳温度=130°C
I SD2 =800mA,外壳温度=130°C I SD3 =2A,外壳温度=130°C
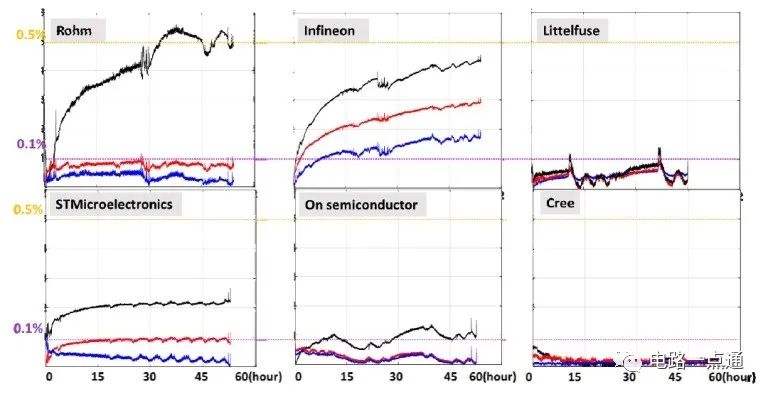
图 6 显示了每次测试的结果。如图所示,来自不同制造商的 DUT 表现出不同的行为。正向压降 V SD在压力测试后有所增加,同时振荡也表现出轻微的偏移。
不同负载电流下的压力测试结果。
图6:不同负载电流下的压力测试结果
以上结果表明,在相同的测试条件下,平面SiC MOSFET体二极管的浪涌可靠性优于沟槽SiC MOSFET体二极管。
图7和图8分别为Rohm和Infineon DUT测试前后的V SD -T校准曲线。对于英飞凌的 DUT,在 2A 应力和 800mA 感应电流的情况下,Tj 差异可高达约 18°C,而在 200mA 应力和 200mA 感应电流的情况下,Tj 差异可低至约 3°C。对于 Rohm 的 DUT,只有 DUT3 的 V SD -T 曲线显示出明显的偏移,Tj 差异约为 10°C。由于这种影响,温度估计会产生错误的结果,从而提供不准确的寿命估计。 Rohm 的 DUT 在压力测试前后的 VSD-T 曲线。

图 7:Rohm 的 DUT 在压力测试前后的V SD -T 曲线 压力测试前后英飞凌 DUT 的 VSD-T 曲线。

图 8:压力测试前后英飞凌 DUT 的V SD -T 曲线
对 Rohm、Infineon 和 STMicroelectronics 的 DUT 进行了 2A 应力的双脉冲测试。根据图 6,这三个 DUT 在 2A 应力的情况下显示 VSD 显着增加。对于所有 DUT,反向恢复峰值和总反向恢复电荷在 2A 应力后显着降低。
低侧开关的导通电流波形如图 9 所示。很明显,在 2A 的压力下,所有 DUT 的反向恢复峰值和总体反向恢复电荷都低得多。 2A 压力测试前后体二极管的反向恢复。
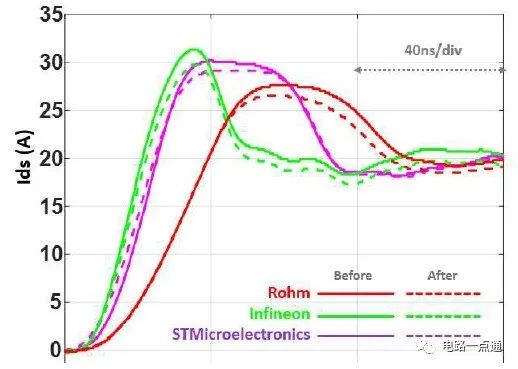
图 9:2A 压力测试前后体二极管的反向恢复
结论
当 DUT 的体二极管开始退化时,电压降 V SD总是可以被认为是退化指示,因为它显示上升趋势。
但是,长期的压力和高温可能会导致 V SD -T 校准曲线上升。在体二极管正向应力测试下,对来自六家不同制造商的商用 1200 V SiC MOSFET(其中两家采用沟槽栅极结构,四种采用平面栅极结构)进行了检查。实验结果表明,随着 V SD的增加和反向恢复电流峰值的降低,双极退化。当应用于具有栅极沟槽结构的 DUT 时,效果似乎更明显。在相同的测试条件下,V SD -T 技术中平面 SiC MOSFET 的体二极管比沟槽 SiC MOSFET 更可靠。
审核编辑:汤梓红
-
二极管
+关注
关注
149文章
10309浏览量
176451 -
MOSFET
+关注
关注
150文章
9413浏览量
229584 -
PCT
+关注
关注
0文章
38浏览量
19169 -
DUT
+关注
关注
0文章
193浏览量
13368
原文标题:1200 V SiC MOSFET 的二极管可靠性研究
文章出处:【微信号:电路一点通,微信公众号:电路一点通】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录





 1200V SiC MOSFET的二极管可靠性研究
1200V SiC MOSFET的二极管可靠性研究




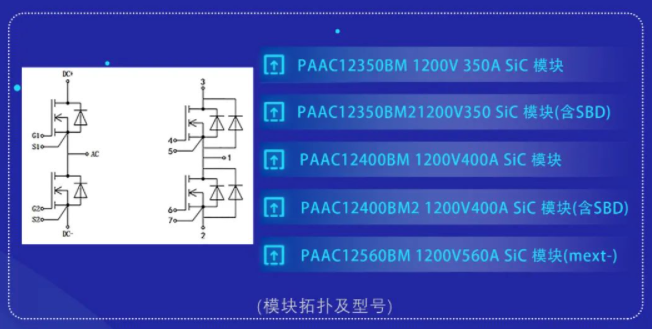










评论