近日Intel公开了三项全新的封装技术:
一、Co-EMIB
利用利用高密度的互连技术,将EMIB(嵌入式多芯片互连桥接) 2D封装和Foveros 3D封装技术结合在一起,实现高带宽、低功耗,以及相当有竞争力的I/O密度。
Co-EMIB能连接更高的计算性能和能力,让两个或多个Foveros元件互连从而基本达到SoC性能,还能以非常高的带宽和非常低的功耗连接模拟器、内存和其他模块。
二、ODI
ODI全称Omni-Directional Interconnect,为封装中小芯片之间的全方位互连通信提供了更大的灵活性。
ODI封装架构中,顶部的芯片可以像EMIB下一样,与其他小芯片进行水平通信,还可以像Foveros下一样,通过TSV与下面的底部裸片进行垂直通信。
ODI利用更大的垂直通孔,直接从封装基板向顶部裸片供电,比传统硅通孔更大、电阻更低,因而可提供更稳定的电力传输,同时通过堆叠实现更高的带宽和更低的时延。此外,这种方法减少了基底芯片所需的硅通孔数量,为有源晶体管释放更多的面积,并优化了裸片的尺寸。
三、MDIO
基于高级接口总线(AIB)物理层互连技术,Intel发布了这种名为MDIO的全新裸片间接口技术。
MDIO技术支持对小芯片IP模块库的模块化系统设计,能效更高,响应速度和带宽密度可以是AIB技术的两倍以上。
-
芯片
+关注
关注
447文章
47838浏览量
409798 -
intel
+关注
关注
19文章
3452浏览量
184822 -
封装技术
+关注
关注
12文章
497浏览量
67788
原文标题:Intel公开三项全新封装技术:灵活、高能集成多芯片
文章出处:【微信号:SEMI2025,微信公众号:半导体前沿】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐
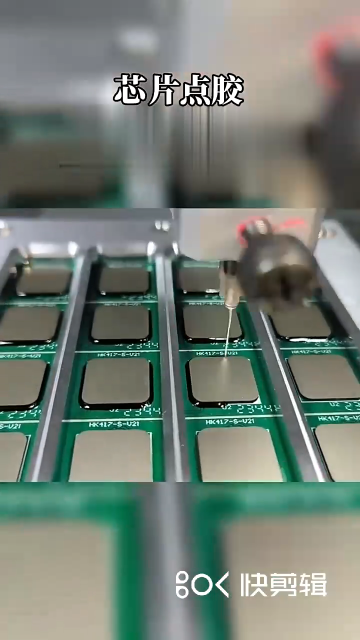
芯问科技太赫兹芯片集成封装技术通过验收
Cadence与Intel代工厂携手革新封装技术,共推异构集成多芯粒架构发展
一文详解芯片上的集成技术
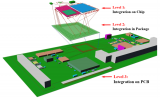
Cadence与Intel代工厂合作通过EMIB封装技术实现异构集成
三项交流电主轴电机启动后转子无法转动却左右剧烈摆动是什么原因呀?
国内首创!通过SDK集成PUF,“芯片指纹”打造MCU高安全芯片
芯片封装材料有哪些种类 芯片封装材料表面处理技术是什么





 Intel公开三项全新封装技术 灵活、高能集成多芯片
Intel公开三项全新封装技术 灵活、高能集成多芯片











评论