电子束光刻(e-beam lithography,EBL)是无掩膜光刻的一种,它利用波长极短的聚焦电子直接作用于对电子敏感的光刻胶(抗蚀剂)表面绘制形成与设计图形相符的微纳结构。电子束光刻系统有着超高分辨率(极限尺寸<10nm的图形转印)和灵活作图(可直写无需掩模)的优点,但因曝光效率低,控制复杂,致使电子束光刻更多应用于制作光刻掩模板、先进的原理样机和纳米级的科学研究及开发。
基于电镜的光刻技术
电子束用于光刻已有几十年的历史,几乎所有现代电子或离子显微镜,包括扫描电镜(SEM)、扫描透射电镜(STEM)、聚焦离子束 (FIB) 和 SEM/FIB 双束,都可以轻松的添加光刻系统。
电子束光刻已经有60多年的历史了,几乎是与光学曝光同步发展起来的,主要标志性的时间有下面几条:1958年美国麻理工研究人员首次利用电子引起的碳污染形成刻蚀掩模,制作出高分辨率二维图形结构;早在1965年就使用电子束曝光制作100nm的结构了;1968年PMMA被作为电子束光刻胶使用;1970年使用PMMA制作出0.15um声表面波器件;1972年使用电子束光刻在硅表面做出横截面为60X60nm铝金属线条。
现代电镜能控制XY电子束位置,且都有配置电子束消隐器。多数情况下,标准的电镜平台都能通过数字接口进行控制,并用于光刻。非常重要的一点是,添加光刻系统并不会降低或限制电镜在成像应用方面的功能或性能,因此,不需要对电镜进行特殊定制。基于电镜的EBL系统可以成为微米和纳米制造方面非常通用的工具,也可用来观察生成的结构。
SEM是光刻技术最常用的电镜类型,虽然扫描隧道电镜(STM)和原子力电镜(AFM)光刻技术的研究工作已经完成,但这些电镜尚未广泛用于光刻。近年来,SEM-FIB双束电镜开始越来越多地用于光刻,利用双束,光刻系统可以控制电子束或离子束,从而提供比单束系统更强的制造能力。
SEM的电子源
SEM中的电子源有两种:
传统电子源使用发夹钨灯丝或六硼化镧(LaB6)单晶尖端
场发射(FE)电子源——冷场或肖特基热场
早期,由于成本较低,传统电子源的电镜一直是光刻技术中最广泛使用的型号,然而,使用冷场或热场发射电子源的SEM,不仅成像效果更好,而且光刻效果也更好。
在选择用于光刻的两种传统电子源时,主要考虑成本、便利性、亮度和稳定性。钨灯丝的使用寿命通常为40-200小时,而LaB6电子源的使用寿命通常要长得多。虽然钨丝的更换成本低于LaB6电子源,但两者的总体成本大致相同。在相同的束斑尺寸下,LaB6电子源的电流比钨灯丝高出3到10倍,因此光刻速度更快;LaB6电子源的稳定性为每小时3%,而钨丝的稳定性为每小时1%。这些电子源的极限光刻线宽基本相同;使用LaB6电子源的SEM更容易优化,因为亮度更高,可以使用更大的电子束电流,但钨灯丝电子源的稳定性更好。
在选择冷场电子源或热场电子源作为光刻应用时,理由就相对简单。热场电子源在3-10小时内的稳定性通常为~1%,而冷场电子源本身不稳定,在几分钟内可能变化±5%,在一小时内可能变化±20%或更多。此外,冷场射源需要定期"闪烁",电子束需要1-2小时才能相对稳定,通常会随着电子枪中的真空度降低而变得越来越不稳定。虽然冷场电子源的成像分辨率可能优于热场电子源,但对于光刻应用来说,冷场电子源的不稳定性是一个显著的缺点(随着技术的进步,冷场SEM的稳定性有了很大的提升)。即便如此,在没有热场SEM可用的情况下,使用冷场SEM 进行光刻仍然是值得的。
电子束光刻的关键参数
最小束直径:直接影响曝光图形的最小尺寸。可通过调整以下措施获得更小的束斑直径,①设置尽量高的加速电压 ②采用较小尺寸的光阑孔径 ③采用小的工作距离 ④设置小的扫描场 ⑤设置小的曝光步长
加速电压:一般是10~100kv加速电压越高,分辨率越高,曝光产生的邻近效应越小,可曝光更厚的抗蚀剂。
电子束流:束流越大曝光速度越快,最大曝光速度受扫描频率限制,大束流的束斑也会较大
扫描速度:扫描速度越快曝光速度越快,以频率表示(如:50MHz)
扫描场大小:扫描场大,则曝光图形大部分可在扫描场内曝光,避免扫描场拼接引起的误差还有工作台移动精度、套准精度、场拼接精度等。
利用传统的电子束光刻加工技术实现的最细线宽通常在10~100 nm 之间(目前已可以实现<10nm),其中电镜是决定性能的主要因素。较小的线宽通常使用30 kV FE SEM、40 kV LaB6 SEM或 ≥100kv STEM 来实现,而低性能、低成本SEM的最小特征尺寸可能为50-100 nm。除了电镜性能外,决定最终分辨率的主要因素还包括光刻胶和基底的类型、加速电压和束流、写入场大小以及用户对电镜的参数优化。
基于SEM的光刻系统
电子束光刻技术起源于扫描电镜,是基于聚焦电子束扫描原理的图形转印技术。电子束光刻系统由电子枪、电子透镜、电子偏转器3个基本部件以及真空系统、工件台控制系统等部件组成,电子枪用于产生能被控制和聚焦的电子。 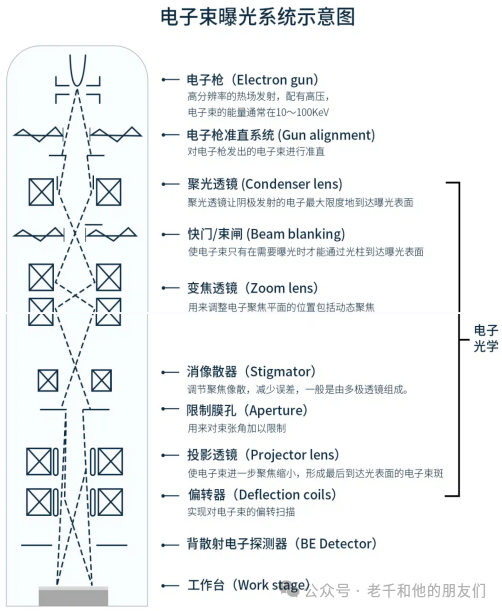
图1 电子束曝光系统
在以研究应用为主要用途的情况下,基于SEM的光刻系统与专用电子束写入系统相比具有许多优势,这些优势包括成本、易用性、维护和多功能性。典型的SEM可产生从约 200 eV到30 kV 的加速电压,并可根据不同应用的需要轻松更换。
4.1 电子束光刻模式:
矢量或光栅写入(高斯与异形)
在SEM正常图像采集过程中,电子束在整个图像区域内从上到下进行光栅扫描,图像中的每条线都是从左至右扫描的。如果电子束在扫描每条光栅线时都能根据需要进行消隐,就可以用类似的光栅进行光刻。然而,基于SEM的光刻系统使用的是矢量写入方法,电子束在任意方向移动,只扫描需要曝光的区域。在完全实现矢量书写的系统中,斜线和圆弧的电子束扫描方向是沿线或弧,填充区域不限于简单的 XY 扫描。此外,为了实现最大的灵活性,基于SEM的光刻系统可以提供两个独立的曝光点间距参数,其中一个参数沿正在写入的线或弧,而第二个参数沿垂直方向。 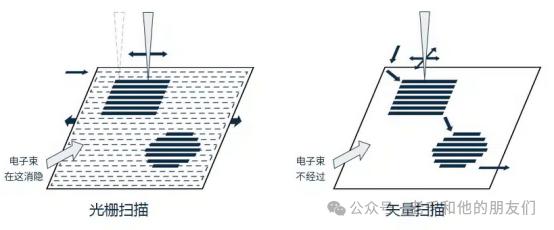
图2 电子束光刻模式
对于基于SEM的光刻系统来说,使用矢量写入模式可大大提高整体写入速度,因为只需对曝光区域进行扫描。使用矢量写入模式可以大大降低对电子束消隐器的要求,因为每个图形元素只需要两次电子束开启/关闭事件。相比之下,光栅写入模式需要非常精确的消隐,尤其是在写入垂直于光栅线扫描方向的窄线时。
矢量写入模式的一个独特功能是,即使SEM没有任何消隐器,也能完成图案写入,因为光刻系统可以在图案元素之间快速跳转电子束,因此在跳转过程中,电子束路径上的剂量微乎其微。下面将详细讨论不使用电子束消隐器的光刻技术。
光栅扫描采用高斯圆形束,电子束在整个扫描场里作连续逐点扫描,通过控制快门(束闸)的通断来进行图形的曝光。光栅扫描的优点是控制简单,不需对偏转系统进行控制。缺点是生产效率低。由于扫描场的范围较小,必须配合工件台的移动来完成曝光。
矢量扫描的优点是曝光效率高,只在有图形区域进行扫描曝光,减少了镜头在非图形区域所花费的时间的,而且可采用可变矩形束。缺点是控制系统复杂,因为矢量扫描必须对偏转器进行控制,不像光栅扫描那样采用固定的偏转方式。 电子束光刻按电子束形状可分为高斯束(圆形束)和变形电子束(矩形束),高斯束电子束通过单点的方式扫描实现曝光,曝光速度慢;而变形束通过不同形状的光阑组合形成特定图形的面束斑,一次曝光较大的面,使得曝光效率大大提高。
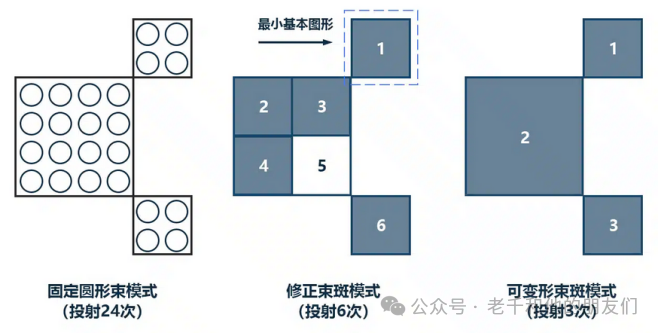
图3 电子束光刻模式:高斯束与变形束
矢量扫描模式下,图形的曝光时间与束斑投射次数有关,在固定高斯束(圆形束)斑模式下,需要进行24次投射。为了加快曝光速率,图形可分解为最小基本图形的组合,以最小基本图形作为电子束斑的形状。在这种修正束斑模式下只需要6次投射就可以了。但是在实际生产过程中图形不是一成不变的,需要经常重设基本束斑形状,因此需要一种更加灵活的投射方式。在可变束斑模式下,电子束斑可根据具体的图形进行调整,改变束斑的基本形状,投射次数减少到3次。
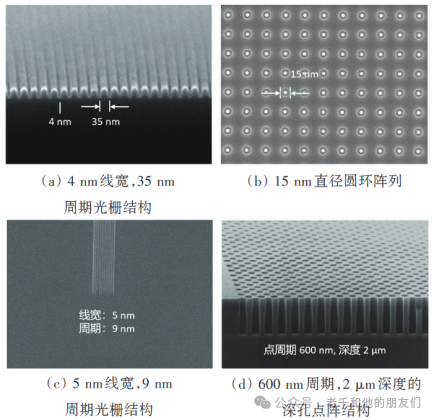
图4 高压高斯电子束极小尺度极高精度的加工能力
4.2 书写速度
从根本上说,任何直接写入系统的总体写入速度都取决于电子束电流、光刻胶的灵敏度以及电子束在曝光区域移动的最大速度。对于大多数SEM来说,电子束电流可在10 pA~10 nA或更大范围内变化,必须根据SEM的特性来选择使用的电流。例如,有些SEM可以用1 nA的电流刻出50 nm的线,而另一些则可能需要用小于50 pA的电流才能达到相同的线宽。
大多数商用SEM光刻系统的电子束最大步频为3MHz或更高。然而,典型的SEM电路可能被限制在较低的频率。一般来说,如果光刻系统的速度比SEM扫描线圈快,那么最终的写入速度将受材料、曝光条件和SEM的限制,而不是光刻系统的限制。如果扫描线圈 "跟不上"光刻系统的速度而导致图案失真,解决办法是减小电子束电流,从而使用较慢的书写速度来提供所需的剂量。
4.3校准
先进的电镜光刻系统提供手动和全自动对准功能。对准是通过对写入区域内的选定区域进行成像,然后将光刻坐标系与样品上的标记进行对准。一般来说,根据对准结果计算出2 × 2 变换矩阵和XY偏移。计算出这些参数后,就可以对曝光进行转换,从而将曝光的图案元素与样品上的标记进行套准。典型的对准精度范围为书写区域的1:1,000 ~1:5,000,精度可低至20 nm。
当基于SEM的光刻系统包含强大的自动对准功能时,系统可以使用标准的自动电镜平台接近所需的位置,然后通过扫描套准标记自动对准到更高的精度。这样,只需使用大多数SEM上的标准自动平台,就能在每个区域进行数十、数百甚至数千个区域的全自动对准,从而实现 "步进-重复"曝光处理。
图像信号与电子束消隐
几乎每台SEM都有图像信号输出,可用于光刻系统的图像采集。虽然基本图案书写不需要图像信号,但当光刻系统用于对准样品上的现有标记时,则需要图像信号。
理想情况下,SEM会配备一个具有快速重复率、快速上升/下降时间和最小开/关传播延迟的电子束消隐器。用于前束光刻的静电消隐器的典型参数是:重复频率大于 1 MHz,上升/下降时间小于50 ns,传播延迟小于100 ns;不过,速度较慢的消隐器也能派上用场。
虽然快速电子束消隐器对于光刻技术来说无疑是理想的,但在使用矢量写入系统时,根本不需要任何消隐器。在没有消隐器的情况下,光刻系统可以在图案元素之间快速跳转电子束,以至于在图案元素之间的电子束路径上接收到的剂量可以忽略不计。
但是,如果不使用消隐器,就会出现两个主要问题。其一,在图案位置之间,电子束总是会射向样品。因此,在移动平台时,必须小心考虑电子束击中的位置。另一个问题是,当电子束在图案元素之间跳转时,扫描线圈需要一些时间才能在长时间跳转后稳定在正确的位置上。如果电子束跳跃了很远的距离,这可能会导致每个图案元素起点的图案失真。
在大多数SEM中,电子束跳跃3-10微米后几乎不会出现变形,但跳跃时间较长时可能会出现明显的变形。精心设计的光刻系统可以让用户通过定义电子束沉降的位置来最大限度地减少失真,从而最大限度地减少跳转到所需图案元素的长度。
当电镜只有慢速电子束消隐器时,慢速消隐器可在曝光区域之间的平台移动过程中使用。
-
SEM
+关注
关注
0文章
185浏览量
14329 -
光刻技术
+关注
关注
1文章
131浏览量
15642
原文标题:基于SEM的电子束光刻技术
文章出处:【微信号:bdtdsj,微信公众号:中科院半导体所】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
相关推荐

电子束沿多层膜表面运动时产生的电磁辐射
【AWorks280试用申请】电子束高压逆变电源控制系统研究
现代焊接技术中的电子束焊接技术
扫描式电子显微镜 (SEM)
活性电子束探测技术对现有失效分析过程的补充
聚焦离子束显微镜(FIB-SEM)
MIT实现9纳米工艺电子束光刻技术
如何进行电子束光刻中的相互邻近效应校正技术研究与分析

美国公司Zyvex使用电子束光刻制造出0.7nm芯片
氦质谱检漏仪电子束***检漏





 基于SEM的电子束光刻技术开发及研究
基于SEM的电子束光刻技术开发及研究

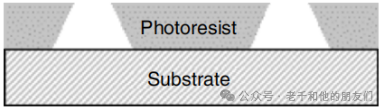










评论