Kirk 曝光方法在光刻机杂散光测试中的应用研究
结合 Kirk 的测试原理,基于实际的光刻机应用工况,通过工艺试验、计算仿真等手段建立有效的数据模型,有助于准确地把握杂散光的影响规律。经分析表明,杂散光对不同尺寸图形的影响具有特定的规律,可以通过工艺曝光方法进行准确测量和表征,所测得的图形尺寸与杂散光测试剂量之间的关系在小尺寸段符合线性规律,在大尺寸段符合指数规律,基于这一特征规律进一步指导与优化了杂散光的测试方案,从而实现更准确、更高效地监控光刻机杂散光性能的目的。
中图分类号:TN405 文章编号:1674-2583(2020)04-0028-04
DOI:10.19339/j.issn.1674-2583.2020.04.009
Kirk曝光方法在光刻机杂散光测试中的应用研究。集成电路应用, 2020, 37(04):28-31.
Study on the Application of Kirk Eposure Method in the Scanner Stray Light Test
ZHANG Jiajin
Abstract — Combined with Kirk‘s test principle, based on the actual application conditions of the lithography scanner, the effective data model is established by means of process test, calculation and simulation, which is helpful to accurately grasp the influence law of stray light. The analysis shows that the influence of stray light on different size patterns have specific rules, which can be accurately measured and characterized by the process exposure method. The relationship between the measured pattern size and stray light test dose conforms to the linear rule in the small size segment and the exponential rule in the large size segment. Based on this characteristic law, the test scheme of stray light is further guided and optimized, so as to realize the purpose of monitoring the stray light performance of lithography scanner more accurately and efficiently.
Index Terms — IC manufacturing, lithography, exposure method, Kirk, stray light.
引言
光刻技术的发展速度是惊人的,其驱动力来源于人们对于高性能芯片的执着追求,在这一发展背景下,光刻技术中的关键设备光刻机起了至关重要的作用,通过设备系统的不断研制改进,持续提升光刻分辨率,使得集成电路的技术节点不断往前推进。
光刻机从干式发展到浸没式,从 DUV 发展到EUV,线条分辨率从百纳米一直缩小至几纳米,在这一演变过程中,曝光系统的杂散光性能逐步成为每一代光刻机成像控制的重要对象。对于高 NA 光刻机的杂散光性能一般需控制在 1.5% 之内,并且需要能够得到准确的测量。
杂散光在光刻曝光过程中会影响成像对比度,从而影响成像分辨率以及工艺窗口,直接导致能量阈度大幅度降低,无法保证成像线宽的均匀性。正是由于杂散光对于成像结果的突出影响,该性能必须得到有效、准确的测试,才能评估该设备状态是否会影响生产良率。对于光刻机的杂散光性能可以通过工艺曝光的方法进行测试,该方法基于 Kirk 的原理,也是目前普遍认可比较成熟的办法。相比于快速引入和发展的传感器测量技术,这种通过工艺曝光方法进行杂散光测试的应用研究还比较有限。
本文将通过检测不同尺寸光刻胶图形的变化,研究分析杂散光的分布特征和影响规律,从而指导与优化现有的杂散光测试方案,进而帮助光刻工艺工程师更直观有效地监控光刻机杂散光性能。
1 基于 Kirk 曝光方法的工艺试验
Kirk 工艺试验采用光刻工艺中大剂量曝光的方式,把硅片面应该成像的掩模图形使用大剂量曝光去除,理论上硅片面成像图形几何中心的杂散光能量达到光刻胶去除的临界值时,硅片面的光刻胶成像图形将被直接显影去除,该剂量可用于计算当前图形结构下的杂散光结果。
该测试需要使用专门设计的图形掩模版,掩模版(1 倍缩放)上包含两个图形区域,一个是方形图形区,区域内设定边长尺寸从 1~100 μm 的 20 多个方形图形,这些图形由不透光的铬层覆盖;另一个是空白透光区,区域内包含了毫米级别的矩形空白透光图形。
Kirk 工艺试验的具体实施流程包含三步:(1)按标准光刻工艺条件对空白透光区进行曝光,得到该光刻工艺条件下光刻胶的能量阈值 E0 结果。(2)使用 50~180 倍 E0 剂量条件对方形图形区进行曝光,利用显微镜确定各剂量下残余的最小方形图形,并记录对应方形图形的边长尺寸。(3)模型拟合剂量与残留方形图形尺寸的关系,得到所需尺寸结构下的拟合剂量值 Eclear,并按如下公式计算杂散光 Stray Light(剂量百分比)结果。
SL(%)=E0 / EClear ×100%
我们在 ArF 光源的实验光刻机上开展Kirk工艺试验,通过实际测试结果评估该光刻机成像系统的杂散光性能。一般而言,曝光视场中心的杂散光最强,因而本次测试选择视场中心点进行测试,按照标准的光刻工艺菜单配置测试片涂胶、曝光(NA 0.75)、显影的参数,并通过上述流程的实施获得光刻胶的能量阈值 E0=11.5 mj 以及显微镜下的测量数据。
接着进行拟合计算,按指数、对数和线性方式分别拟合,同时计算 5 μm 方形图形的杂散光结果,图形边长尺寸已取对数,拟合结果。
从拟合结果看,指数拟合的拟合度较差,对应的数据拟合结果可信度偏低,该测试结果可以去除,而对数拟合和线性拟合的 R2 均满足了 0.95 的要求,在当前情况下,对于 Kirk 工艺试验数据的处理分析而言,两种拟合方式并存将增加测试结果的不确定性,为了提高测试结果的准确性,需要进一步判断何种方式拟合更为准确。
2 详细工艺试验与模拟仿真分析
2.1 详细工艺试验
为了评估和判断 Kirk 工艺试验数据的准确拟合方式,我们需要提高测试剂量的密度,这样就可以得到更为准确的各尺寸图形结构下的杂散光结果,通过详细工艺试验获得测量数据所示,并同时计算各尺寸图形的杂散光结果。
由于测量数据密度的增加,整体分布规律基本显现,可以认为整体分布规律符合指数形式(与第一节线性拟合关系相当)。对图 3 数据进行指数拟合,获得 5 μm 方形图形的去除剂量为 948.1 mj,对应杂散光结果为 1.21%,而 5 μm 方形图形实际准确的去除剂量由详细工艺试验可得为 880 mj,对应的杂散光结果为 1.30%,拟合结果与实际结果仍有一定的偏差,可以认为仅仅按照指数拟合也很难取得准确的数据结果,对于测试结果的分布规律我们需要借助模拟仿真进一步分析。
2.2 模拟仿真原理
杂散光通常按其影响距离范围可分为短程杂散光、中程杂散光、远程杂散光。一般认为,短程杂散光影响距离小于 1 μm,中程杂散光影响距离覆盖 100 μm 左右,而远程杂散光则会产生全局性的影响,可以近似为均匀的背景能量。由于短程杂散光仅仅产生局部小范围的影响,对当前工况的仿真结果干扰有限,所以在本次杂散光的模拟仿真中仅包含中远程杂散光的影响。
本次模拟仿真主要研究物面掩模测试区内不透光图形在像硅片面成像区域形成的杂散光能量分布情况,由于平面两个维度方向上的杂散光影响相同,模拟过程我们可以先考虑 x 方向一个维度的杂散光影响。设定掩模图形(1 倍缩放)为方形图形,沿 x 坐标该图形的边长为 w,半宽度为 w/2,以宽度中点为原点,则物面掩模透过率函数 T(x)可表达为式。
该函数分布也可以理解为物面中程杂散光光源的有效分布。这些物面杂散光点光源对应的像硅片面的光强能量分布符合高斯点扩散函数,在像面同样以成像图形中心为原点,在物面原点处的杂散光点光源对应的像硅片面光强能量分布可为式
其中,x 是离开像面原点的距离,A 为振幅参数,R 为范围参数。进一步可以认为像硅片面图形成像区域的中程杂散光能量分布是物面中程杂散光光源的有效分布与物面杂散光点光源对应的像硅片面光强能量分布的卷积,则像面任意位置x处的能量可以用卷积式表示。
s 为物面杂散光点光源离开坐标原点的距离。
基于以上的分析并结合实际应用工况,我们把物平面上的杂散光光源有效区域分为四个杂光区,并且定义产生影响的中程杂散光边界线垂直于坐标轴,首先考虑 x 正向杂光区范围内的中程杂散光对像面图形的正半区域影响。同时也加入背景长程杂散光的影响,则受 x 正向杂光区影响并沿 x 轴形成的杂散光能量分布(光强百分比)可表示为式。
其中,C 为常量,表示长程杂散光的背景能量,(Sx , Sy) 为物面中程杂散光点光源坐标位置,且产生影响的中程杂散光边界线定义为距离 x 轴上的测量点 100μm,x 范围为 0~w/2,即图形的正半区域。
通过模拟仿真不同宽度尺寸图形在像硅片面成像区域的杂光分布情况,可以进一步得到各尺寸成像图形中心的杂散光结果(光强百分比)如式。
式中,w 代表了图形的尺寸,同时成像图形中心的光强应该包含了四个杂光区的影响。由于图形中心杂散光能量最弱,因此当该能量大于能量阈值 E0,该图形则被认为完全去除。该模拟仿真结果可与 Kirk 工艺试验结果进行对照分析。
2.3 模拟仿真分析
本次模拟仿真中,根据当前应用工况,取振幅参数 A=0.0509,范围参数 R=1.1517,常量 C=0.007。根据式,评估局部区域杂散光对像面图形正半区域的影响,模拟可得 5μm/10μm 方形图形在成像区域沿 x 轴形成的杂散光能量分布(光强百分比)。
根据式,模拟 1~20 μm 图形的杂散光结果(光强百分比),并与工艺试验结果共同绘制。
通过分析详细工艺试验结果并参照仿真结果,我们可以得到以下结论。
(1)精细化的详细测试能够得到各尺寸图形结构下较为准确的杂散光结果,从测试结果的整体趋势看,随着能量递增,被去除图形的尺寸不断增大,尺寸增量相比能量增量在不断地递增。
(2)结合模拟仿真进一步分析,可以看到不同尺寸图形结构下的杂散光模拟结果与实测结果的趋势基本匹配,对于 4 μm 以下图形,杂散光结果随图形尺寸增加反比例递减,对于 4 μm 以上图形,杂散光结果变化趋势逐步变缓。根据这一趋势变化特征,我们对实测结果进行分段拟合,小尺寸段按线性拟合,大尺寸段按指数拟合,拟合误差相比整体指数拟合明显提升。
(3)从测试结果及变化趋势,可以进一步推断,在该实验光刻机的曝光系统中,中短程杂散光对 4 μm 以下图形影响占主导,杂光影响随图形尺寸变化逐步递减;另一方面,随着图形尺寸的增大,远程背景杂散光的影响逐渐占据主导,当图形尺寸大于 20 μm 以后,杂光影响将基本不变。
3 杂散光测试方案优化
当前的 Kirk 工艺试验流程可以根据上述总结的变化规律进行优化,优化内容主要包括剂量的步距设定和测量图形设计。
在当前的实验光刻机曝光系统中,剂量步距设定与图形尺寸相关,2~4 μm 图形去除剂量的递增系数约为 182 mj/μm(约 15E0),因此,可以将剂量递增步距设为 15E0。同样对于 5 μm 以上大尺寸图形去除剂量的递增系数约 56 mj/μm,按 30E0 剂量递增步距核算,则图形可设计为 6 μm 尺寸递增变化。
基于剂量步距的精确优化,掩模版上对应的测试图形设计分为小尺寸图形区和大尺寸图形区,在实际测试中两个图形测试区分别代表了杂散光对图形的不同影响规律,即小尺寸图形区对应线性规律,而大尺寸图形区对应指数规律。小尺寸图形区的主要图形为 2 μm、3 μm、4 μm 整数尺寸的图形,而大尺寸图形区的主要图形为 5 μm、11 μm、17μm 整数尺寸的图形。除了主要图形外,测量图形设计中还包含了辅助图形,传统测试方法中我们只关注了残余图形而忽略了去除图形,因此测试结果并非实际能量对应的最小尺寸的残余图形,导致了数据拟合的误差,因此在主图形附近增加了判断去除图形情况的辅助图形。辅助图形尺寸的设定与最终的测试误差相关,本例中的辅助图形尺寸设定可保证杂散光的最终测量结果偏差小于 0.05%。具体图形设计。
在实际测试中,根据不同评估需要可以选择不同图形区图形进行工艺试验。以小尺寸图形区的测试为例,首先必须分别测得 E0 和 Estart,Estart 为曝光起始能量,记录 2 μm 尺寸附近的去除图形和残余图形,然后按剂量步距曝光,同样记录每组图形的去除图形和残余图形,去除图形和残余图形必须同时被测得,否则需重新设定剂量步距,最后提取残留图形尺寸用于数据拟合,测试记录。
通过以上优化就可以更准确地获得曝光系统中杂散光的性能状态,同时测量图形的精简也提升了测量的针对性,提高了测试效率。
4 结论
在光刻机的曝光系统中,杂散光对不同尺寸图形的影响具有特定的规律,可以通过工艺曝光方法进行准确测量和表征。本文基于 Kirk 测试原理,进行了详细工艺试验和仿真模拟分析,进一步明确了杂散光对测试图形的影响规律,分析表明所测得的图形尺寸与杂散光测试剂量之间的关系在小尺寸段符合线性规律,在大尺寸段符合指数规律,基于这一特征规律,也反馈指导我们优化了现有的 Kirk 工艺试验方案,有效提升了曝光系统杂散光测试效率和测试准确性。
责任编辑:pj
-
光刻机
+关注
关注
31文章
1121浏览量
46373 -
集成电路制造
+关注
关注
0文章
10浏览量
6900 -
杂散光
+关注
关注
0文章
9浏览量
2403
发布评论请先 登录
相关推荐
IC设计为什么需要仿真模拟?仿真模拟的重要性有哪些?
半导体芯片切割,一道精细工艺的科技之门

基于数值计算的模拟仿真方法进行碲镉汞芯片的热应力分析
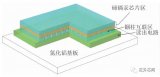
串激电机生产的精细工艺

探索串激电机生产的精细工艺(一)





 数拟详细工艺试验与模拟仿真分析
数拟详细工艺试验与模拟仿真分析















评论