越来越多的封装/ PCB系统设计需要热分析。功耗是封装/ PCB系统设计中的一个关键问题,需要仔细考虑热区域和电气区域。为了更好地理解热分析,我们可以以固体中的热传导为例,并使用两个域的对偶性。图1和表1给出了电场和热场之间的基本和基本关系。
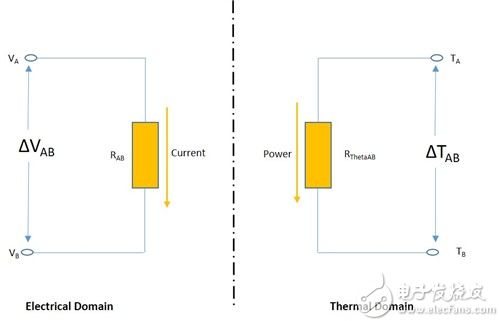
图1.电域和热域之间的基本关系

电和热域之间存在一些差异,例如:
当温度梯度存在于固体或固定流体介质中时发生热传导。热对流和辐射是比传导更复杂的热传输机制。热对流发生在固体表面与不同温度下的流体材料接触时。热辐射是来自所有物质的电磁辐射的发射,温度大于绝对零度。图2显示了三种热传输工作图。所有上述热传递机制的一维应用的描述性方程可以表示为表2所示。
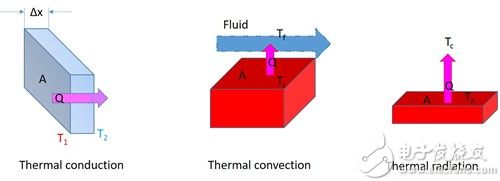
图2.三种热传输机制图

哪里:
Q是单位时间内传热量(J / s)
k是热导率(W /(Km))
A是物体的截面积(m2)
ΔT是温差
Δx是材料的厚度
hc是对流换热系数
hr是辐射传热系数
T1是一侧的初始温度
T2是另一侧的温度
Ť小号是固体表面的温度(ÔC)
Tf是流体的平均温度(oC)
Th是热端温度(K)
Tc是冷端温度(K)
ε是物体的发射率(对于黑体)(0〜1)
σ是Stefan-Boltzmann常数= 5.6703×10-8(W /(m2K4))
SigrityPowerDC是一种经过验证的电气和热量技术,多年来一直用于设计,分析和签署实际封装和PCB。集成的电气/热量联合仿真功能可帮助用户轻松确认设计是否符合规定的电压和温度阈值,而无需花费大量精力来筛选难以判断的影响。借助这项技术,您可以获得准确的设计余量并降低设计的制造成本。下图显示了PowerDC用于电气/热量联合仿真的方法:

图3. PowerDC电气/热协同仿真方案图
除了E / T协同仿真外,PowerDC还提供其他与热量有关的功能,例如:
-
热模型提取(图4)
-
热应力分析(图5)
-
多板分析(图6)
-
芯片封装板协同仿真(图7)
借助这些技术和功能,您可以方便快捷地评估包装或印刷电路板设计的图形和数字热流和热辐射。

图4.包热模型提取
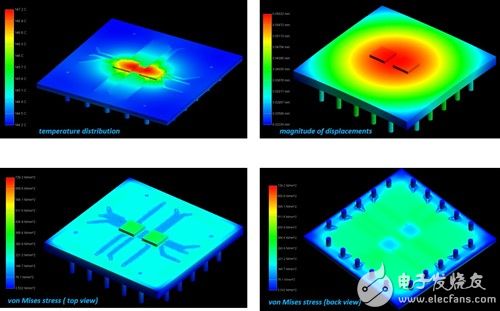
图5.封装热应力分析示例
图6.多电路板热分析
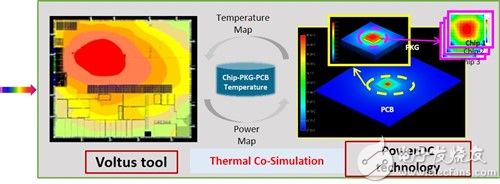
图7.使用Voltus-PowerDC进行芯片封装热协同仿真
-
pcb
+关注
关注
4220文章
22472浏览量
385744 -
封装
+关注
关注
123文章
7278浏览量
141095 -
热分析
+关注
关注
1文章
32浏览量
5518
发布评论请先 登录
相关推荐
周界安防系统介绍、优势和解决方案
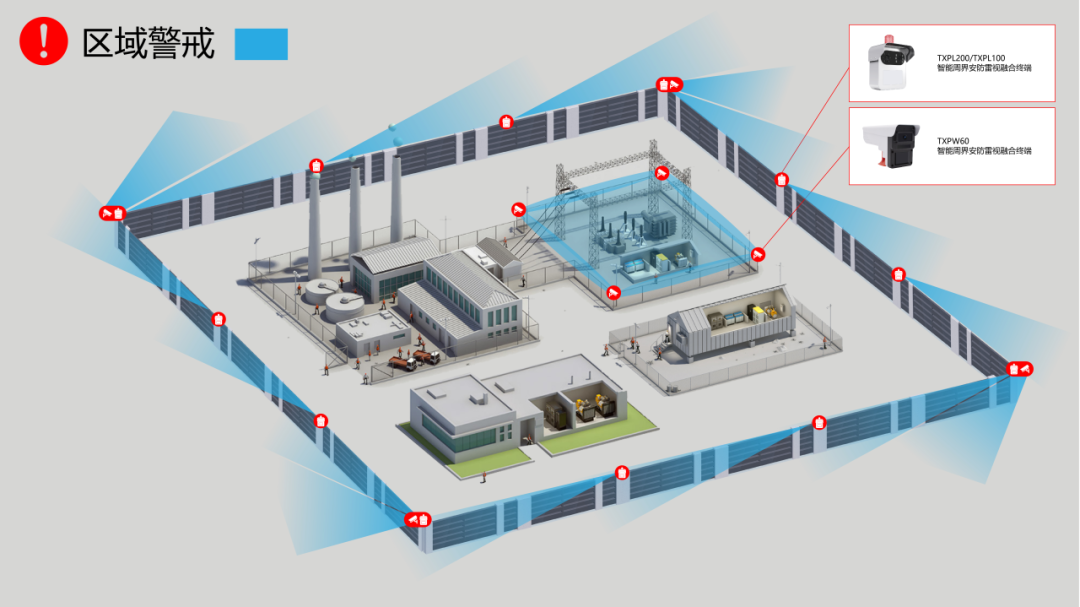
电流监控系统的应用场景和解决方案
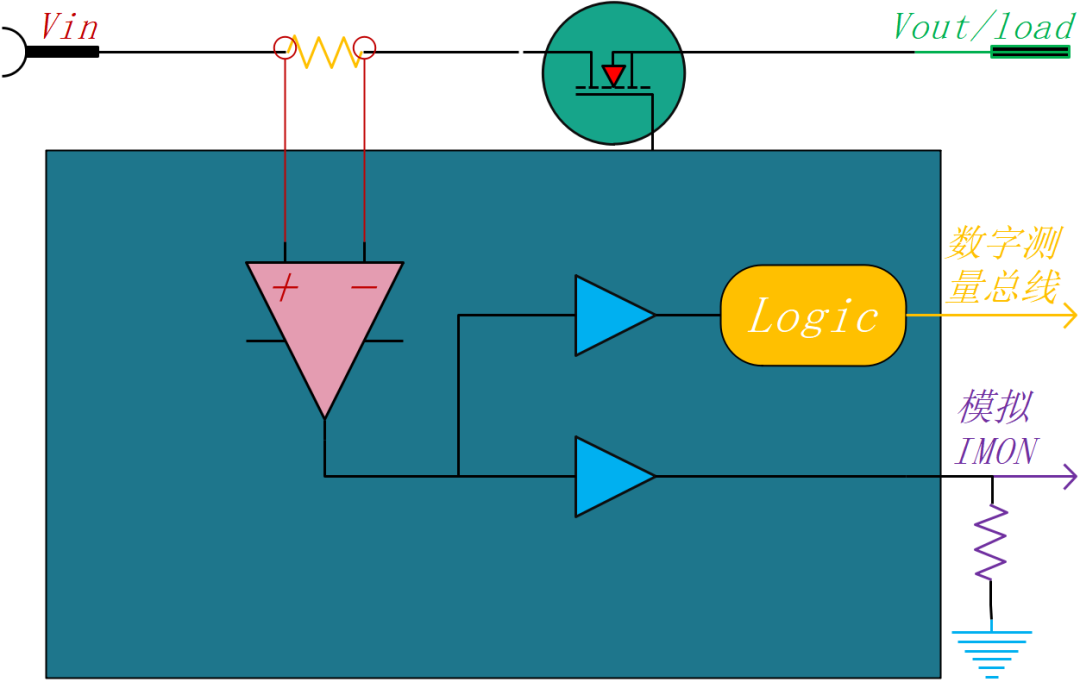
自动驾驶点云标注:挑战与解决方案
面部表情识别的技术挑战与解决方案
面部表情识别技术的挑战与解决方案
陶瓷线路板在激光雷达传感器中面临的挑战和解决方案

利用陶瓷电路板优化信号要点:挑战和解决方案
PCI Express Gen 4验证挑战和解决方案





 封装/ PCB系统的热分析:挑战和解决方案
封装/ PCB系统的热分析:挑战和解决方案

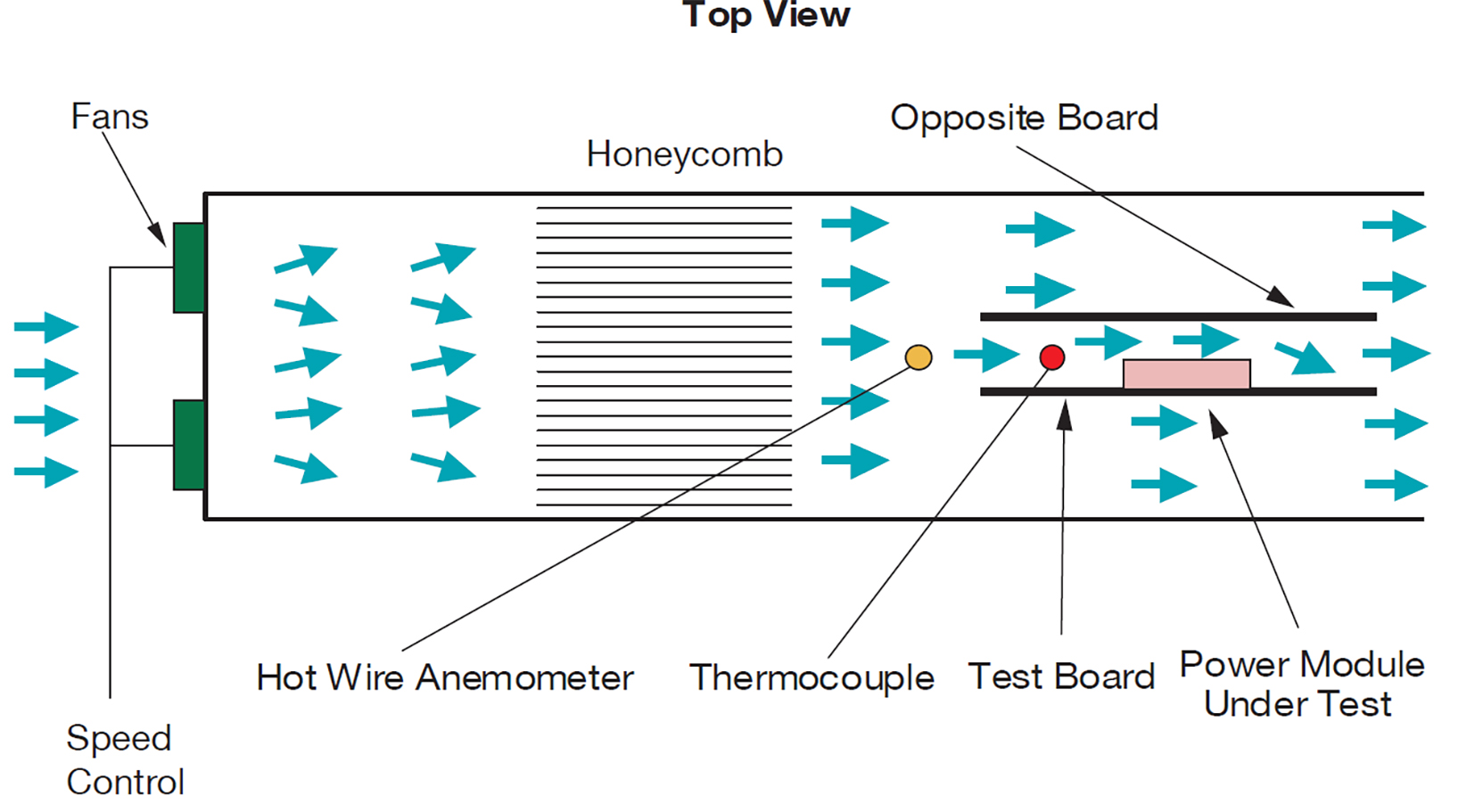











评论