2.5D与矽传孔 - 新兴封装技术:小型化趋势永无止境
讨论封装技术时当然也不容错过2.5D 与矽穿孔(TSV)封装整合,例如AMD的Fury X绘图卡。图7显示在其2.5D整合方案中的GPU覆晶封装至晶片中介层,周围并围绕4个海力士(Hynix)高频宽记忆体(HBM) DRAM模组。该HBM模组利用中介层表面顶部形成的铜互连以电连接至GPU。
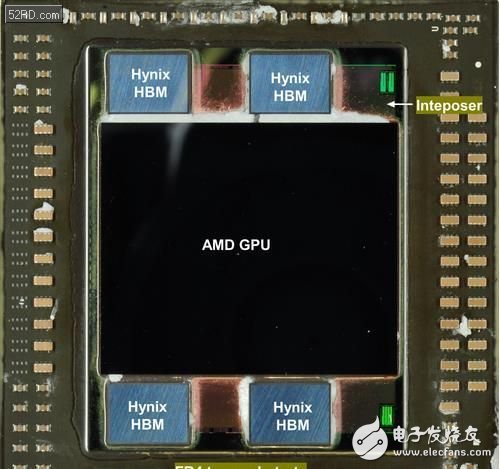
图7:AMD Fury X GPU
图8是AMD Fury X GPU的封装横截面图,显示连接至矽中介层与底层FR4基板的Hynix HBM模组部份。AMD GPU也以覆晶封装至相同的中介层,但连接至HBM右侧(超出此图范围之外)。矽中介层连同4个HBM模组与GPU依次嵌入于FR4基板上。
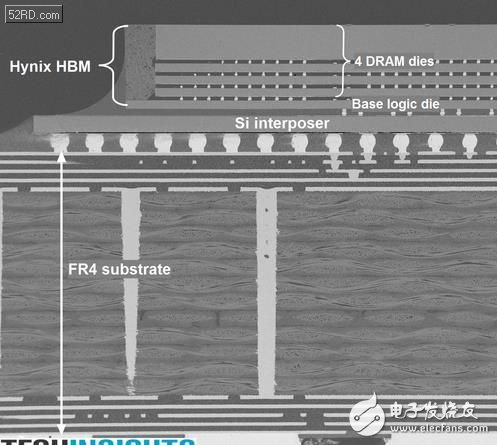
图8:AMD Fury X封装横截面
图9可以看到用于连接HBM模组至FR4基板与GPU的铜走线,这些都是使用传统65nm双金属镶嵌制程形成的。我们还可以看到用于连接中介层至FR4基板的铜填充TSV。
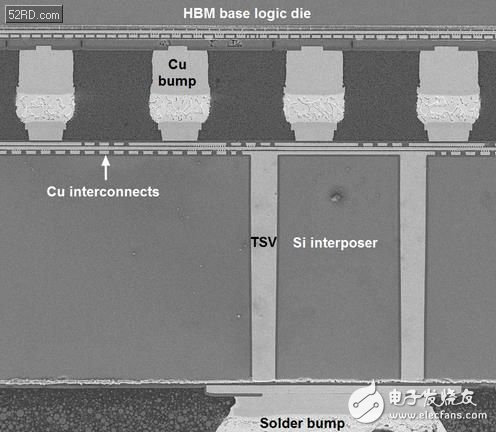
图9:矽中介层与铜互连
本文简要地介绍了三种主要的封装整合方案:多晶片模组(MCM)、嵌入式元件封装(ECP)以及 2.5D的TSV封装。这些方案都是针对需要提高封装整合度的理想解决方案。
新兴封装技术的出现,主要的驱动力量就来自于永无止境地追求更轻薄短小的智慧型手机。如今,业界盛传Apple将为即将推出的iPhone 7取消耳机孔,目的就是为了打造更纤薄的手机。然而我们并不确定元件制造商将会采用哪一种封装技术来搭配。iPhone 7预计要到今年九月才会发布,这漫长的等待时间怎不教人心急?
- 第 1 页:新兴封装技术:小型化趋势永无止境
- 第 2 页:嵌入蓝牙模组
- 第 3 页:2.5D与矽传孔
本文导航
非常好我支持^.^
(0) 0%
不好我反对
(0) 0%
相关阅读:
- [电子说] 金川兰新电子半导体封装新材料生产线项目主体封顶 2023-10-24
- [电子说] 使用半大马士革工艺流程研究后段器件集成的工艺 2023-10-24
- [电子说] ESD介绍及TVS的原理和应用 2023-10-24
- [电子说] 怎样延长半导体元器件的寿命呢? 2023-10-24
- [电子说] 瑞能半导体:碳化硅助力加速新能源汽车行业发展 2023-10-24
- [电子说] 氮化镓充电器如何变得更快更强 2023-10-24
- [制造/封装] 晶圆键合的种类和应用 2023-10-24
- [制造/封装] 什么是引线键合?引线键合的演变 2023-10-24
( 发表人:方泓翔 )
