倒装晶片自60年代诞生后,这个技术已逐渐替换常规的打线接合,逐渐成为封装潮流,为高端器件及高密度封装领域中经常采用的封装形式。倒装晶片主要应用在无线局域网络天线、系统封装、多芯片模块、图像传感器、微处理器、医用传感器以及无线射频识别等等。
倒装晶片几何尺寸可以用一个“小”字来形容,焊球直径可以小至50微米、焊球间距可以小至100微米,外形尺寸小至1平方毫米。如果smt贴片加工厂家要同时进行量产的话,对组装设备的要求甚高,这里先谈三大挑战。
倒装晶片组装设备的三大挑战:
1、板支撑及定位系统要平整及精确
2、供料器功能强大
3、照相机及影像处理技术高
在本文中,小编将通过三个方面讲解如何应对倒装晶片装配的三大挑战。
一、板支撑及定位系统要平整及精确
在进行倒装晶片装配时,基板材料一般有硬质板、柔性电路板或薄型电路板。如果应用在柔性电路板上,对基板的平整及支撑非常关键,否则会出现“弹簧床”现象,一旦移开贴装头,基板就回弹,造成元件偏移。
采用高精度升降平台和真空治具传送基板及载具,以形成一个平整的支撑及精确的定位系统,来需要满足以下要求:
1、基板Z方向的精确支撑控制,支撑高度编程调节;
2、可处理条带/引线框架、奥尔载盘上载及下载、载具/托盘、电路板/面板,厚度由0.1毫米至12.0毫米;
3、内置真空发生器;
4、精准记录基板的X、Y及Z轴。
二、供料器功能强大
为要满足批量smt贴片加工和smt贴片打样高度高良率的生产要求,供料技术也是至为关键的。倒装晶片的包装方式主要有JEDEC盘、晶圆盘、卷带料盘。对应的供料器则为:固定式料盘供料器、自动堆叠式料盘供料器,晶圆供料器以及带式供料器。
供料器必须具有精确高速供料的能力,对于晶圆供料器,还要求其能处理多种元件包装方式,如元件包装可以是JEDEC盘或裸晶,甚至晶片在机器内完成翻转动作。
Innova及Innova+直接晶圆供料器:
1、可以支持最大300毫米的晶圆盘
2、供料速度:1毫米晶圆每小时最高4,700个元件
3、晶片尺寸0.7至11平方毫米
4、支持墨水和无墨水晶圆片阵列测绘,便于自动检出不需拾取的坏件
5、可直接导入倒装芯片及裸晶片
6、晶圆预张功能,快速换盘(少于4秒)
7、可以放置多达25层料盘
8、晶圆扩张深度:
9、可编程(Innova+),由夹圈固定(Innova)
10、具备晶片追踪功能
三、照相机及影像处理技术高
处理细小焊球间距的倒装晶片的影像,需要百万像素的数码相机。较高像素的数码相机有较高的放大倍率,但像素越高,视像区域越小,这意味着大的元件可能需要多次影像。
照相机的光源一般为发光二极管,分为侧光源、前光源和轴向光源,可以单独控制。倒装晶片的成像光源采用侧光或前光,或两者结合。
编辑:hfy
-
无线局域网
+关注
关注
1文章
227浏览量
29522 -
smt
+关注
关注
36文章
2722浏览量
67430 -
晶片
+关注
关注
1文章
387浏览量
31165
发布评论请先 登录
相关推荐
倒装芯片和晶片级封装技术及其应用
倒装晶片为什么需要底部填充
倒装晶片的贴装工艺控制
倒装晶片的定义
倒装晶片装配对板支撑及定位系统的要求
倒装晶片的组装工艺流程
倒装晶片对照相机和影像处理技术的要求
倒装晶片的组装基板的设计及制造
倒装晶片贴装设备
倒装芯片应用的设计规则
LED倒装晶片所需条件及其工艺原理与优缺点的介绍
倒装晶片装配对板支撑及定位系统的要求
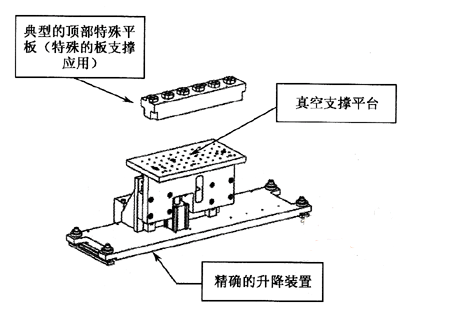
倒装晶片装配对供料器的要求

倒装晶片的组装工艺流程





 如何应对倒装晶片装配的三大挑战
如何应对倒装晶片装配的三大挑战










评论