什么是绝缘栅极双极性晶体管
什么是绝缘栅极双极性晶体管
绝缘栅双极晶体管(IGBT)本质上是一个场效应晶体管,只是在漏极和漏区之间多了一个P型层.根据国际电工委员会IEC/TC(CO)1339文件建议,其各部分名称基本沿用场效应晶体管的相应命名。
下图为一个N沟道增强型绝缘栅双极晶体管结构,N+区称为源区,附于其上的电极称为源极.N+区称为漏区.器件的控制区为栅区,附于其上的电极称为栅极.沟道在紧靠栅区边界形成.在漏,源之间的P型区(包括P+和P一区)(沟道在该区域形成),称为亚沟道区(Subchannelregion).而在漏区另一侧的P+区称为漏注入区(Draininjector),它是IGBT特有的功能区,与漏区和亚沟道区一起形成PNP双极晶体管,起发射极的作用,向漏极注入空穴,进行导电调制,以降低器件的通态电压.附于漏注入区上的电极称为漏极.为了兼顾长期以来人们的习惯,IEC规定:源极引出的电极端子(含电极端)称为发射极端(子),漏极引出的电极端(子)称为集电极端(子)。
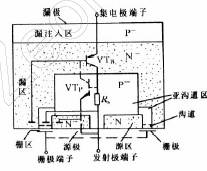
正是由于IGBT是在N沟道MOSFET的N+基板上加一层P+基板,形成了四层结构,由PNP-NPN晶体管构成IGBT.但是,NPN晶体管和发射极由于铝电极短路,设计时尽可能使NPN不起作用.所以说,IGBT的基本工作与NPN晶体管无关,可以认为是将N沟道MOSFET作为输入极,PNP晶体管作为输出极的单向达林顿管.采取这样的结构可在N一层作电导率调制,提高电流密度。
IGBT的开关作用是通过加正向栅极电压形成沟道,给PNP晶体管提供基极电流,使IGBT导通.反之,加反向栅极电压消除沟道,流过反向基极电流,使IGBT关断.IGBT的驱动方法和MOSFET基本相同,只需控制输入极N沟道MOSFET,所以具有高输入阻抗特性.当MOSFET的沟道形成后,从P+基极注入到N一层的空穴(少子),对N一层进行电导调制,减小N一层的电阻,使IGBT在高电压时,也具有低的通态电压。
IGBT(InsulatedGateBipolarTransistor:绝缘栅双极晶体管)作为新型电力半导体场控自关断器件,集功率MOSFET的高速性能与双极性器件的低电阻于一体,具有输入阻抗高,电压控制功耗低,控制电路简单,耐高压,承受电流大等特性,在各种电力变换中获得极广泛的应用。与此同时,各大半导体生产厂商不断开发IGBT的高耐压、大电流、高速、低饱和压降、低成本技术,主要采用1um以下制作工艺,研制开发取得一些新进展。
IGBT的工作特性包括静态和动态两类:
1.静态特性IGBT的静态特性主要有伏安特性、转移特性和开关特性。
IGBT的伏安特性是指以栅源电压Ugs为参变量时,漏极电流与栅极电压之间的关系曲线。输出漏极电流比受栅源电压Ugs的控制,Ugs越高,Id越大。它与GTR的输出特性相似.也可分为饱和区1、放大区2和击穿特性3部分。在截止状态下的IGBT,正向电压由J2结承担,反向电压由J1结承担。如果无N+缓冲区,则正反向阻断电压可以做到同样水平,加入N+缓冲区后,反向关断电压只能达到几十伏水平,因此限制了IGBT的某些应用范围。
IGBT的转移特性是指输出漏极电流Id与栅源电压Ugs之间的关系曲线。它与MOSFET的转移特性相同,当栅源电压小于开启电压Ugs(th)时,IGBT处于关断状态。在IGBT导通后的大部分漏极电流范围内,Id与Ugs呈线性关系。最高栅源电压受最大漏极电流限制,其最佳值一般取为15V左右。
IGBT的开关特性是指漏极电流与漏源电压之间的关系。IGBT处于导通态时,由于它的PNP晶体管为宽基区晶体管,所以其B值极低。尽管等效电路为达林顿结构,但流过MOSFET的电流成为IGBT总电流的主要部分。此时,通态电压Uds(on)可用下式表示
Uds(on)=Uj1+Udr+IdRoh(2-14)
式中Uj1——JI结的正向电压,其值为0.7~IV;
Udr——扩展电阻Rdr上的压降;
Roh——沟道电阻。
通态电流Ids可用下式表示:
Ids=(1+Bpnp)Imos
式中Imos——流过MOSFET的电流。
由于N+区存在电导调制效应,所以IGBT的通态压降小,耐压1000V的IGBT通态压降为2~3V。
IGBT处于断态时,只有很小的泄漏电流存在。
2.动态特性IGBT在开通过程中,大部分时间是作为MOSFET来运行的,只是在漏源电压Uds下降过程后期,PNP晶体管由放大区至饱和,又增加了一段延迟时间。td(on)为开通延迟时间,tri为电流上升时间。实际应用中常给出的漏极电流开通时间ton即为td(on)tri之和。漏源电压的下降时间由tfe1和tfe2组成,如图所示。

IGBT在关断过程中,漏极电流的波形变为两段。因为MOSFET关断后,PNP晶体管的存储电荷难以迅速消除,造成漏极电流较长的尾部时间,td(off)为关断延迟时间,trv为电压Uds(f)的上升时间。实际应用中常常给出的漏极电流的下降时间Tf由图中的t(f1)和t(f2)两段组成,而漏极电流的关断时间
t(off)=td(off)+trv十t(f)
式中,td(off)与trv之和又称为存储时间。

1979年,MOS栅功率开关器件作为IGBT概念的先驱即已被介绍到世间。这种器件表现为一个类晶闸管的结构(P-N-P-N四层组成),其特点是通过强碱湿法刻蚀工艺形成了V形槽栅。
80年代初期,用于功率MOSFET制造技术的DMOS(双扩散形成的金属-氧化物-半导体)工艺被采用到IGBT中来。[2]在那个时候,硅芯片的结构是一种较厚的NPT(非穿通)型设计。后来,通过采用PT(穿通)型结构的方法得到了在参数折衷方面的一个显著改进,这是随着硅片上外延的技术进步,以及采用对应给定阻断电压所设计的n+缓冲层而进展的[3]。几年当中,这种在采用PT设计的外延片上制备的DMOS平面栅结构,其设计规则从5微米先进到3微米。
90年代中期,沟槽栅结构又返回到一种新概念的IGBT,它是采用从大规模集成(LSI)工艺借鉴来的硅干法刻蚀技术实现的新刻蚀工艺,但仍然是穿通(PT)型芯片结构。[4]在这种沟槽结构中,实现了在通态电压和关断时间之间折衷的更重要的改进。
硅芯片的重直结构也得到了急剧的转变,先是采用非穿通(NPT)结构,继而变化成弱穿通(LPT)结构,这就使安全工作区(SOA)得到同表面栅结构演变类似的改善。
这次从穿通(PT)型技术先进到非穿通(NPT)型技术,是最基本的,也是很重大的概念变化。这就是:穿通(PT)技术会有比较高的载流子注入系数,而由于它要求对少数载流子寿命进行控制致使其输运效率变坏。另一方面,非穿通(NPT)技术则是基于不对少子寿命进行杀伤而有很好的输运效率,不过其载流子注入系数却比较低。进而言之,非穿通(NPT)技术又被软穿通(LPT)技术所代替,它类似于某些人所谓的“软穿通”(SPT)或“电场截止”(FS)型技术,这使得“成本—性能”的综合效果得到进一步改善。
1996年,CSTBT(载流子储存的沟槽栅双极晶体管)使第5代IGBT模块得以实现[6],它采用了弱穿通(LPT)芯片结构,又采用了更先进的宽元胞间距的设计。目前,包括一种“反向阻断型”(逆阻型)功能或一种“反向导通型”(逆导型)功能的IGBT器件的新概念正在进行研究,以求得进一步优化。
IGBT功率模块采用IC驱动,各种驱动保护电路,高性能IGBT芯片,新型封装技术,从复合功率模块PIM发展到智能功率模块IPM、电力电子积木PEBB、电力模块IPEM。PIM向高压大电流发展,其产品水平为1200—1800A/1800—3300V,IPM除用于变频调速外,600A/2000V的IPM已用于电力机车VVVF逆变器。平面低电感封装技术是大电流IGBT模块为有源器件的PEBB,用于舰艇上的导弹发射装置。IPEM采用共烧瓷片多芯片模块技术组装PEBB,大大降低电路接线电感,提高系统效率,现已开发成功第二代IPEM,其中所有的无源元件以埋层方式掩埋在衬底中。智能化、模块化成为IGBT发展热点。
现在,大电流高电压的IGBT已模块化,它的驱动电路除上面介绍的由分立元件构成之外,现在已制造出集成化的IGBT专用驱动电路.其性能更好,整机的可靠性更高及体积更小。
根据前面描述的IGBT的工作原理,可以得到如图所示的IGBT输出特性。
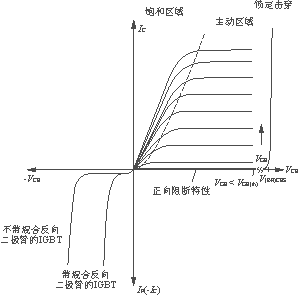
(a)IGBT的输出特性(n沟道增强型)
(b)转移特性IC=f(VCE)
IGBT的输出特性与转移特性
非常好我支持^.^
(1) 3.1%
不好我反对
(31) 96.9%
相关阅读:
- [电子说] 用VHDL语言创建一个8位算术逻辑单元(ALU) 2023-10-24
- [制造/封装] Transphorm 最新技术白皮书: 常闭耗尽型 (D-Mode)与增强型 (E-Mode) 氮化镓晶体管的 2023-10-24
- [制造/封装] 什么是引线键合?引线键合的演变 2023-10-24
- [电子说] TR-PP-11B手持式军用电台拆解 2023-10-24
- [电子说] MOS管为什么需要电源启动?电源缓启动能做什么? 2023-10-24
- [电子说] 单管收音机电路图讲解 2023-10-24
- [电子说] 简易LED恒流电路分析 2023-10-24
- [电子说] 基于555芯片的振荡器电路分析 2023-10-24
( 发表人:admin )
