MOS管,IGBT,以及三极管他们有什么区别?
mos管、igbt、三极管比较,mos开关速度最快,三极管最慢,而igbt内部是靠mos管先开通驱动三极管开通(这个原理决定了它的开关速度比mos慢,比三极管快,和几代技术无关)。mos管的最大劣势是随着耐压升高,内阻迅速增大(不是线性增大),所以高压下内阻很大,不能做大功率应用。随着技术发展,无论mos管还是igbt管,它们的各种参数仍在优化。目前igbt技术主要是欧美和日本垄断,国内最近2年也几个公司研究工艺,但目前都不算成熟,所以igbt基本都是进口。igbt的制造成本比mos高很多,主要是多了薄片背面离子注入,薄片低温退火(最好用激光退火),而这两个都需要专门针对薄片工艺的昂贵的机台(wafer一般厚度150um-300um之间)。
在低压下 igbt相对mos管在电性能和价格上都没有优势,所以基本上看不到低压igbt,并不是低压的造不出来,而是毫无性价比。在600v以上,igbt的优势才明显,电压越高,igbt越有优势,电压越低,mos管越有优势。导通压降,一般低压mos管使用都控制在0.5v以下(基本不会超过1v的)。比如ir4110,内阻4毫欧姆,给它100a的导通电流,导通压降是0.4v左右。
mos开关速度快,意味着开关损耗小(开关发热小),同样电流导通压降低,意味着导通损耗小(还是发热小)。
上面说的是低压状况。高压情况就差很多了。
开关速度无论高压低压都是mos最快。 但高压下mos的导通压降很大,或者说mos管内阻随耐压升高迅速升高,比如600v 耐压的coolmos,导通电阻都是几百毫欧姆或几欧姆,这样它的耐流也很小(通过大电流就会烧掉),一般耐流几安或者几十安培。而igbt在高耐压压下,导通压降几乎没明显增大(原因还是主要导通电流是通过三极管),所以高压下igbt优势明显,既有高开关速度(尽管比mos管慢,但是开关比三极管快很多),又有三极管的大电流特性。
目前市场上新生代的EUV-X器件的IGBT饱和(导通)压降也能做到1.2V以下了。比先代IGBT的2.7~3.2V下降不少了, 几乎与VMOS 相差无几了。而IGBT的优点——开关速度高(纳秒级),通态压降低,开关损耗小(功率损耗是第一代的五分之一),耐脉冲电流冲击力强,且耐压高,驱动功率小等优点更加突出。已集双极型晶体管(GTR)和单极型MOSFET优点于一身。 未来的低成本,低压型(耐压200~300v)的IGBT电动车驱动模块,排除价格因素,普遍应用IGBT模块也应是迟早的事。
在需要耐压超过150V的使用条件下,MOS管已经没有任何优势!以典型的IRFS4115为例:VDS-150V,ID-105A(Tj=25摄氏度,这个唬人指标其实毫无实际使用价值),RDS-11.8 m 欧姆;与之相对应的 即使是第四代的IGBT型SKW30N60对比;都以150V,20A的电流,连续工况下运行,前者开关损耗6mJ/pulse,而后者只有1.15mJ/pulse,不到五分之一的开关损耗!就这点,能为用户省去多少烦恼?要是都用极限工作条件,二者功率负荷相差更悬殊!其实,很多时候,我们的影像中,还停留在多年前的IGBT的概念中。。。更不必比较现在的六,七代及以后的IGBT技术指标了!正因为如此,有大功率需求的诸如冶金,钢铁,高速铁路,船舶等领域已广泛应用IGBT 元器件,很少采用MOSFET来作为功率元器件。
正向单流栅极IGBT驱动电路的设计方案:
为了理解dV/dt感生开通现象,我们必须考虑跟IGBT结构有关的电容。图1显示了三个主要的IGBT寄生电容。集电极到发射极电容C,集电极到栅极电容C和栅极到发射极电容CGE。
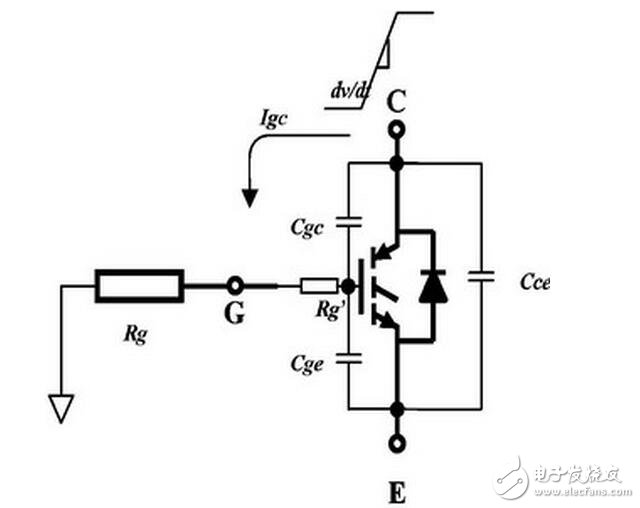
图1 IGBT器件的寄生电容
这些电容对桥式变换器设计是非常重要的,大部份的IGBT数据表中都给出这些参数:
输出电容,COES=CCE+CGC(CGE短路)
输入电容,CIES=CGC+CGE(CCE短路)
反向传输电容,CRES=CGC

图2 半桥电路
图2给出了用于多数变换器设计中的典型半桥电路。集电极到栅极电容C和栅极到发射极电容C组成了动态分压器。当高端IGBT(Q2)开通时,低端IGBT(Q1)的发射极上的dV/dt会在其栅极上产生正电压脉冲。对于任何IGBT,脉冲的幅值与栅驱动电路阻抗和dV/dt的实际数值有直接关系。IGBT本身的设计对减小C和C的比例非常重要,它可因此减小dV/dt感生电压幅值。
如果dV/dt感生电压峰值超过IGBT的阀值,Q1产生集电极电流并产生很大的损耗,因为此时集电极到发射极的电压很高。
为了减小dV/dt感生电流和防止器件开通,可采取以下措施:
关断时采用栅极负偏置,可防止电压峰值超过V,但问题是驱动电路会更复杂。
减小IGBT的CGC寄生电容和多晶硅电阻Rg’。
减小本征JFET的影响
图3给出了为反向偏置关断而设计的典型IGBT电容曲线。CRES曲线(及其他曲线)表明一个特性,电容一直保持在较高水平,直到V接近15V,然后才下降到较低值。如果减小或消除这种“高原”(plateau) 特性,C的实际值就可以进一步减小。
这种现象是由IGBT内部的本征JFET引起的。如果JFET的影响可以最小化,C和C可随着VCE的提高而很快下降。这可能减小实际的CRES,即减小dV/dt感生开通对IGBT的影响。
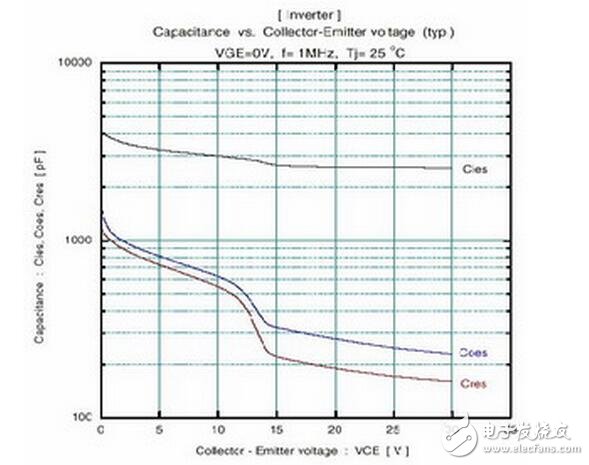
图3 需负偏置关断的典型IGBT的寄生电容与V的关系。
IRGP30B120KD-E是一个备较小C和经改良JFET的典型IGBT。这是一个1200V,30A NPT IGBT。它是一个Co-Pack器件,与一个反并联超快软恢复二极管共同配置于TO-247封装。
设计人员可减小多晶体栅极宽度,降低本征JFET的影响,和使用元胞设计几何图形,从而达到以上的目标。
对两种1200V NPT IGBT进行比较:一种是其他公司的需负偏置关断的器件,一种是IR公司的NPT单正向栅驱动IRGP30B120KD-E。测试结果表明其他公司的器件在源电阻为56?下驱动时,dV/dt感生电流很大。
比较寄生电容的数据,IR器件的三种电容也有减小:
输入电容,CIES减小25%
输出电容,COES减小35%
反向传输电容,CRES减小68%

图4 寄生电容比较
图5显示出IR器件的减小电容与V的关系,得出的平滑曲线是由于减小了JFET的影响。当V=0V时,负偏置栅驱动器件的C为1100pF,IRGP30B120KD-E只有350pF,当VCE=30V时,负偏置栅驱动器件的C为170pF,IRGP30B120KD-E的CRES为78pF。很明显,IRGP30B120KD-E具有非常低的C,因此在相同的dV/dt条件下dV/dt感生电流将非常小。
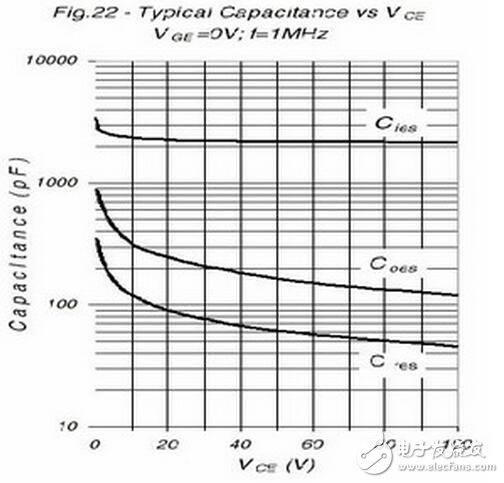
图5 IRGP30B120KD-E寄生电容与VCE的关系
图6的电路用来比较测试两种器件的电路性能。两者的dV/dt感生电流波形也在相同的dV/dt值下得出。

图6 dV/dt感生开通电流的测试电路
测试条件:
电压率,dV/dt=3.0V/nsec
直流电压,Vbus=600V
外部栅到发射极电阻Rg=56?
环境温度,TA=125°C

图7 其他公司的IGBT的低端IGBT开关电压和dV/dt感生电流的18A峰值
图8 IRGP30B120KD-E IGBT的低端IGBT开关电压和dV/dt感生电流的1.9A峰值
dV/dt感生电流的减小清楚说明单正向栅驱动设计的优胜之处。但在这个测试中,Co-Pack二极管电流的影响并没有完全计算在内。为了只显示出IGBT对整体电流的影响,我们只利用相同的分立式反并联二极管再重复测试,如图9中的Ice(cntrl)。

图9 利用相同的分立式Co-Pack二极管产生的dV/dt感生电流
图10显示出在没有IGBT情况下,负偏置栅驱动器IGBT的I电流。图11为IRGP30B120KD-E单正向栅驱动器的I电流。两种情况下的电流都很低,分别为1A和0.8A。
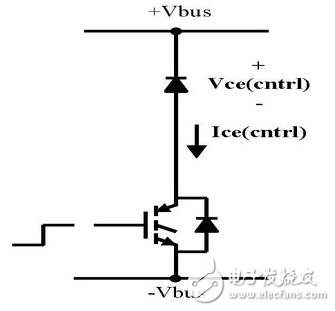
图10 其他公司的IGBT的Co-Pack二极管内的低端IGBT的VCE和dV/dt感生电流1A峰值

图11 IRG30B120KD-E的Co-Pack二极管内的低端IGBT的VCE和dV/dt感生电流0.8A峰值
如果从整体IGBT/二极管电流中减去图10和图11的二极管电流,结果是
I(负偏置栅驱动IGBT)= 18-1 = 17A
I(IRGP30B120KD-E)= 1.9-0.8 = 0.8A
可见总的减小为17:0.8 = 21:1
在相同的测试条件下,当栅电压是在0V或单正向栅驱动情况下,IRGP30B120KD的电路性能显示dV/dt感生开通电流减小比例为21:1。如果IGBT采用这种方式驱动,电流很小,对功耗的影响几乎可以忽略。

图12 栅驱动波形
采用单正向栅驱动IGBT有下列好处:
不需要负偏置
驱动器电路成本更低
更高的栅抗噪声功能
更高的dV/dt耐容
与不能提供负偏置驱动的IR单片式栅驱动器兼容

图13 具有电平转换的栅驱动IC电路
上述设计对PT和NPT IGBT同样有效。
结论:
单正向栅驱动IGBT是器件发展的巨大进步。IRGP30B120KD-E的C值很低,在单正向栅驱动条件下,其开关性能非常理想。器件不需要负偏置栅驱动便能可靠关断,即使在集电极的dV/dt为3V/ns。与单片式栅驱动器的兼容性更为桥式变换器和交流电机驱动提供更优越和成本更低的解决方案。所以我们期望这些先进的IGBT能为新的IC设计提供更大的优势。
