什么是MIS
什么是MIS
金属-绝缘体-半导体(简写为 MIS)系统的三层结构如图1所示。如绝缘层采用氧化物,则称为金属-氧化物-半导体(简写为MOS)系统。硅片上生长一层薄氧化膜后再覆盖一层铝,就是 最常见的MOS结构。60年代以来MIS系统无论在技术应用方面还是在物理研究方面都有着十分特殊的作用。
金属-绝缘体-半导体系统
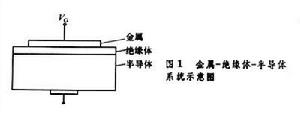
当半导体衬底接地,金属层(通常称为栅极)上施加电压时,半导体表面形成电荷层。以P型半导体衬底为例,当栅压为负,它会吸引空穴到半导体表面,使表面 形成带正电荷的空穴积累层;当栅压为正,它既有把多数载流子空穴从P型半导体表面排斥走的作用,又有吸引少数载流子电子到半导体表面的作用。当正栅压较小 时,主要是空穴被排斥走,形成带负电荷的耗尽层,负电荷来源于电离的受主,这时虽然也有电子被吸引到表面,但为数尚少。当正栅压增大到超过一定的阈值电 压,吸引到表面的电子浓度迅速增大,在表面形成电子导电层,因为其载流子和体内导电类型相反,因而称为反型层。反型层与衬底之间被耗尽层隔开,如同PN结 一样,称为场感应结。图2中给出了与反型层情况相应的能带图。
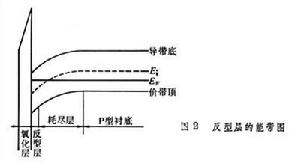
如果如图3所示,在P型衬底的MOS系统中增加两个N型区,分别称为源(用 S表示)区和漏(用D表示)区,这就是N沟道的MOS晶体管。当栅压低于阈值电压时,由于源区和漏区被P型区隔开,源和漏间相当于两个背靠的PN结,因 此,当源、漏间加一定电压后,没有明显的电流,只有微量的PN结反向电流。但当栅极正电压超过阈值电压后,P型Si表面出现的反型层(N型层)把源区和漏 区沟通,形成导电沟通。这时再在源、漏之间加一定的电压,就会有明显的电流流过。也就是说,通过控制栅压的极性和数值,可以使MOS晶体管分别处于导通或 截止的状态,利用这一性质做成的MOS集成电路,可以实现各种逻辑功能。由于MOS集成电路具有工艺较简单、结构尺寸较小、连线数目较少等优点,使之较易 实现大规模集成,因而是当前大规模集成电路中最重要的类型之一。
金属-绝缘体-半导体系统
MIS系统实际上构成一个电容器,金属层和半导体衬底是它的两个极板。它与一般电容器的区别在于电容值并不是恒定的,因而可以引入微分电容C(V),它是偏压V的函数,这个函数关系称为MIS电容器的C-V特性。根据绝缘层的厚度、半导体衬底的掺杂浓度,从理论上很容易计算出C-V曲线,而实际测量得到的C-V曲线总是偏离理想的情况。这是因为在实际的 MIS电容的绝缘层中往往存在有各种电荷和在绝缘体和半导体的界面附近存在有界面态。正因为如此,可以通过对实际C-V曲线的分析,研究绝缘层中电荷和界面态的性质。金属-SiO2-Si系统是研究最多的MIS结构,其中主要的电荷形式有:可动离子电荷(例如Na+,K+)、Si-SiO2界面固定正电荷、辐射电离的陷阱和界面态。基于掩蔽作用和钝化作用发展起来的硅平面技术,是目前最重要的半导体工艺技术,在这里Si-SiO2系统成为半导体器件的基本组成部分。SiO2中的电荷以及Si-SiO2界面态,会影响器件的参数,特别是影响到器件长期使用的可靠性和稳定性。正是由于对金属-SiO2-Si系统做了广泛的研究,找到了减少以致消除各种电荷状态不良影响的手段,才使得Si晶体管以及大规模集成电路得以有如此迅速的发展。
MOS系统的表面反型层厚度为几埃至几十埃,因而可以把反型层中的电子看成是二维的电子气。近年来其中丰富的物理现象引起了很多物理学家的兴趣。特别是 因为可以通过改变栅压在同一样品上使反型层中的电子浓度变化若干个数量级,为研究多电子效应随浓度的变化提供了实验数据。
参考书目
A. S.格罗夫著,齐建译:《半导体器件物理与工艺》,科学出版社,北京,1976。(A.S.Grove,Physics and Technology of Semicondotor Device,John Wiley & Sons,New York,1967.)
以SiO2为栅介质时,叫MOS器件,这是最常使用的器件形式。历史上也出现过以Al2O3为栅介质的MAS器件和以Si3N4为栅介质的MNS器件,以及以SiO2+Si3N4为栅介质的MNOS器件,统称为金属-绝缘栅-半导体器件--MIS器件。
以Al为栅电极时,称铝栅器件。以重掺杂多晶硅(Poly-Si)为栅电极时,称硅栅器件。它是当前MOS器件的主流器件。硅栅工艺是利用重掺杂的多晶硅 来代替铝做为MOS管的栅电极,使MOS电路特性得到很大改善,它使VTP下降1.1V,也容易获得合适的VTN值并能提高开关速度和集成度。
硅栅工艺具有自对准作用,这是由于硅具有耐高温的性质。栅电极,更确切的说是在栅电极下面的介质层,是限定源、漏扩散区边界的扩散掩膜,使栅区与源、漏交 迭的密勒电容大大减小,也使其它寄生电容减小,使器件的频率特性得到提高。另外,在源、漏扩散之前进行栅氧化,也意味着可得到浅结。 selfalignedpoly-siliconprocess自对准多晶硅工艺
铝栅工艺为了保证栅金属与漏极铝引线之间有一定的间隔,要求漏扩散区面积要大些。而在硅栅工艺中覆盖源漏极的铝引线可重迭到栅区,这是因为有一绝缘层将栅区与源漏电极引线隔开,从而可使结面积减少30%~40%。
硅栅工艺还可提高集成度,这不仅是因为扩散自对准作用可使单元面积大为缩小,而且因为硅栅工艺可以使用“二层半布线”即一层铝布线,一层重掺杂多晶硅布 线,一层重掺杂的扩散层布线。由于在制作扩散层时,多晶硅要起掩膜作用,所以扩散层不能与多晶硅层交叉,故称为两层半布线.铝栅工艺只有两层布线:一层铝 布线,一层扩散层布线。硅栅工艺由于有两层半布线,既可使芯片面积比铝栅缩小50%又可增加布线灵活性。
当然,硅栅工艺较之铝栅工艺复杂得多,需增加多晶硅淀积、等离子刻蚀工序,而且由于表面层次多,台阶比较高,表面断铝,增加了光刻的困难,所以又发展了以 Si3N4作掩膜的局部氧化LOCOS--Localoxidationonsilicon (又称为MOSIC的局部氧化隔离工艺LocalOxidationIsolationforMOSIC),或称等平面硅栅工艺。
扩散条连线由于其电容较大,漏电流也较大,所以尽量少用,一般是将相应管子的源或漏区加以延伸而成。扩散条也用于短连线,注意扩散条不能跨越多晶硅层,有 时把这层连线称为“半层布线”。因硼扩散薄层电阻为30~120Ω/□,比磷扩散的R□大得多,所以硼扩散连线引入的分布电阻更为可观,扩散连线的寄生电 阻将影响输出电平是否合乎规范值,同时也因加大了充放电的串联电阻而使工作速度下降。因此,在CMOS电路中,当使用硼扩散条做连线用时要考虑到这一点。
当 在NMOS的栅上施加相对于源的正电压VGS时,栅上的正电荷在P型衬底上感应出等量的负电荷,随着VGS的增加,衬底中接近硅-二氧化硅界面的表面处的 负电荷也越多。其变化过程如下:当VGS比较小时,栅上的正电荷还不能使硅-二氧化硅界面处积累可运动的电子电荷,这是因为衬底是P型的半导体材料,其中 的多数载流子是正电荷空穴,栅上的正电荷首先是驱赶表面的空穴,使表面正电荷耗尽,形成带固定负电荷的耗尽层。
这时,虽然有VDS的存在,但因为没有可运动的电子,所以,并没有明显的源漏电流出现。增加VGS,耗尽层向衬底下部延伸,并有少量的电子被吸引到表面, 形成可运动的电子电荷,随着VGS的增加,表面积累的可运动电子数量越来越多。这时的衬底负电荷由两部分组成:表面的电子电荷与耗尽层中的固定负电荷。如 果不考虑二氧化硅层中的电荷影响,这两部分负电荷的数量之和等于栅上的正电荷的数量。当电子积累达到一定水平时,表面处的半导体中的多数载流子变成了电 子,即相对于原来的P型半导体,具有了N型半导体的导电性质,这种情况称为表面反型。
根据晶体管理论,当NMOS晶体管表面达到强反型时所对应的VGS值,称为NMOS晶体管的阈值电压VTN(ThresholdvoltageforN- channeltransistor)。这时,器件的结构发生了变化,自左向右,从原先的n+-p-n+结构,变成了n+-n-n+结构,表面反型的区域 被称为沟道区。在VDS的作用下,N型源区的电子经过沟道区到达漏区,形成由漏流向源的漏源电流。显然,VGS的数值越大,表面处的电子密度越大,相对的 沟道电阻越小,在同样的VDS的作用下,漏源电流越大。
当VGS大于VTN,且一定时,随着VDS的增加,NMOS的沟道区的形状将逐渐的发生变化。在VDS较小时,沟道区基本上是一个平行于表面的矩形,当 VDS增大后,相对于源端的电压VGS和VDS在漏端的差值VGD逐渐减小,并且因此导致漏端的沟道区变薄,当达到VDS=VGS-VTN时,在漏端形成 了VGD=VGS-VDS=VTN的临界状态,这一点被称为沟道夹断点,器件的沟道区变成了楔形,最薄的点位于漏端,而源端仍维持原先的沟道厚度。器件处 于VDS=VGS-VTN的工作点被称为临界饱和点。
在逐渐接近临界状态时,随着VDS的增加,电流的变化偏离线性,NMOS晶体管的电流-电压特性发生弯曲。在临界饱和点之前的工作区域称为非饱和区,显 然,线性区是非饱和区中VDS很小时的一段。继续在一定的VGS条件下增加VDS(VDS>VGS-VTN),在漏端的导电沟道消失,只留下耗尽 层,沟道夹断点向源端趋近。由于耗尽层电阻远大于沟道电阻,所以这种向源端的趋近实际上位移值?L很小,漏源电压中大于VGS-VTN的部分落在很小的一 段由耗尽层构成的区域上,有效沟道区内的电阻基本上维持临界时的数值。因此,再增加源漏电压VDS,电流几乎不增加,而是趋于饱和。
这时的工作区称为饱和区,左图显示了器件处于这种状态时的沟道情况,右图是完整的NMOS晶体管电流—电压特性曲线。图中的虚线是非饱和区和饱和区的分界线,VGS
双极性晶体管的输出特性曲线形状与MOS器件的输出特性曲线相似,但线性区与饱和区恰好相反。MOS器件的输出特性曲线的参变量是VGS,双极性晶体管的输出特性曲线的参变量是基极电流IB。
衡量沟道长度调制的大小可以用厄莱(Early)电压VA表示,它反映了饱和区输出电流曲线上翘的程度。
非常好我支持^.^
(14) 93.3%
不好我反对
(1) 6.7%
相关阅读:
- [电子说] 迈威通信MISCOM8220GX三层交换机强势登场 2023-10-19
- [电子说] 您需要了解的有关下一个MISRA®标准的信息:MISRA C++ 2023®简介 2023-08-25
- [光电显示] QSFP-DD中CMIS协议和DDM功能解析 2023-08-22
- [电子说] QSFP-DD模块CMIS协议和DDM知识解析 2023-08-17
- [电子说] QSFP-DD模块的CMIS协议和DDM功能应用 2023-08-16
- [电子说] QSFP-DD模块的CMIS协议和DDM功能详细解析 2023-08-16
- [电子说] 什么是SPI?SPI通信的4种工作模式 2023-08-11
- [电子说] 静态代码分析器工具Helix QAC 2023.2: 提供 100% 的 MISRA C:2012 和 MISRA C:2023 规则 2023-07-31
( 发表人:admin )
