多芯光纤是一根光纤有多个纤芯,是和“单芯光纤”相对应的一个概念。
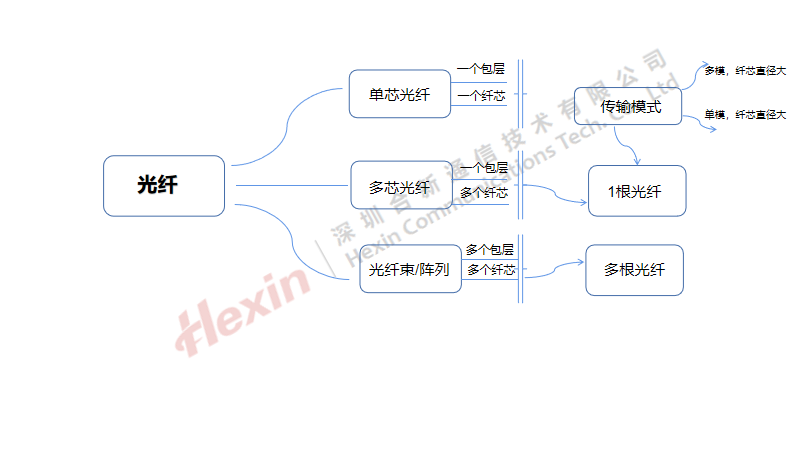
常用的单芯光纤,有多模和单模。
而多芯光纤可以有xnn个纤芯,但它是一根光纤,传输的信号则可以为独立为xn个通道,每个纤芯传输一个信道。而多光纤束可以做成各种形状,省空间,传输容量又够大。但多芯光纤有两个困难是影响到实际运用的:
一.串扰,二.扇入扇出
扇入扇出,就咱们单芯光纤与多芯光纤怎么对接,一般2个方式:1、用熔融拉锥,2.用腐蚀
熔融拉锥,把光纤比例排列,然后加熔融,向两侧拉伸。当拉伸的时候,中间会越来越细,把几百um的光纤束的直径拉倒125um,然后拦腰切断,锥形端面就和多芯光纤一致了。
把多芯光纤和光线束熔融拉伸后的锥面做对接,这就完成了从多芯光纤到单芯光纤的扇入扇出。
腐蚀:把单芯光纤的前端放到腐蚀液,包层就被均匀的融化了。腐蚀后,切割端面,纤芯和包层的直径比例变了。再把多个光纤排列粘合,就可以完成与多芯光纤的扇入扇出。
多芯光纤的扇入扇出,一种是物联方式,一种是化学方式,工艺过程的控制都挺难,相对来说,化学方法可以一根根挑选、排列、耦合,最后在粘合,成品率会高些。
声明:本文内容及配图由入驻作者撰写或者入驻合作网站授权转载。文章观点仅代表作者本人,不代表电子发烧友网立场。文章及其配图仅供工程师学习之用,如有内容侵权或者其他违规问题,请联系本站处理。
举报投诉
-
光纤传感器
+关注
关注
16文章
296浏览量
34336 -
光纤通信
+关注
关注
20文章
428浏览量
44207 -
光纤连接器
+关注
关注
2文章
393浏览量
22824 -
光纤通道
+关注
关注
0文章
221浏览量
14001 -
光纤激光器
+关注
关注
12文章
171浏览量
19401
发布评论请先 登录
相关推荐
如何解决FPGA布局布线的拥塞问题呢?有哪些方法?
14.2节提到的问题①,即设计中有很大的扇出,对于如何获知该扇出信号有多种途径。常见的途径是通过FPGAEditor(Xilinx)或者Fitter里Resource Section


佰维存储晶圆级先进封测制造项目落地东莞松山湖!
晶圆级先进封测是指利用光刻,刻蚀,电镀,PVD,CVD,CMP,Strip等前期晶片制造工程,实现凸块(Bumping),重布线(RDL),扇入(Fan-in),扇出(Fan-out),硅通孔(TSV)这样的技术可以将芯片直接封装到晶片上,节约物理空间
解析扇入型封装和扇出型封装的区别
),通过RDL替代了传统封装下基板传输信号的作用,使得扇出型封装可以不需要基板而且芯片成品的高度会更低,所以扇出型封装的发明初衷其实是降低成本,而且由于扇出型封装在封装面积上没有扇入那

简单介绍硅通孔(TSV)封装工艺
在上篇文章中介绍了扇入型晶圆级芯片封装(Fan-In WLCSP)、扇出型晶圆级芯片封装(Fan-Out WLCSP)、重新分配层(RDL)封装、倒片(Flip Chip)封装,这篇文章着重介绍硅通孔(TSV)封装工艺。

扇出型晶圆级封装技术的优势分析
扇出型晶圆级封装技术的优势在于能够利用高密度布线制造工艺,形成功率损耗更低、功能性更强的芯片封装结构,让系统级封装(System in a Package, SiP)和3D芯片封装更愿意采用扇出型晶圆级封装工艺。
发表于 10-25 15:16
•349次阅读

半导体后端工艺:晶圆级封装工艺(上)
晶圆级封装是指晶圆切割前的工艺。晶圆级封装分为扇入型晶圆级芯片封装(Fan-In WLCSP)和扇出型晶圆级芯片封装(Fan-Out WLCSP),其特点是在整个封装过程中,晶圆始终保持完整。

一文详解扇出型晶圆级封装技术
扇出型晶圆级封装技术采取在芯片尺寸以外的区域做I/O接点的布线设计,提高I/O接点数量。采用RDL工艺让芯片可以使用的布线区域增加,充分利用到芯片的有效面积,达到降低成本的目的。扇出型封装技术完成芯片锡球连接后,不需要使用封装载板便可直接焊接在印刷线路板上,这样可以缩短信
发表于 09-25 09:38
•803次阅读

多芯光纤传感技术研究
陈未萍重点介绍了多芯光纤的设计、制造技术以及配套器件的制备技术。长盈通公司一直致力于特种光纤的研发与创新,其在多芯光纤预制棒制备领域采用的精密钻孔工艺,实现了高精度的芯间距尺寸排列,成功开发了低插入损耗的三芯

什么是BGA扇出 典型BGA 封装的内部结构
在 PCB 布局设计中,特别是BGA(球栅阵列),PCB扇出、焊盘和过孔尤为重要。扇出是从器件焊盘到相邻过孔的走线。
发表于 07-18 12:38
•1979次阅读
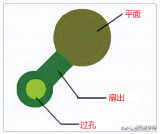
为什么光纤端面要研磨成8度角?
首先我们先了解一下光纤是如何传导光信号的。光纤裸纤的结构图一般分为三层:纤芯、包层和涂覆层。光纤纤芯和包层是由不同折射率的玻璃组成,中心为高
发表于 06-06 16:32
激光解键合在扇出晶圆级封装中的应用
来源;《半导体芯科技》杂志 作者:黄泰源、罗长诚、钟兴进,广东鸿浩半导体设备有限公司 摘要 扇出晶圆级封装广泛应用于手机、车载等电子产品上。制造过程中需要使用到暂时性基板,而移除暂时性基板最适





 如何解决多芯光纤的扇入扇出
如何解决多芯光纤的扇入扇出

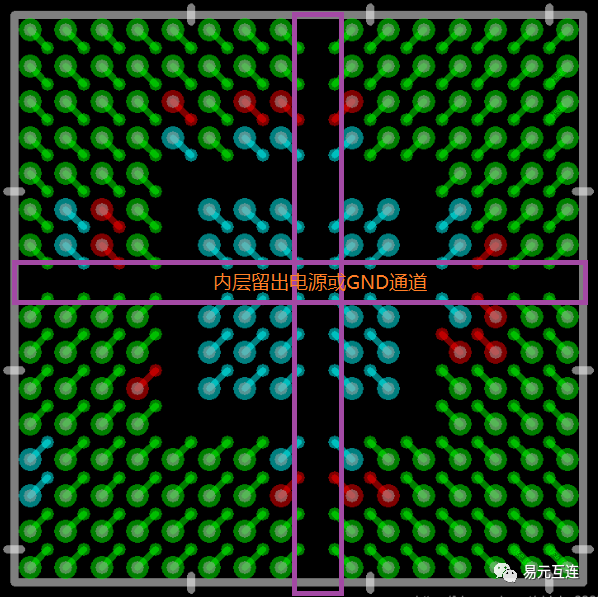










评论