电子封装正朝着更小尺寸、更强性能、更优电气和热性能、更高I/O数量和更高可靠性的方向飞速发展。然而,传统的Sn基焊料互连封装技术,尽管具有低键合温度和低成本等优势,其局限性也日益凸显,如焊料外溢、电气性能较差以及焊接温度导致的芯片或基板翘曲等问题。在这样的背景下,先进封装技术应运而生,成为推动半导体行业继续前行的关键力量。
一、集成电路封装发展概况
半导体业界已明确五大增长引擎,这些应用推动了电子封装技术的不断进步。移动和便携式设备,如智能手机、智能手表和笔记本电脑,要求封装尺寸更小、重量更轻,同时保持高性能和低功耗。高性能计算(HPC)则对处理速度和计算能力提出了更高要求。自动驾驶汽车和物联网(IoT)则需要高度集成、低功耗和长寿命的封装解决方案。大数据(云计算)和即时数据(边缘计算)应用则要求封装具有高带宽和低延迟。
目前,大规模回流焊工艺和热压焊技术是电子组件中两种广泛使用的互连封装技术。然而,Sn基焊料的电气性能较差,且焊接温度较高,容易导致芯片或基板翘曲,限制了其进一步发展。因此,业界迫切需要寻找新的封装技术,以满足未来应用的需求。
二、先进封装技术的诞生
随着集成电路产业的不断发展,摩尔定律在传统半导体行业面临挑战。为了维持半导体行业的发展,业界提出了More Moore和More than Moore两条路径。More Moore路径致力于晶体管的不断缩放以提高性能,而More than Moore路径则通过电路设计、系统算法优化或封装技术来提高芯片的性能。然而,随着先进制程逐渐向原子尺寸逼近,晶体管的制造难度呈指数级增加,且成本高昂,量产进度落后于预期。
在这样的背景下,先进封装技术登上历史舞台,成为拓展摩尔定律技术路线的重要方向。目前,已经出现许多先进的封装技术,如2-D扇出(芯片优先)IC集成、2-D倒装芯片集成、封装上封装(PoP)、封装中系统(SiP)、µ凸点3-D IC集成和无凸点3-D IC集成等。
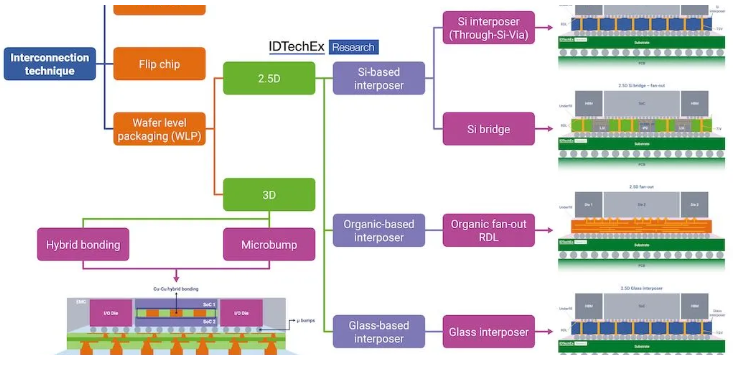
为了提高互连密度,IBM提出了倒装键合(Flip Chip)技术,利用焊锡凸点将芯片与芯片键合在一起。然而,当互连密度提高到一定地步时,焊点将很容易完全转化为金属间化合物(IMC),进而降低焊点的机械性能与导电性能。因此,业界开始探索铜铜直接键合技术,其中铜铜混合键合技术已经得到了应用。该技术将铜焊点镶嵌在介电材料中,并利用热处理同时键合两种材料,由于固态的铜原子会发生扩散,因而可以实现键合。整个过程一直处于固态,因此不会有桥接问题,且能显著提升焊点密度和降低信号传导所需的能量。
三、铜铜互联封装技术应用
硅通孔技术(TSV)
硅通孔技术是通过在硅孔中填充钨、铜、多晶硅等导电物质,形成垂直方向上的电气互连。TSV技术避免了长布线带来的尺寸限制和信号延迟等问题,有效减小了封装体的尺寸。相对于二维封装技术,TSV具有更强的电气性能、更高的堆叠密度和更宽的带宽,同时功耗更低。因此,TSV技术非常适合便携式电子产品和物联网/可穿戴设备等应用。
然而,TSV的填充工艺具有较大难度,因为硅通孔的孔径较小且比较深,高深宽比使得其有较大的表面张力,并且孔外的电流密度一般高于孔内,物质很难扩散到孔内部。因此,业内的科研人员围绕TSV的填充工艺展开了大量研究,以降低成本并提高沉积速率。
再布线层技术(RDL)
为了不断扩展摩尔定律,除了晶体管的新型纳米技术的发展外,2.5D和3D的先进封装技术也在快速发展。在集成扇出(InFO)封装中引入再分配层(RDL)可实现更好的集成能力和更低的成本。便携设备中芯片的厚度限制抑制了其散热能力,因此下一代移动应用需要提高热性能。预计由RDL技术制造的并排封装将是未来的移动封装解决方案,因为与PoP相比,并排结构可以增加芯片厚度,并且RDL可以通过用RDL代替传统印刷电路板(PCB)来提供小的形状因数,从而提高热性能。然而,需要解决与台阶高度、翘曲、底切和泄漏相关的关键挑战,以实现精细间距RDL集成。
电镀铜是RDL工艺制造的重要步骤之一。由于RDL具有直径小于50μm的盲孔和节距范围为50μm至20μm甚至更小的布线,因此通孔填充能力和均匀性仍然是该应用的主要挑战。
铜柱凸点技术
随着I/O密度的提高,传统的焊料凸块封装工艺已经无法满足使用需求。C2(Chip Connection)技术逐渐成为主流,与C4技术中的焊球相比,铜柱直径不受高度影响,因此可以进一步缩小节距。铜柱凸点的主要制作工艺包括物理气相沉积(PVD)、光刻、电镀、蚀刻和回流焊。铜柱凸点技术不仅提高了互连密度,还提升了电气性能和可靠性。
电镀键合技术
电镀键合技术是在两个微结构之间进行互连或接触的作用。使用这种电镀键合工艺可以应用于芯片封装。电镀键合技术通过将两个承载要连接的金属结构的基板连接在一起,然后浸入电镀溶液中并向通电层施加电势,使金属沉积在阴极并结合形成连接。多种金属电镀溶液可用于电镀接合,包括Cu、Au、Ni、Ni/Fe和多种其他金属。电镀键合技术具有工艺简单、成本低廉和可靠性高等优点,在先进封装技术中具有广泛的应用前景。
铜铜直接键合技术以其独特的优势,在先进封装技术中占据了重要地位。在键合过程中,铜一直处于固态,不会产生外溢,可实现窄节距互连。铜具有低电阻率、强抗电迁移能力、快速导热和优秀的机械性能等优点,同时具有良好的工艺兼容性和较低的成本。因此,铜铜直接键合技术可实现高密度、高可靠性的互连。
-
集成电路
+关注
关注
5446文章
12465浏览量
372682 -
先进封装
+关注
关注
2文章
517浏览量
972
原文标题:【芯片封装】先进封装铜互联技术,如何重塑电子世界?
文章出处:【微信号:深圳市赛姆烯金科技有限公司,微信公众号:深圳市赛姆烯金科技有限公司】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录





 先进封装技术推动半导体行业继续前行的关键力量
先进封装技术推动半导体行业继续前行的关键力量






















评论