本文是篇综述,回顾了学术界、工业界在解决2.5D封装热力问题上的努力。研究内容包含对翘曲应变、BGA疲劳寿命的仿真测试评估,讨论了材料物性、结构参数的影响。
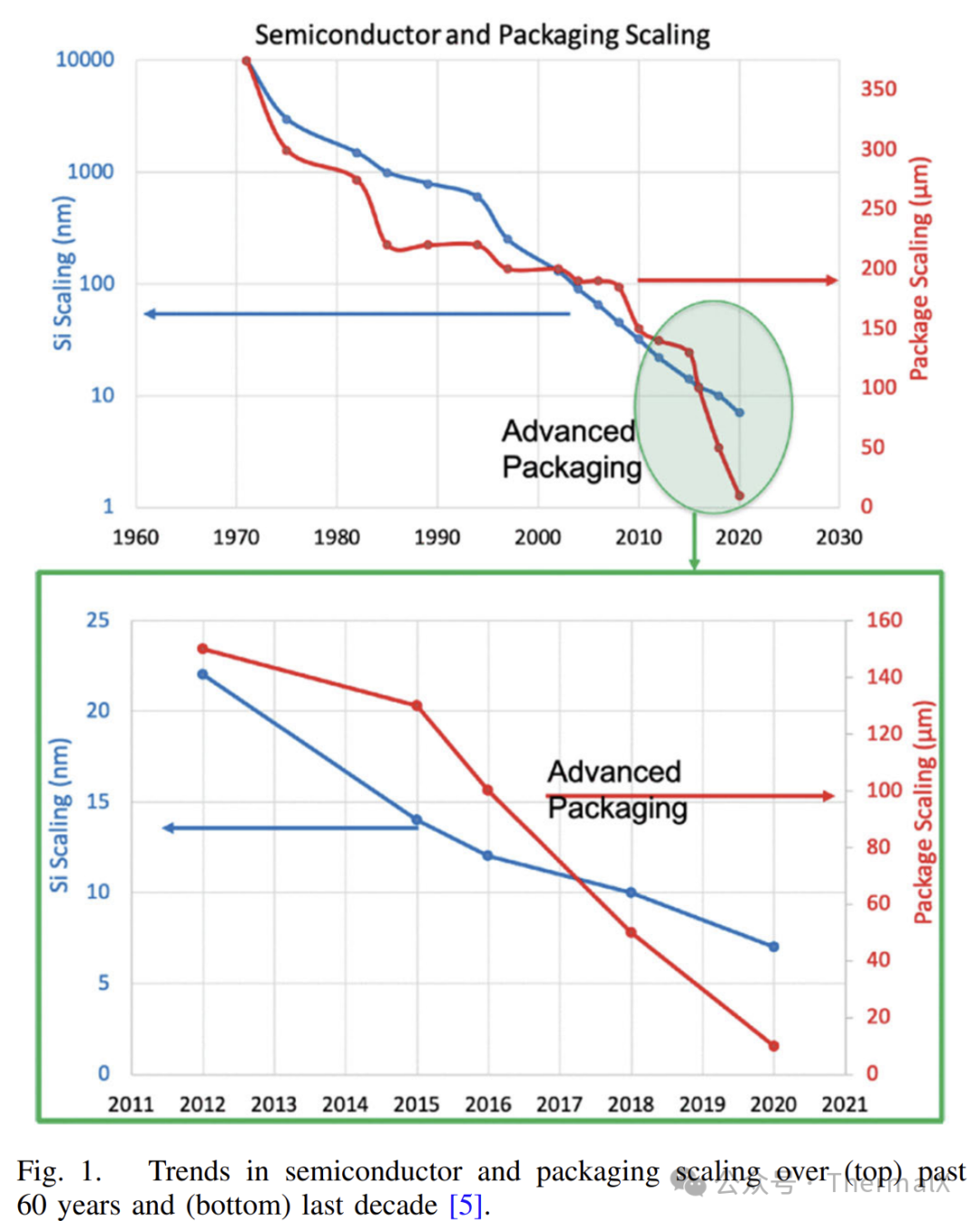
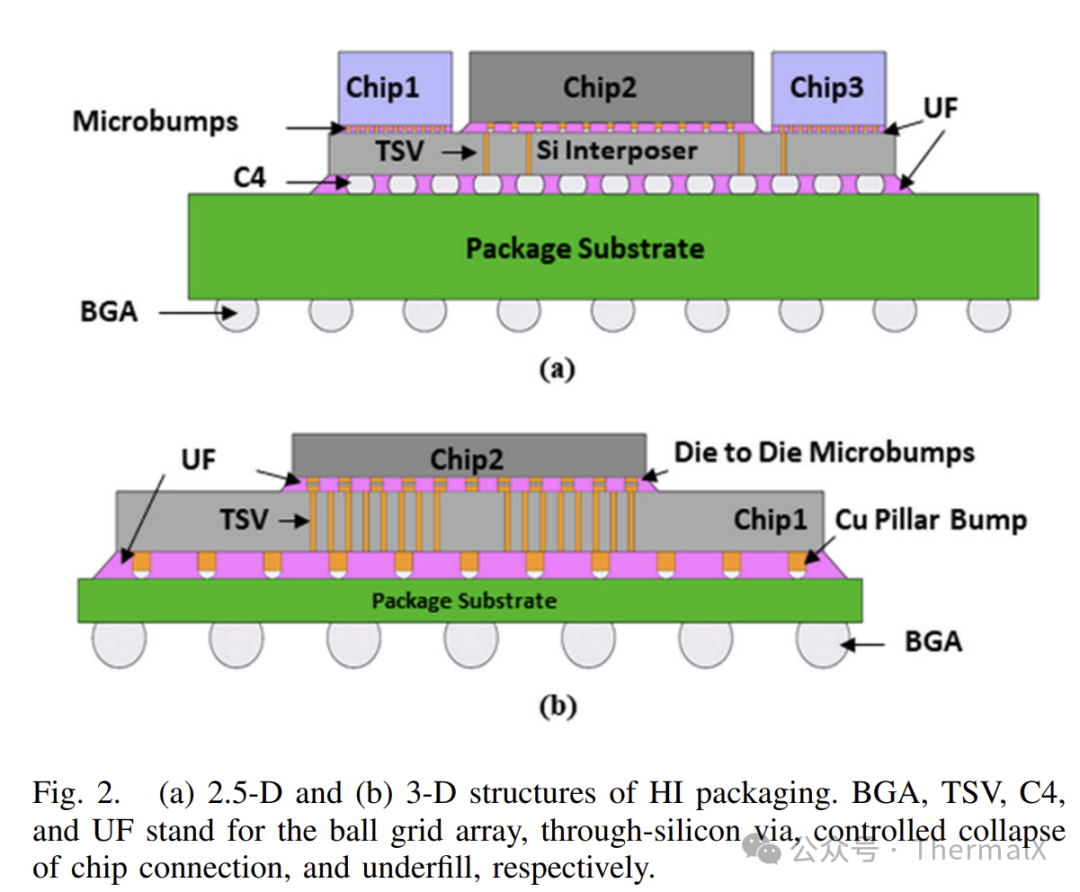
根据JEDEC,封装失效机理可分为三类:1)温度变化导致的热力;2)化学或电化学导致的金属腐蚀或迁移;3)高温下的老化。2.5D封装中,最主要的失效是第一类,因封装尺寸越来越大,各部件材料CTE的不匹配,会引起热变形或翘曲。翘曲不仅会导致焊球的non-wet或桥接,还会导致焊接界面的分层或断裂,当封装焊到PCB后,应力会导致BGA的疲劳失效。
翘曲有三类:
凸、凹、复杂翘曲。
翘曲的影响:
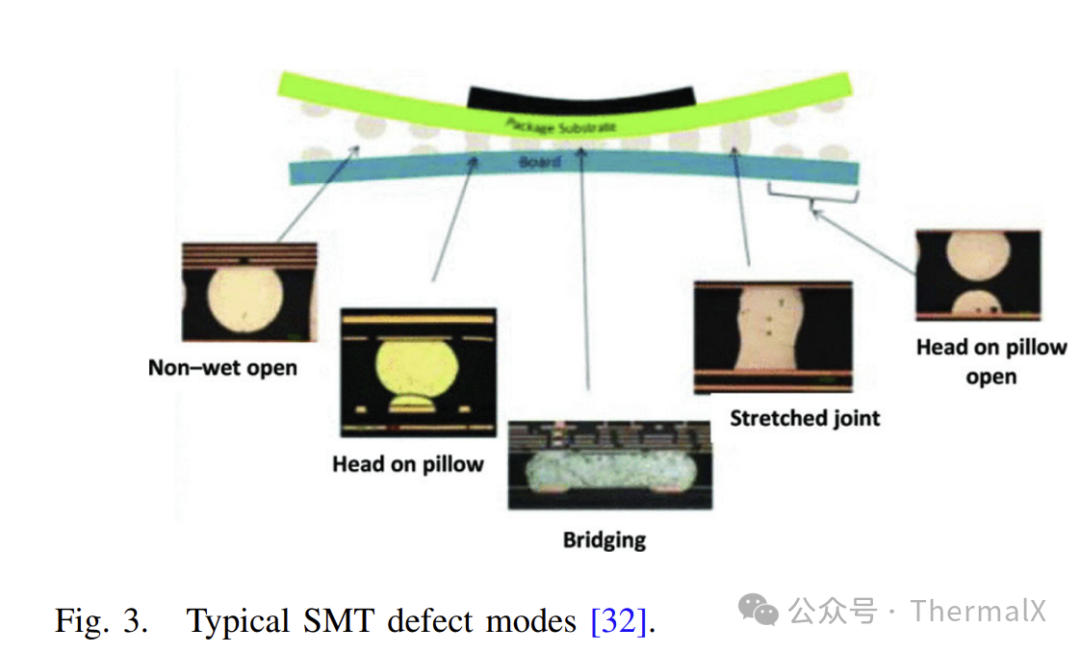
翘曲仿真一般都会做简化和等效,因此通过实验结果来验证仿真的准确性至关重要。
翘曲的测试方法:shadow morie,3DIC,激光反射,条纹投影。前两者应用最广:
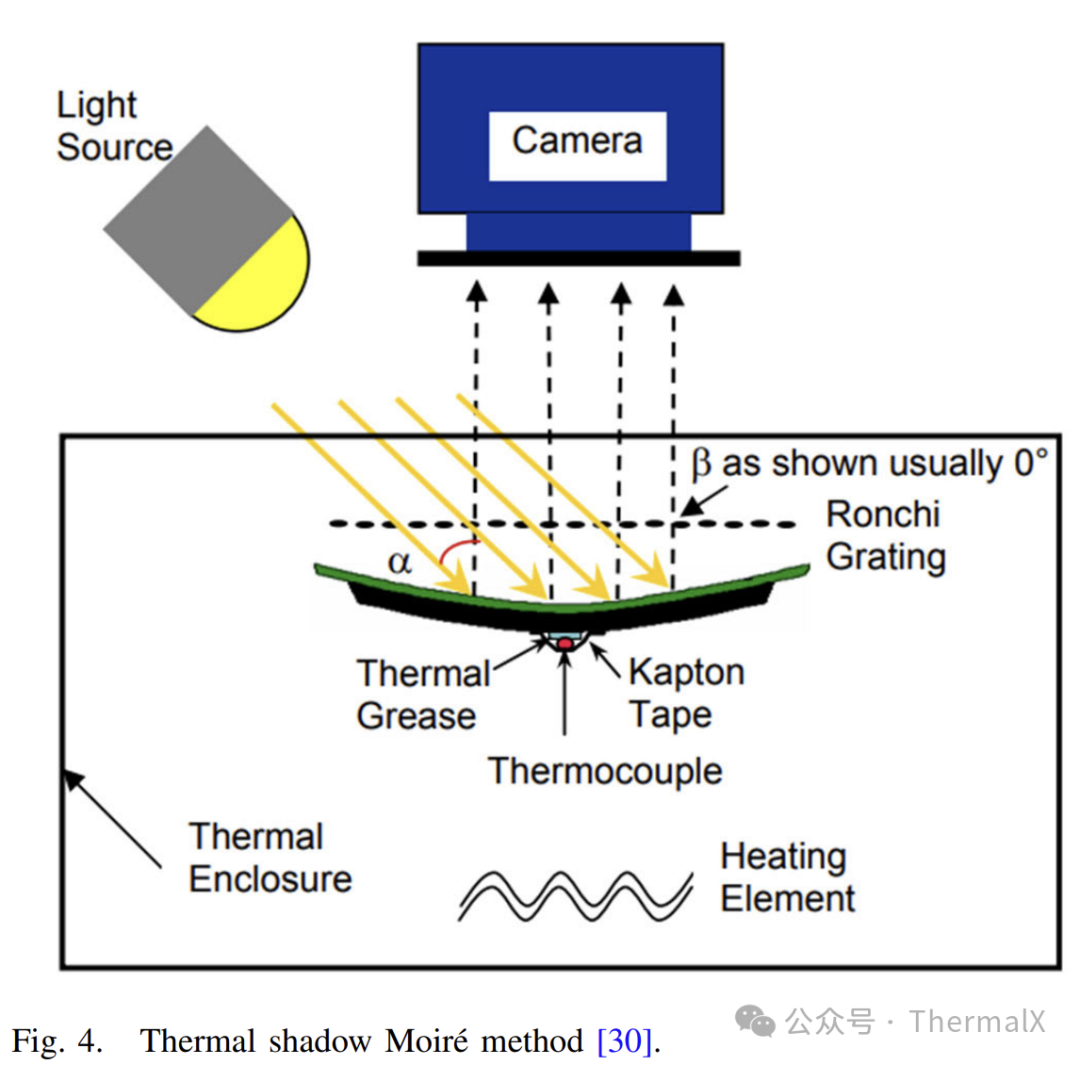

文章回顾了过往众多论文里控制翘曲的各种参数分析,包含材料物性、几何结构:

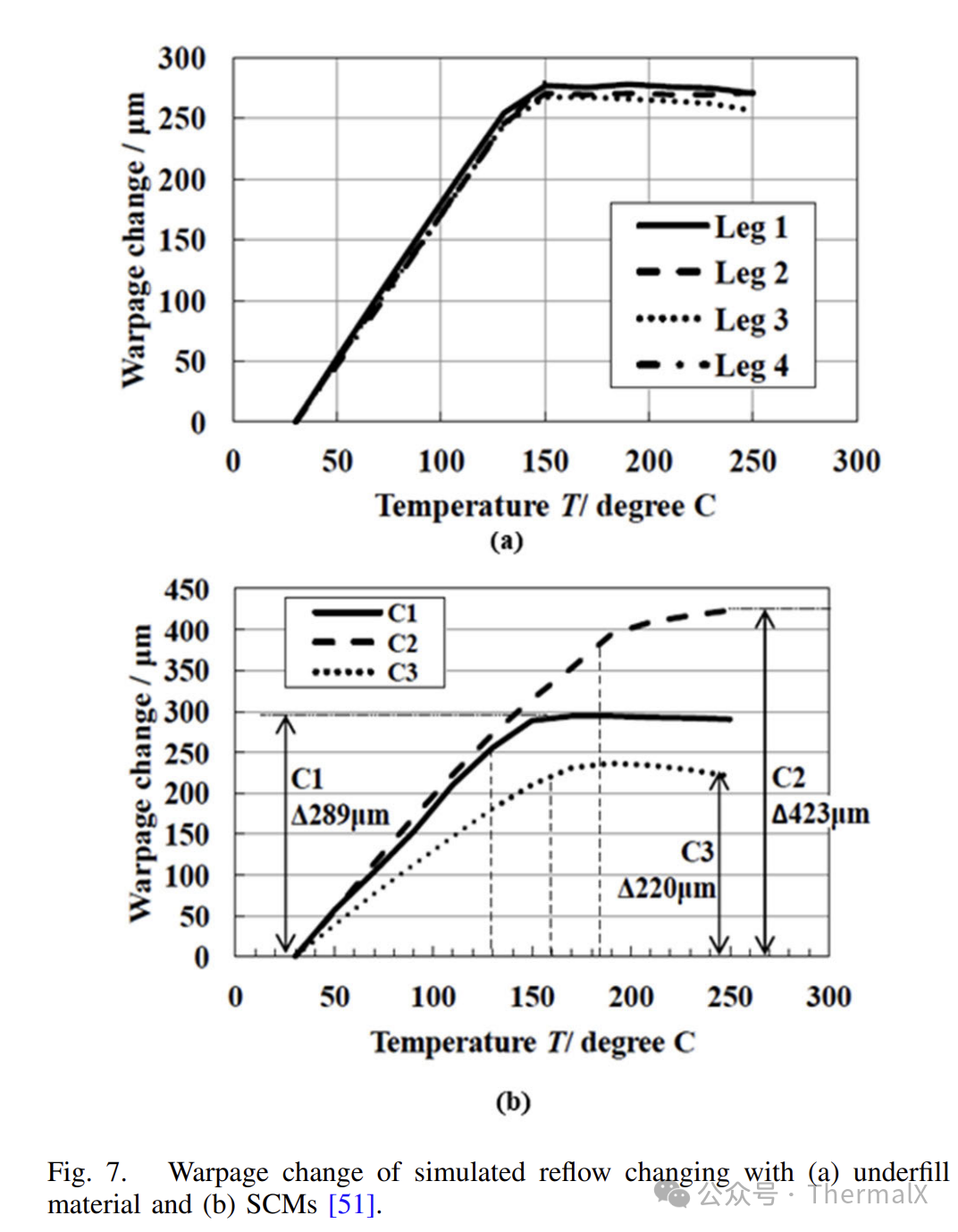
SCM:substrate core material.

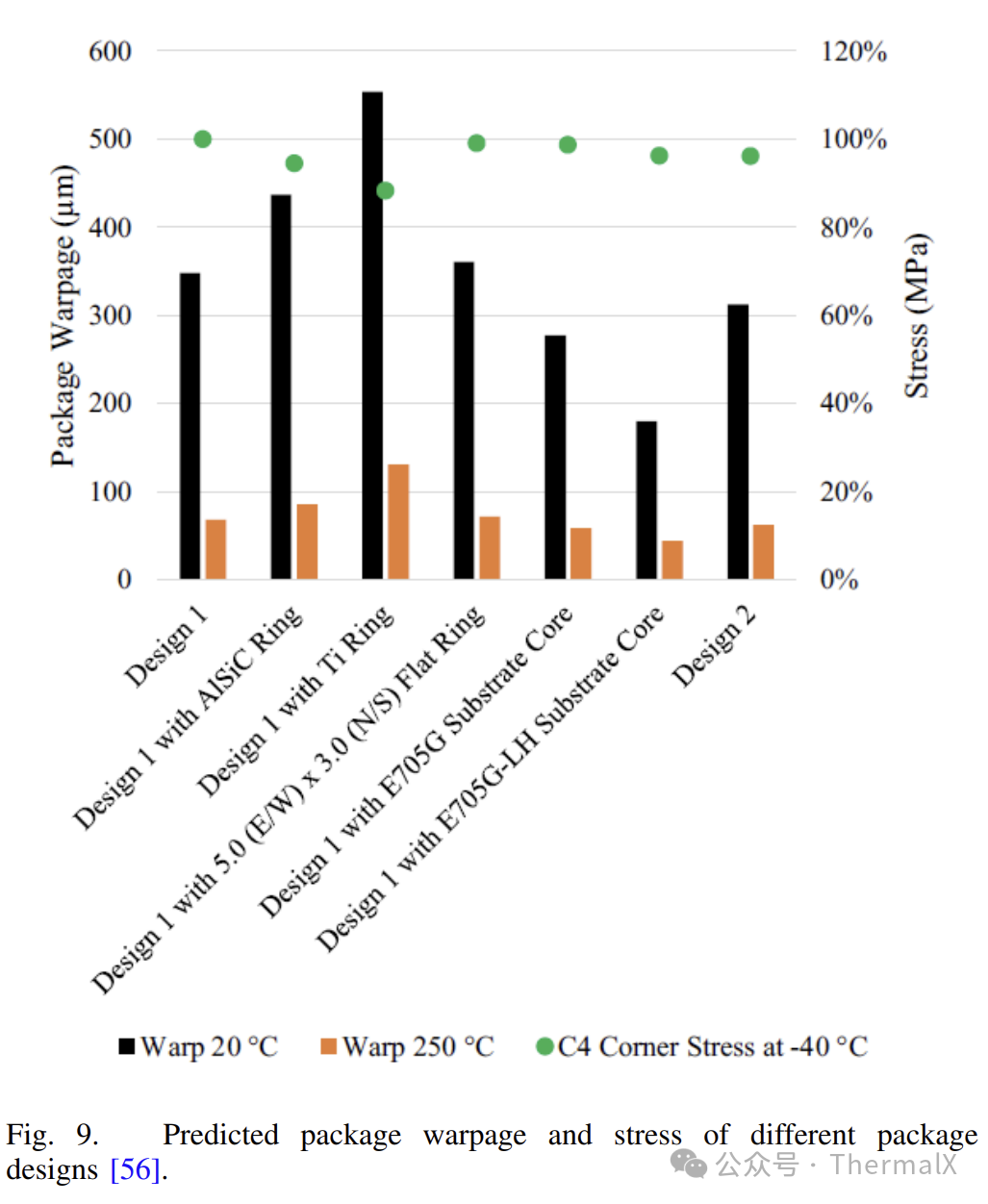

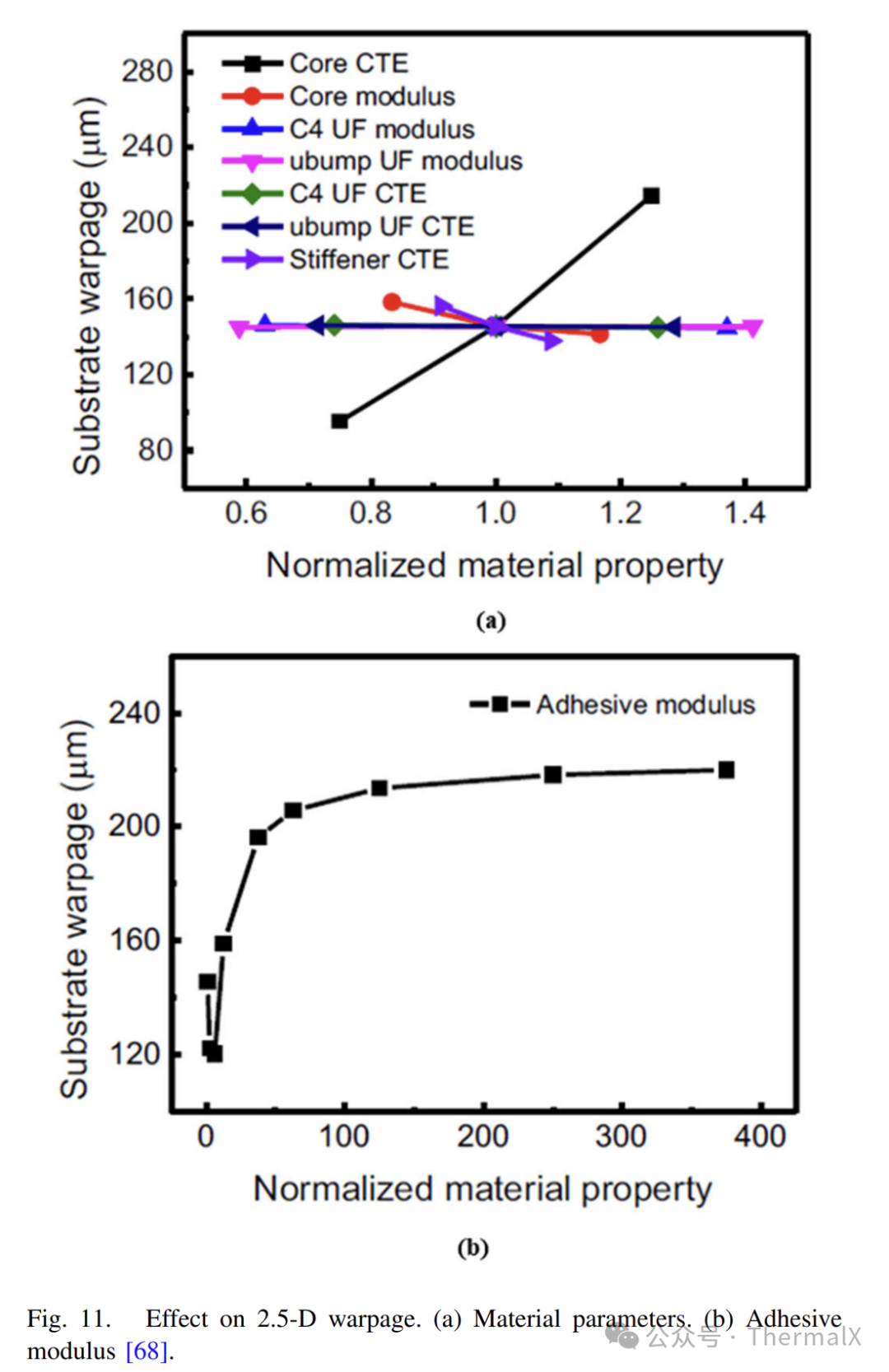
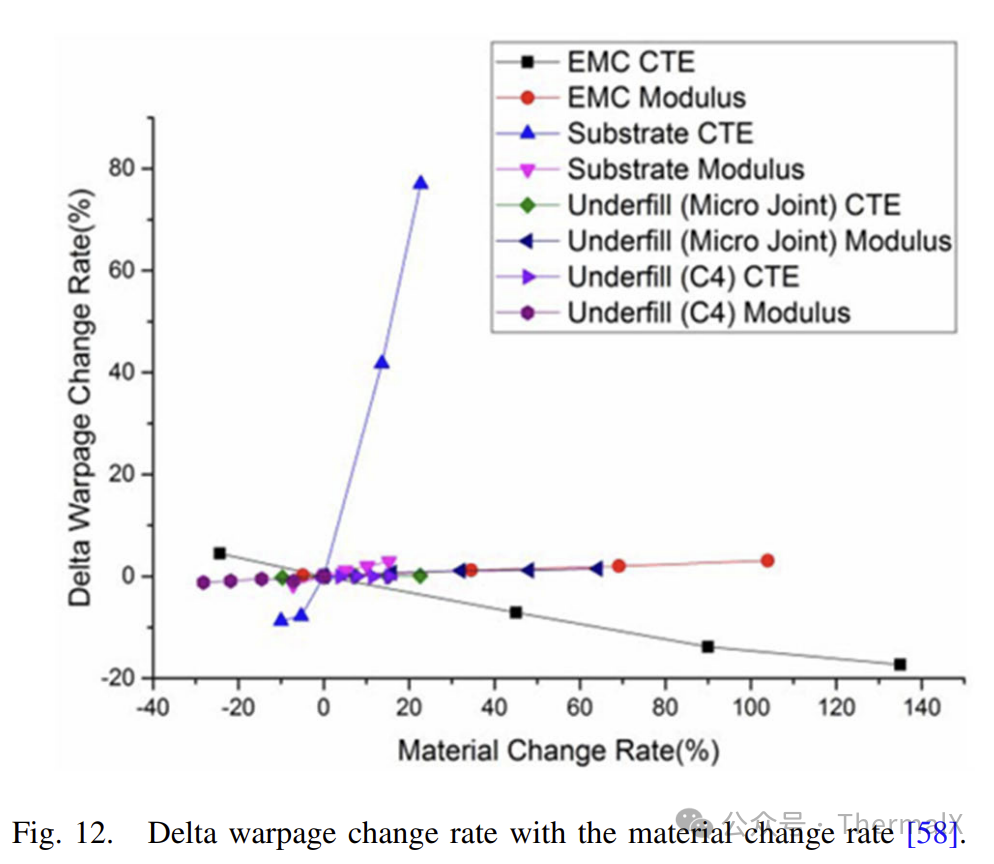
RA:Ring adhesive
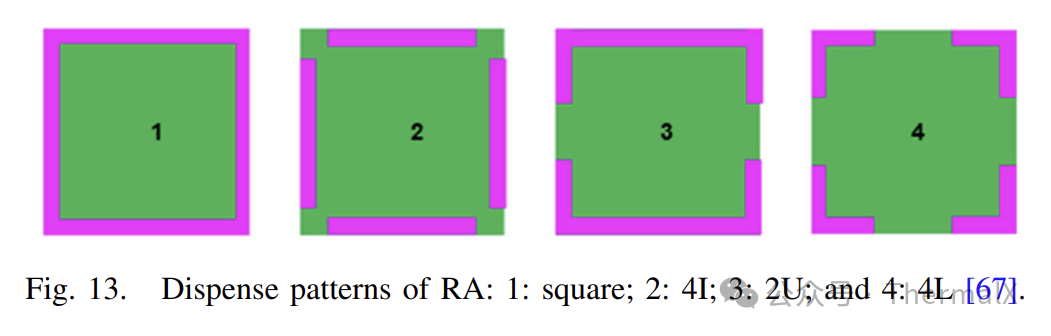
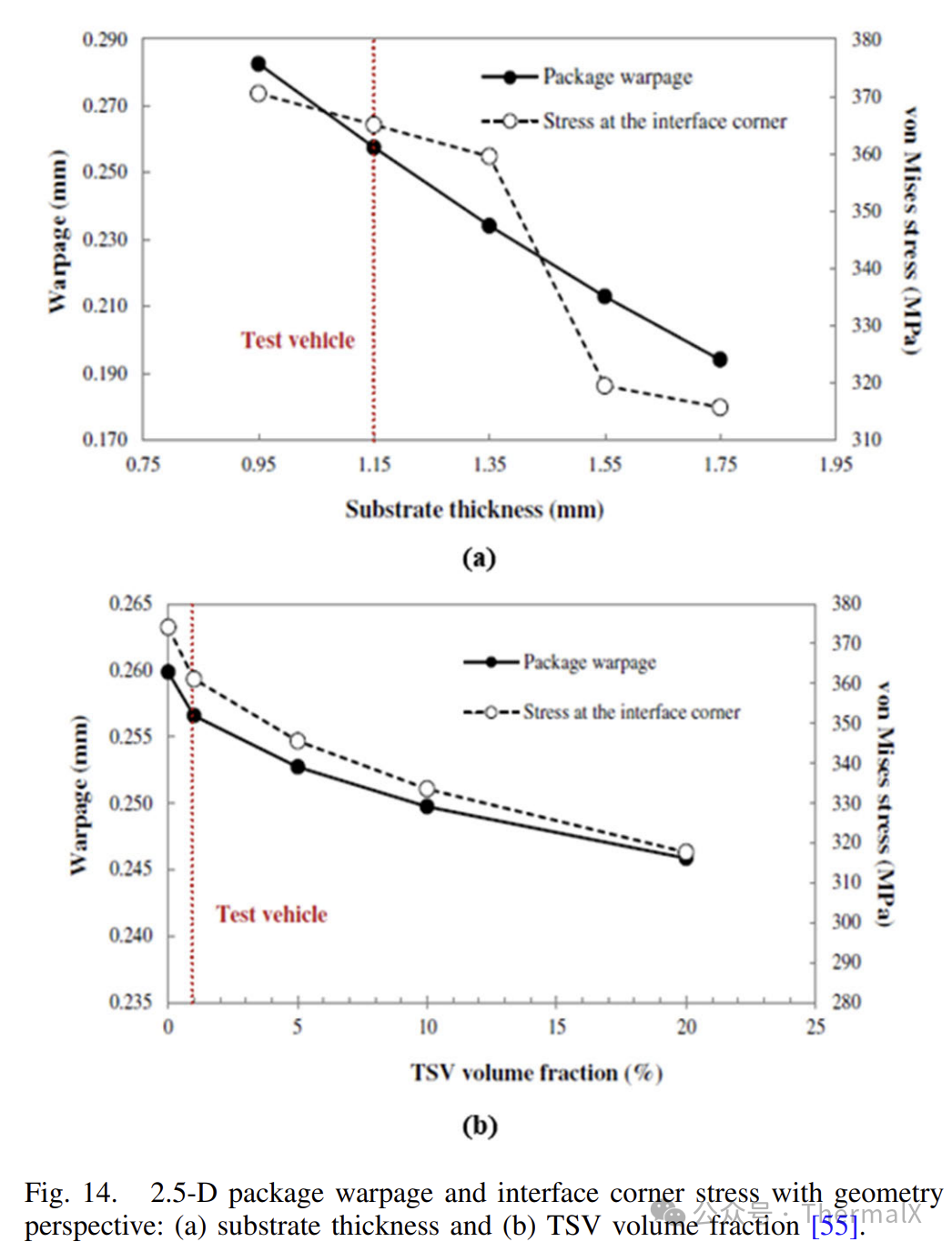
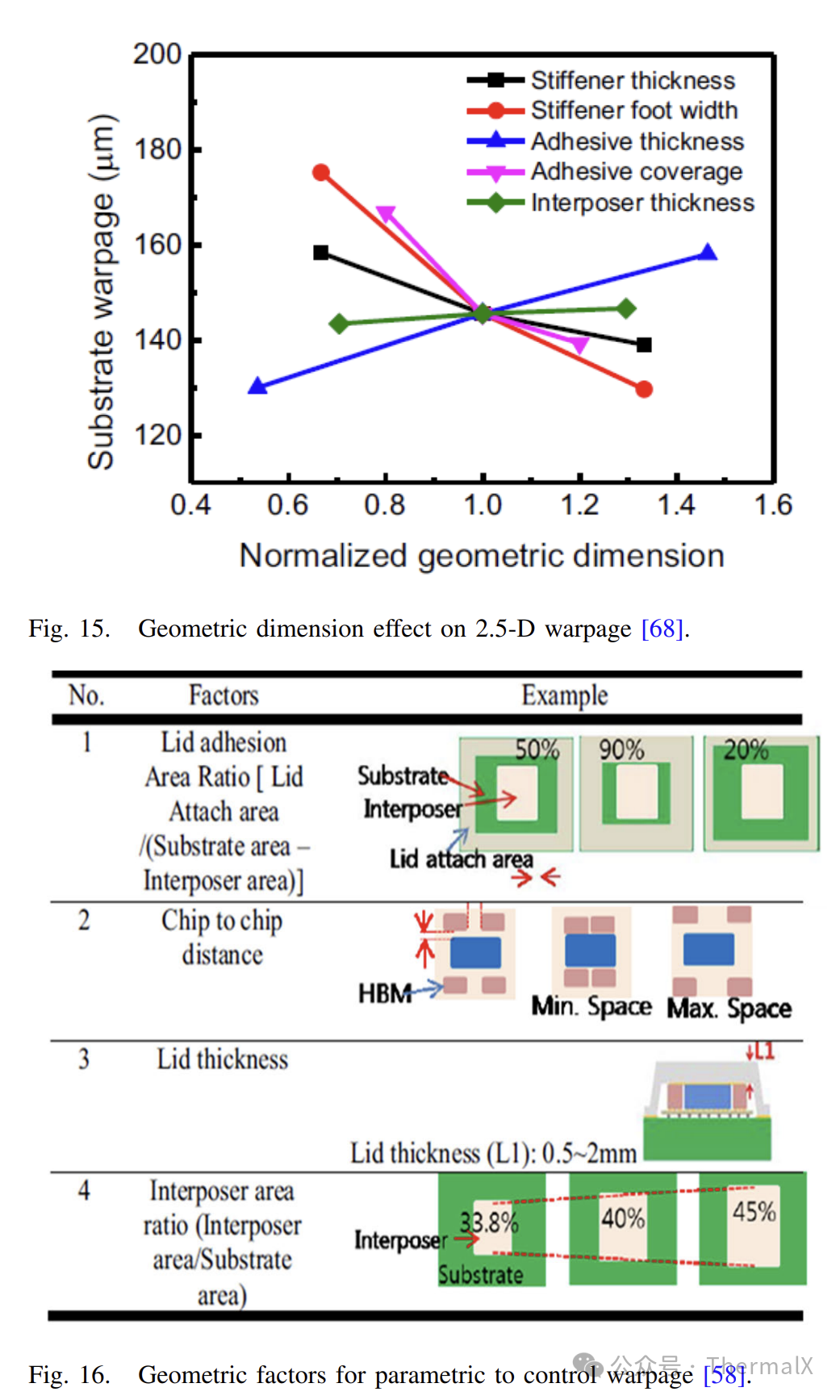
BGA疲劳寿命
焊点影响可靠性,从一些研究中,BGA相比C4或ubump的失效余量更小。本文主要分析thermal cycle和power cycle下BGA的疲劳失效。
Anand模型经常用来评估SAC合金的非弹性变形。Anand 模型是一个统一的temperature-dependent 粘塑性本构模型,考虑非弹性应变率、微观结构和变形阻力。
疲劳寿命仿真的输入为热循环负载,计算其引起的力学数据如冯米塞斯应力 、拉伸应力,塑性应变,应变能密度,蠕变应变和总应变。根据这些力学数据再结合一些模型就可以计算出寿命,例如Darveaux模型。
Darveaux模型通过计算非弹性应变能密度下的裂纹生长速率、裂纹开始时的次数,结合焊点长度,可得到焊点失效时的循环次数。

除了Darveaux模型,还有Syed模型、Coffin-Manson模型、Engelmaier–Wild模型等。
Thermal cycle的测试方法在JESD22-A104F
Power cycle的测试方法在JESD22-A122A
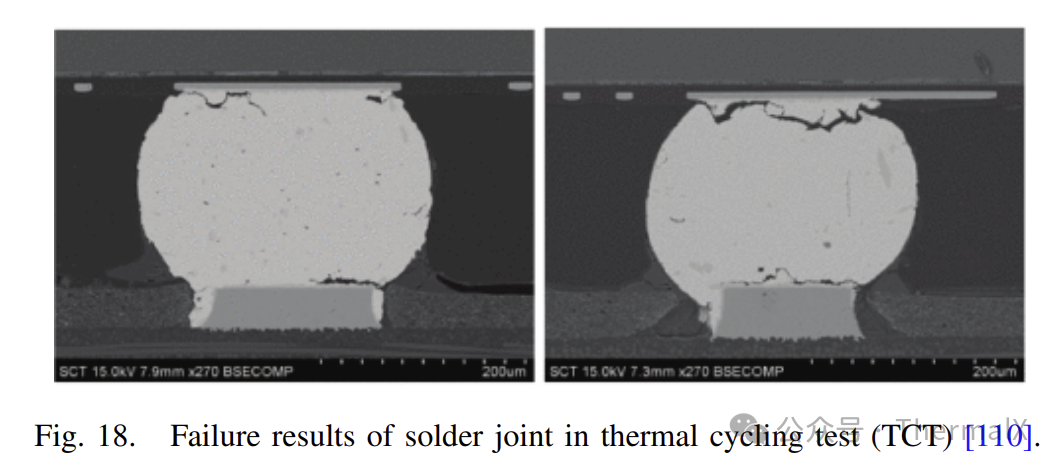
不同物性、结构参数下BGA疲劳寿命分析:
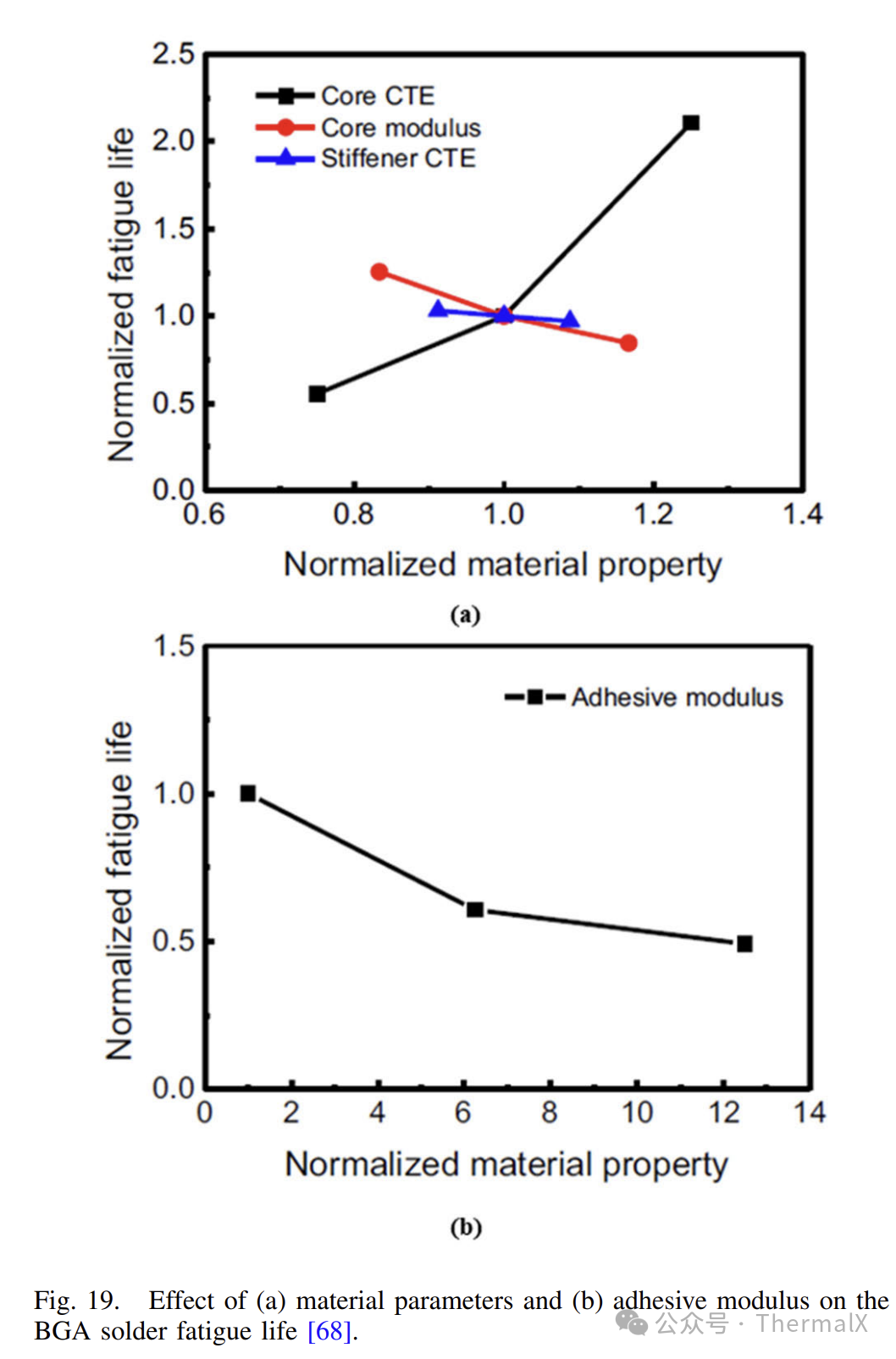
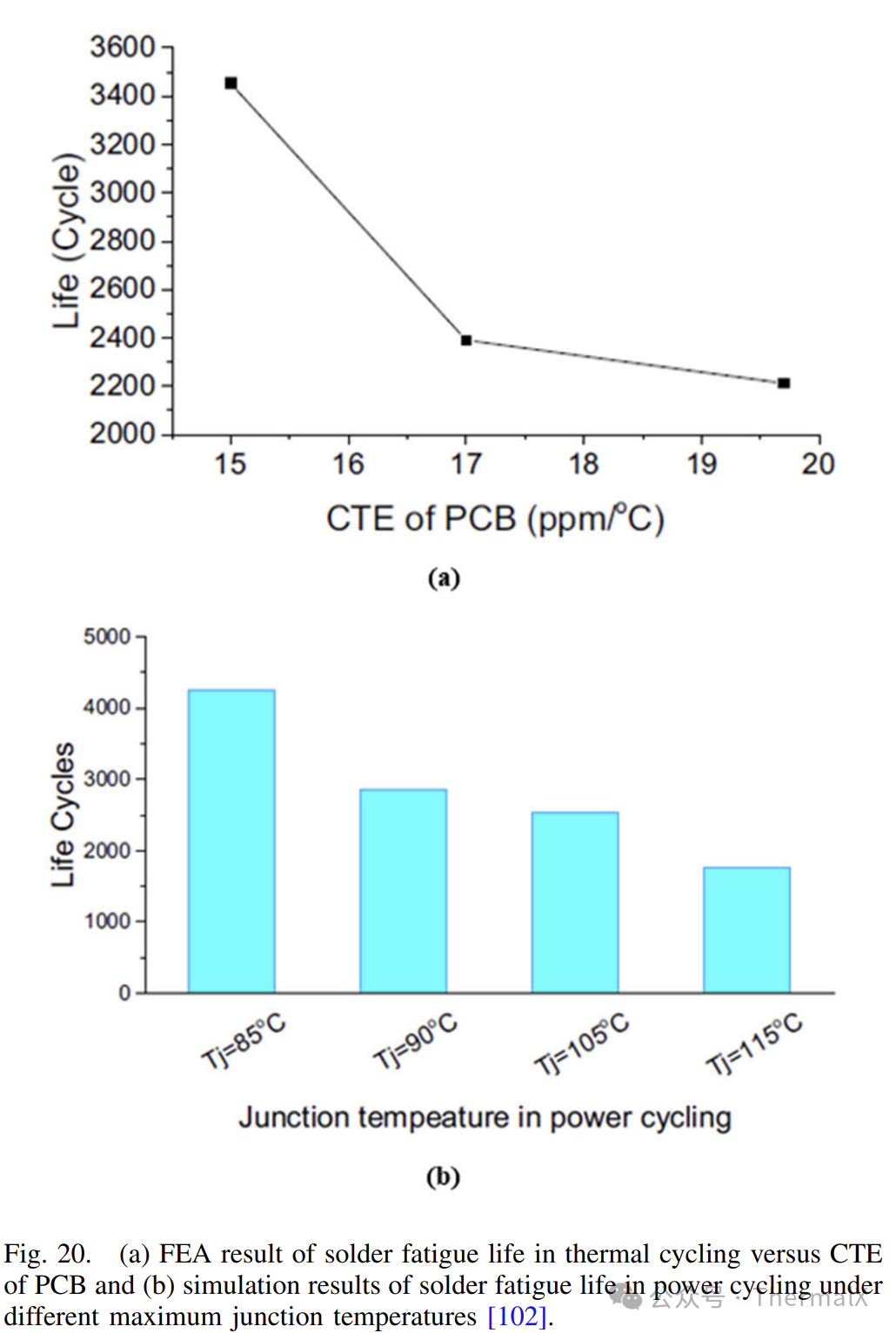
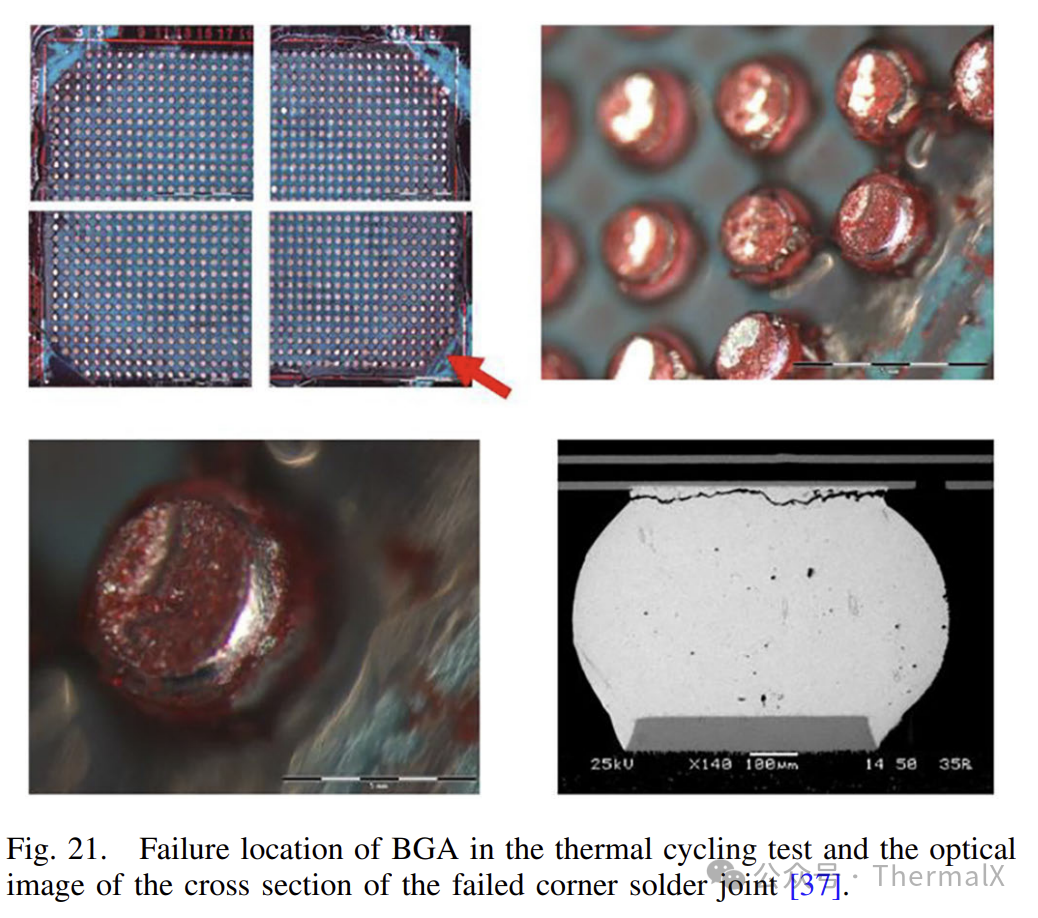
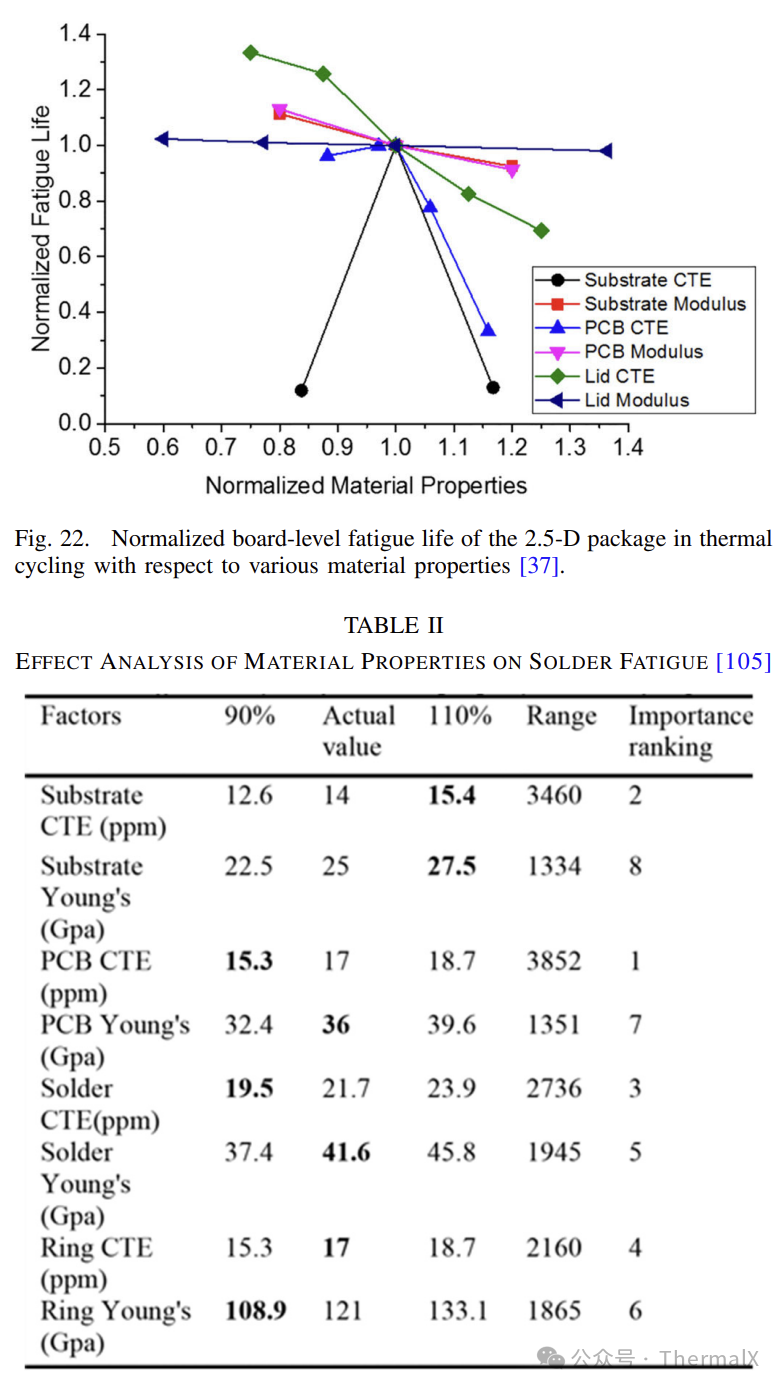
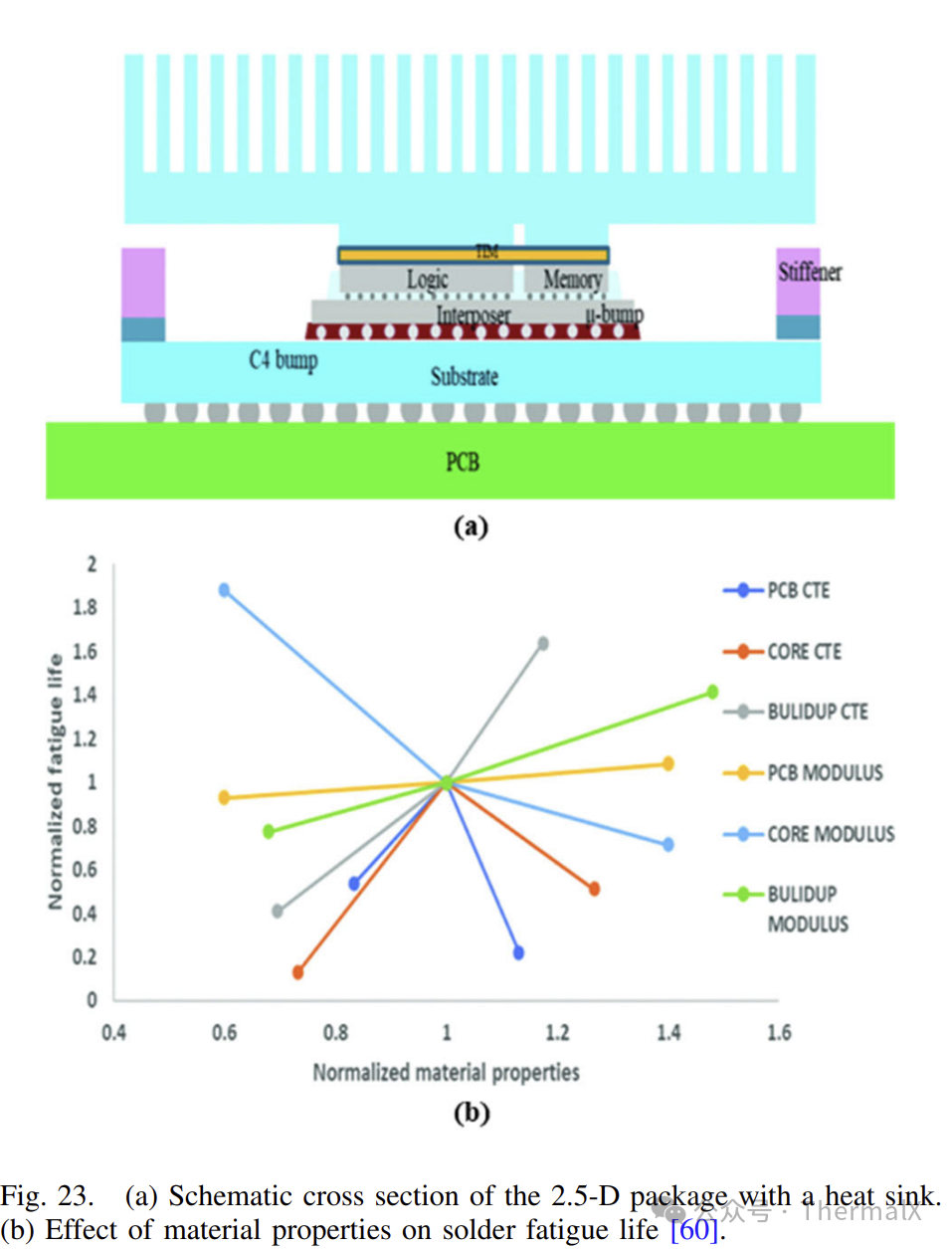
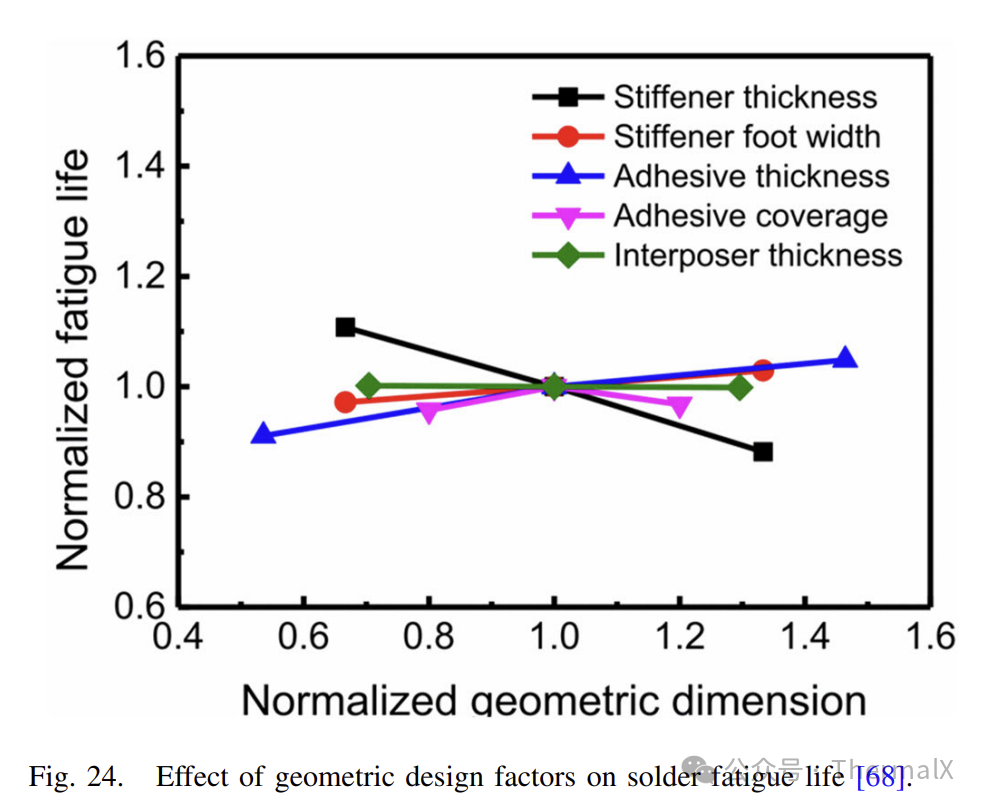
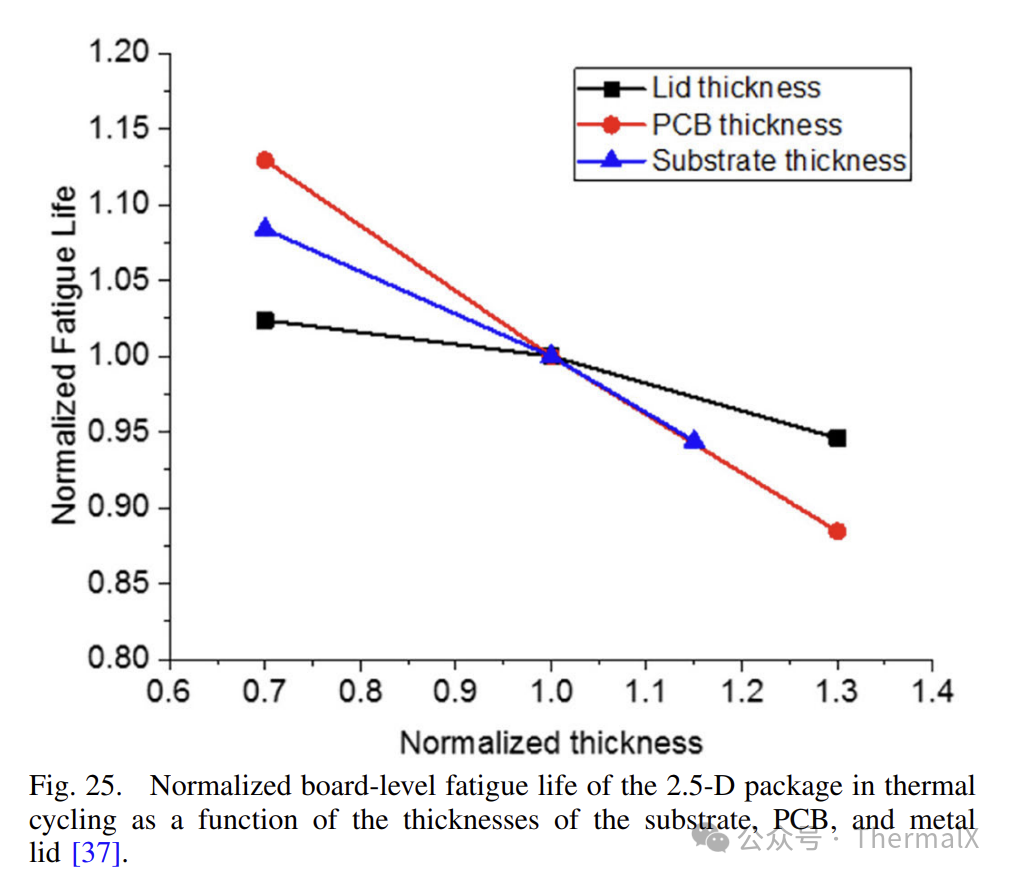
总结和展望
尽管对 2.5D 封装的翘曲和 BGA 疲劳寿命进行了诸多研究,但在准确预测封装行为方面仍存在挑战。虽然按照 JEDEC 标准中的测试条件可进行标准化实验测量,但由于缺乏全面的分析方法,仿真存在局限性。这阻碍了准确有效地评估各种参数对 2.5D 封装可靠性的影响,有限的准确性甚至可能导致相同材料和几何因素出现矛盾趋势。这些局限性的原因是多方面的,可归因于材料特性数据库不足、等效模型过于简化、封装组件间复杂的相互作用以及不同假设的理论模型。
-
BGA
+关注
关注
5文章
581浏览量
50957 -
2.5D封装
+关注
关注
0文章
24浏览量
449
原文标题:2.5D封装的热力挑战
文章出处:【微信号:深圳市赛姆烯金科技有限公司,微信公众号:深圳市赛姆烯金科技有限公司】欢迎添加关注!文章转载请注明出处。
发布评论请先 登录
2.5D集成电路的Chiplet布局设计

2.5D封装系统的存储计算

2.5D/3D芯片-封装-系统协同仿真技术研究
2.5D封装应力翘曲设计过程

智原推出2.5D/3D先进封装服务, 无缝整合小芯片
深入剖析2.5D封装技术优势及应用

最全对比!2.5D vs 3D封装技术
2.5D封装为何成为AI芯片的“宠儿”?






 2.5D封装的热力挑战
2.5D封装的热力挑战















评论