摘要
等离子体蚀刻工艺,特别适用于在具有非氧化物成分的特征上选择性蚀刻氧化物,例如氮化硅,尤其是当该特征具有在氧化物蚀刻期间易于刻面的角部时。主要的含氟气体,优选六氟丁二烯 (C4F6),与显着更大量的稀释气体氙 (Xe) 结合,可在不发生蚀刻停止的情况下提高氮化物的选择性。

发明领域
本发明一般涉及硅集成电路的蚀刻。特别地,本发明涉及在能够大大降低对氮化硅15和其他非氧化物材料的蚀刻速率但仍然在氧化物中产生垂直轮廓的工艺中蚀刻氧化硅和相关材料。
背景技术
在硅集成电路的制造中,芯片上器件数量的持续增加以及随之而来的最小特征尺寸的减小对制造过程中使用的许多制造步骤中的许多步骤提出了越来越困难的要求,包括 25 个不同的沉积层材料到有时困难的拓扑结构上。
氧化物蚀刻提出了一些最困难的挑战。氧化物是用于 30 二氧化硅,特别是二氧化硅 (SiO 2 ) 的有点通用的术语,尽管众所周知,还包括略微非化学计量的成分 SiO x 。
各向异性可以通过干式等离子体蚀刻来实现,其中蚀刻气体,通常是氟基气体,被电激发成等离子体。可以调整等离子体条件以在 60 多种材料中产生高度各向异性的蚀刻。然而,各向异性不应通过以纯溅射模式操作等离子体反应器来实现,其中等离子体以足够高的能量向晶片喷射粒子以溅射氧化物。
发明内容
在氟基氧化物蚀刻中使用氙 (Xe) 作为稀释气体提供了非常好的氮化物选择性和宽的工艺窗口,尤其是与六氟丁二烯 (C4F6) 结合使用时。对于氮化物选择性,氙气的量应该比碳氟化合物的量大得多。氪 (Kr) 承诺类似的效果。
优选实施例的详细描述
当在氟基氧化物蚀刻中用作稀释气体时,氙 (Xe) 表现出与氩 (Ar) 截然不同的行为。在 IPS 反应器中进行了一系列初步实验,其中质谱仪连接到腔室,同时 C4F6 与氦 (He)、Ar 或 Xe 的混合物进入腔室并在相当现实的条件下激发成等离子体激发功率和压力。

审核编辑:符乾江
-
半导体
+关注
关注
336文章
29977浏览量
258202 -
刻蚀
+关注
关注
2文章
217浏览量
13679
发布评论请先 登录





 氧化硅刻蚀速率的提高方法
氧化硅刻蚀速率的提高方法


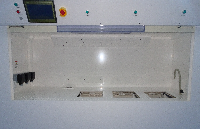













评论